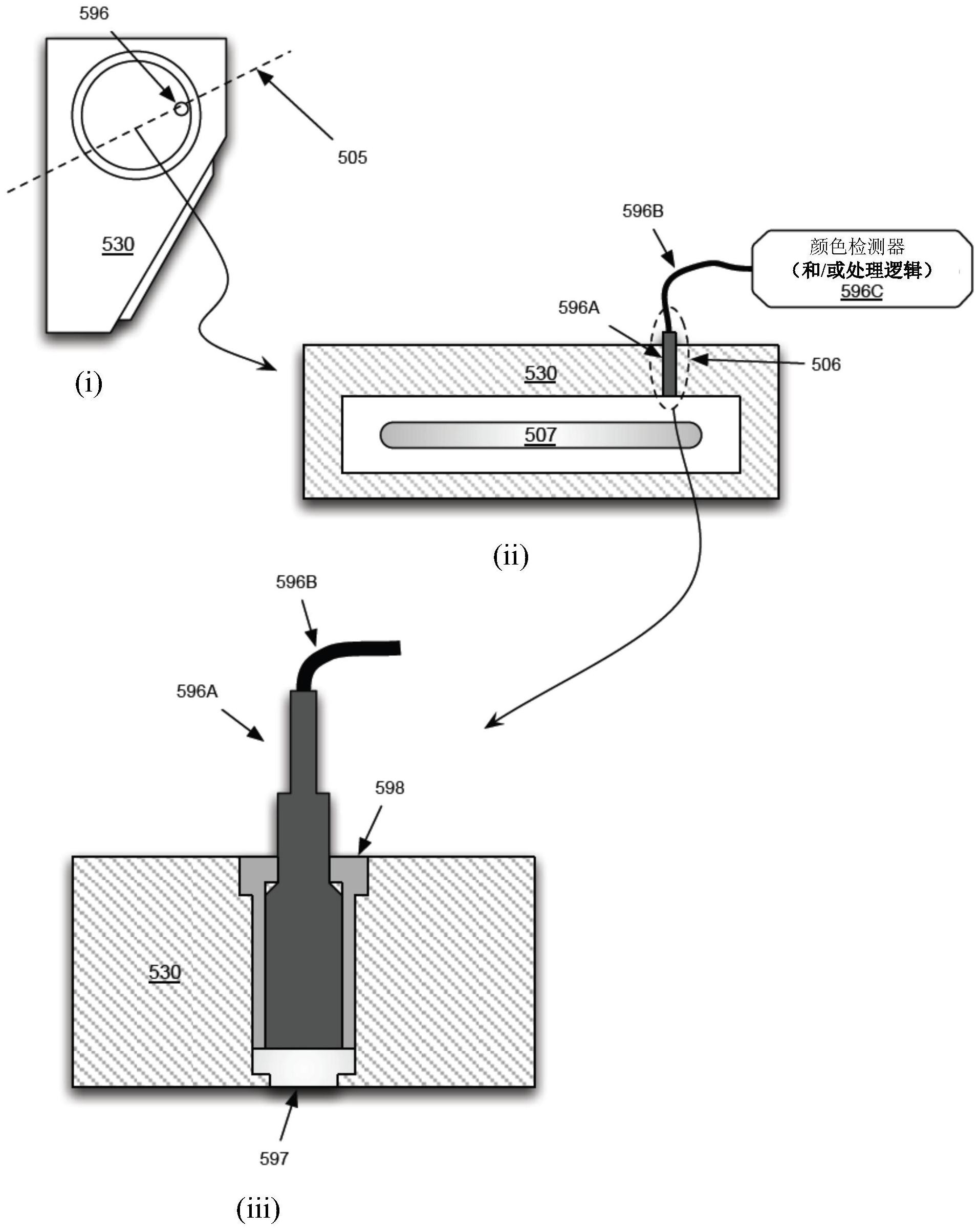
技术摘要:
本发明涉及通过颜色感测估计晶片上氧化物层还原效率的方法和装置。公开了制备具有用于随后电镀操作的金属晶种层的半导体衬底的方法。在一些实施方式中,该方法可以包括:使所述半导体衬底的表面与等离子体接触,以通过还原在该表面上的金属氧化物来处理该表面,之后, 全部
背景技术:
集成电路的制造通常涉及将导电金属层电镀到半导体晶片的表面上的一个或多 个步骤。例如,在一些集成电路(IC)制造程序中,可以使用电镀操作来用金属填充在半导体 晶片的表面中形成的、例如用作各种电路元件之间的导电路径的沟槽和通孔之类的各种特 征。电镀金属通常是铜,但是根据IC设计,其它金属可能是合适的和/或有利的,包括钌、钯、 铱、铑、锇、钴、镍、金、银和铝。在一些实施方式中,这些金属的合金可能是合适的和/或有利 的。 在典型的电镀操作中,晶片的表面暴露于包含待电镀的金属的溶解离子的电镀浴 液,并且在电镀浴中的电极(其用作阳极)和晶片的表面(其用作阴极)之间形成电路。在施 加外加电压时流过该电路的电流使电子流到阴极表面并将其附近的溶解的金属离子还原, 从而导致溶液中的中性元素金属电镀到晶片的表面上。 然而,为了实现该电路并且为了使溶解的金属离子的电化学还原发生,晶片的表 面(用作电路的阴极)必须至少在一定程度上相对导电。因此,由于半导体晶片的裸露表面 通常基本上不导电,所以在电镀操作中的实际电镀步骤通常先于沉积导电晶种层,导电晶 种层提供必要的导电表面。晶种层的沉积可以通过沉积晶种材料的任何可行方法来完成。 合适的方法可以包括例如物理气相沉积(PVD)、化学气相沉积(CVD)、等离子体增强化学气 相沉积(PECVD)、共形膜沉积(CFD)、原子层沉积(ALD)等。通常,晶种层沉积和电镀之后是边 缘斜面去除(EBR)操作,其通过在晶片的边缘上施加蚀刻剂溶液的薄粘性流而去除晶片边 缘处沉积的晶种金属,该晶种金属不期望存在于晶片边缘处。 然而,通常,在沉积晶种层之后,晶片从真空中移出并暴露于洁净室环境空气中。 在一些情况下,在晶片被电镀之前可能存在从几分钟到几小时的范围的排队时间。延迟时 间以及对环境空气的相关暴露会导致晶种层的氧化-通常称为“晶种老化”。这样的由晶种 老化产生的基本上不导电的氧化物层会降低电镀效率或者甚至防止电镀发生。此外,晶片 的表面润湿特性也可能改变,这也促成晶片上的缺陷。由于太多的预电镀晶种老化,因而在 图案晶片上,已经看到电镀后的孔隙和凹陷,这导致无用的IC器件,并因此负面地影响总晶 片产率。此外,观察到,例如在较低技术节点(例如,22nm以下)中,晶种老化效应恶化,其中 晶种层通常非常薄,例如在一些情况下为50埃或更小。也可以看到晶种溶解和电流密度的 4 CN 111739814 A 说 明 书 2/28 页 降低,其中在局部区域中的晶种越薄,则进入具有较高的、较致密的图案密度的通孔和沟槽 越深,从而也导致电镀晶片后的缺陷。因此,已经开发了用于处理氧化物层还原和/或去除 的方法和装置,并且本文公开了对这些方法和装置的进一步改进。
技术实现要素:
本文公开了制备具有用于随后电镀操作的金属晶种层的半导体衬底的方法。在一 些实施方式中,所述方法可以包括:使所述半导体衬底的表面与等离子体接触,以通过还原 在所述表面上的金属氧化物来处理所述表面,之后,从所述表面测量等离子体接触后的颜 色信号,所述颜色信号具有一个或多个颜色分量。所述方法然后可以进一步包括:基于所述 等离子体接触后的颜色信号估计由于所述等离子体处理而导致的氧化物还原的程度。在一 些实施方式中,基于所述等离子体接触后的颜色信号的b*分量来估计由于所述等离子体处 理而导致的所述氧化物还原的程度。 还公开了用于还原存在于准备用于随后的电镀操作的半导体衬底的金属晶种层 的表面上的金属氧化物的等离子体处理装置。在一些实施方式中,所述装置可以包括:处理 室,在所述处理室内具有至少一个处理站;衬底保持器,其构造成将衬底保持在所述处理站 处;等离子体产生器,其构造成产生在所述处理室内的等离子体并且/或者将等离子体提供 给所述处理室;以及颜色传感器,其被配置为从衬底测量颜色信号,所述颜色信号具有一个 或多个颜色分量。所述装置可以进一步包括:具有非暂时性计算机可读指令的控制器,其用 于操作所述装置以及其各种部件。在一些实施方式中,所述控制器可以包括用于下述操作 的指令:操作所述等离子体产生器以产生在所述处理室内的等离子体并且/或者将等离子 体提供给所述处理室,使得所述等离子体在所述处理站处接触衬底的表面,以通过还原在 所述表面上的金属氧化物来处理所述表面。在一些实施方式中,可以包括用于下述操作的 指令:在所述等离子体与所述衬底的表面接触之后,操作所述颜色传感器以从所述表面测 量等离子体接触后的颜色信号,所述颜色信号具有一个或多个颜色分量。在一些实施方式 中,可以包括用于下述操作的指令:基于所述等离子体接触后的颜色信号估计由于所述等 离子体处理而导致的氧化物还原的程度。在一些实施方式中,所述装置的所述颜色传感器 可以被定位和/或被配置以便在所述衬底位于所述处理站时从所述衬底测量所述颜色信 号。在一些实施方式中,所述装置还可以包括:加载锁,其配置成提供通向所述处理室的衬 底入口;以及所述颜色传感器可以被定位和/或配置为在所述衬底位于所述加载锁内时从 所述衬底测量所述颜色信号。 具体而言,本发明的一些方面可以阐述如下: 1.一种制备具有用于随后电镀操作的金属晶种层的半导体衬底的方法,所述方法包 括: -使所述半导体衬底的表面与等离子体接触,以通过还原在所述表面上的金属氧化物 来处理所述表面; -在与所述等离子体接触之后,从所述表面测量等离子体接触后的颜色信号,所述颜色 信号具有一个或多个颜色分量;以及 -基于所述等离子体接触后的颜色信号估计由于所述等离子体处理而导致的所述氧化 物还原的程度。 5 CN 111739814 A 说 明 书 3/28 页 2.根据条款1所述的方法,其中基于所述等离子体接触后的颜色信号的b*分量来估计 由于所述等离子体处理而导致的所述氧化物还原的所述程度。 3.根据条款1所述的方法,其中估计由于所述等离子体处理而导致的所述氧化物还原 的所述程度包括: -将所述等离子体接触后的颜色信号与一个或多个基准颜色信号进行比较。 4.根据条款3所述的方法,其中所述比较是基于所述颜色信号的b*分量进行的。 5.根据条款1所述的方法,其中估计由于所述等离子体处理而导致的所述氧化物还原 的所述程度包括: -计算一个或多个度量,所述度量中的每个指示所述等离子体接触后的颜色信号和来 自成组的一个或多个基准颜色信号的基准颜色信号之间的差异。 6.根据条款5所述的方法,其中每个度量与所述等离子体接触后的颜色信号的b*分量 和基准颜色信号的b*分量之间的差的绝对值单调地相关。 7.根据条款1-6中任一项所述的方法,其还包括: -在与所述等离子体接触之前,从所述表面测量等离子体接触前的颜色信号,所述颜色 信号具有一个或多个颜色分量;并且其中估计由于所述等离子体处理而导致的所述氧化物 还原的所述程度包括: -比较所述等离子体接触前的颜色信号和所述等离子体接触后的颜色信号。 8.根据条款7所述的方法,其中所述比较是基于所述颜色信号的b*分量进行的。 9.根据条款7所述的方法,其中估计由于所述等离子体处理而导致的所述氧化物还原 的所述程度包括: -计算指示所述等离子体接触前的颜色信号和所述等离子体接触后的颜色信号之间的 差异的度量。 10.根据条款9所述的方法,其中所述度量与所述等离子体接触前的颜色信号的b*分量 和所述等离子体接触后的颜色信号的b*分量之间的差的绝对值单调地相关。 11.根据条款1-6中任一项所述的方法,其中所述等离子体包含氢自由基。 12.根据条款1-6中任一项所述的方法,其中所述金属是铜。 13.根据条款1-6中任一项所述的方法,其中所述金属是钴。 14.根据条款1-6中任一项所述的方法,其中测量所述等离子体接触后的颜色信号在所 述测量期间使用位于距离所述衬底表面约0.1英寸-5英寸处的颜色传感器来执行。 15.根据条款14所述的方法,其中测量所述等离子体接触后的颜色信号在所述测量期 间使用位于距离所述衬底表面约0.4英寸-1英寸处的颜色传感器来执行。 16.一种用于还原存在于准备用于随后的电镀操作的半导体衬底的金属晶种层的表面 上的金属氧化物的等离子体处理装置,所述装置包括: -处理室,在所述处理室内具有至少一个处理站; -衬底保持器,其构造成将衬底保持在所述处理站处; -等离子体产生器,其构造成产生在所述处理室内的等离子体并且/或者将所述等离子 体提供给所述处理室; -颜色传感器,其被配置为从衬底测量颜色信号,所述颜色信号具有一个或多个颜色分 量;以及 6 CN 111739814 A 说 明 书 4/28 页 -具有非暂时性计算机可读指令的控制器,所述非暂时性计算机可读指令用于: -操作所述等离子体产生器以产生在所述处理室内的等离子体并且/或者将所述等离 子体提供给所述处理室,使得所述等离子体在所述处理站接触衬底的表面,以通过还原在 所述表面上的金属氧化物来处理所述表面; -在所述等离子体与所述衬底的表面接触之后,操作所述颜色传感器以从所述表面测 量等离子体接触后的颜色信号,所述颜色信号具有一个或多个颜色分量;以及 -基于所述等离子体接触后的颜色信号估计由于所述等离子体处理而导致的所述氧化 物还原的程度。 17.根据条款16所述的装置,其中所述颜色传感器被定位和/或被配置以便在所述衬底 位于所述处理站时从所述衬底测量所述颜色信号。 18.根据条款16所述的装置,其还包括: -加载锁,其配置成提供通向所述处理室的衬底入口;以及 其中所述颜色传感器被定位和/或配置以便在所述衬底位于所述加载锁内时从所述衬 底测量所述颜色信号。 19.根据条款16-18中任一项所述的装置,其中,所述颜色传感器被配置为测量具有b* 颜色分量的颜色信号。 20.根据条款19所述的装置,其中,估计由于所述等离子体处理而导致的所述氧化物还 原的所述程度基于所述等离子体接触后的颜色信号的所述b*分量来进行。 21.根据条款16-18中任一项所述的装置,其中所述等离子体产生器远离所述处理室。 附图说明 图1A是制备具有用于随后电镀操作的金属晶种层的半导体衬底的方法的流程图, 其包括测量至少一种颜色信号。 图1B是制备具有用于随后电镀操作的金属晶种层的半导体衬底的另一方法的流 程图,其包括测量至少两种颜色信号。 图2示意性地示出了使用“a*”、“b*”和“L*”颜色分量的三色分量颜色空间。 图3预设了图解一种电镀方法的更详细的流程图,该方法包括等离子体预处理和 与图1A和1B所示的操作类似的用于估计预处理中氧化物还原程度的操作。 图4示出了等离子体处理装置的示例的横截面示意图。 图5A示意性地示出了具有4个处理站的多站式等离子体处理装置。 图5B(i)示出了其中安装有颜色传感器的等离子体处理装置的加载锁的示意图。 图5B(ii)示出了显示颜色传感器在加载锁内的定位的竖直横截面示意图(如图5B (i)中的虚线505所示)。 图5B(iii)示出了详细显示颜色传感器的光纤头的竖直横截面示意图(放大的,如 图5B(ii)中的虚线椭圆506所示的)。 图6A示出了图解处理具有金属晶种层的衬底的方法的示例性流程图。 图6B示出了图解处理具有金属晶种层的衬底的另一方法的示例性流程图。 图7A-7D示出了图解使用等离子体处理装置处理具有金属晶种层的衬底的各个阶 段的横截面示意图的示例。 7 CN 111739814 A 说 明 书 5/28 页 图8示出了在等离子体预处理之前和之后对6个具有200埃氧化物层的晶片进行b* 颜色分量测量的结果。 图9A示出了H2等离子体处理对L*颜色分量的影响。 图9B示出了H2等离子体处理对a*颜色分量的影响。 图9C示出了H2等离子体处理对b*颜色分量的影响。 图10(a)示出了在“多层配方”的过程中b*颜色分量的值与时间的函数关系,其中 晶片通过出站加载锁两次。 图10(b)示出了来自图10(a)的数据的一部分的特写重绘图。 图11A绘制了从6个在250℃下已经被等离子体处理持续6个不同的持续时间的晶 片(每个具有200埃的氧化物层)测得的b*颜色分量的值。 图11B绘制了从5个在75℃下已经被等离子体处理持续5个不同的持续时间的晶片 (每个具有200埃的氧化物层)测得的b*颜色分量的值。












