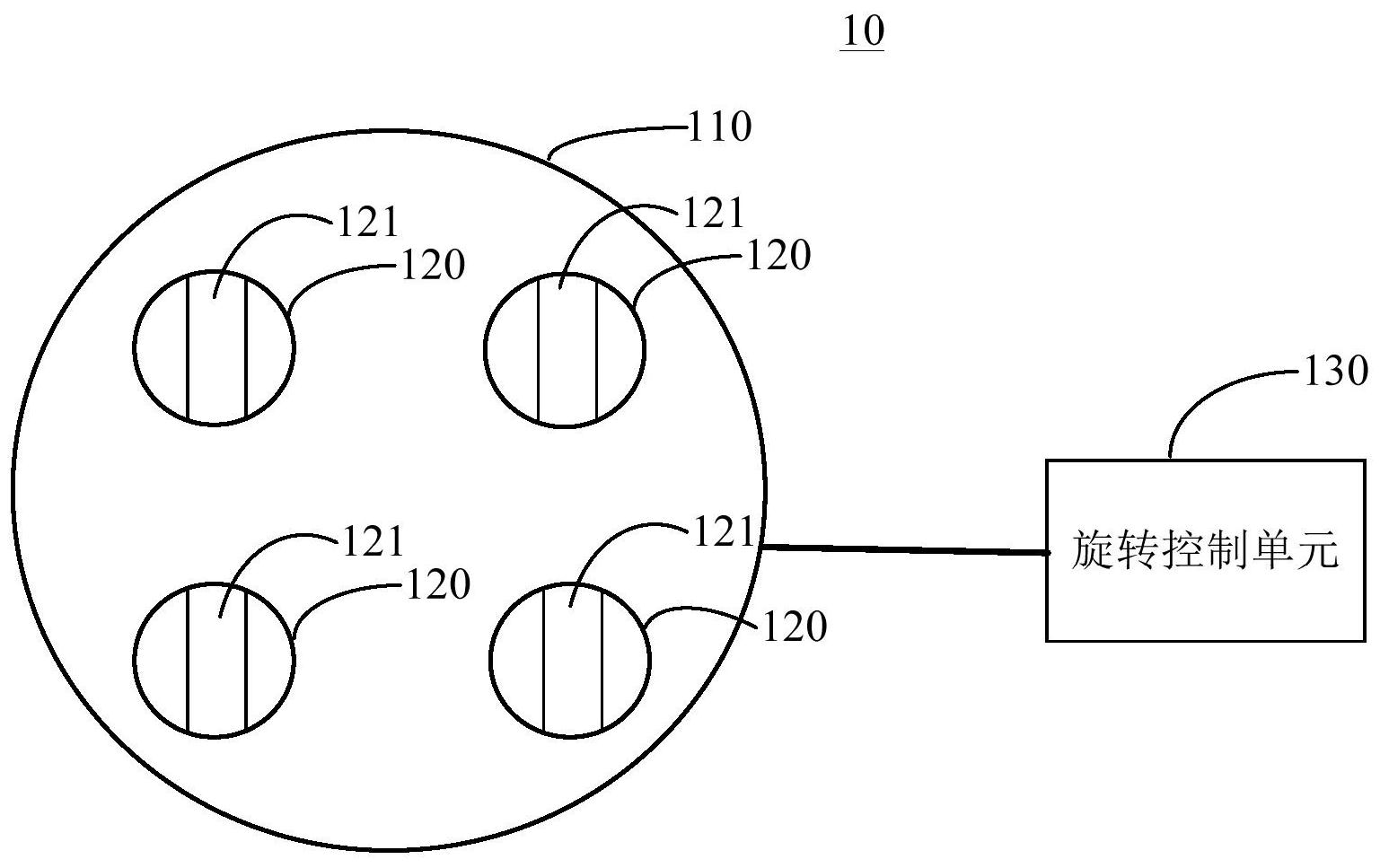
技术摘要:
本申请涉及一种微腔刻蚀基底盛放装置及微腔刻蚀系统。上述微腔刻蚀基底盛放装置,包括基座、置片架以及旋转控制单元。所述置片架可转动的设置于所述基座,所述置片架开设有置片槽,所述置片槽用于放置基底材料。所述旋转控制单元与所述置片架连接,用于控制所述置片架 全部
背景技术:
环芯型微腔的关键参数品质因子Q受其硅基支撑柱体圆度的影响。在形成硅基支 撑柱的过程中,一般使用氟化氙粉末作为干法刻蚀的原料,通过氮气加压,使其均匀弥散在 圆形刻蚀腔内,并均匀的和硅基进行接触,从而刻蚀掉部分硅基,形成硅基支撑柱。而在该 过程中,硅基支撑柱的圆度会受到两个方面的影响:氟化氙粉末弥散的均匀程度、硅片自身 的非对称性;这两者会导致环芯微腔的支撑柱出现方形等非圆形模样,从而影响到微腔的 品质因子。 为了能够缓解上述两种不均匀情况带来的后果,常用的方法是通过减少氟化氙的 刻蚀量来实现的。一种方式是提高刻蚀腔内的空气湿度,这是由于氟化氙和空气中的水蒸 气发生化学反应,生成氟化氢后会失去对硅基的刻蚀能力,如此一来低浓度氟化氙就更容 易均匀分布在刻蚀腔内,通过牺牲刻蚀速度就能够实现硅基支撑柱的高圆度。第二种方式 是减少刻蚀系统喷出的氟化氙粉末量。该种方法缺少一定的稳定性,不能够保证每次刻蚀 结果均理想。
技术实现要素:
基于此,本申请提供一微腔刻蚀基底盛放装置及微腔刻蚀系统,以使微腔在反应 过程中更均匀地刻蚀。 一种微腔刻蚀基底盛放装置,包括: 基座; 置片架,可转动的设置于所述基座,所述置片架开设有置片槽,所述置片槽用于放 置基底材料;以及 旋转控制单元,与所述置片架连接,用于控制所述置片架以预设转速进行旋转。 在其中一个实施例中,所述置片架包括: 转轴,可转动的设置于所述基座,一端与所述旋转控制单元可转动连接;以及 旋转台,与所述转轴的另一端固定连接,所述置片槽开设于所述旋转台远离所述 基座的一面。 在其中一个实施例中,所述置片槽开设于所述旋转台的中心位置。 在其中一个实施例中,所述置片槽沿所述旋转台的径向,贯穿所述旋转台。 在其中一个实施例中,所述旋转台与所述转轴的另一端固定连接方式为焊接或螺 纹连接。 在其中一个实施例中,所述置片架的数量为多个,多个所述置片架等间隔设置于 所述基座。 3 CN 111554610 A 说 明 书 2/5 页 在其中一个实施例中,所述置片架的数量为六个,六个所述置片架的中心的连线 为一个正六边形。 在其中一个实施例中,所述旋转控制单元包括: 旋转电机,与所述转轴连接; 电机控制电路,与所述旋转电机电连接,用于控制所述旋转电机以预设转速进行 旋转。 在其中一个实施例中,所述基座具有容纳腔,所述旋转控制单元设置于所述容纳 腔。 在其中一个实施例中,所述基座为空心柱体,且所述基座的材料为不锈钢。 一种微腔刻蚀系统,包括: 上述实施例中任一项所述的微腔刻蚀基底盛放装置;以及 刻蚀装置,具有刻蚀腔,所述微腔刻蚀基底盛放装置置于所述刻蚀腔内。 上述微腔刻蚀基底盛放装置,包括基座、置片架以及旋转控制单元。所述置片架可 转动的设置于所述基座,所述置片架开设有置片槽,所述置片槽用于放置基底材料。所述旋 转控制单元与所述置片架连接,用于控制所述置片架以预设转速进行旋转。刻蚀使用时,将 上述微腔刻蚀基底盛放装置放到刻蚀腔中,并在所述置片槽中放入准备进行氟化氙刻蚀的 基底材料,启动所述旋转控制单元,以使得基底材料在置片架的带动下匀速缓慢旋转。基底 材料的旋转使得氟化氙气体能较为均匀的接触正在刻蚀的微腔,可有效提升在低湿度、高 氟化氙浓度下微腔刻蚀的圆度,从而使环芯微腔有较高的Q值。 附图说明 为了更清楚地说明本申请实施例或传统技术中的技术方案,下面将对实施例或传 统技术描述中所需要使用的附图作简单地介绍,显而易见地,下面描述中的附图仅仅是本 申请的一些实施例,对于本领域普通技术人员来讲,在不付出创造性劳动的前提下,还可以 根据这些附图获得其他的附图。 图1为本申请一个实施例提供的微腔刻蚀基底盛放装置结构图; 图2为本申请一个实施例提供的置片架主视图; 图3为本申请一个实施例提供的微腔刻蚀基底盛放装置主视图; 图4为本申请一个实施例提供的微腔刻蚀基底盛放装置俯视图; 图5为本申请一个实施例提供的微腔刻蚀基底盛放装置主视图; 图6为本申请一个实施例提供的微腔刻蚀系统结构图。 主要元件附图标号说明 10、微腔刻蚀基底盛放装置;110、基座;111、容纳腔;120、置片架;121、置片槽; 122、转轴;123、旋转台;130、旋转控制单元;131、旋转电机;132、电机控制电路;20、微腔刻 蚀系统;200、刻蚀装置;210、刻蚀腔。












