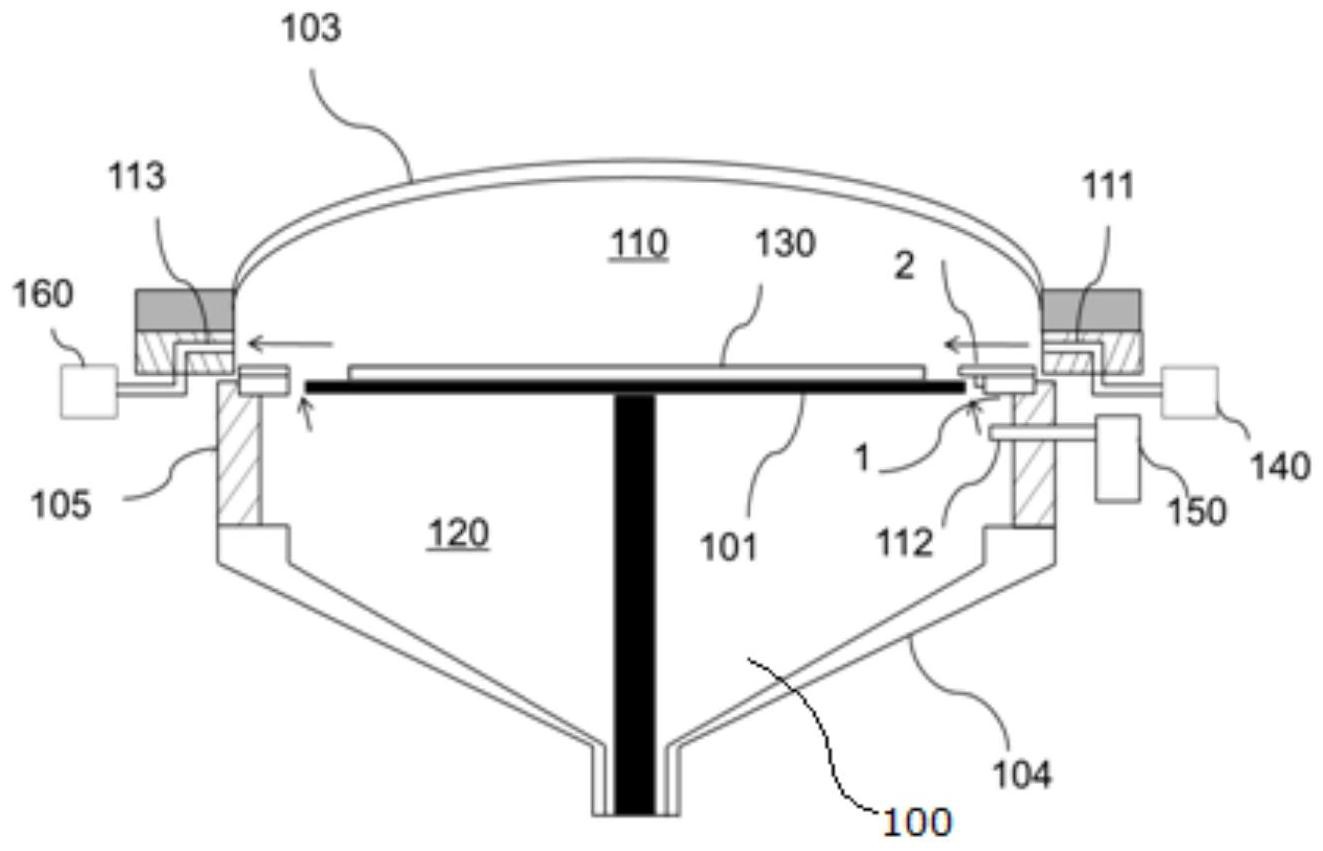
技术摘要:
本发明公开一种用于外延生长设备的预热环以及外延生长设备,该预热环包括上环部和下环部,上环部与下环部同轴自上而下叠置,上环部的外径与下环部的外径相等,上环部的内径小于下环部的内径,上环部的一侧设有排气通道,从而使净化气体和处理气体快速排走,上环部的内 全部
背景技术:
半导体装置尺寸的持续减小,依赖于输送至半导体处理室的处理气体的流动及温 度的更精确的控制。通常,在半导体横流(cross-flow)处理室中,处理气体可被输送至反应 腔室,并被引导经过待处理的基板的表面,处理气体的温度可通过围绕基板支撑件的预热 环来控制。 图1示出了现有技术的预热环示意图,如图1所示,该预热环为一个圆环结构,上表 面为平面。 图2示出了现有技术的预热环在反应腔室内气流流向示意图,包括:预热环33,基 板支撑件101,基板130,净化气体34、处理气体35;一部分净化气体34会通过基板支撑件101 和预热环33之间间隙向上流动,净化气体34流入基板处理区域会稀释基板130边缘的处理 气体浓度。稀释气体主要产生于基板130边缘附近,且会形成紊流及额外流阻,如区域“A”所 示区域,处理气体35需要经过紊流及额外流阻而前进至基板3的表面。因此,在基板130边缘 处的沉积效率变差。虽然在沉积期间旋转基板130能产生旋转对称沉积,但由于稀释所造成 的不良沉积效率,而导致膜的均匀性降低,特别是基板130边缘附近。
技术实现要素:
本发明的目的提供一种用于外延生长设备的预热环以及外延生长设备,防止在基 板边缘附近形成紊流及额外流阻而使处理气体被稀释,提高基板成膜均匀性。 为了实现上述目的,根据本发明的一方面,提供一种用于外延生长设备的预热环, 所述预热环包括上环部和下环部,所述上环部与所述下环部同轴自上而下叠置,所述上环 部的外径与所述下环部的外径相等,所述上环部的内径小于所述下环部的内径,所述上环 部的一侧设有排气通道。 优选地,所述排气通道包括开口; 所述下环部的上端面设有与所述开口相配合的第一弧形凸台,所述第一弧形凸台 沿所述下环部的上端面周向设置,且所述第一弧形凸台的厚度与所述上环部的厚度相等。 优选地,所述上环部的所述开口处具有相互平行的第一端面和第二端面,所述第 一弧形凸台具有相互平行的第三端面和第四端面,所述第一端面与所述第三端面贴合,所 述第二端面与所述第四端面贴合。 优选地,所述第一端面、所述第二端面、所述第三端面和所述第四端面均与所述上 环部的同一轴截面平行,且所述第一端面和所述第二端面相对于所述轴截面对称,所述第 三端面和所述第四端面相对于所述轴截面对称。 优选地,所述上环部的下端面设有沿其周向设置的第二弧形凸台,所述第二弧形 4 CN 111599716 A 说 明 书 2/7 页 凸台具有第五端面和第六端面,所述第五端面与所述第一端面对齐,所述第二端面与所述 第六端面对齐,所述第二弧形凸台的外径与所述下环部的内径相等,所述第二弧形凸台的 厚度小于或等于所述下环部的厚度。 优选地,所述排气通道包括多个通孔,多个所述通孔沿所述上环部的周向分布,所 述多个通孔的圆心在同一圆弧上,且所述圆弧与所述上环部同心,所述圆弧的外径小于或 等于所述下环部的内径,每个所述通孔的轴线均与所述上环部的轴线平行。 优选地,所述上环部的下端面设有沿其周向设置的第一环形凸台,所述下环部的 上端面设有沿其周向设置的第二环形凸台,所述第一环形凸台与所述第二环形凸台相配 合,所述第一环形凸台的外径与所述上环部的外径相等,所述第一环形凸台的内径与所述 第二环形凸台的外径相等,所述第二环形凸台的内径与所述下环部的内径相等,所述第一 环形凸台的厚度与所述第二环形凸台的厚度相等。 优选地,所述第二弧形凸台的径向宽度为1mm~2mm。 优选地,所述上环部的径向宽度为20mm~45mm,所述下环部的径向宽度为20mm~ 35mm。 根据本发明的另一方面,提供一种外延生长设备,包括反应腔室和位于所述反应 腔室内的基座以及所述的预热环,所述预热环环绕于基座的外周,并与所述基座之间留有 间隙,所述反应腔室的一侧设有气体排放区,另一侧设有处理气体进气区,所述排气通道靠 近于所述气体排放区。 本发明的有益效果在于:上环部和下环部上下同轴叠置,上环部的排气通道靠近 气体排放区,从而使净化气体和处理气体快速排走,上环部的内径小于下环部的内径,使上 环部对下环部的内周面形成遮蔽,避免净化气体通过基板支撑件和下环部之间的间隙向上 流动,防止在基板边缘附近形成紊流及额外流阻,改善基板边缘沉积效率,提高基板成膜均 匀性。 本发明的其它特征和优点将在随后












