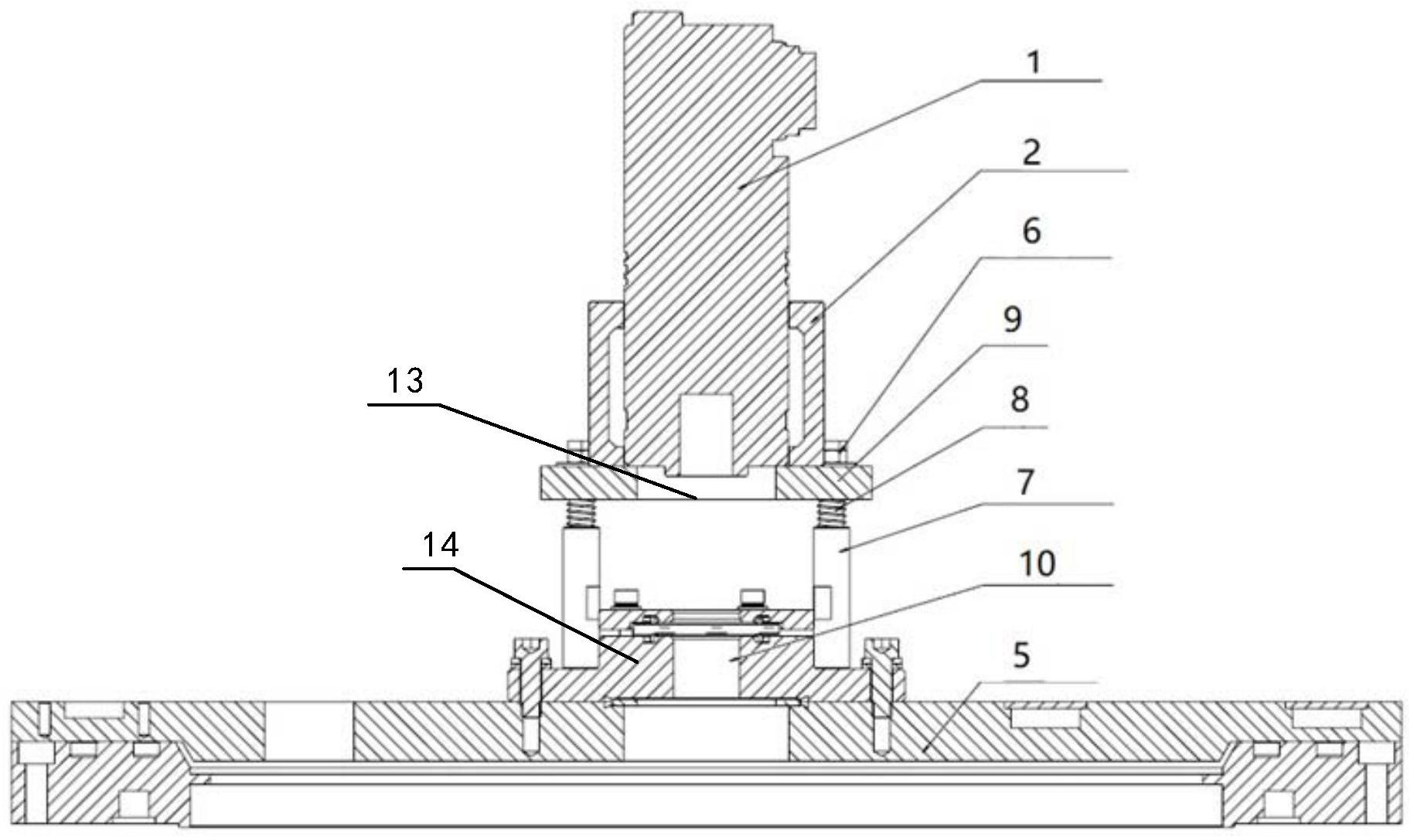
技术摘要:
本发明公开了一种半导体工艺设备中的测温装置及半导体工艺设备,其中测温装置包括:红外测温仪;红外测温仪夹紧件,用于夹紧于红外测温仪;调节机构,设置在工艺腔室上,红外测温仪夹紧件设置在调节机构上,调节机构包括:承载块,用于承载红外测温仪夹紧件,承载块上 全部
背景技术:
对于许多半导体设备,例如硅外延机台、碳化硅长晶炉等,温场的控制对于气相沉 积、晶体生长有着十分重要的作用。由于其腔室内部温度高、密封要求严格,使得热电偶等 传统测温方式不再适用。红外测温仪凭借其非接触、高精度、高量程等特点在半导体设备上 得到广泛使用。但通常红外测温仪的固定方式不可调节,导致测温点固定,无法得到腔室内 所测部件的不同区域的温度分布。然而腔室内所测部件不同区域的温度分布,对于工艺结 果有着十分重要的影响。参考图1,为现有技术中,红外测温仪工作原理图。红外测温仪1由 红外测温仪夹紧件2固定在工艺腔室5的外部,其位置不可调整。其红外光线透过护管3,打 到工艺腔室5内待测部件4上。通过接收待测部件4辐射的红外线测算得出该点的温度。 针对这种情况,有必要提供一种测温装置,可以测量待测部件不同位置的温度分 布。
技术实现要素:
本发明的目的是提出一种半导体工艺设备中的测温装置及半导体工艺设备,可以 测量待测部件不同位置的温度分布。 为实现上述目的,本发明提出了一种半导体工艺设备中的测温装置,设置在所述 半导体设备的工艺腔室上,所述测温装置包括: 红外测温仪; 红外测温仪夹紧件,用于夹紧于所述红外测温仪; 调节机构,设置在所述工艺腔室上,所述红外测温仪夹紧件设置在所述调节机构 上,所述调节机构包括: 承载块,用于承载所述红外测温仪夹紧件,所述承载块上与所述红外测温仪对应 的位置处设置有通光部; 调整部件,设置于所述工艺腔室上,位于所述承载块下方,与所述承载块连接,所 述调整部件用于调整所述承载块相对于竖直方向的倾斜角度和/或相对于所述工艺腔室的 水平位置,以调整所述红外测温仪相对于竖直方向的倾斜角度和/或相对于所述工艺腔室 的水平位置。 作为优选方案,所述调整部件包括: 设置在所述工艺腔室上的底座; 多个可伸缩结构,设置在所述底座上,环绕所述承载块的外周设置,且与所述承载 块连接,每个所述可伸缩结构均能够沿竖直方向伸缩。 作为优选方案,所述可伸缩结构包括螺杆、压缩弹簧和螺母,所述螺杆底部与所述 4 CN 111609936 A 说 明 书 2/6 页 底座连接,顶部贯穿所述承载块,所述压缩弹簧设置于所述承载块和所述底座之间且套设 于所述螺杆上,所述螺母设置于所述承载块的上表面且螺纹连接于所述螺杆的顶部。 作为优选方案,所述螺杆上设有刻度。 作为优选方案,所述调整部件包括第一水平移动机构,所述第一水平移动机构包 括: 沿第一方向设置的第一滚珠丝杆; 第一滚珠螺母,套设于所述第一滚珠丝杆上,所述第一滚珠螺母与所述承载块连 接; 第一导轨,平行于所述第一滚珠丝杆设置,所述承载块可滑动地设置于所述第一 导轨上;通过旋转所述第一滚珠丝杆,所述承载块能够在所述第一导轨上沿所述第一方向 移动。 作为优选方案,所述调整部件还包括第二水平移动机构,所述第二水平移动机构 包括: 承载件,设置于所述第一水平移动机构下方,用于承载所述第一水平移动机构; 沿第二方向设置的第二滚珠丝杆; 第二滚珠螺母,套设于所述第二滚珠丝杆上,所述第二滚珠螺母与所述承载件连 接; 第二导轨,平行于所述第二滚珠丝杆设置,所述承载件可滑动地设置于所述第二 导轨上;通过旋转所述第二滚珠丝杆,所述承载件能够在所述第二导轨上沿所述第二方向 移动。 作为优选方案,所述调整部件包括:多个可伸缩结构、第三水平移动机构、底座,所 述底座设置在所述工艺腔室上,所述第三水平移动机构设置在所述底座上,多个所述可伸 缩结构设置在所述第三水平移动机构上,其中, 多个所述可伸缩结构环绕所述承载块的外周设置,且与所述承载块连接,每个所 述可伸缩结构均能够沿竖直方向伸缩; 所述第三水平移动机构包括: 滑块,所述螺杆的下端与所述滑块连接; 沿第三方向设置的第三滚珠丝杆; 第三滚珠螺母,套设于所述第三滚珠丝杆上,所述第三滚珠螺母与所述滑块连接; 第三导轨,平行于所述第三滚珠丝杆设置,所述滑块可滑动地设置于所述第三导 轨上;通过旋转所述第三滚珠丝杆,所述滑块能够在所述第三导轨上沿所述第三方向移动。 作为优选方案,所述调整部件还包括:第四水平移动机构,所述第四水平移动机构 设置于所述第三水平移动机构与所述底座之间,包括: 承载滑块,设置于所述第三水平移动机构下方,用于承载所述第三水平移动机构; 沿第四方向设置的第四滚珠丝杆; 第四滚珠螺母,套设于所述第四滚珠丝杆上,所述第四滚珠螺母与所述承载滑块 连接; 第四导轨,平行于所述第四滚珠丝杆设置,所述承载滑块可滑动地设于所述第四 导轨上;通过旋转所述第四滚珠丝杆,所述第二承载板能够在所述第四导轨上沿所述第四 5 CN 111609936 A 说 明 书 3/6 页 方向移动。 本发明还提供了一种半导体工艺设备,包括反应腔室,所述反应腔室的顶壁上设 置有测温窗口,还包括上述的测温装置,所述测温装置设置于所述反应腔室上,位于所述测 温窗口的上方。 作为优选方案,所述测温窗口的形状尺寸与所述测温装置的检测范围相匹配。 本发明的有益效果在于: 通过调节机构调整红外测温仪相对于竖直方向的倾斜角度和/或调整红外测温仪 相对于工艺腔室的水平位置,使红外测温仪的红外线接收口可以接收待测部件不同区域发 射的红外光,扩大可测温的范围。 进一步地,调整部件包含多个水平移动机构,扩大了红外测温仪的测量范围。 进一步地,红外测温仪既能倾斜角度又能水平移动,进一步扩大了测量范围。 本发明的装置具有其它的特性和优点,这些特性和优点从并入本文中的附图和随 后的












