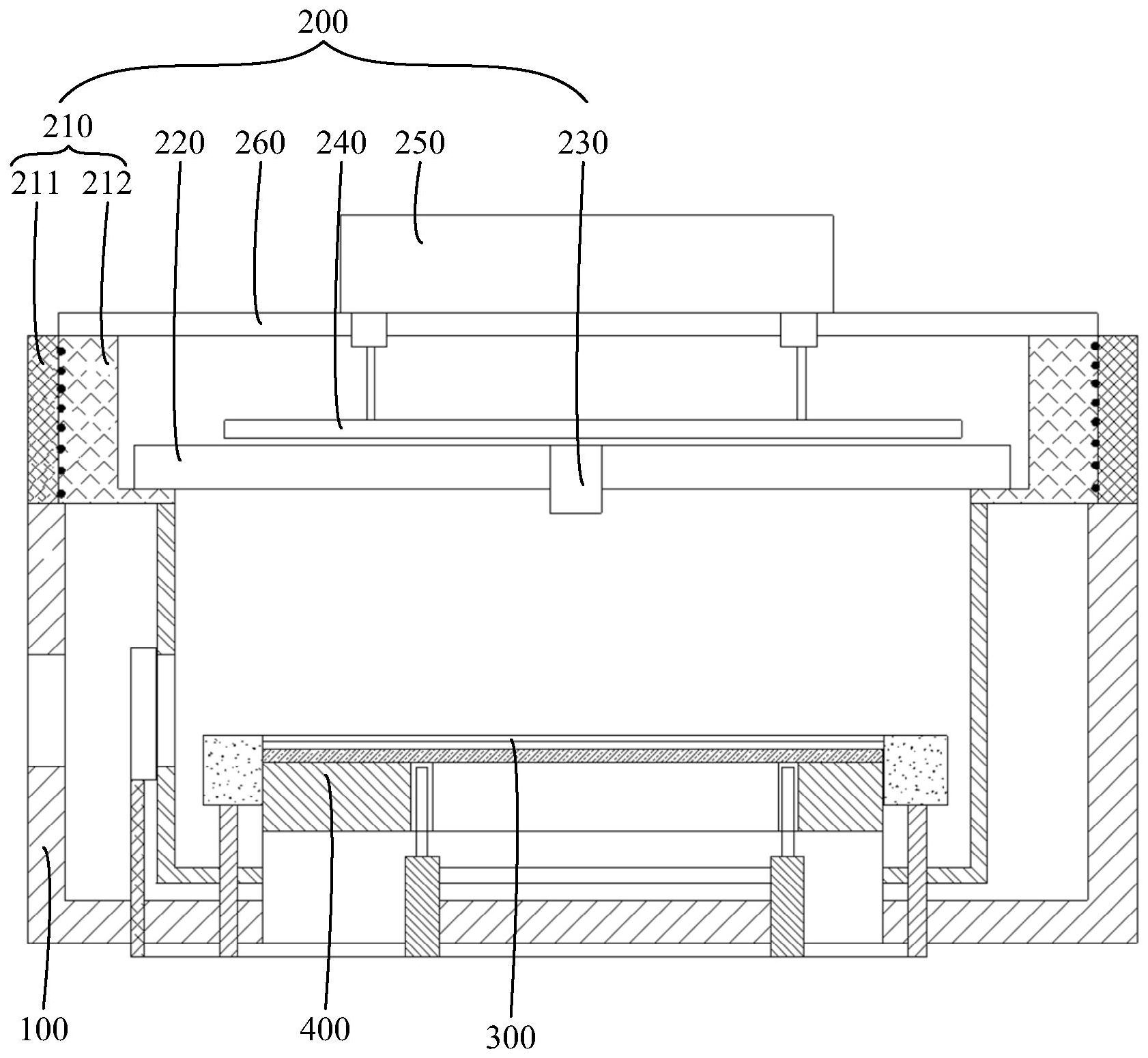
技术摘要:
本发明公开一种半导体工艺设备的反应腔室及半导体工艺设备,反应腔室设置有用于承载晶片的基座,反应腔室包括腔室本体、上电极和驱动机构;上电极包括介质窗和电极壳体,电极壳体包括第一壳体和第二壳体,第一壳体与腔室本体相连接,第一壳体套装于第二壳体,第二壳体 全部
背景技术:
半导体刻蚀设备(刻蚀机)是半导体制造过程中的一种重要的半导体工艺设备。相 关技术中,刻蚀机的介质窗底面(或进气喷嘴底面)到晶片上表面的距离为腔室GAP值,在不 同的加工工艺中,腔室GAP(工艺间隙)值相差较大,因此刻蚀机需要更换不同的调整支架, 以调整介质窗底面(或进气喷嘴底面)至晶片上表面的距离,从而能够满足不同工艺所适合 的腔室GAP值。 当调整腔室GAP值时,需要将腔室打开,然后在更换调整支架,然而,半导体工艺设 备的反应腔室为真空条件,因此需要先对半导体工艺设备的反应腔室进行处理后才能开 腔,从而导致调整支架更换步骤复杂,致使半导体工艺设备调整腔室GAP值所花费的时间较 长,进而影响半导体工艺设备的加工效率。
技术实现要素:
本发明公开一种半导体工艺设备的反应腔室及半导体工艺设备,以解决半导体工 艺设备调整腔室GAP值所花费的时间较长,从而造成半导体工艺设备的加工效率较差的问 题。 为了解决上述问题,本发明采用下述技术方案: 一种半导体工艺设备的反应腔室,所述反应腔室内设置有用于承载晶片的基座, 所述反应腔室包括腔室本体、上电极和驱动机构; 所述上电极包括介质窗和电极壳体,所述电极壳体包括第一壳体和第二壳体,所 述第一壳体与所述腔室本体相连接,所述第一壳体套装于所述第二壳体,所述第二壳体可 相对于所述第一壳体移动; 所述驱动机构设置于所述第一壳体上,且与所述第二壳体相连接,用于驱动所述 第二壳体远离或靠近所述基座; 所述介质窗设置于所述第二壳体中,所述介质窗可随所述第二壳体远离或靠近所 述基座。 一种半导体工艺设备,包括上述反应腔室。 本发明采用的技术方案能够达到以下有益效果: 本发明公开的半导体工艺设备的反应腔室中,驱动机构设置于第一壳体上,且驱 动机构与第二壳体相连接,驱动机构能够驱动第二壳体远离或靠近基座,介质窗设置于第 二壳体中,因此介质窗可以随着第二壳体远离或靠近基座,进而可以调节介质窗底面至晶 片上表面之间的距离,从而实现腔室GAP值的调节。此方案中,电极壳体为两层结构,并且两 层结构可以相对移动,进而使得反应腔室无需开腔即可实现对腔室GAP值的调整,进而使得 3 CN 111725111 A 说 明 书 2/6 页 半导体工艺设备在更换加工工艺时,腔室GAP值调整方便,所花费的时间较短,进而提高半 导体工艺设备的加工效率。 附图说明 此处所说明的附图用来提供对本发明的进一步理解,构成本发明的一部分,本发 明的示意性实施例及其说明用于解释本发明,并不构成对本发明的不当限定。在附图中: 图1为本发明实施例公开的反应腔室的剖视图; 图2为本发明实施例公开的反应腔室的俯视图; 图3为本发明实施例公开的反应腔室的局部示意图; 图4~图6为本发明实施例公开的反应腔室的部分结构剖视图; 图7为本发明实施例公开的反应腔室中,第二壳体的结构示意图; 图8为本发明实施例公开的反应腔室中,第二壳体的局部剖视图。 附图标记说明: 100-腔室本体、 200-上电极、210-电极壳体、211-第一壳体、2111-倒角、212-第二壳体、2121-第一 密封槽、2122-承载台、220-介质窗、230-进气喷嘴、240-上电极线圈、250-匹配器、260-顶 盖、 300-晶片、 400-基座、 510-第一密封圈、520-第二密封圈、530-第三密封圈、 600-限位槽、 700-驱动机构、710-驱动源、720-传动件、 800-距离传感器。












