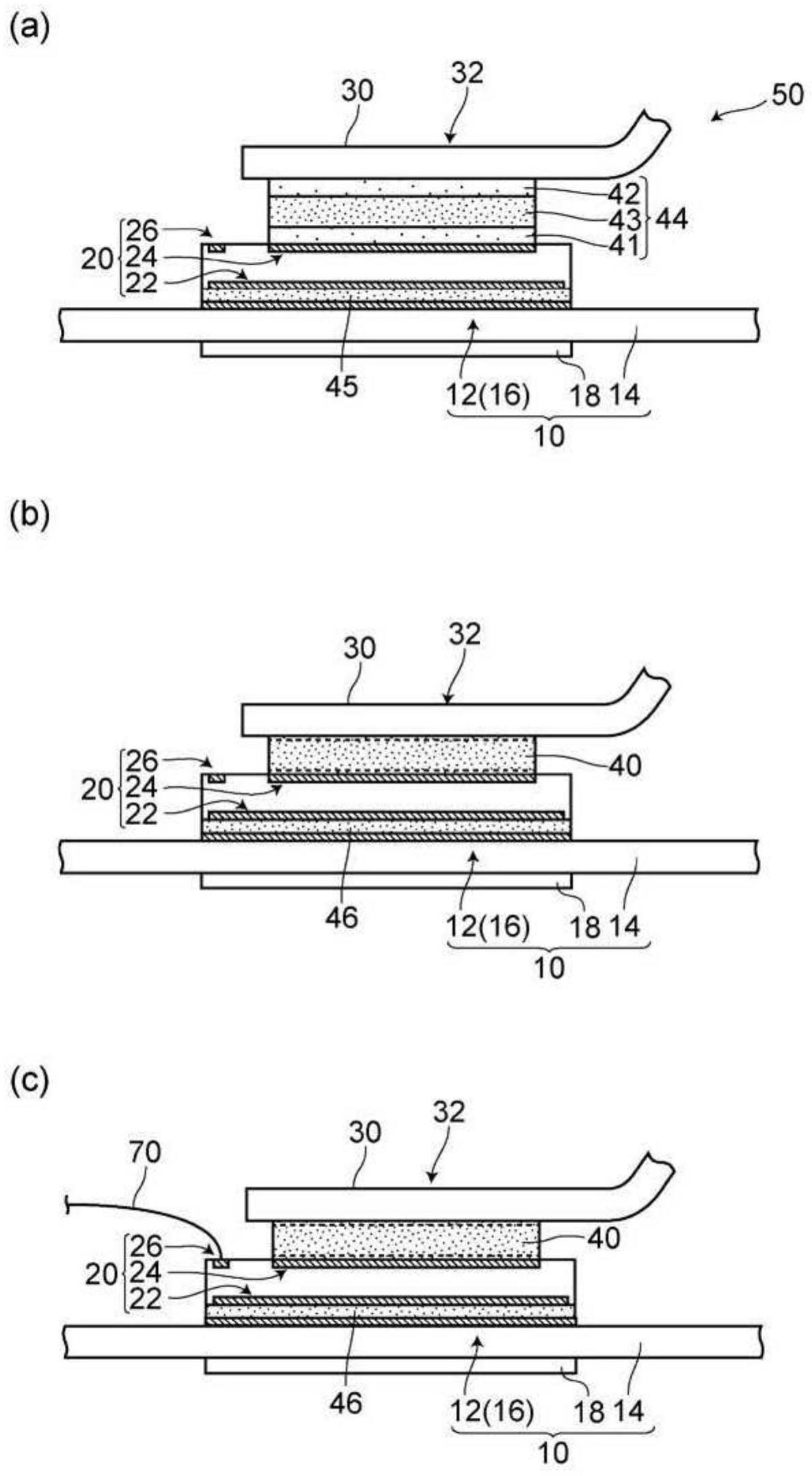
技术摘要:
本发明的半导体装置的制造方法包括:组装体形成工序,在电极24与电极连接片32之间配置焊锡材料44,焊锡材料44具有被配置于电极24的表面且含有助焊剂的第一焊锡材料层41、被配置于电极连接片32的表面且含有助焊剂的第二焊锡材料层42、以及被配置于第一焊锡材料层41与第 全部
背景技术:
以往,有一种半导体装置的制造方法已被普遍知晓,其用于制造经由焊锡而接合 有半导体芯片与引线的半导体装置(参照专利文献1)。 如图9所示,专利文献1中记载的以往的半导体装置900包括:基板910,其具有半导 体芯片搭载面912;半导体芯片920,其被搭载于半导体芯片搭载面912上,且具有形成于与 半导体芯片搭载面912是相向的面上的集电极922、以及具有形成于与半导体芯片搭载面 912相向的面是相反侧的面上的发射极924(电极)及形成于与发射极924分离的位置上的栅 电极926;以及引线930,其具有电极连接片932,并且该电极连接片932经由焊锡940而与发 射极924相接合。 根据以往的半导体装置900,电极连接片932是经由焊锡940而与发射极924相接 合,即,由于是仅经由焊锡940(不经由导线等中间构件)来直接连接半导体芯片920与引线 930,因此,半导体装置900适于具有较大的电流容量且使用大电流的电子设备(例如电源)。 以往的半导体装置900是通过如下制造方法(以往的半导体装置的制造方法)来进 行制造的。即,以往的半导体装置的制造方法包含:组装体形成工序,该工序形成配置有基 板910、半导体芯片920以及引线930的组装体,使得发射极924与电极连接片932成为夹着焊 锡材料的相向状态;以及接合工序,该工序在将焊锡材料熔融后,通过将焊锡材料固化来将 发射极924与电极连接片932经由焊锡940进行接合。 【先行技术文献】 【专利文献1】特开2010-123686号公报 【专利文献2】特开2017-199809号公报 一般来说,众所周知,为了缓和作用于半导体芯片与引线之间的焊锡的应力(例如 热应力),将该焊锡的厚度保持在一定厚度以上是比较有效的方法(参照专利文献2)。 然而,在使用含有助焊剂的焊锡材料(例如糊状的焊锡膏)来作为焊锡材料944的 情况下,由于接合工序前的焊锡材料944变得过厚(参照图10(a)),故而在将引线930配置在 焊锡材料944上后,焊锡材料944会有可能在压坏后溢出到不希望的位置上,并且制造后的 半导体装置的可靠性也有可能会下降(参照图10(b))。 另一方面,在使用不含助焊剂的焊锡材料(粒状焊锡)来作为焊锡材料944的情况 下,由于无法通过助焊剂来去除焊锡材料表面的氧化物,故而为了防止焊锡与半导体芯片 之间的接合强度、及焊锡与引线之间的接合强度变低,就必须在特殊的条件(在氢气氛下 等)下实施接合工序,因此接合工序就会变得繁杂。 所以,本发明为了解决上述问题,目的是提供一种半导体装置的制造方法,该制造 方法能够制造可靠性不易下降的半导体装置,并且还能够防止接合工序变得繁杂。 3 CN 111602233 A 说 明 书 2/11 页
技术实现要素:
【1】本发明的半导体装置的制造方法所制造的半导体装置具备:基板,其具有半导 体芯片搭载面;半导体芯片,其被搭载于所述半导体芯片搭载面上,且具有形成在与所述半 导体芯片搭载面相向的面是相反侧的面上的电极;以及引线,其具有电极连接片,并且所述 电极连接片经由焊锡而与所述电极相接合,所述半导体装置的制造方法,其特征在于,包 括:组装体形成工序,在所述电极与所述电极连接片之间配置焊锡材料,所述焊锡材料具有 被配置于所述电极的表面且含有助焊剂的第一焊锡材料层、被配置于所述电极连接片的表 面且含有助焊剂的第二焊锡材料层、以及被配置于所述第一焊锡材料层与所述第二焊锡材 料层之间的且不含有助焊剂的第三焊锡材料层相叠层后的构造,并且,所述组装体形成工 序形成配置有所述基板、所述半导体芯片以及所述引线的组装体,使得所述电极与所述电 极连接片成为夹着所述焊锡材料的相向状态;以及接合工序,在将所述焊锡材料熔融后,通 过将所述焊锡材料固化来将所述电极与所述电极连接片经由所述焊锡进行接合。 此外,在本说明书中,“焊锡材料”是指:在通过接合工序来接合对象物之前的焊 锡。 【2】在本发明的半导体装置的制造方法中,最好是:所述第一焊锡材料层及所述第 二焊锡材料层均由糊状的焊锡材料构成,而所述第三焊锡材料层则由固体状的焊锡材料构 成。 【3】在本发明的半导体装置的制造方法中,最好是:在所述组装体形成工序中,所 述第三焊锡材料层的厚度在所述焊锡材料厚度的60%~90%的范围内。 【4】在本发明的半导体装置的制造方法中,最好是:在所述组装体形成工序中,所 述第三焊锡材料层的组成与除去助焊剂成分的所述第一焊锡材料层的组成或除去助焊剂 成分的所述第二焊锡材料层的组成相同。 【5】在本发明的半导体装置的制造方法中,最好是:在所述组装体形成工序中,将 所述第一焊锡材料层及所述第三焊锡材料层配置在所述第二电极上,并且在将第二焊锡材 料层配置在所述电极连接片上后,将所述第三焊锡材料层与所述第二焊锡材料层重叠来形 成所述组装体。 【6】在本发明的半导体装置的制造方法中,最好是:在所述组装体形成工序中,在 所述半导体芯片上按照所述第一焊锡材料层、所述第三焊锡材料层及所述第二焊锡材料层 的顺序来进行配置后,将所述第二焊锡材料层与所述引线的所述电极连接片重叠来形成所 述组装体。 【7】在本发明的半导体装置的制造方法中,最好是:所述焊锡的厚度大于等于300μ m。 【8】在本发明的半导体装置的制造方法中,最好是:在所述组装体形成工序中,使 用分配器来配置所述第一焊锡材料层及所述第二焊锡材料层。 发明效果 在本发明的半导体装置的制造方法中,组装体形成工序在电极与电极连接片之间 配置焊锡材料,所述焊锡材料具有被配置于第一焊锡材料层与第二焊锡材料层之间的且不 含有助焊剂的第三焊锡材料层。通过采用这种方法,在不含有助焊剂的第三焊锡材料层中, 由于助焊剂不会在接合工序时(回流时)蒸发,并且第三焊锡材料层部分的厚度也不会因助 4 CN 111602233 A 说 明 书 3/11 页 焊剂的蒸发而导致在接合工序后变薄,因此,就可以无需使接合工序前的(第一~第三焊锡 材料层整体的)焊锡材料的厚度变得过厚(比接合工序后的焊锡的厚度稍厚即可)。所以,即 使是将引线配置在焊锡材料上也不易压坏焊锡材料,从而就能够防止焊锡材料溢出到不希 望的位置上。这样一来,就能够制造可靠性不易下降的半导体装置。 此外,根据本发明的半导体装置的制造方法,由于组装体形成工序在电极与电极 连接片之间配置焊锡材料,所述焊锡材料具有被配置于第一焊锡材料层与第二焊锡材料层 之间的且不含有助焊剂的第三焊锡材料层,因此就能够制造将焊锡的厚度保持在一定厚度 以上的半导体装置。因此,就能够缓和作用于半导体芯片与引线之间的焊锡的应力(例如热 应力),并且在该观点下,也能够制造可靠性不易下降的半导体装置。 根据本发明的半导体装置的制造方法,由于组装体形成工序在电极与电极连接片 之间配置焊锡材料,所述焊锡材料具有被配置于电极的表面且含有助焊剂的第一焊锡材料 层、以及被配置于引线的电极连接片的表面且含有助焊剂的第二焊锡材料层,因此就能够 通过助焊剂在去除电极、电极连接片以及第三焊锡材料层的表面的掺杂物后的状态下进行 接合,从而就能够制造焊锡与半导体芯片或引线之间的密合强度较高的半导体装置。所以, 就无需为了防止焊锡与半导体芯片之间的接合强度或焊锡与引线之间的接合强度变得低 下而要在特殊的条件(在氢气氛下等)下实施接合工序,从而就能够防止接合工序变得繁 杂。 附图说明 图1是展示实施方式一涉及的半导体装置1的图。其中,图1(a)是半导体装置1的平 面图,图1(b)是图1(a)中的A-A截面图,图1(c)是半导体装置1的主要部分放大截面图。此 外,在图1(c)中为了便于说明而省略树脂80的图示。 图2是实施方式一涉及的半导体装置的制造方法的流程图。 图3是实施方式一涉及的半导体装置的制造方法的工序图。其中,图3(a)是展示基 板准备工序的图,图3(b)是展示半导体芯片搭载工序的图。 图4是实施方式一涉及的半导体装置的制造方法的工序图。其中,图4(a)是展示第 一焊锡材料层配置工序的图,图4(b)是展示第二焊锡材料层配置工序以及第三焊锡材料层 配置工序的图。 图5是实施方式一涉及的半导体装置的制造方法的工序图。其中,图5(a)是展示引 线框配置工序的图,图5(b)是展示接合工序(回流工序)的图,图5(c)是展示导线接合工序 的图。 图6是实施方式二涉及的半导体装置的制造方法的工序图。其中,图6(a)是展示第 一焊锡材料层配置工序的图,图6(b)是展示第二焊锡材料层配置工序以及第三焊锡材料层 配置工序的图,图6(c)是展示引线框配置工序的图。 图7是变形例一涉及的半导体装置的制造方法的工序图。其中,图7(a)是展示半导 体芯片配置工序的图,图7(b)是展示第一焊锡材料层配置工序、第二焊锡材料层配置工序 以及第三焊锡材料层配置工序的图,图7(c)是展示引线框配置工序的图。 图8是展示变形例二涉及的半导体装置2的图。其中,图8(a)是半导体装置2的立体 图,图8(b)是图8(a)中的B-B截面图。在图8中,符号10a、10b表示基板,12a、12b表示半导体 5 CN 111602233 A 说 明 书 4/11 页 芯片搭载面,14a、14b表示绝缘性基板,18a、18b表示散热用金属板,40a、40b表示焊锡。 图9是展示以往的半导体装置900的截面图。在图9中,符号946表示焊锡,符号960、 962表示端子,符号970表示导线,符号980表示树脂。 图10是展示以往的半导体装置的制造方法的问题点的图。其中,图10(a)是展示引 线配置前的组装体的情况的图,图10(b)是展示引线配置后的组装体的情况的图。符号944、 945表示焊锡材料(糊状的焊锡材料)。












