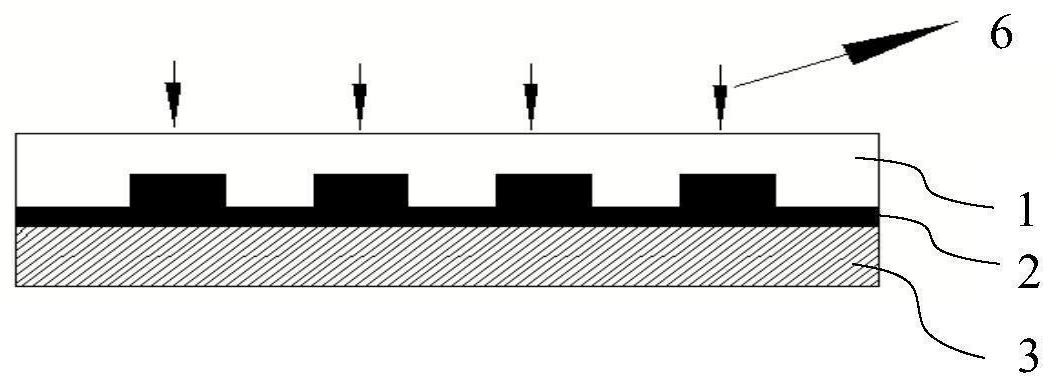
技术摘要:
本发明公开了一种高深宽比纳米光栅的制作方法。制作原始模具:制作得到带有低深宽比的光栅结构的原始模具;纳米压印,通过纳米压印工艺复制光栅结构制备得到PDMS软模板;在玻璃基片上旋涂纳米压印胶为图形转移层,PDMS软模板覆盖上去,固化后分离脱模;去除压印胶残余 全部
背景技术:
纳米压印技术,最早由Stephen Y Chou教授在1995年率先提出,是微纳米器件制 作工艺中的一个重要技术,这是一种不同与传统光刻技术的全新图形转移技术,纳米压印 技术不使用光线或者辐照使光刻胶感光成形,它是将预先制备好的模具压入液态的阻蚀 剂,使阻蚀剂产生物理变形而实现阻蚀剂图形化,而不是通过改变阻蚀剂的化学特性来实 现阻蚀剂的图形化。相较于传统的光刻技术,其具有产量更高,成本更低和工艺更简单的优 点。 传统的光栅制作方法通常有两种技术方案:①光刻工艺――刻蚀工艺;②纳米压 印工艺或者是纳米压印后刻蚀。在技术方案①中,通过曝光和显影将光栅结构转移基片表 面的光刻胶上,然后利用光刻胶作为掩膜,通过刻蚀工艺刻蚀基片从儿将光栅结构转移到 基片。在技术方案②中,通过第一次压印将原始模具的光栅结构复制得到PET软模,再进行 第二次压印将PET软模的光栅结构复制到基片的纳米压印胶上,固化后的纳米压印胶便可 以直接作为光栅结构;或者是将具有光栅结构的纳米压印胶作为掩膜,通过刻蚀工艺刻蚀 基片,从而将光栅结构复制到基片上。在上述两种技术方案中,由于光刻胶和纳米压印胶的 刻蚀选择比低,不能制作得到高深宽比的光栅结构或者是制作高深宽比的光栅结构时存在 很大的困难。另外普通光刻无法加工周期为纳米尺度的光栅,使用电子束直写速度太慢,步 进式或EUV等光刻技术设备太昂贵,成本太高。如果只使用纳米压印制作高深宽比的光栅结 构,脱模很困难,容易造成缺陷。 因此,需要提供一种新的技术方案,可以实现高深宽比纳米光栅结构的制作。
技术实现要素:
针对上述问题,本发明提供了一种高深宽比纳米光栅的制作方法,可以实现纳米 级的高深宽比光栅结构的制作。 为了达到上述目的,本发明的技术方案如下: 步骤一,制作原始模具:使用电子束直写和刻蚀技术制作得到带有低深宽比的光 栅结构的原始模具; 步骤二,纳米压印: (1)PDMS软模板制备:通纳米压印工艺将步骤一制备得到的原始模具上的光栅结 构进行复制得到PDMS软模板,从而将原始模具的纳米光栅结构复制到PDMS软模板上; (2)在所需制作高深宽比纳米光栅的玻璃基片上旋涂一层纳米压印胶作为图形转 移层,将带有纳米光栅结构的PDMS软模板覆盖到涂好图形转移层的玻璃基片上,PDMS软模 板置于图形转移层表面上,然后进行紫外曝光使图形转移层固化,再将PDMS软模板与玻璃 3 CN 111606300 A 说 明 书 2/4 页 基片分离脱模,在玻璃基片上复制得到低深宽比的纳米光栅结构的图形转移层; 步骤三,去除压印胶残余层: 通过ICP刻蚀刻蚀整体减薄图形转移层,将图形转移层纳米光栅结构中处于凹陷 部分的压印胶被全部刻蚀干净,图形转移层纳米光栅结构中处于凹陷部分的压印胶为残余 层,使得在图形转移层纳米光栅结构中处于凹陷部分的位置处暴露出玻璃基片表面; 步骤四,镀金属层: 通过热蒸镀或金属溅射的方式在整个玻璃基片上镀一层金属,形成金属层; 步骤五,剥离(lift-off): 将整个玻璃基片放在纳米压印胶清洗液中浸泡,附着在玻璃基片上的所有图形转 移层及其上面的金属层一起脱落,而蒸镀在已去除图形转移层、且露出于玻璃基片表面上 的金属层形成金属纳米结构掩膜; 步骤六,再次通过ICP刻蚀刻蚀具有金属纳米结构掩膜的玻璃基片的表面,在玻璃 基片表面形成高深宽比的纳米光栅结构。 本发明的所述的高深宽比具体是指深宽比在5:1以上,所述的低深宽比具体是指 深宽比在5:1以上。 这样形成在的玻璃基片上表面的具有纳米光栅团的金属层,金属和玻璃基片材料 具有很高的刻蚀选择比(玻璃基片的刻蚀速率远远高于金属的刻蚀速率),从而能刻蚀得到 深度更深的光栅结构。 所述的原始模具的模具基底为硅片、玻璃或者是其他三五族半导体材料。 所述步骤四中的金属层覆盖在暴露出的玻璃基片表面和图形转移层纳米光栅结 构中处于凸起部分的位置表面。 所述的金属层的金属为铬、金等。 所述的玻璃基片采用硅晶圆、石英、磷化铟等其它的材料。 进一步的,在步骤二中,在旋涂图形转移层前,旋涂在玻璃基片表面预先旋涂一层 的增粘层,增粘层为质量分数为2%的香波和聚乙二醇双硬酸脂混合材料组成的水溶液化 学试剂,能够增加压印胶和基底的粘附性。 所述的纳米压印胶清洗液为由硫酸和双氧水以特定配比构成的混合溶液。 进一步的,在上述步骤三和步骤六中,根据实际的光栅尺寸来选择刻蚀的技术方 案,具体采用ICP刻蚀、RIE刻蚀或者是湿法腐蚀。 所述步骤六在刻蚀具有金属纳米结构掩膜的玻璃基片的表面时,金属纳米结构掩 膜的金属层被刻蚀完毕,到露出玻璃基片的表面时刻蚀停止。 本发明的有益效果: 本发明相较于通常制作光栅结构的技术方案,能简单有效地容易制备得到纳米级 的高深宽比的纳米光栅结构,得到光学处理效果更好的器件。 附图说明 为了使本发明的目的、技术方案和优点更加清楚,下面将结合附图对本发明做详 细的描述,其中: 图1a-图1h为本发明实施列提供高深宽比纳米光栅的制作方法中各步骤的结构示 4 CN 111606300 A 说 明 书 3/4 页 意图。 图1a为脱模后获得的PDMS软模板的工艺结构示意图; 图1b为玻璃基片和图形转移层结合后形成的工艺结构示意图; 图1c为PDMS软模板覆盖到图形转移层上的曝光固化工艺结构示意图; 图1d为玻璃基片上光栅结构的示意图; 图1e为刻蚀去除图形转移层(2)残余层的工艺结构示意图; 图1f为去除图形转移层后的结构示意图; 图1g为热蒸镀的实施工艺结构示意图; 图1h为再ICP刻蚀后获得的纳米光栅结构的结果图; 图中:PDMS软模板(1)、图形转移层(2)、玻璃基片(3)、金属层(4)、金属纳米结构掩 膜(5)、UV光(6)。












