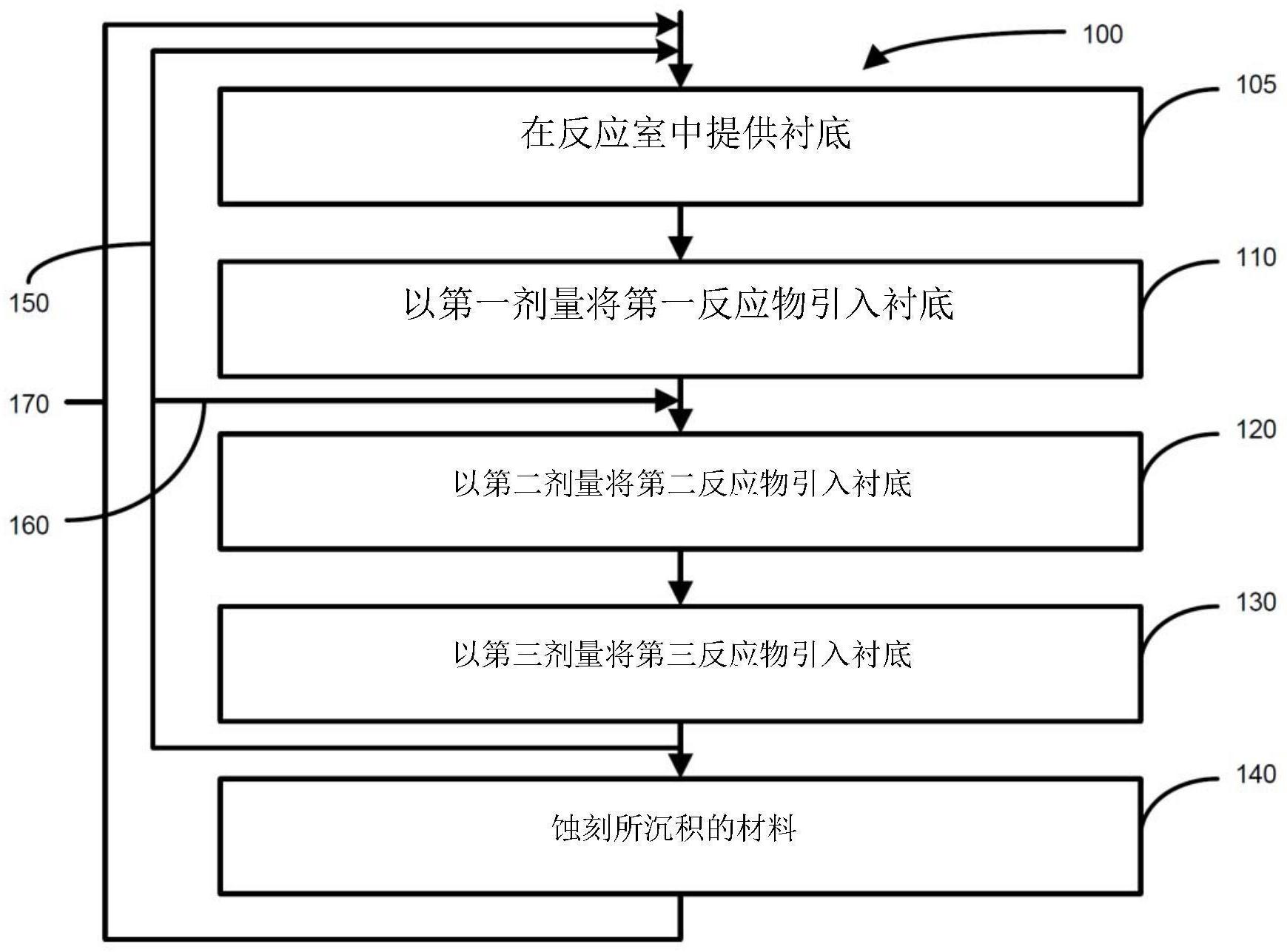
技术摘要:
提供了一种通过以下方式填充一个或多个凹陷部的方法:在反应室中提供所述衬底;并以第一剂量将第一反应物引入所述衬底;以第二剂量将第二反应物引入所述衬底,其中所述第一剂量和所述第二剂量在所述第一反应物和所述第二反应物反应的重叠区域中重叠,并留下所述第一区 全部
背景技术:
在诸如集成电路(IC)的电子器件的制造期间,可以在衬底内制成诸如间隙或沟槽 的凹陷部。填充凹陷部可以采用多种形式,具体取决于特定的应用。 典型的沟槽填充工艺可能会产生一些缺点,包括沟槽中空隙的形成。当在完全填 充沟槽之前,填充材料在沟槽顶部附近形成收缩时,可能会形成空隙。这样的空隙可能影响 集成电路上的器件的器件隔离以及IC的整体结构完整性。不幸的是,防止在沟槽填充期间 形成空隙通常会对沟槽施加尺寸限制,这可能会限制器件的器件组装密度。 如果填充沟槽以用于器件隔离,那么测量器件隔离的有效性的关键参数可以是场 阈值电压,即,产生关联相邻隔离器件的寄生电流所需的电压。场阈值电压可能受许多物理 特性和材料特性的影响,例如沟槽宽度、沟槽填充材料的介电常数、衬底掺杂、场注入剂量 和处理期间的衬底偏置。 空隙的形成可以通过减小沟槽深度和/或使沟槽侧壁逐渐变小来减少,从而使得 沟槽的开口在顶部比在沟槽的底部宽。在减小沟槽深度方面的权衡可能会降低器件隔离的 有效性,而具有逐渐减小的侧壁的较大沟槽顶部开口可能会占用额外的集成电路空间。当 试图减小器件尺寸时,这些问题可能会变得越来越突出。因此,可能需要用于填充凹陷部的 改进的方法和设备。
技术实现要素:
本公开的各种实施方案涉及在衬底的表面内填充诸如沟槽的凹陷部的方法。虽然 本公开的各种实施方案解决现有方法的缺点的方式将在下面进行更详细的讨论,但是总体 上,本公开的各种实施方案提供了适于填充衬底表面内的凹陷部的改进的方法和设备。例 如,示例性方法和设备可用于用期望的材料诸如介电材料无缝地填充高纵横比的凹陷部。 根据本公开的至少一个实施方案,一种填充形成在衬底表面内的凹陷部的方法包 括以下步骤:在反应室中提供衬底,以第一剂量将第一反应物引入衬底的凹陷部的表面上, 以第二剂量将第二反应物引入衬底的凹陷部的表面上,其中第一剂量和第二剂量在重叠区 域中重叠并留下第一剂量和第二剂量不重叠的区域,以第三剂量将第三反应物引入衬底, 该第三反应物在第一剂量和第二剂量不重叠的区域中与第一反应物或第二反应物反应,从 而沉积材料,并且将所沉积的材料蚀刻在凹陷部内。根据各个方面,重叠区域中的第一反应 物的浓度与第一区域和第二区域不重叠的区域中的第一反应物的浓度不同。在方法进行到 蚀刻所沉积的材料的步骤之前,可以将多个沉积循环重复一次或多次,所述沉积循环包括 将第一反应物引入衬底,将第二反应物引入衬底以及将第三反应物引入衬底的步骤。另外, 一个或多个沉积循环结合蚀刻所沉积材料的步骤可重复多次以填充凹陷部。根据另外的方 4 CN 111593330 A 说 明 书 2/7 页 面,以饱和剂量引入第一反应物和第二反应物中的一者,并且以亚饱和剂量引入第一反应 物和第二反应物中的另一者。根据另外的实例,在蚀刻所沉积的材料的步骤期间,相对于第 一区域和第二区域不重叠的区域,重叠区域中的材料蚀刻速率可以更高。通过具有一定剂 量的第一反应物和第二反应物,使得反应物在凹陷部顶部的重叠区域中重叠,第一反应物 和第二反应物可以在凹陷部的顶部反应,以阻止或减少在凹陷部顶部的进一步反应。在凹 陷部的底部中第一反应物和第二反应物不重叠的初始未反应区域中,第一反应物或第二反 应物仍可与第三反应物反应,从而从底部向上填充凹陷部。 根据另一个实施方案,提供了一种半导体处理设备,例如,以提供改进的或至少替 代性的凹陷部填充方法,诸如本文所述的方法。根据本公开的至少一个实施方案,一种半导 体处理设备包括:一个或多个用于容纳衬底的反应室,所述衬底包括在其中形成有凹陷部 的表面;用于第一反应物的第一源,该第一源经由第一阀与反应室之一气体连通;用于第二 反应物的第二源,该第二源经由第二阀与反应室之一气体连通;用于第三反应物的第三源, 该第三源经由第三阀与反应室之一气体连通;蚀刻剂源,该蚀刻剂源经由第四阀与反应室 之一气体连通;以及控制器,该控制器可操作地连接到第一气阀、第二气阀、第三气阀和第 四气阀,并且被配置和编程为进行以下控制:以第一剂量将第一反应物引入衬底的凹陷部 上;以第二剂量将第二反应物引入衬底的凹陷部上,其中第一剂量和第二剂量在重叠区域 中重叠并留下第一剂量和第二剂量不重叠的区域(例如,第一剂量和第二剂量中的一者的 浓度可忽略不计或者小于第一反应物或第二反应物中另一者的约百分之一并且/或者小于 重叠区域中相同反应物的浓度的约百分之一);以第三剂量将第三反应物引入衬底,该第三 反应物在第一区域和第二区域不重叠的区域中与第一反应物或第二反应物反应,从而沉积 材料;并且将所沉积的材料蚀刻在凹陷部中。在蚀刻所沉积材料的步骤之前,可以如上所述 重复沉积循环,所述沉积循环包括引入第一反应物,引入第二反应物和引入第三反应物。类 似地,一个或多个沉积循环结合蚀刻所沉积材料的步骤可重复多次以填充凹陷部。 根据本公开的另外的示例性实施方案,可使用本文所述的方法和/或设备形成半 导体结构。 出于概述本发明和优于现有技术而实现的优势的目的,上文中描述了本发明的某 些目标和优势。当然,应当理解,未必所有这些目的或优点都可以根据本发明的任何特定实 施方案来实现。因此,举例来说,所属领域的技术人员将认识到,本发明可以按实现或优化 如本文中所教示或建议的一种优势或一组优势,但不一定实现如本文中可能教示或建议的 其他目的或优势的方式来实施或进行。对于所属领域的技术人员来说,这些和其他实施方 案将从参考附图的某些实施方案的以下详细描述变得显而易见,本发明不限于所公开的任 何特定实施方案。 附图说明 当结合以下说明性附图考虑时,可通过参考详细描述和权利要求来获得对本公开 的示例性实施方案的更全面的理解。 图1A示出了根据本公开的至少一个实施方案的适于填充凹陷部的PEALD(等离子 体增强原子层沉积)设备的示意图。 图1B示出了使用可根据本公开的至少一个实施方案使用的流通系统(FPS)的前体 5 CN 111593330 A 说 明 书 3/7 页 供应系统的示意图。 图2示出了根据本公开的至少一个实施方案的用于填充凹陷部的方法的流程图。 图3示出了根据本公开的另一个实施方案的用于填充凹陷部的方法的流程图。 图4示出了根据本公开的另一个实施方案的结构。












