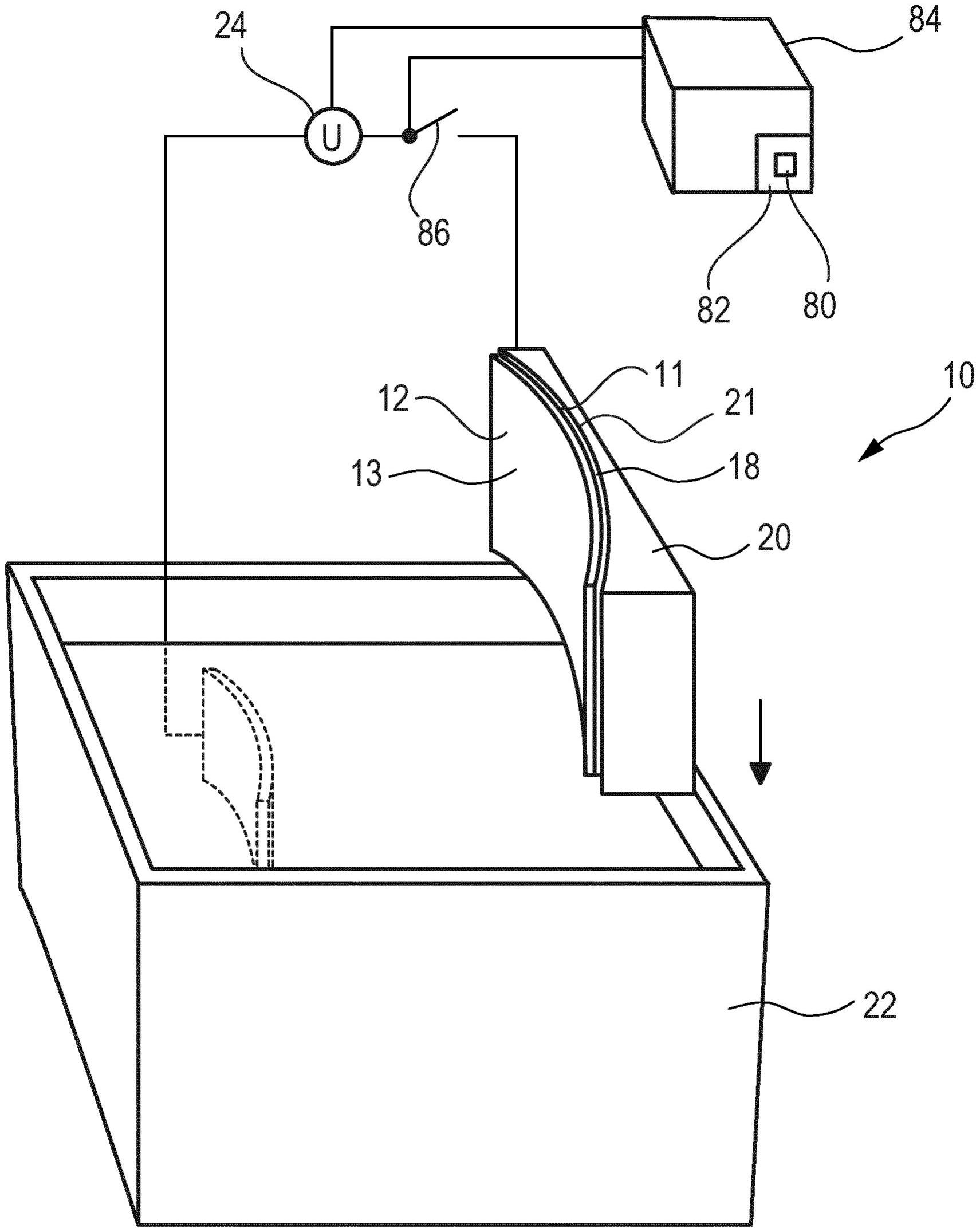
技术摘要:
本发明涉及一种用于对用于弧形X射线光栅的阳极元件的阳极氧化的设备,所述设备(10)包括:阳极元件(12);阴极元件(14);电解介质(16);导体元件(18);以及载体元件(20);其中,所述阳极元件(12)包括第一侧面(11)和第二侧面(13),其中,所述第二侧面(13)背对着所述第一侧 全部
背景技术:
在具有几μm的宽度和大约200-300μm的深度的沟槽或壁结构的情况下需要特殊的 光栅部件用于暗场X射线成像或相位对比成像。沟槽被填充有X射线吸收材料,而壁对于X射 线辐射是可透过的或低吸收的。在暗场X射线成像系统中,所谓的G2光栅以源与图像之间的 大于2m的距离被安装在探测器的前方。G2光栅用来分析从X射线辐射源行进通过另外的光 栅和对象的X射线辐射的波前。这需要G2光栅的光栅表面在X射线辐射源的位置的方向上的 聚焦。 从US2007/0183583A1,已知通过外力弯曲X射线光栅使得被构建在光栅表面上的 光栅被聚焦在X射线辐射源的位置上。X射线光栅的弯曲可能由于X射线光栅的壁结构的基 本材料的脆性结合沟槽的填充材料而冒损坏光栅结构和得到低良率的风险。
技术实现要素:
因此需要提供避免损坏光栅结构和得到低良率的风险的设备和方法。 本发明的目的通过独立权利要求的主题得以解决;另外的实施例被并入从属权利 要求中。应当注意,本发明的以下描述的方面也适用于系统、方法、弧形X射线光栅、计算机 程序单元和计算机可读介质。 根据本发明,一种用于对用于弧形X射线光栅的阳极元件的阳极氧化的设备,所述 设备包括:阳极元件;阴极元件;电解介质;导体元件;以及载体元件;其中,所述阳极元件包 括第一侧面和第二侧面,其中,所述第二侧面背对着所述第一侧面;其中,所述载体元件包 括沿着围绕曲率中心的圆弧延伸的弧形表面截面;其中,所述载体元件被配置为接收所述 阳极元件的所述第二侧面以用于将所述导体元件附接到所述阳极元件的所述第一侧面;其 中,所述弧形表面截面被配置为在从所述载体元件卸下所述阳极元件的所述第二侧面之后 接收所述导体元件;其中,所述电解介质被配置为连接所述阳极元件与所述阴极元件;其 中,所述阴极元件连同所述阳极元件和所述电解介质一起被配置为生成定义平面的至少一 组电场线,其中,所述组电场线的至少笔直外延与所述曲率中心相交,其中,对所述至少一 组电场线的所述生成导致对所述弧形表面截面上的所述阳极元件的阳极氧化。 在本发明的一方面中,提供了一种用于对用于弧形X射线光栅的阳极元件的阳极 氧化的方法,其中,所述方法包括以下步骤:将阳极元件附接到载体元件,其中,所述阳极元 件包括第一侧面和第二侧面,其中,所述第二侧面背对着所述第一侧面,并且其中,所述载 体元件接收所述第二侧面,并且其中,所述载体元件包括沿着围绕曲率中心的圆弧延伸的 弧形表面截面;将导体元件附接到所述阳极元件的所述第一侧面;从所述载体元件卸下所 5 CN 111601915 A 说 明 书 2/11 页 述阳极元件;将被附接到所述阳极元件的所述第一侧面的所述导体元件附接到所述载体元 件;将具有所述阳极元件的所述载体元件和阴极元件引入电解介质中,使得在所述阴极元 件与所述阳极元件之间生成定义平面的至少一组电场线,其中,所述组电场线的至少笔直 外延与所述弧形表面截面的所述曲率中心相交。 本发明提供了一种可以在壁结构和沟槽被创建之前产生被聚焦到焦点的X射线光 栅的基本材料的设备。这种所谓的“先聚焦”产生使用阳极元件作为用于要被产生的X射线 光栅的壁结构和沟槽的材料。首先,阳极元件的第一侧面被附接到载体元件。然后,作为电 性导体元件的导体元件被附接到阳极元件的第二侧面。此后,被附接到阳极元件的导体元 件可以被附接到载体元件的弧形表面部分,使得阳极元件呈现弧形表面部分的弧形形状。 承载导体元件和阳极元件的载体元件被引入电解介质中。连同也位于电解介质中的阴极元 件一起,该设备在阴极元件与导体元件之间生成电场,其中,阳极元件被布置在阴极元件与 导体元件之间。因此,在阴极元件处开始的电场线延伸通过阳极元件,并且在导体元件处终 止。至少一组电场线定义平面,其中,该组的那些电场线的外延与弧形表面截面的曲率中心 相交。 对于暗场X射线成像或相位对比成像,尽可能准确地将X射线光栅与彼此对准是重 要的。光栅能够多准确地被对准到彼此强烈地取决于光栅区内的光栅的周期的均匀性和光 栅的形状,因为与光栅的理想形状的偏离使针对整个光栅区准确地对准光栅成为不可能。 如果光栅被机械地弯曲以考虑X射线成像设备的锥束,则这通常通过将力施加于光栅的边 缘来实现。这诱发对整个光栅区的张力。尤其是对于常规放射摄影(例如43cm x 43cm)所需 的大面积光栅,利用这种方法诱发完美的预定光栅形状是不可能的。与预定理想光栅形状 的这种偏离使光栅的准确对准不可能,这导致得到的图像中的更低信噪比。 在本发明中,对延伸通过阳极元件的电场线的生成导致对阳极元件的阳极氧化。 对阳极元件的阳极氧化导致对阳极元件的材料的氧化。由于对阳极元件的材料的氧化,在 阳极元件中生成沿着电场线延伸的孔。由于电场线指向交点,所以阳极元件中的孔也指向 交点。此外,由于阳极元件被布置在弧形表面截面上,所以阳极元件的固有形状是弧形形 状,并且孔被嵌入在阳极元件的该弧形形状中。通过该设备产生的阳极元件因此以聚焦的 形状被阳极氧化。由于阳极元件已经在阳极氧化期间处于聚焦的形状,所以阳极元件可以 被用作用于具有弧形形状的X射线光栅的基本材料。该X射线光栅不必在产生之后被弯曲, 因为基本材料是预聚焦的且预成形的。因此,得到的弧形X射线光栅是无张力的,并且因此 将保持预定形状而无需对外力的施加。因此,暗场X射线成像或相位对比成像所需的对X射 线光栅的非常准确的对准能够被实现,从而导致得到的图像中的高信噪比。因此,得到的无 张力弧形X射线光栅允许改善X射线干涉测量成像。 在一范例中,所述载体元件的所述弧形表面截面可以被配置为接收所述阳极元件 的所述第二侧面。 在一范例中,所述导体元件可以被用作用于所述阳极氧化的牺牲阳极氧化导体, 所述牺牲阳极氧化导体用来确保在通过所述阳极元件的所述电场线的完全延伸上的完全 阳极氧化。 在另一范例中,所述圆弧可以具有到所述曲率中心的恒定距离。 在一范例中,所述设备是包括DC电压生成器的电解槽。在另一范例中,所述电解槽 6 CN 111601915 A 说 明 书 3/11 页 可以包括AC电压生成器。 在一范例中,所述电解介质是液体。 在一范例中,所述阴极元件连同所述阳极元件和所述电解介质一起生成定义多个 平行平面的若干组电场线,其中,每组电场线的至少外延与焦线相交,所述焦线与所有平面 相交。 根据一范例,所述阳极元件包括铝箔元件。铝箔在阳极氧化中作为阳极元件的使 用导致阳极氧化的铝氧化。 根据一范例,所述载体元件的所述弧形表面截面具有凹形圆弧,并且所述阴极元 件被布置在所述曲率中心与所述阳极元件之间。 根据另一范例,所述载体元件的所述弧形表面截面具有凸形圆弧,并且所述阳极 元件被布置在所述曲率中心与所述阴极元件之间。 在一范例中,所述另外的载体元件包括被布置为与所述弧形表面截面相对并且面 向所述弧形表面截面的相反方向的扁平表面截面。 根据一范例,所述阴极元件是弧形区电极,并且所述弧形区电极沿着围绕所述曲 率中心的圆弧延伸。 在另一范例中,所述阴极元件可以是被布置在所述曲率中心的线电极或点电极。 根据一范例,所述阴极元件包括用于提供图案化和/或平铺电场的结构化表面。 在一范例中,所述曲率中心与所述阴极元件之间的距离在0.5m与4m之间、优选地 在1m与3.5m之间、更优选地在1.5m与3m之间、最优选地在2m与2.5m之间的范围内。 根据本发明,还提供了一种用于产生弧形X射线光栅的系统,所述系统包括:用于 弧形直接光刻的设备;以及根据上面的描述的用于对阳极元件的阳极氧化的设备;其中,所 述用于弧形直接光刻的设备被配置为在所述第一侧面提供图案掩模。 在一范例中,所述系统还包括溅镀设备,其中,所述溅镀设备被配置为在所述阳极 元件的所述第一侧面上提供蚀刻掩模。 在另一范例中,所述系统还包括用于从所述阳极元件移除材料的蚀刻设备,其中, 所述蚀刻设备被配置为从所述蚀刻掩模和所述阳极元件的未被图案掩模覆盖的那些部分 移除材料,从而得到弧形X射线光栅。 从阳极元件对材料的移除生成阳极元件中的沟槽。被图案掩模保护的阳极元件的 材料提供阳极元件中的壁元件。沟槽和壁元件形成阳极元件上的光栅结构。 蚀刻设备将沿着已经在对阳极元件的阳极氧化期间生成的孔移除材料。这意味 着,到壁元件的沟槽沿着阳极氧化的阳极元件中的孔的方向延伸。因此,沟槽和壁元件指向 与孔相同的交点,即指向阳极元件的形状的曲率中心。这得到具有无张力光栅表面的弧形X 射线光栅,因为用于在X射线光栅的产生之后提供X射线光栅的弧形形状的弯曲被防止。 在一范例中,所述弧形X射线光栅可以是相位对比X射线成像设备(例如暗场X射线 成像设备)的部件。在又一范例中,所述弧形X射线光栅可以是G2光栅。 在另一范例中,所述弧形X射线光栅可以被卷绕,并且针对卷绕电池几何形状以卷 绕构造方式被提供。 在又一范例中,所述载体元件可以具有包括若干弯曲和扁平截面的复杂结构。 在一范例中,如果所述阳极元件的所述第二侧面覆盖所述另外的载体元件的所述 7 CN 111601915 A 说 明 书 4/11 页 弧形表面截面,则所述图案掩模具有对应于所述另外的载体元件的所述弧形表面的圆弧。 根据一范例,所述系统包括另外的载体元件,所述另外的载体元件包括与所述载 体元件的所述弧形表面截面互补的弧形表面截面;并且其中,所述另外的载体元件的所述 弧形表面截面被配置为在从所述载体元件卸下所述导体元件并且从所述阳极元件移除所 述导体元件之后接收所氧化的阳极元件的所述第二侧面。 通过将所氧化的阳极元件附接到所述另外的载体元件,对所氧化的阳极元件的第 一侧面的另外的处理可以被执行。 根据一范例,所述用于弧形直接光刻的设备还被配置为在所述阳极元件的第一侧 面或第二侧面上的平面上提供图案掩模,其中,所述图案掩模提供具有可变间距的光栅图 案。 根据本发明,还提供了一种用于对阳极元件的阳极氧化的方法,其使用根据上面 的描述的设备或根据上面的描述的用于产生弧形X射线光栅的系统,所述方法包括以下步 骤:a)利用具有第一侧面和第二侧面的阳极元件覆盖载体元件的至少部分,其中,所述第二 侧面连接到所述载体元件;b)将导体元件附接到所述阳极元件的所述第一侧面;c)从所述 载体元件卸下所述阳极元件;d)覆盖所述载体元件的所述弧形表面截面的至少部分,其中, 所述导体元件被附接到所述阳极元件的所述第一侧面;e)在电解介质中调整具有所述阳极 元件的所述载体元件和阴极元件,使得在所述阴极元件与所述阳极元件之间生成的至少一 组电场线定义至少一个平面,并且那些场线的至少外延与所述弧形表面截面的曲率中心相 交;以及f)提供通过所述电解介质的在所述阴极元件与所述阳极元件之间的电流,以在所 述弧形表面截面上的所述阳极元件上执行阳极氧化。 在一范例中,在步骤f)中,在所述阳极元件中生成孔,其中,所述孔沿着所述电场 线被对准。 在一范例中,所述电流可以是DC或AC电流或其混合。 根据一范例,所述方法包括以下另外的步骤:g)从所述载体元件卸下所述导体元 件;h)从所氧化的阳极元件移除所述导体元件;以及i)利用所述阳极元件的所述第二侧面 覆盖另外的载体元件的弧形表面截面的至少部分,其中,所述另外的载体元件的所述弧形 表面截面与所述载体元件的所述弧形表面截面互补。 根据一范例,所述方法包括以下另外的步骤:j)使用溅镀设备和蚀刻掩模上的图 案掩模在所述阳极元件的所述第一侧面上提供所述蚀刻掩模,其中,所述图案掩模具有利 用用于弧形直接光刻的设备对应于所述另外的载体元件的所述弧形表面的圆弧;以及k)利 用蚀刻设备从所述阳极元件移除未被所述图案掩模覆盖的材料,所述移除得到弧形X射线 光栅。 根据本发明,还提供了一种根据上面的描述的方法产生的弧形X射线光栅,所述弧 形X射线光栅包括:弧形光栅表面;其中,所述弧形光栅表面定义焦点或焦线;并且其中,所 述弧形光栅表面是无张力的。无张力意味着不需要外力来提供X射线光栅的弧形形状,即弧 形光栅表面没有外部弯曲应力。因此,如果不需要力来保持光栅处于其原始弧形形状使得 光栅随着时间保持处于其原始弧形形状,则光栅是“无张力的”。与之相比,例如,如果光栅 的弯曲通过将机械力施加到光栅的边缘来实现,则光栅不是无张力的。在这样的情况下,如 果外力被移除,则当材料松弛时,光栅中的张力导致光栅与其原始弧形形状随着时间的偏 8 CN 111601915 A 说 明 书 5/11 页 离。在这种情况下,一旦光栅从使之成形的外部机械力被释放,光栅中的张力就能够被视为 与光栅与其原始弧形形状的偏离成比例。 然而,在一些范例中,由于光栅结构的填充过程或由于另外的过程步骤,光栅表面 可以包括内部张力。 根据本发明,还提供了一种用于控制根据上面的描述的设备或根据上面的描述的 系统的计算机程序单元,当由处理单元运行时,所述计算机程序单元适于执行根据上面的 描述的方法的步骤。 根据本发明,还提供了一种计算机可读介质,存储有根据上面的描述的程序单元。 参考下文所述的实施例,本发明的这些方面和其他方面将变得显而易见并且得到 阐明。 附图说明 本发明的示范性实施例将在下文中参考附图来进行描述: 图1示出了用于对阳极元件的阳极氧化的设备的示意图; 图2a、b示出了具备具有凸形(a)和凹形(b)弧形表面截面的载体元件的设备的示 意图; 图3示出了设备的实施例的截面侧视图; 图4示出了溅镀设备的示意图; 图5a、b示出了提供弧形(a)光栅图案和具有可变间距(b)的光栅图案的用于弧形 直接光刻的设备的示意图; 图6示出了蚀刻设备的示意图; 图7示出了具有无张力弧形光栅表面的弧形X射线光栅; 图8a-j示出了方法的过程步骤; 图9示出了方法的示意性流程图;并且 图10示意性地且示范地示出了偏离理想形状的光栅的部分。












