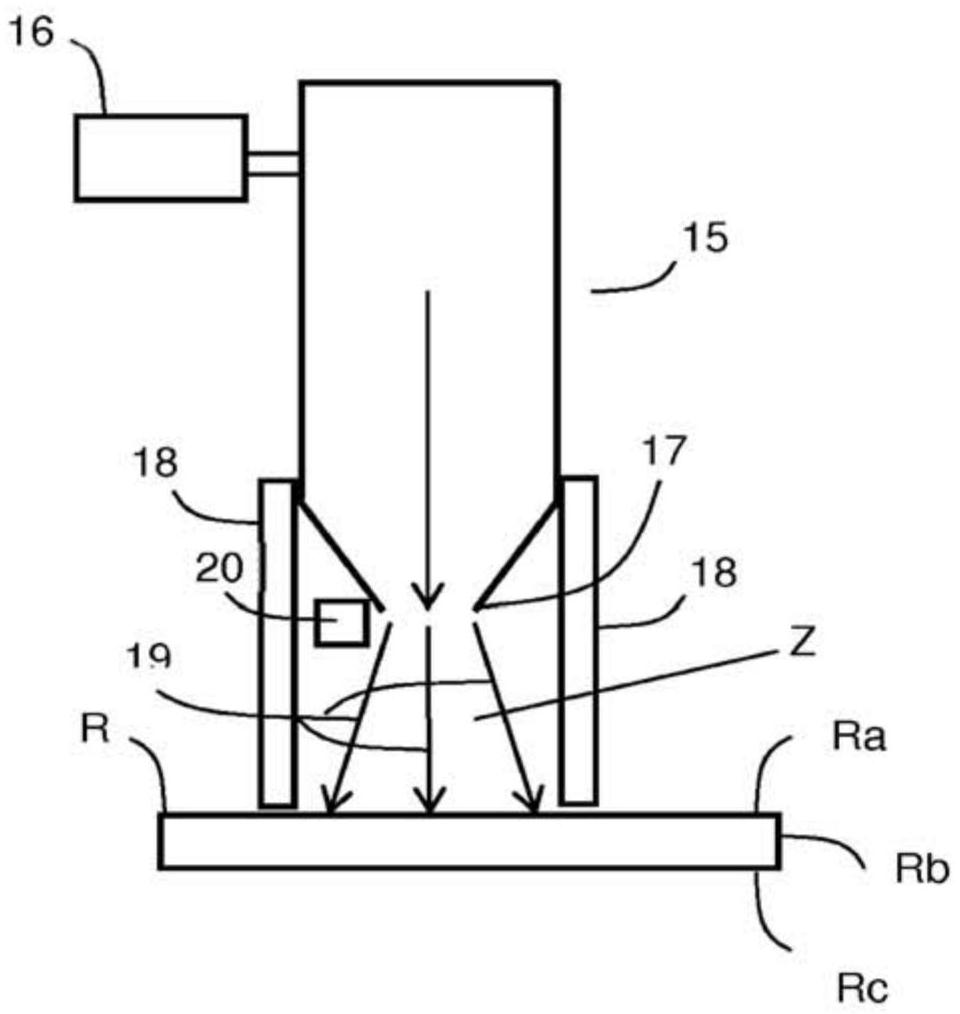
技术摘要:
本申请涉及一种二氧化碳雪清洁设备,包括:二氧化碳源;二氧化碳雪喷嘴,其与二氧化碳源成流体连通;充电元件;以及收集表面。还描述了一种清洁表面的方法,该方法包括以下步骤:(i)将二氧化碳流传送流出二氧化碳雪喷嘴以形成二氧化碳雪流;(ii)为二氧化碳雪流充电;(i 全部
背景技术:
光刻设备是被构造成将期望的图案施加到衬底上的机器。例如,光刻设备可用于 制造集成电路(IC)。光刻设备可以例如将图案从图案形成装置(例如掩模或掩模版)投影到 设置在衬底上的辐射敏感材料(抗蚀剂)的层上。 为了在衬底上投影图案,光刻设备可以使用电磁辐射。该辐射的波长确定了可以 在衬底上形成的特征的最小尺寸。与使用例如具有193nm波长的辐射的光刻设备相比,使用 具有在4nm至20nm范围内(例如6.7nm或13.5nm)的波长的极紫外(EUV)辐射的光刻设备可用 于在衬底上形成较小的特征。 在光刻设备中,EUV辐射是由诸如激光之类的辐射源通过使液态锡滴电离而产生 的。液态锡滴在辐射源的前面通过,并且当辐射冲击锡滴时,锡滴被电离并且释放EUV辐射。 与以这种方式产生EUV辐射相关联的一个问题是锡可能会污染所述光刻设备的各个部分, 诸如图案形成装置。 适用于光刻设备的图案形成装置可以是掩模版。掩模版可能会被来自所述光刻设 备内部的颗粒或污染物污染。颗粒可污染所述掩模版的正面、掩模版的背面以及掩模版的 侧面和/或边缘中的一个或更多个。颗粒可能是由诸如从所述光刻设备所用气体而得到的 无机污染物、曝光期间从所述衬底溅出的抗蚀剂碎屑、或设备各部件之间的机械接触之类 的源生成的。污染物可包括金属颗粒或金属氧化物颗粒。 掩模版污染的问题与极紫外(EUV)光刻特别相关。保护元件通常可以用来保护掩 模版免受光刻设备内污染物的污染。然而,在EUV光刻中,由于所使用的EUV辐射的波长,则 诸如防护薄膜之类的某些保护元件不能轻易地被使用。 在EUV光刻设备中,收集器反射镜是用于向扫描器中高功率输出的关键组件。收集 器反射镜与锡等离子体非常接近,导致收集器暴露于锡微粒的高负荷中。在扫描器中,存在 扫描器光学器件、掩模版和晶片中的一个或更多个的微粒污染物(例如锡、来自薄膜的碎 屑、或来自EUV光刻设备的其他部件的碎屑)。 特别地,掩模版颗粒污染被认为是一个问题,因为掩模版颗粒污染会显着降低所 生产的图案形成装置的产率。掩模版的污染可以例如降低EUV透射到衬底的用于图案形成 的效率。颗粒可以吸收EUV辐射,或者还可以改变掩模版的反射率,由此影响EUV辐射到衬底 4 CN 111742267 A 说 明 书 2/12 页 上的反射。如此,在待施加到衬底上的图案中可能出现不可接受的缺陷。光刻设备的部件、 或防护薄膜的部件可以由包括无机物、有机物、金属、陶瓷或任何其他合适材料的材料制 成。如此,可以是EUV掩模版的图案形成装置可能被多种材料类型污染。 即使是掩模版表面上的单个颗粒也可以极大地影响待施加到衬底上的图案,而且 小至50nm或更小的颗粒可以在图案形成过程中引起缺陷。EUV掩模版上的颗粒可能会吸收 EUV辐射,由此降低或以其他方式改变掩模版的反射率。例如,颗粒还可以改变EUV辐射从 EUV掩模版反射或折射的角度。如此,可以不利地影响到所述图案形成过程的图案形成过程 的效率、准确性和精度中的一项或更多项,由此导致施加到所述衬底上的图案的缺陷。这些 缺陷仅在对已衬底执行图案化之后才能被检测到,且因此已经浪费了衬底。因此,对于EUV 掩模版,所述掩模版的前部、连同所述掩模版的背面以及所述掩模版的侧面/边缘,保持清 洁是很重要的:如果背面的颗粒与夹持突节一致,则它们可能会导致重叠误差,以及侧面/ 边缘上的颗粒可以被传输到掩模版的正面。因此,在正常使用期间,EUV掩模版将需要时常 或根据需要进行清洁。 类似地,收集器的污染导致收集器的降低的反射率。这样的结果是较少的入射EUV 辐射由收集器反射,并且被聚焦,由此降低了EUV源的功率。由于EUV源的降低的功率,因此 在光刻期间需要较长的曝光时间,这降低了所述光刻设备的吞吐量。如果光学元件被污染, 则这将降低光学元件的性能。如果传感器被污染,则这可能会对传感器的灵敏度和/或准确 性产生不利影响,且甚至使传感器无法使用。 尽管主要论述了在EUV光刻设备中使用的图案形成装置(诸如掩模版)的清洁,但 应当理解,本发明的清洁设备和方法适用于待清洁的各种表面,且还可以适用于收集器、光 学元件、反射镜、传感器等。此外,除了锡以外的污染物,诸如但不限于有机物、无机物、其他 金属和陶瓷,也可能存在于光刻设备的部件上,且因此也需要清洁。 如果掩模版确实被污染了,则必须将掩模版从光刻设备中去除以进行清洁。从所 述光刻设备去除掩模版是耗时的且困难的过程,需要大量的技能和专门知识。去除掩模版 还增加了掩模版在光刻设备之外被进一步污染的机会。此外,掩模版极其精巧易碎。如此, 在外部清洁期间存在对掩模版造成不可修补的损坏的重大危险。因此,当从光刻设备中去 除掩模版时,以及在光刻设备外部清洁所述掩模版时,必须格外小心。通常,需要专门的设 施来用于清洁掩模版,专门的设施可能极其昂贵。 特别地,掩模版的侧面和边缘对于颗粒污染是令人关注的,因为在这些位置处,在 清洁期间是用手或通过工具来输送掩模版的。因此,掩模版的这些区域特别容易受到损坏 和交叉污染。 因此,需要开发一种设备和一种方法,用于在就地即在光刻设备内清洁掩模版而 无需去除掩模版。此外,需要减轻从所述待清洁的表面(诸如掩模版)去除的任何污染物对 光刻设备的其他区域造成污染的风险。 已知使用二氧化碳雪来清洁各种各样的表面。可以经由三种不同的方法来使用二 氧化碳以清洁表面,即,使用宏观干冰粒、利用宏观或微观二氧化碳雪颗粒对所述待清洁的 表面进行喷洒的雪流、或通过使用超临界二氧化碳。 在使用宏观干冰粒的系统中,通过研磨作用和动量传送来实现清洁。多个粒能够 实体地清除表面污染物,并且固体二氧化碳(通常称为“干冰”)升华成气态二氧化碳能够将 5 CN 111742267 A 说 明 书 3/12 页 污染物从待清洁的表面推出。 在使用超临界二氧化碳的系统中,超临界流体的低粘度意味着它能够进入狭窄的 空间,在该空间中它能够溶解污染物。超临界二氧化碳能够容易地溶解有机污染物,因此可 用于从咖啡豆中提取咖啡因或从烟草中提取尼古丁。 在依赖于二氧化碳雪的系统中,通过使液态二氧化碳或气态二氧化碳传送穿过孔 口而产生雪。当液态二氧化碳或气态二氧化碳传送穿过孔口和流出孔口时,压力下降会导 致至少一些二氧化碳凝固以形成二氧化碳“雪”。 在许多行业(诸如食品业和制造业)中,雪清洁的使用是标准的。然而,当掩模版在 就地处于光刻设备内时,使用二氧化碳雪清洁来清洁掩模版尚未可行,因为存在所移出的 污染物被重新沉积在光刻设备内的其他地方的风险。 在已知的雪清洁设备中,二氧化碳被传送流出中央喷嘴,这导致二氧化碳雪形成。 围绕所述中央喷嘴,可以设置环形的清洁干燥空气流,环形的清洁干燥空气流有助于引导 二氧化碳雪的流动。这样,二氧化碳雪的流动被清洁干燥的空气的环形帘状流所围绕。二氧 化碳雪可以通过清洁干燥的空气流而被引导至待清洁的表面。然后,二氧化碳雪在待清洁 的表面升华,由此去除了颗粒污染物。在其他二氧化碳雪清洁系统中,没有额外的清洁干燥 空气流。然而,在已知方法中,这些颗粒仅被二氧化碳雪流和空气流吹离待清洁的表面。因 此,已经被去除的颗粒可以仅污染所述光刻设备的另一表面。 尽管本申请通篇总体上涉及EUV光刻设备,特别是涉及EUV掩模版,但本发明不仅 仅限于EUV光刻设备,并且应当理解,本发明的主题可以用于清洁任何光刻设备的任何表 面,特别是用于清洁光刻设备中的任何收集器、光学元件、反射镜、反射表面、壁和传感器或 类似物。
技术实现要素:
已在考虑到前述问题,利用清洁光刻设备(特别地,EUV光刻设备;甚至更特别地, EUV光刻设备的光学元件)的已知方法的情况下实施本发明,EUV光刻设备的光学元件包括 在EUV光刻设备中使用的图案形成装置(诸如掩模版)、反射镜、反射表面、收集器、壁和传感 器。 根据本发明的第一方面,提供了一种二氧化碳雪清洁设备,包括:二氧化碳源;二 氧化碳雪喷嘴,其与二氧化碳源成流体连通;充电元件;以及收集表面。 已出人意料地发现,对二氧化碳雪流进行充电(使得二氧化碳雪花带电,或者使得 二氧化碳雪流的成分带电)改善了从待清洁的表面去除颗粒(尤其是金属颗粒)的效率,尽 管也可以使用非金属颗粒。所述充电元件对二氧化碳雪流充电,并且此电荷传送到待清洁 的表面并且释放出颗粒。与带电二氧化碳流相比,所述收集表面优选地电性相反。所述收集 表面(优选地,与所述二氧化碳流的电性相反)然后将吸引并且收集被二氧化碳雪移出的颗 粒或污染物,且由此防止颗粒或污染物污染光刻设备的其他区域或部分。 二氧化碳雪清洁先前仅被用于清除仅松散地附着在待清洁的表面上或本身并不 特别稳固的污染物/颗粒,诸如涂料。已出人意料地发现,二氧化碳雪清洁特别适合于清洁 来自EUV掩模版的污染物/颗粒,该污染物/颗粒可能更强固地附着在EUV掩模版表面上。遍 及本文中,术语“颗粒”和“污染物”可互换使用。 6 CN 111742267 A 说 明 书 4/12 页 还出人意料地发现,通过为二氧化碳雪流充电,从EUV掩模版表面去除的颗粒也可 能被充电。不希望受到理论的约束,假定在二氧化碳分子与待清洁的表面上的污染物之间 发生电荷转移。使用二氧化碳雪清洁来清洁EUV掩模版的侧面和边缘时,特别需要注意的是 将其仅重新沉积在掩模版的正面。所述收集表面防止污染物被转移到所述光刻设备的另一 区域或防止污染物被沉积到掩模版的另一表面,由此降低了进一步污染的风险。在本发明 之前,已做出努力以避免电荷积聚在二氧化碳雪清洁设备和待清洁的表面上。 在一些实施例中,二氧化碳雪喷嘴具有单个出口,二氧化碳雪通过该出口被排出。 优选地,单个出口是圆形的,或者是其他任何合适的形状。在其他实施例中,二氧化碳雪喷 嘴包括多个出口。优选地,所述多个出口被布置成相对于彼此是基本线性的。替代地,所述 多个出口可以布置成形成环形孔、三角形或期望的任何其他形状。 二氧化碳雪花具有等于其中每个带电二氧化碳分子的电荷之和的总电荷。二氧化 碳雪花中的二氧化碳分子可以由充电元件而带正电或带负电。如此,二氧化碳雪花以及因 此二氧化碳雪流可以带正电,或替代地带负电。电荷可以由带电添加剂而不是二氧化碳本 身携带。由于二氧化碳流可以包括带电添加剂,因此提及带电的二氧化碳流包括其中带电 添加剂携带电荷的情况。 在一些实施例中,所述收集表面可以带电。在其他实施例中,所述收集表面可以可 替代地带静电。当清洁期间带电颗粒接触所述收集表面时,所述收集表面带电可以允许电 流流动。所述收集表面带静电在从待清洁的表面去除的带电颗粒与所述收集表面之间提供 静电吸引力。所述收集表面也可以是不带电的导电表面,该不带电的导电表面将通过镜面 电荷现象吸引带电颗粒。 所述收集表面可以处于在二氧化碳喷嘴与待清洁的表面之间。所述收集表面可以 邻近于二氧化碳雪喷嘴。如先前所描述,所述收集表面防止颗粒污染周围区域,诸如EUV光 刻设备的其他表面。因此,相邻的布置降低了颗粒从待清洁的表面逸出到其他区域的风险, 并且使所述收集表面捕获所述颗粒的概率最大化。所述收集表面可以基本上围绕二氧化碳 雪喷嘴。因此,收集表面可以形成被围封的区域,在该被围封的区域中包含了在清洁期间去 除的颗粒。所述收集表面可以是任何合适的形状,并且可以是基本上平面的、弯曲的或、具 有更复杂的几何形状。 优选地,所述收集表面基本上位于从待清洁的表面去除的至少一部分颗粒或污染 物的路径中。这样,颗粒或污染物遇到的第一表面是收集表面,而非所述光刻设备本身的表 面。所述收集表面可以是静止的。所述收集表面可以与二氧化碳喷嘴一起移动,或者考量二 氧化碳喷嘴的移动。例如,收集表面可以相对于二氧化碳喷嘴处于固定位置,使得随着二氧 化碳喷嘴发生移动,所述收集表面以相同的方式移动。所述收集表面可能能够与二氧化碳 喷嘴无关地移动。应当理解,当二氧化碳喷嘴相对于待清洁的表面的角度被改变时,从表面 去除的颗粒的轨迹也被改变。因此可以移动所述收集表面,使得收集表面基本上保留在已 经从待清洁的表面去除的颗粒的路径中。 收集表面可以是连续的或可以是不连续的。可能有多于一个收集表面。 在一些实施例中,充电元件是电子源、电离辐射源、等离子体源、或摩擦带电表面。 这些充电元件类型中的任何一种都适合于为二氧化碳雪流进行充电,特别是为构成二氧化 碳雪流的二氧化碳分子进行充电。二氧化碳雪流的充电可以通过二氧化碳电离、电离解离 7 CN 111742267 A 说 明 书 5/12 页 或通过任何其他合适的方式来实现。实际上,可以使用能够为二氧化碳流充电的任何方法。 应当理解,尽管涉及单个充电元件,但是在本发明中可以采用多个充电元件。此 外,如果需要,可以在本发明中采用多种不同类型的充电元件。 在一些实施例中,二氧化碳雪可能需要与充电元件14的充电部分直接接触以便变 得带电。因此,可能需要确保将充电元件的充电部分的温度维持在合适的温度,使得二氧化 碳雪花不会融化。类似地,可能期望提供加热元件以便避免在设备中的特定点处积聚二氧 化碳雪。因此,充电元件可以具备用以将充电元件维持在降低的温度的冷却元件和/或用以 将充电元件加热的加热元件。 所述收集表面可以是导电的。特别地,所述收集表面可以是连接到电压源的电极。 电压源可以是电池或任何其他合适的电压器件。电极可以由任何合适的材料制成,例如但 不限于铜、铝、铁或钢。 收集表面可以是固有静电材料。例如,驻极体(其是具有永久静电荷和/或永久偶 极极化的稳定介电材料)可以适合用作根据本发明的收集表面。 所述收集表面可以是磁性的。在一些实施例中,所述收集表面可以是电磁体。在一 些实施例中,所述收集表面可以是永磁体。尽管金属锡是弱顺磁性的,但是例如,离子化的 锡颗粒可以是强铁磁性的,并且因此会强烈地被吸引到磁性收集表面。 当带电的二氧化碳雪流接触待清洁的表面时,净电荷可能开始在待清洁的表面上 积聚。如果电荷被突然从表面消散,则这种电荷的积聚可能是危险的,并且可能损坏待清洁 的表面,特别是如果表面是精巧易碎的EUV掩模版时。因此,在实施例中,可能需要实时测量 待清洁的表面的电荷,以确保电荷不超过临界水平。 因此,如果需要,可以切换由充电元件确定的二氧化碳雪流的电荷正负号。这可以 通过从一个充电元件切换到另一充电元件、通过切换所述充电元件的电流、或通过任何其 他合适的方法来完成。以这种方式,通过与带电的二氧化碳雪流接触而积聚在待清洁的表 面上的电荷可以被减少、中和、甚至电性反转。在某些情况下,可能有必要更改所述收集表 面的电势正负号,以考虑二氧化碳雪流以及由此从待清洁的表面去除的颗粒的改变电荷。 在一些实施例中,可以通过开环电路或闭环电路来防止电荷在待清洁的表面上的积聚或积 累。在一些实施例中,待清洁的表面可以通过使带电的待清洁的表面与离子化气体接触来 中和,或者通过任何其他合适的放电方法来中和。 在一些实施例中,可以同步地切换由充电元件确定的二氧化碳雪流的电荷正负号 和收集表面的电荷正负号。优选地,贯穿整个清洁过程,二氧化碳雪流和收集表面的电荷正 负号是交替的,以防止在待清洁的表面上积聚总电荷。 该设备可以包括真空喷嘴,通过该真空喷嘴可以将二氧化碳气体和污染物从该设 备中抽出。 在一些实施例中,二氧化碳雪清洁设备还包括带电添加剂源以提供带电添加剂。 优选地,带电添加剂被带电元件充电。优选地,二氧化碳雪流包括所述带电添加剂。所述带 电添加剂可以有利地携带额外的电荷作为二氧化碳雪流的一部分,或者单独地并且因此充 当二氧化碳雪流中二氧化碳的补充电荷载体。实际上,可以设想二氧化碳本身不携带或仅 携带最少的电荷,并且可以设想带电添加剂由充电元件充电。所述带电添加剂可以选自包 括水、冰、甲醇、乙醇、异丙醇和丙醇,或任何其他合适的添加剂的组。如果带电添加剂比二 8 CN 111742267 A 说 明 书 6/12 页 氧化碳能够更容易地被充电和/或带电添加剂与二氧化碳相比能够更长久地保持电荷,则 该带电添加剂是合适的。另外,带电添加剂必须基本上对于待清洁的表面是惰性的,即,带 电添加剂必须在二氧化碳雪清洁条件下不得与待清洁的表面发生化学反应。所述带电添加 剂必须具有足够的挥发性,以使带电添加剂能够在没有加热或只有最小限度加热的情况下 从待清洁的表面上被除去。 在一些实施例中,充电元件邻近于二氧化碳雪喷嘴。当二氧化碳雪流离开二氧化 碳雪喷嘴时,充电元件邻近,因此有助于电荷转移到二氧化碳雪花和/或带电添加剂。在一 些实施例中,充电元件基本上围绕二氧化碳雪喷嘴。因此,在这样的实施例中,当充电元件 离开二氧化碳雪喷嘴时,充电元件还基本上围绕着二氧化碳雪流,由此增加了可以为二氧 化碳雪流充电的充电元件的表面积。 充电元件可以是任何合适的电子源,诸如但不限于电子束枪或电子枪。优选地,自 由电子以足够的能量被引导朝向二氧化碳雪流,以为二氧化碳雪流充电。二氧化碳雪流例 如可以通过电子电离来充电。 替代地,充电元件可以是用于使二氧化碳雪流带正电或带负电的任何其他合适的 器件。 在一些实施例中,二氧化碳雪清洁设备包括基本上围绕二氧化碳雪喷嘴的气流。 因此,气流可以将二氧化碳雪流引导朝向待清洁的表面。优选地,气流的至少一部分位于所 述二氧化碳雪喷嘴与所述收集表面之间。优选地,二氧化碳雪清洁设备还包括用于加热所 述气流的加热器。因此,待清洁的表面经历了从二氧化碳雪流到经加热的气流的显著温度 变化,这可能有助于从待清洁的表面去除颗粒。 经加热的气流可以加速从待清洁的表面去除所述颗粒的速率和效率。在使用中, 二氧化碳雪清洁系统被传送穿过待清洁的表面。气流的第一部分传递掠过颗粒并且加热所 述颗粒。这会导致颗粒在加热时膨胀,并且颗粒的加热速度快于下层EUV掩模版,这意味着 它们将以不同的速率膨胀,因而松开了污染物和待清洁的表面之间的结合。随着设备继续 传送跨越待清洁的表面,以及随着二氧化碳雪与颗粒接触,则颗粒将迅速冷却并且进一步 弱化所述颗粒与所述EUV掩模版之间的结合。二氧化碳雪也将以实体方式移出所述颗粒,并 将其推离所述EUV掩模版。随着设备继续传送跨越所述EUV掩模版,气流的第二部分将传送 跨越所述颗粒先前所位于的区域,并且将使得待清洁的表面升温,以便避免待清洁的表面 过冷和可能的水结冰或冷凝物形成。 在一些实施例中,二氧化碳雪清洁设备包括电压源,其中电压被施加在收集表面 与二氧化碳雪喷嘴之间。 所述收集表面优选地与所述二氧化碳雪流电性相反,使得从二氧化碳雪流中获得 电荷的颗粒被吸引到所述收集表面。可以将所述收集表面接地,使得遇到所述收集表面的 带电颗粒能够收集在表面上,但是电荷不会在收集表面上积聚。导电的接地收集表面仍将 由镜面电荷效应吸引带电颗粒。 根据本发明的第二方面,提供了一种清洁表面的方法,该方法包括以下步骤: (i)将二氧化碳流传送流出二氧化碳雪喷嘴以形成二氧化碳雪流; (ii)为二氧化碳雪流充电; (iii)将带电的二氧化碳雪流引导到待清洁的表面上; 9 CN 111742267 A 说 明 书 7/12 页 (iv)在收集表面上收集由带电的二氧化碳雪流从待清洁的表面移除的颗粒。 在一些实施例中,该方法要求所述收集表面是带电的。在一些实施例中,该方法要 求收集表面是带静电的。在其他实施例中,该方法要求所述收集表面是导电的以由镜面电 荷效应产生吸引力。 在一些实施例中,由电子源、电离辐射源、等离子体源(其中二氧化碳雪流传送穿 过所述等离子体源的等离子体的至少一部分)、或通过撞击摩擦带电表面来为二氧化碳雪 流充电。 在一些实施例中,该方法还包括提供带电添加剂。优选地,带电添加剂由电子源、 电离辐射源、等离子体源或与摩擦带电表面的碰撞中的至少一种来充电。优选地,带电添加 剂可以选自包括水、冰、甲醇、乙醇、异丙醇和丙醇、或任何其他合适的添加剂的组合。 在一些实施例中,该方法还包括提供了气流,气流将二氧化碳雪流引导到待清洁 的表面上。优选地,气流由基本上围绕二氧化碳雪喷嘴的出口提供。优选地,气流的至少一 部分位于所述二氧化碳雪喷嘴与所述收集表面之间。所述气流也可以被加热。 在根据本发明的第二方面的方法的一些实施例中,在所述收集表面与所述二氧化 碳雪喷嘴之间施加电压,其中该电压由电压源供应。 在根据本发明的第二方面的方法的一些实施例中,在清洁期间,待清洁的表面相 对于二氧化碳雪流或喷嘴移动。在其他实施例中,二氧化碳雪流或喷嘴相对于待清洁的表 面移动。 根据本发明第二方面的方法可以用于清洁EUV光刻设备的表面,特别是根据所需 的EUV光刻设备的扫描器光学器件、传感器、收集器、壁或任何其他表面。 在根据本发明的第二方面的方法的一些实施例中,在清洁期间,待清洁的表面是 光刻设备的表面,该光刻设备可以是EUV光刻设备。待清洁的表面可以是EUV光刻设备的EUV 掩模版。待清洁的表面可以是EUV正面、EUV掩模版的背面、和EUV掩模版的侧面中的一个或 更多个。优选地,在所述EUV光刻设备内部清洁所述EUV掩模版。 根据本发明的第二方面的方法或根据本发明的第一方面的二氧化碳雪清洁设备 可以用于清洁光刻设备的表面,该光刻设备可以是EUV光刻设备。光刻设备的表面可以是 EUV掩模版。光刻设备的表面可以是掩模版的正面、掩模版的背面、以及掩模版的侧面中的 一个或更多个。 根据本发明的第二方面的方法可以包括就地检查待清洁的表面。当污染物水平达 到或超过预定水平时,可以进行清洁。预定水平可以被选择为例如接近于可以影响束的完 整性和/或形状的水平的污染物水平。期望在达到这样的水平之前清洁所述掩模版。也可以 按设定的间隔执行清洁。所述设定的间隔可以基于例如运行时间的小时数或经成像的晶片 的数量。 根据本发明的第三方面,提供一种光刻设备,该光刻设备包括如本发明的第一方 面所限定的二氧化碳雪清洁设备。有利地,可以在光刻设备内就地清洁所述光刻设备的部 件,诸如EUV掩模版。这具有减少在移除和重新安装期间对掩模版的无意损坏的风险的优 点。这也减少了光刻设备的停机时间,即不能使用该设备的时间。 清洁所述光刻设备内部的EUV掩模版的另一个重要好处是,该掩模版被保持在扫 描器自身内部的超净环境内,并且限制了所述掩模版的输送。可以在光刻设备的专用部分 10 CN 111742267 A 说 明 书 8/12 页 中、以及在所述掩模版在掩模版台上被使用的同时在所述光刻设备的掩模版库中进行就地 清洁。 根据本发明的第四方面,提供根据本发明的第一方面的设备或根据本发明的第二 方面的方法来清洁光刻设备的表面的用法。该表面可以是光刻设备的掩模版。该表面是掩 模版的正面、掩模版的背面、以及掩模版的侧面中的一个或更多个。光刻设备可以是EUV光 刻设备。 关于本发明的任何方面公开的特征可以与本发明的任何其他方面的一个或更多 个特征组合。明确披露了所有这些组合。 附图说明 现在将参考所附示意性附图、仅通过举例方式来描述本发明的实施例,并且在附 图中: -图1描绘了一种光刻系统,该光刻系统包括光刻设备和可以使用本发明的设备 和/或方法加以清洁的辐射源。 -图2A是根据本发明的第一方面的二氧化碳雪清洁设备的示意图;及 -图2B是根据本发明的第一方面的二氧化碳雪清洁设备的示意图; -图3是根据本发明的第一方面的二氧化碳雪清洁设备的示意图;以及 -图4是采用根据本发明的第一方面的二氧化碳雪清洁设备的二氧化碳雪清洁和 颗粒收集的示意图。












