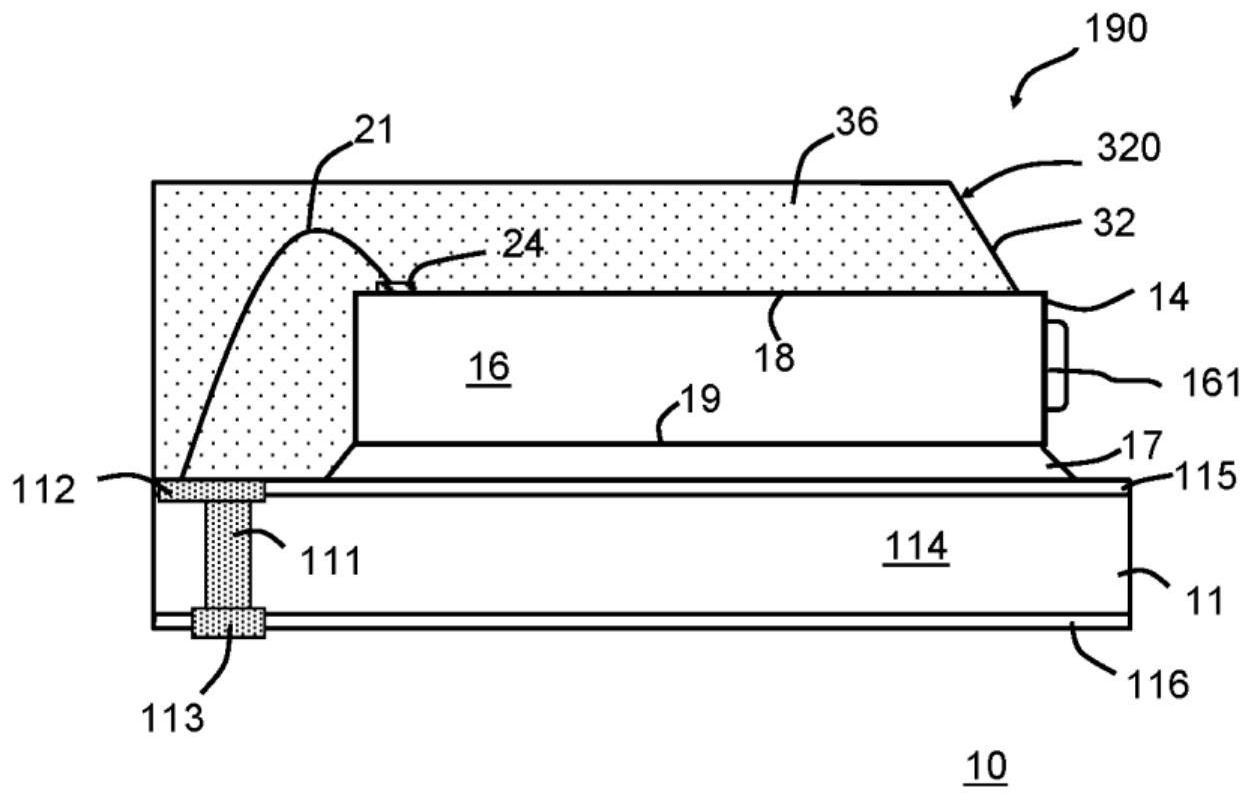
技术摘要:
半导体装置和制造半导体装置的方法。封装电子装置结构包含具有主表面的衬底。半导体装置连接到衬底的主表面,半导体装置具有第一主表面、与第一主表面相对的第二主表面,以及在第一主表面与第二主表面之间延伸的侧表面。封装体包封半导体装置的一部分,其中半导体装置 全部
背景技术:
先前的半导体封装以及形成半导体封装的方法是不适当的,例如,导致成本过高、 热性能差、可靠性降低、性能相对低或封装尺寸太大。更具体来说,一些封装半导体装置包 含例如传感器或光学装置的半导体装置,所述半导体装置需要将装置中作为有源表面的一 个或多个侧表面暴露于封装的外部。此类装置包含例如激光装置,所述激光装置可以并入 到光探测和测距(“LIDAR”)系统中。用于生产其中半导体装置的一个或多个侧表面暴露的 封装半导体装置的前述方法产生较差结果,问题包含损坏半导体装置和导电互连件,例如, 引线键合。另外,导电互连件已通过开放的侧表面或在封装的空腔内暴露于环境,从而产生 可靠性问题。通过比较此类方法与本公开并参考图式,所属领域的普通技术人员将显而易 见常规和传统方法的其它限制和缺点。 因此,希望具有一种封装结构和方法,所述封装结构和方法提供一种克服现有技 术的缺点的封装电子装置。还希望结构和方法容易地并入到制造流程中,容纳多种裸片互 连方案并且具有成本效益。
技术实现要素:
除了其它特征之外,本说明书包含封装电子装置结构以及相关联方法,其包括具 有暴露于封闭结构的侧表面中的有源侧表面的电子装置。在一些实例中,封闭结构包括模 制封装体。在其它实例中,封闭结构包括盖结构。在两个结构中,保护例如导电互连结构的 元件免受环境影响,以与前述装置相比提高可靠性。封装电子装置结构可以容纳多种裸片 互连方案。相关联方法可以并入到标准制造流程中,以提供节约成本的集成方案。 更具体来说,在一个实例中,用于形成封装电子装置结构的方法包括提供具有主 表面的衬底。所述方法包含将第一装置附接到衬底的主表面。所述方法包括形成包封第一 装置的一部分的封装体,其中第一装置的侧表面暴露于封装体外部。在一些实例中,附接第 一装置包括附接半导体装置,半导体装置具有发射极区作为暴露于封装体外部的半导体装 置的侧表面的一部分。在一些实例中,所述方法包含将第二装置附接到与第一装置间隔开 的主表面,以在第一装置与第二装置之间提供间隙;以及形成封装体包括形成封装体,使得 间隙不含封装体。在一些实例中,形成封装体包括:放置阻挡结构以包围间隙;以及将封装 体模制到第一装置的至少一部分上。在一些实例中,放置阻挡结构包括放置具有跨越间隙 4 CN 111613541 A 说 明 书 2/10 页 延伸的部分的模套工具,模套工具具有安置于模套工具与第一装置和第二装置之间的保护 膜。在一些实例中,第一装置包括第一半导体装置。在一些实例中,第二装置包括虚设装置。 在一些实例中,第二装置包括第二半导体装置。在一些实例中,通过间隙分离衬底。在一些 实例中,将第一装置电连接到衬底,其中:第一装置的侧表面包含发射极区。在一些实例中, 电连接包括将导电互连结构附接到第一装置和衬底;以及形成封装体包括形成模制结构, 模制结构用封装体覆盖导电互连结构。在一些实例中,形成封装体包括覆盖第一装置的至 少50%的主表面。在一些实例中,形成封装体包括提供具有封装体侧表面的封装体,其中暴 露第一装置的侧表面;以及封装体侧表面在截面图中具有倾斜形状。 在另一实例中,封装电子装置结构包含具有主表面的衬底。半导体装置连接到衬 底的主表面,半导体装置具有第一主表面、与第一主表面相对的第二主表面,以及在第一主 表面与第二主表面之间延伸的侧表面。封装体包封半导体装置的一部分,其中半导体装置 的侧表面通过封装体的侧表面暴露。在一些实例中,封装体包括模制结构,模制结构接触并 覆盖半导体装置的第一主表面。在其它实例中,结构进一步包含将半导体装置电连接到衬 底的导电互连结构,并且封装体包封导电互连结构。在一些实例中,封装体包括模制结构, 模制结构接触并覆盖半导体装置的第一主表面的至少一部分。在一些实例中,半导体装置 包括激光装置;以及半导体装置的侧表面包含发射极区。 在另外的实例中,用于形成封装电子装置结构的方法包含提供具有主表面的衬 底。所述方法包含将半导体装置附接到衬底的主表面,半导体装置具有第一主表面、与第一 主表面相对的第二主表面,以及在第一主表面与第二主表面之间延伸的侧表面。所述方法 包含通过导电互连结构将半导体装置电连接到衬底。所述方法包含用保护材料覆盖导电互 连结构以及半导体装置的第一主表面的至少一部分。所述方法包含将盖结构附接到衬底, 盖结构包括侧面、顶部和开口,其中半导体装置的侧表面通过开口暴露于盖结构外部。在一 些实例中,衬底和盖结构包括类似材料。在一些实例中,衬底和盖结构包括层压材料。在其 它实例中,附接盖结构包含将侧面附接到衬底的主表面;以及将顶部附接到侧面;并且所述 方法进一步包含在盖结构附接到衬底之后移除盖结构的一部分以提供开口。在一些实例 中,移除盖结构的部分进一步包含将衬底单体化。在一些实例中,移除盖结构的部分包含将 衬底单体化。在一些实例中,附接盖结构包括附接包围半导体装置的单件盖结构;所述方法 进一步包括在盖结构附接到衬底之后移除盖结构的一部分以提供开口;以及移除盖结构的 部分包含将衬底单体化。 其它实例包含于本公开中。在图式、权利要求书和/或本公开的说明书中可以找到 此类实例。 附图说明 图1说明本说明书的实例封装电子装置的截面图; 图2是形成本说明书的封装电子装置的实例方法的流程图; 图3至7说明根据本说明书的在制造的各个阶段图1的封装电子装置的部分截面 图; 图8说明在制造的中间阶段本说明书的实例封装电子装置的部分截面图; 图9说明本说明书的实例封装电子装置的截面图; 5 CN 111613541 A 说 明 书 3/10 页 图10是形成本说明书的封装电子装置的实例方法的流程图; 图11至15说明根据本说明书的在制造的各个阶段图9的封装电子装置的部分截面 图;以及 图16说明本说明书的实例封装电子装置的截面图。 为了说明的简单和清楚起见,图中的元件未必按比例绘制,并且相同附图标记在 不同图中表示相同元件。另外,为了描述的简单起见省略众所周知的步骤和元件的描述和 细节。如本文所使用,术语「和/或」包含相关联的所列项目中的一个或多个的任何以及所有 组合。另外,本文中所使用的术语仅出于描述特定实例实施例的目的,并且并不意图限制本 公开。如本文中所使用,除非上下文另外明确指示,否则单数形式也意图包含复数形式。应 进一步理解,术语「包括(comprises/comprising)」和/或「包含(includes/including)」在 用于本说明书时指定所陈述的特征、数目、步骤、操作、元件和/或组件的存在,但是并不排 除一个或多个其它特征、数目、步骤、操作、元件、组件和/或其群组的存在或添加。应理解, 尽管术语「第一、第二等」可以在本文中用于描述各个部件、元件、区域、层和/或区段,但这 些部件、元件、区域、层和/或区段应不受这些术语限制。这些术语仅用于区分一个部件、元 件、区域、层和/或区段与另一部件、元件、区域、层和/或区段。因此,例如,下文论述的第一 部件、第一元件、第一区域、第一层和/或第一区段可能被称为第二部件、第二元件、第二区 域、第二层和/或第二区段,而不脱离本公开的教示。参考“一个实例”或“实例”是指结合实 施例描述的特定特征、结构或特性包含于本发明的至少一个实例中。因此,贯穿本说明书在 不同位置中出现短语“在一个实例中”或“在实例中”不一定都是指同一个实例,但在一些情 况下指同一个实例。此外,如所属领域普通技术人员将明白,特定特征、结构或特性可以通 过任何合适方式组合在一个或多个实例实施例中。另外,术语「在……时」是指特定动作至 少出现在起始动作的持续时间的某一部分内。词语「大约、近似或基本上」的使用是指元件 的值预期为接近一种状态值或位置。然而,众所周知在本领域中总是存在防止精确地陈述 值或位置恰的微小差异。除非另外规定,否则如本文中所使用,词语「在……上面」或「 在……上」包含所规定的元件可以直接或间接物理接触的定向、放置或关系。应进一步理 解,下文说明和描述的实例可以适当地具有实例和/或可以在不存在本文未具体公开的任 何要素的情况下实践。












