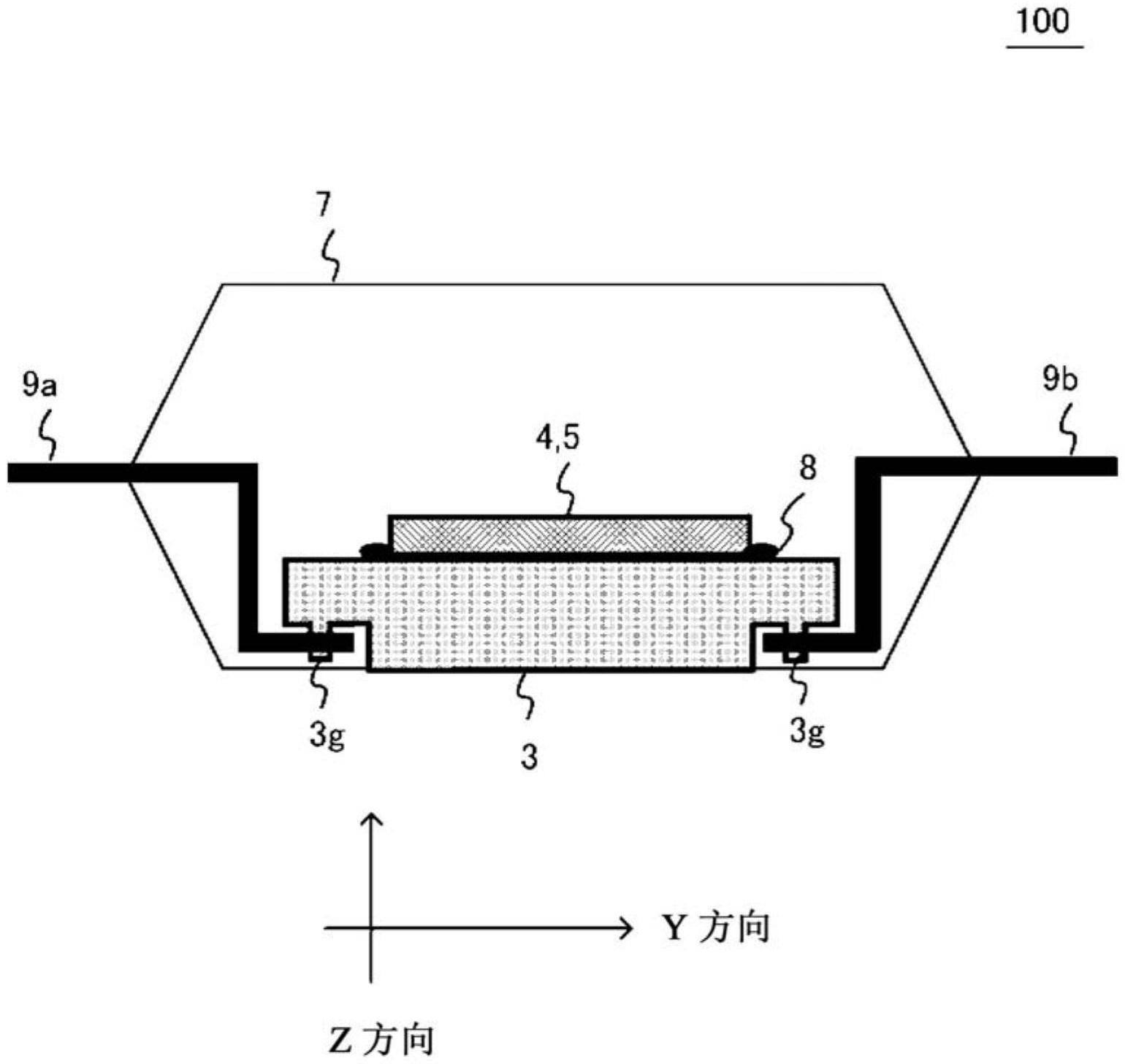
技术摘要:
一种半导体装置(100),其特征在于,具有:散热器(3),其具有搭载面(3b)、散热面(3a)、侧面(3c)及卡合部(3d、3e、3f、3g);半导体芯片(4),其搭载于所述散热器的搭载面;引线框(9),其与所述散热器的卡合部卡合;以及模塑树脂(7),其将所述散热器、所述半导体芯片及所述 全部
背景技术:
移动电话用基站代表无线通信的器件市场。在该无线通信的器件市场中,目前,Si 器件、GaAs器件是主流。在指向高功率化的领域中,对于半导体器件,由于通信容量的增大 而要求宽频带化、小型化(例如,参照专利文献1)。因此,在指向高功率化的领域中,GaN器件 逐渐成为主流,另一方面,对半导体器件的低成本化的要求严格。 就GaN器件而言,也正在推进通过模塑树脂将引线框封装后的低成本的模塑封装 件构造的研究。在模塑封装件构造中,为了确保半导体芯片的散热性,使用具有铜或铜合金 类的散热器的引线框。例如,正在开发将在散热器的上表面设置的销钉与引线框通过铆接 进行固定的半导体装置。就该半导体装置而言,由于在散热器的上表面存在无法进行部件 安装的区域,因此阻碍封装件的小型化。 已知在散热基板(散热器)的两端具有上边长、下边短的梯形凸部的构造(例如,参 照专利文献2)。在引线的保持体的下部设置有与上述梯形凸部一致的槽形凹部。凸部和凹 部嵌合。在本构造中,由于在散热器的两端存在用于嵌合的区域,因此在散热器的上表面产 生无法进行部件安装的区域。这种构造的半导体装置不适用于实现封装件的小型化。 另外,已知将引线从上方插入到以从搭载部件的下表面穿透至上表面的方式设置 的安装用孔中的构造(例如,参照专利文献3)。本构造在搭载部件设置有安装用孔。由于将 引线插入至该孔,因此在搭载部件的上表面产生无法进行部件安装的区域。因此,该半导体 装置也不适用于实现封装件的小型化。 专利文献1:日本特开昭52-150970号公报 专利文献2:日本特开昭48-066776号公报 专利文献3:日本特开2004-103790号公报
技术实现要素:
如上说明所示,就通过铆接而将在散热器的上表面设置的销钉与引线框固定的半 导体装置而言,在散热器的上表面产生无法进行部件安装的区域,因而阻碍了封装件的小 型化。本申请的目的在于提供能够在散热器的上表面全部区域进行部件安装的引线框构造 及半导体装置。 本申请的说明书所公开的半导体装置的特征在于,具有:散热器,其具有搭载面、 散热面、侧面以及卡合部;半导体芯片,其搭载于所述散热器的搭载面;引线框,其与所述散 热器的卡合部卡合;以及模塑树脂,其将所述散热器、所述半导体芯片及所述引线框封装, 所述散热器的卡合部配置于所述散热器的避开搭载面的位置。 发明的效果 本申请的说明书所公开的半导体装置的特征在于,具有:散热器,其具有搭载面、 3 CN 111615747 A 说 明 书 2/6 页 散热面、侧面以及卡合部;半导体芯片,其搭载于所述散热器的搭载面;引线框,其与所述散 热器的卡合部卡合;以及模塑树脂,其将所述散热器、所述半导体芯片及所述引线框封装, 所述散热器的卡合部配置于所述散热器的避开搭载面的位置,由此,能够提供可在散热器 的上表面全部区域进行部件安装的引线框构造及半导体装置。 附图说明 图1是对本发明的实施方式涉及的半导体装置的外观构造进行说明的图。 图2是对本发明的实施方式涉及的半导体装置的电极端子的构造进行说明的图。 图3是对实施方式1涉及的半导体装置的引线框的构造进行说明的图。 图4是对实施方式1涉及的半导体装置的散热器的构造进行说明的图。 图5是对实施方式1涉及的半导体装置的引线框的构造进行说明的图。 图6是对实施方式2涉及的半导体装置的引线框的构造进行说明的图。 图7是对实施方式3涉及的半导体装置的引线框的构造进行说明的图。 图8是对实施方式4涉及的半导体装置的引线框的构造进行说明的图。












