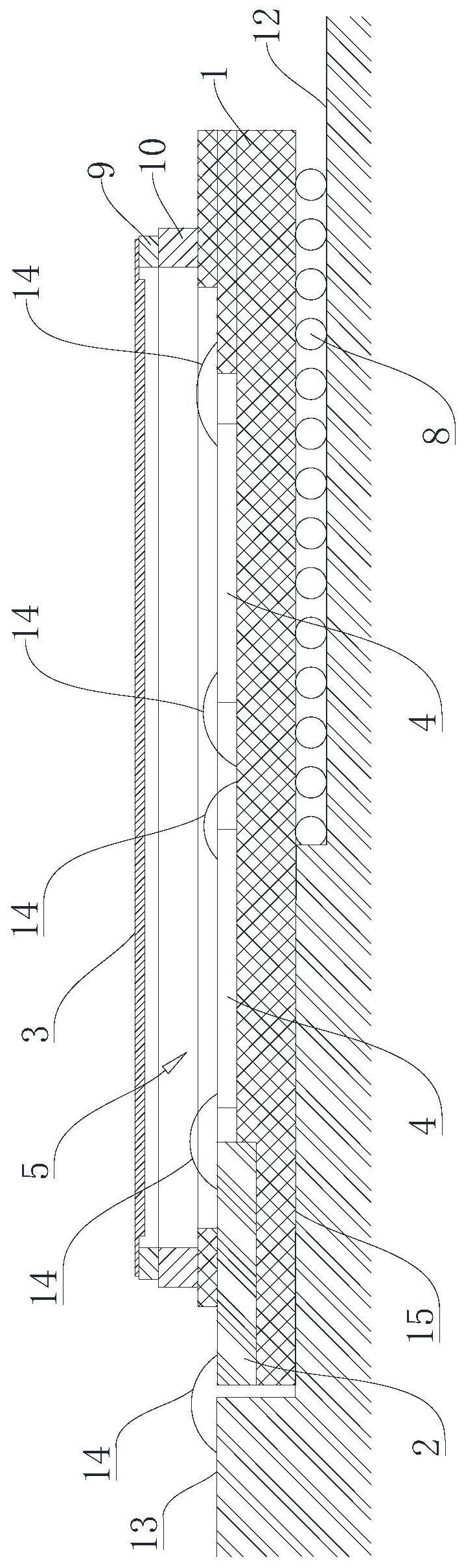
技术摘要:
本发明提供了一种陶瓷封装外壳,属于芯片封装技术领域,包括陶瓷基体、陶瓷绝缘子、盖板和焊盘结构;陶瓷基体为多层结构,设有腔体;陶瓷绝缘子设于陶瓷基体上,上部有贯穿腔体侧壁设置的射频传输结构;盖板密封盖设于腔体;焊盘结构设于陶瓷基体底部。本发明提供的陶 全部
背景技术:
随着微波半导体技术的不断发展,器件的工作频率越来越高,这样也就要求封装 外壳适应封装更高使用频率的器件以及更小的驻波,金属腔镶嵌陶瓷绝缘子结构外壳是适 应封装更高频率器件的理想封装外壳形式,它可以将一个或多个微波毫米波半导体芯片密 封在一个单独的盒体中,通过陶瓷绝缘子作为输入输出端子与外电路实现微波信号的互 连,由于整个外壳是全密封结构,隔绝了外界环境对芯片的侵蚀,器件具有较高的可靠性。 在封装外壳的整体结构中,陶瓷绝缘子是镶嵌在金属封接框和底座之间的,它的一端通过 外引线与外部电路连接,另一端伸入到封装外壳内部与半导体芯片相连接,起到连接内部 芯片和外部电路的作用。 传统的微波封装外壳为金属墙陶瓷绝缘子外壳,这类外壳采用金属地盘作为芯片 承载衬底,虽然散热性能优异,但绝缘子的结构限制了其引出端的数量,无法进行高密度的 互连。
技术实现要素:
本发明的目的在于提供一种陶瓷封装外壳,旨在解决现有的微波封装外壳无法进 行高密度的互连的技术问题。 为实现上述目的,本发明采用的技术方案是:提供一种陶瓷封装外壳,包括: 陶瓷基体,为多层结构,所述陶瓷基体上设有开口向上的腔体; 陶瓷绝缘子,设于所述陶瓷基体上,所述陶瓷绝缘子上部形成有射频传输结构,所 述射频传输结构贯穿所述腔体侧壁设置,所述腔体内设有至少一个与所述射频传输结构导 电连接的芯片和/或无源元件; 盖板,密封盖设于所述腔体;以及 焊盘结构,设于所述陶瓷基体底部。 作为本申请另一实施例,所述陶瓷基体上设有嵌装槽,所述陶瓷绝缘子嵌装于所 述嵌装槽中。 作为本申请另一实施例,所述陶瓷基体与所述绝缘子一体设置。 作为本申请另一实施例,所述焊盘结构包括: 第一焊盘,为盘状构件,设于所述陶瓷基体的底面上,且对应于所述陶瓷绝缘子, 所述第一焊盘用于接地;以及 第二焊盘,设于所述陶瓷基体的底面上,且位于所述第一焊盘外侧,所述第二焊盘 用于传输信号。 作为本申请另一实施例,所述第二焊盘呈阵列状的设置多个,且分别连接有焊球。 3 CN 111599802 A 说 明 书 2/5 页 作为本申请另一实施例,所述陶瓷封装外壳还包括封口环,为金属构件,所述封口 环设于所述腔体开口的外周,所述盖板密封盖设于所述封口环。 作为本申请另一实施例,所述封口环和所述陶瓷基体之间还设有过渡环,所述过 渡环用于减缓所述陶瓷基体和所述封口环之间的封接应力。 作为本申请另一实施例,所述陶瓷基体为氮化铝陶瓷基体。 本发明提供的陶瓷封装外壳的有益效果在于:与现有技术相比,本发明陶瓷封装 外壳的陶瓷基体采用多层结构,可进行多层布线,有效提高布线密度,陶瓷绝缘子能使外壳 适用于封装更高频率的芯片,同时,腔体内可安装多个芯片和多种无源元件,满足了用户对 高集成度的封装需求,底部的焊盘结构也使得封装外壳具有更多的引出端。实际上,本发明 的陶瓷封装外壳将射频传输端口技术和高气密性的多芯片陶瓷封装技术相结合,使封装外 壳同时具备优异的微波性能、高密度的布线、高集成度的元器件分布以及数量更多的引出 端,有效解决了传统的微波封装外壳无法进行高密度互连的问题。 本发明还提供一种封装外壳安装结构,用于安装上述的陶瓷封装外壳,包括电路 板,所述电路板上设有第一阶梯结构,所述第一阶梯结构的上表面与所述陶瓷封装外壳的 陶瓷绝缘子的上表面平齐,所述第一阶梯结构的上表面设有用于与所述射频传输结构导电 连接的键合结构,所述电路板的上板面上设有与所述焊盘结构焊接的电路板焊盘结构。 作为本申请另一实施例,所述陶瓷封装外壳的焊盘结构包括: 第一焊盘,为盘状构件,设于所述陶瓷基体的底面上,且对应于所述陶瓷绝缘子, 所述第一焊盘用于接地; 第二焊盘,呈阵列状的设置多个,且分别连接有焊球,所述第二焊盘设于所述陶瓷 基体的底面上,且位于所述第一焊盘外侧,所述第二焊盘用于传输信号; 所述电路板焊盘结构包括与所述第一焊盘焊接的第三焊盘及与所述第二焊盘焊 接的第四焊盘; 所述电路板上还设有第二阶梯结构,所述第二阶梯结构高于所述电路板的上板面 且低于所述第一阶梯结构的上表面,所述第二阶梯结构的上表面设有所述第三焊盘,所述 电路板的上板面上设有所述第四焊盘。 本发明提供的封装外壳安装结构的有益效果在于:与现有技术相比,本发明封装 外壳安装结构,适用于上述陶瓷封装外壳的安装,安装时先将陶瓷基体底部的焊盘结构与 电路板上的电路板焊盘结构焊接,随后再用键合线将射频传输结构与第一阶梯结构上的键 合结构导电连接,由于在电路板上设置了第一阶梯结构,使得键合结构与陶瓷绝缘子之间 基本没有高度差,便于键合连接,同时保证阻抗匹配。 附图说明 为了更清楚地说明本发明实施例中的技术方案,下面将对实施例或现有技术描述 中所需要使用的附图作简单地介绍,显而易见地,下面描述中的附图仅仅是本发明的一些 实施例,对于本领域普通技术人员来讲,在不付出创造性劳动的前提下,还可以根据这些附 图获得其他的附图。 图1为本发明实施例提供的陶瓷封装外壳的主视结构剖视图; 图2为本发明实施例提供的陶瓷封装外壳的俯视结构示意图; 4 CN 111599802 A 说 明 书 3/5 页 图3为本发明实施例提供的陶瓷封装外壳的仰视结构示意图; 图4为本发明实施例采用的陶瓷绝缘子的立体结构示意图; 图5为本发明实施例所提供的陶瓷封装外壳与封装外壳安装结构的装配示意图; 图中:1、陶瓷基体;2、陶瓷绝缘子;3、盖板;4、芯片;5、腔体;6、射频传输结构;601、 带状线;602、共面波导;7、第一焊盘;8、焊球;9、封口环;10、过渡环;11、信号键合指;12、电 路板;13、第一阶梯结构;14、键合线;15、第二阶梯结构。












