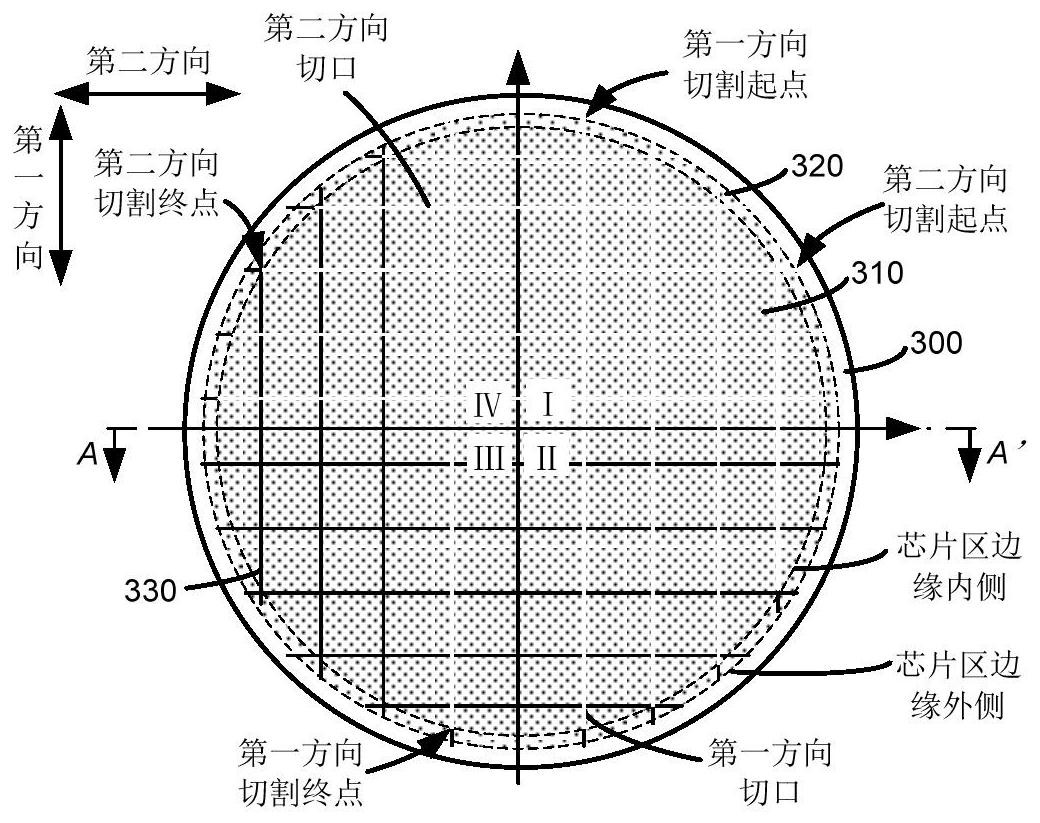
技术摘要:
本发明公开了一种切割方法,包括:提供待切割的晶圆,晶圆的背面贴有背胶层,晶圆正面包括芯片区和芯片区边缘,芯片区和芯片区边缘包括多条同时贯穿芯片区和芯片区边缘且相交的切割道,以隔开各个芯片;沿着切割道切割晶圆,开始切割的位置为切割起点,停止切割的位置 全部
背景技术:
目前半导体芯片形成在晶圆上,通常晶圆表面形成有成千上万的芯片,在晶圆上 同时形成多个芯片能够节省工艺成本。在形成芯片的同时,芯片之间也形成有便于切割的 切割道,用于分离形成单个芯片。 目前,在沿着切割道切割芯片时,芯片区边缘易出现较多飞溅的碎片,最终切割后 得到芯片的良率较低。 因此,现有技术亟须一种提高切割后芯片良率的切割方法。
技术实现要素:
本发明实施例公开了一种切割方法,将切割终点控制在芯片区边缘的内侧,减少 飞溅碎片的产生,减低了切割刀锯表面出现撞击缺口机率,提高了切割后芯片的良率。 本发明公开了一种切割方法,包括:提供待切割的晶圆,晶圆的背面贴有背胶层, 晶圆正面包括芯片区和芯片区边缘,芯片区和芯片区边缘包括多条同时贯穿芯片区和芯片 区边缘且相交的切割道,以隔开各个芯片;沿着切割道切割晶圆,开始切割的位置为切割起 点,停止切割的位置为切割终点,切割起点或切割终点位于芯片区边缘的内侧;和沿着其他 切割道重复上述切割过程,直至将芯片区切割为多个芯片。 根据本发明的一个方面,切割道包括第一方向切割道和第二方向切割道,第一方 向切割道和第二方向切割道垂直相交。 根据本发明的一个方面,沿第一方向切割道切割形成第一方向切口,第一方向切 割起点位于芯片区边缘外侧,第一方向切割终点位于芯片区边缘内侧,或者第一方向切割 起点位于芯片区边缘内侧,第一方向切割终点位于芯片区边缘外侧。 根据本发明的一个方面,刀锯沿着第一方向切割道一端的芯片区边缘的内侧开始 切割,切割至第一方向切割道另一端的芯片区边缘的内侧时,停止切割,切割起点和切割终 点均位于芯片区边缘内侧。 根据本发明的一个方面,在形成第一方向切口后,还包括:沿着第二方向切割道切 割晶圆以形成第二方向切口,第二方向的切割起点或切割终点位于芯片区边缘的内侧。 根据本发明的一个方面,形成第二方向切口的工艺步骤还包括:以第二方向切割 道与第一方向切口相交的位置为切割起点,沿第二方向切割道双向切割晶圆,切割至对应 的芯片区边缘的内侧时,停止切割,切割终点位于第二方向切割道两端的芯片区边缘的内 侧。 根据本发明的一个方面,芯片区边缘为环形,环形的中心与晶圆的圆心重合,以晶 圆的圆心为中心将芯片区和芯片区边缘均分为第Ⅰ区域、第Ⅱ区域、第Ⅲ区域和第Ⅳ区域, 第一方向和第二方向的切割起点位于第Ⅰ区域和第Ⅲ区域的芯片区边缘外侧,切割终点位 3 CN 111599752 A 说 明 书 2/6 页 于第Ⅱ区域和第Ⅳ区域对应的芯片区边缘内侧。 根据本发明的一个方面,第一方向和第二方向的切割起点同时位于对应的第Ⅳ区 域的芯片区边缘外侧。 根据本发明的一个方面,第一方向和第二方向的切割起点位于第Ⅰ区域、第Ⅱ区域 和第Ⅲ区域的芯片区边缘的外侧,第Ⅳ区域的芯片区边缘内侧均为对应的第一方向和第二 方向的切割终点。 与现有的技术方案相比,本发明的技术方案具备以下优点: 本发明的技术方案中沿着切割道切割晶圆,开始切割的位置为切割起点,停止切 割的位置为切割终点,切割起点或切割终点位于芯片区边缘的内侧。切割过程切割起点或 者切割终点位于芯片区边缘的内侧能够减少飞溅碎片的数量,降低碎片撞击刀锯的机率, 后续切割时不会进一步破坏芯片的结构,提高了切割得到的芯片的良率。 进一步的,刀锯沿着第一方向切割道一端的芯片区边缘的内侧开始切割,切割至 第一方向切割道另一端的芯片区边缘的内侧时,停止切割,切割起点和切割终点均位于芯 片区边缘内侧。这种切割方法能够保证切割过程均不会切割芯片区边缘,避免飞溅的碎片 产生,降低了刀片被撞击的概率,提高了切割后芯片的良率。 进一步的,形成第二方向切口的工艺步骤还包括:以第二方向切割道与第一方向 切口相交的位置为切割起点,沿第二方向切割道双向切割晶圆,切割至对应的芯片区边缘 的内侧时,停止切割,切割终点位于第二方向切割道两端的芯片区边缘的内侧。以第二方向 切割道中间位置为切割起点,使得切割终点均位于芯片区边缘的内侧,进一步降低刀锯被 撞击的概率,提高了切割后芯片的良率。 附图说明 图1a和图1b是根据本发明一个实施例的切割方法晶圆结构示意图; 图2a和图2b是根据本发明另一个实施例的切割方法晶圆结构示意图; 图3a和图3b是根据本发明又一个实施例的切割方法晶圆结构示意图;












