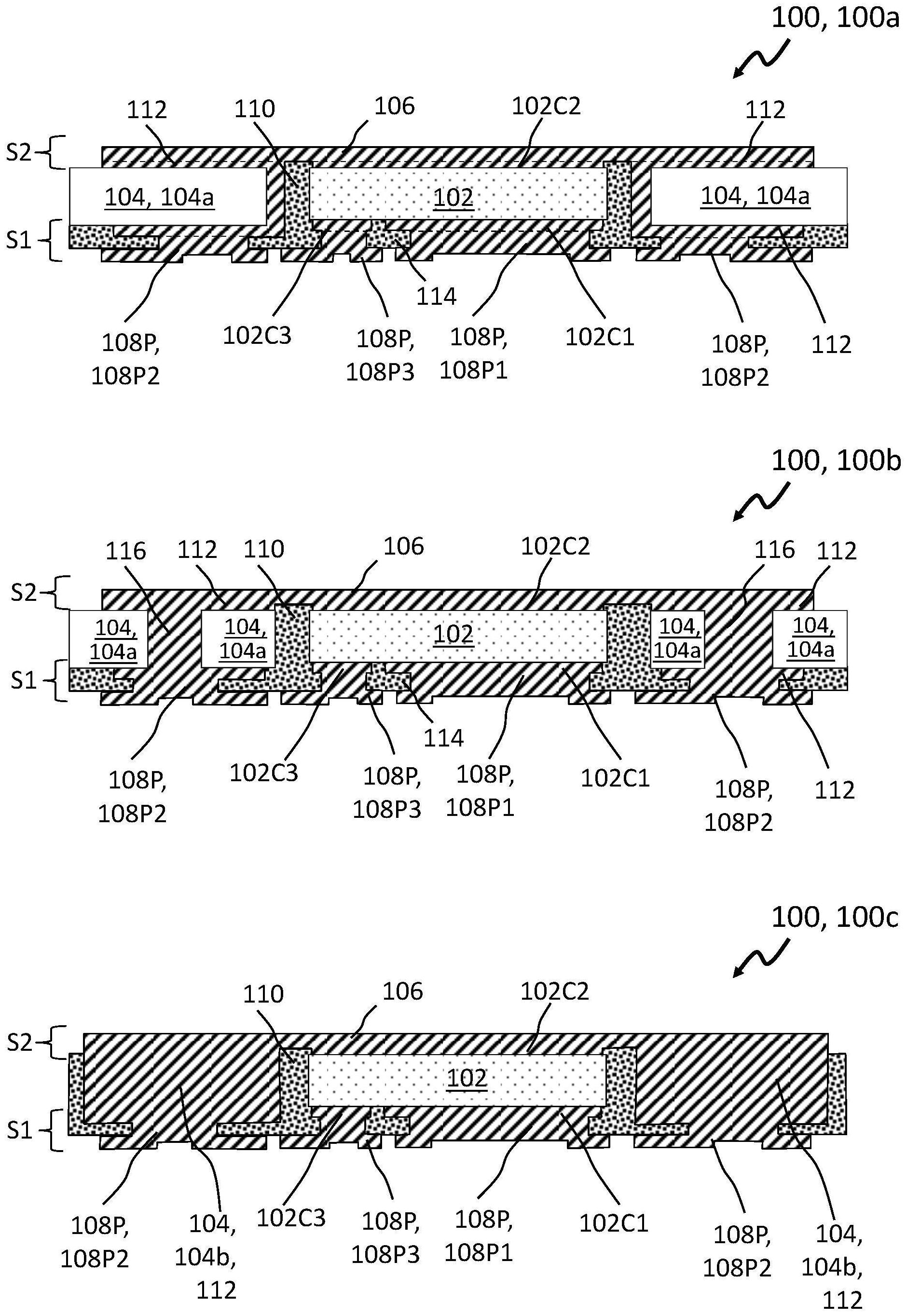
技术摘要:
提供了一种管芯封装。所述管芯封装可以包括:管芯,该管芯具有位于该管芯的第一侧上的第一管芯接触部以及位于该管芯的与该管芯的第一侧相对的第二侧上的第二管芯接触部;与管芯横向相邻的绝缘材料;基本上直接接触管芯的第二管芯接触部的整个表面的金属结构,其中,所 全部
背景技术:
成本和性能可以被视为有关分立功率封装的两个主要相关方面。在嵌入式芯片的 制造当中,一个典型的挑战是如何以最低的可能成本制造具有最佳可能电性能和热性能的 封装。良好的电性能可能需要管芯和封装之间的良好导电接触。这样的接触通常是作为昂 贵的激光微过孔和/或镀覆通孔形成的。例如,当前的CE第二代3X3封装的布局可以包括处 于管芯的两侧上的两层。出于这一原因,热性能可能不是非常好,尤其是制造成本可能很 高。 Blade 3x3封装的当前后继者可以总共有四层并且具有大量的镀覆微过孔和通 孔。管芯可以位于封装的中心线上,并且管芯的两侧与外层之间的连接可以是通过镀覆微 过孔提供的,出于这一原因,管芯背侧可以不直接暴露至封装顶面。当前封装的限制可以是 不良热性能和非常高的成本。
技术实现要素:
提供了一种管芯封装。所述管芯封装可以包括:管芯,所述管芯具有位于所述管芯 的第一侧上的第一管芯接触部以及位于所述管芯的与所述管芯的第一侧相对的第二侧上 的第二管芯接触部;与所述管芯横向相邻的绝缘材料;基本上直接接触所述管芯的第二管 芯接触部的整个表面的金属结构,其中,所述金属结构由与所述第二管芯接触部相同的材 料制成;所述管芯的第一侧上的与所述第一管芯接触部电接触的第一接触焊盘;以及所述 管芯的第一侧上的经由所述金属结构与所述第二管芯接触部电接触的第二接触焊盘;其 中,所述绝缘材料使所述金属结构与所述第一管芯接触部电绝缘。 附图说明 在附图中,在不同图示中始终以大致类似的附图标记指代相同的部分。附图未必 是按比例绘制的,相反其重点在于大体上说明本发明的原理。在下文的描述当中,将参考下 面的附图描述本发明的各种实施例,其中: 图1示出了根据各种实施例的三管芯封装的示意性截面图; 图2示出了根据各种实施例的形成管芯封装的过程的可视化;并且 图3示出了形成管芯封装的方法的流程图。 具体执行方式 下文的详细描述参考了附图,附图以举例说明的方式示出了具体细节以及可以实 践本发明的实施例。 “示例性”一词在本文中被用于意指“用作示例、实例或者例示”。本文被描述为“示 例性”的任何实施例或设计未必要被理解为相比其他实施例或设计是优选的或者具有优 5 CN 111554648 A 说 明 书 2/11 页 势。 联系形成于侧或表面“之上”的沉积材料使用的词语“在……之上”在本文中可以 用于表示所沉积的材料可以直接形成于所暗示的侧或表面上,例如,与之直接接触。联系形 成于侧或表面“之上”的沉积材料使用的词语“在……之上”在本文中还可以用于表示所沉 积的材料可以间接形成于所暗示的侧或表面上,其中一个或多个额外的层布置在所暗示的 侧或表面与所沉积的材料之间。 在各种实施例中,提供了一种形成管芯封装的方法,该方法与现有方法相比具有 简化的并且成本很低的工艺流。所述方法允许通过使用(例如)等离子体蚀刻工艺和/或喷 水打磨(water blasting)工艺形成通往(半导体)管芯(又称为(半导体)芯片)的正面的一 个或多个大面积开口,而不用昂贵的激光钻孔工艺。管芯的与其正面相对的背面可以直接 向管芯封装的顶面敞开,从而确保相对于顶部的最佳可能(即,尽可能低的)热阻RTH。 在各种实施例中,提供了基于简单的非对称层压板的管芯封装。所述管芯封装可 以只包括一个路由层,并且管芯背面可以直接连接至封装顶面。 图1示出了根据各种实施例的三种管芯封装100(为了便于参照被区分为100a、 100b和100c)的示意性截面图。图2示出了根据各种实施例的形成管芯封装的过程200的可 视化。图3示出了根据各种实施例的形成管芯封装的方法的流程图300。 如图1所示,管芯封装100(100a、100b、100c)的每者可以包括管芯102,例如,半导 体管芯,例如,硅管芯。管芯102可以具有位于管芯102的第一侧S1上的第一管芯接触部 102C1以及位于管芯102的与管芯102的第一侧S1相对的第二侧S2上的第二管芯接触部 102C2。 管芯102可以(例如)形成二极管,例如,功率二极管。在这种情况下,第一管芯接触 部102C1可以是二极管的阳极,并且第二管芯接触部102C2可以是二极管的阴极,或反之亦 然。 在各种实施例中,例如,在管芯102形成晶体管(例如,功率晶体管)的情况下,管芯 102可以进一步包括位于管芯102的第一侧S1上的第三管芯接触部102C3。第三管芯接触部 102C3可以(例如)是晶体管的控制端子;并且第一管芯接触部102C1和第二管芯接触部 102C2可以是晶体管的受控端子。 第一管芯接触部102C1、第二管芯接触部102C2和(如果存在的话)第三管芯接触部 可以由相同材料制成。 在各种实施例中,管芯封装100可以是功率半导体器件。 管芯封装100可以进一步包括与管芯102横向相邻的绝缘材料110。绝缘材料110可 以被布置为与半导体管芯横向相邻,还与第一管芯接触部102C1、第二管芯接触部102C2和 (如果存在的话)第三管芯接触部102C3横向相邻。绝缘材料110可以(例如)包括有或没有 (例如,无机)填充颗粒或增强剂的环氧树脂或由其构成,或者可以包括其他适当绝缘材料 或由其构成。 绝缘材料110在各种实施例中可以被作为层压于管芯102之上和周围的箔布置在 管芯封装100中,例如,所述箔为树脂箔(例如,味之素增层膜(ABF)或类似树脂箔),例如,其 为PCB和衬底行业当中所使用的,例如,有或没有填充颗粒(例如,Hitachi等提供的)的箔。 在各种实施例中,可以对所述绝缘材料(例如,树脂)进行印刷、模制等。 6 CN 111554648 A 说 明 书 3/11 页 在存在第三管芯接触部102C3的情况下,另一绝缘材料114可以被布置到第一管芯 接触部102C1和第三管芯接触部102C3之间,从而使第一管芯接触部102C1和第三管芯接触 部102C3相互电绝缘。在各种实施例中,绝缘材料110和另一绝缘材料114的材料可以相同或 类似。在各种实施例中,绝缘材料110和另一绝缘材料114可以是在共同的过程中布置的,例 如,如下文所述。 管芯封装100可以进一步包括基本上直接接触管芯102的第二管芯接触部102C2的 整个表面(例如,面向背离管芯的半导体材料的方向的整个顶表面)的金属结构106。作为安 放金属结构106的替代方式,金属结构106可以基本上直接接触管芯102的第二管芯接触部 102C2的表面,并且第二管芯接触部102C2的该表面可以没有绝缘材料。 金属结构106可以由与第二管芯接触部102C2相同的材料制成。金属结构106和第 二管芯接触部102C2的材料可以(例如)包括铜、铝铜合金、镍铜合金或镀铜的铝,或者由其 构成。在示出了管芯封装100a的图1的截面示意图中,虚线指示第二管芯接触部102C2和金 属结构106之间的接触区。在管芯封装100b和100c中,未添加该线,但是接触区将处于类似 位置上。 在各种实施例中,可以形成同质合并结构,在该结构中,第二管芯接触部102C2和 金属结构106可以具有相同的热膨胀系数(CTE),使得第二管芯接触部102C2和金属结构106 之间的连接相对于温度变化(例如,热循环)具有高鲁棒性。此外,通过第二管芯接触部 102C2的整个表面与金属结构106的直接接触,第二管芯接触部102C2与空气(或者可以在金 属结构106的外表面(即,与管芯相对)处提供的(例如)冷却流体、冷却结构和/或冷却装 置,)之间可以具有低热阻RTH。下文将在图2的背景下进一步提供有关如何形成金属结构106 的细节。 在各种实施例中,管芯封装100可以包括用于从管芯封装102的外部接触管芯102 的接触焊盘108P。管芯封装100可以(例如)包括位于管芯的第一侧S1上的第一接触焊盘 108P1,其可以与第一管芯接触部102C1电接触。这意味着,第一接触焊盘108P1可以与第一 管芯接触部102C1位于管芯102的同一侧上。 管芯封装100可以进一步包括经由金属结构106与第二管芯接触部102C2电接触的 第二接触焊盘108P2。第二接触焊盘108P2也可以被布置在管芯102的第一侧S1上。 任选地,例如,在管芯封装100形成晶体管的情况下,管芯封装100可以进一步包括 与第三管芯接触部108C3电接触的第三接触焊盘108P3。第三接触焊盘108P3可以被布置在 管芯102的第一侧S1上。 这意味着所有的接触焊盘108P可以被布置在管芯102的同一(第一)侧上。接触焊 盘108(108P1、108P2、108P3)可以全都被布置在管芯封装100的同一主表面上,该主表面还 可以被称为管芯封装100的前表面。 在各种实施例中,第三管芯接触部102C3和第三接触焊盘108P3可以由与第二管芯 接触部102C2和金属结构106相同的材料构成。 在各种实施例中,绝缘材料110可以使金属结构106与第一管芯接触部102C1电绝 缘。如果存在第三管芯接触部102C3,那么绝缘材料110可以使第三管芯接触部102C3与金属 结构106电绝缘。 在各种实施例中,管芯封装100可以任选进一步包括横向围绕管芯102的载体104。 7 CN 111554648 A 说 明 书 4/11 页 尽管图1和图2仅示出了示意性截面图,但是应当理解,载体104可以从所有侧面围绕管芯 102。例如,载体104可以包括在其内布置管芯102的通孔222(参见图2)。绝缘材料110可以布 置在管芯102和载体110之间。在各种实施例中,绝缘材料110可以履行将管芯102固定至载 体104的额外功能。绝缘材料110可以(例如)是粘合剂,并且/或者可以被按照将管芯102固 定就位的方式成形。 载体104可以具有多个通孔222,使得多个管芯102可以被布置到通孔222内,即,每 个通孔222布置一个管芯102。这可以充当多个彼此相同或不同的管芯封装100的基础。换言 之,可以形成包括多个管芯封装100的多管芯封装(图2所示),可以在后续工艺中将所述多 个管芯封装100分离成多个单独的管芯封装100,将联系图2对此予以描述。 在各种实施例中,管芯封装100可以包括对金属结构106和第二接触焊盘108P2进 行电连接的金属连接结构112。换言之,金属连接结构112可以包括金属或由金属构成,并且 可以与金属结构106和第二接触焊盘108P2直接接触。在示出了管芯封装100a的图1的示意 性截面图中,两条虚线指示金属结构106和金属连接结构112之间的接触区。在管芯封装 100b和100c中,未添加任何对应线,但是接触区将位于类似位置上。 金属连接结构112在各种实施例中可以包括与金属结构106和/或第二管芯接触 102C2相同的材料,或者由与金属结构106和/或第二管芯接触102C2相同的材料构成。 金属连接结构112在各种实施例中可以是载体104的部分。 载体104可以(例如)包括电绝缘体块材料,并且金属连接结构112可以穿过和/或 沿电绝缘体块材料延伸。例如,所述绝缘体块材料可以包括印刷电路板(PCB)(例如,PCB层 压板)、阻燃剂(FR)材料(例如,FR4)、复合环氧树脂材料(CEM)(例如CEM1或CEM3)、双马来酰 亚胺-三嗪树脂(BT)材料、酰亚胺、聚酰亚胺、ABF,或者由其构成,或者可以由前述示例性材 料的组合构成。所述绝缘体块材料可以(例如)被形成为单体式结构或者被形成为多层结 构。 金属连接结构112可以(例如)是沿通孔222的(例如,所有)内侧壁布置的,并且可 以至少部分地延伸至载体104的主表面。在图1中的顶部示出了管芯封装100a的这种实施 例,其中,载体104、104a具有形成于通孔222的内侧壁上并且形成于载体104、104a的两个主 表面上(即,位于载体104、104a的第一侧S1上并且位于载体104、104a的第二侧S2上)且与形 成于通孔222的内侧壁上的部分连接的金属连接结构112。金属连接结构112可以(例如)被 形成为金属层。所述金属层的厚度可以处于大约5μm到大约30μm的范围内,例如,从大约10μ m到大约20μm,例如,15μm左右。所述金属层可以具有至少10μm的厚度,例如,处于10μm和100 μm之间。在该情况下,所述金属层可以能够传导大约20到30安培的电流。对于更大电流而 言,可以使用填充有金属的镀覆通孔(参见图1,中间)或者由金属或基本上由金属构成的载 体104、104b,例如,引线框架(参见图1,底部)。如果预见到只有较小的电流,那么可以使用 具有低于10μm的厚度的金属层和/或穿过载体104的镀覆过孔或微过孔(未示出)作为金属 连接结构112。 在各种实施例中,如图1中所示,对于示例性管芯封装104b而言,金属连接结构112 可以是金属块,例如,铜块,其从载体104的第一侧S1完全穿过绝缘体块材料延伸至载体104 的与载体104的第一侧S1相对的第二侧S2。例如,载体104、104a可以是或包括PCB。 在各种实施例中,载体104、104b可以包括金属体块材料,其中,所述金属体块材料 8 CN 111554648 A 说 明 书 5/11 页 可以形成提供第二管芯接触部102C2和金属结构106之间的电连接的金属连接结构112。所 述金属体块材料可以与金属结构106的材料相同,例如,铜、铝铜合金、镍铜合金或者镀铜的 铝。 金属结构106在各种实施例中可以横向延伸至载体104,以便接触金属连接结构 112。换言之,金属结构106可以与载体104重叠,其重叠的距离至少足够直接接触金属连接 结构112。 在图1所示的实施例中,金属结构106(沿横向)完全地在管芯102之上,在绝缘材料 110之上以及在大部分载体104之上延伸。具体而言,金属结构106在整个管芯背面金属化部 102C2之上延伸,金属化部102C2通常可以被结构化并且比管芯102的半导体(例如,硅)体块 材料小大约20到100μm(如果只对半导体材料划片那么用于将半导体晶圆划片成各个管芯 102的划片工艺将更容易,因而在划片区域内通常不形成或者去除金属结构)。 在管芯封装100a内,在金属连接结构112仅布置在载体104、104a的绝缘体块材料 的外侧上的情况下,金属结构106与金属连接结构112的部分直接接触,该部分布置在载体 104的主表面之一上并且具有与第二管芯接触部102C2的主表面处于同一平面内的表面。 在管芯封装100b中,在金属连接结构112穿过载体104、104a的绝缘体块材料延伸 并且布置在载体104、104a的绝缘体块材料的外侧上的情况下,金属结构106与金属连接结 构112的部分直接接触,该部分布置在载体104的主表面之一上并且具有与第二管芯接触部 102C2的主表面处于同一平面内的表面。 在管芯封装100c中,在载体104、104b的金属体块材料形成金属连接结构112的情 况下,金属结构106与载体104、104b直接接触。载体104、104b的外表面与第二管芯接触部 102C2的主表面处于同一平面内。 在图2中,示出了根据各种实施例的形成管芯封装100的过程200。考虑所使用的载 体104、104a,在图2中形成管芯封装100、100a。然而,所应用的过程对于管芯封装100a、100b 和100c而言相同或基本相同,对于不同的实施例而言只有载体104(以及相应的对载体104 的预处理,如果适用的话)可能存在差异。因此,在涉及(例如)图2的金属连接结构时,仅使 用附图标记112。但是应当理解,所描述的过程一般还适用于使用不同载体(例如,如图1所 示)的实施例,因而金属连接结构112还包括镀覆通孔116,或者由金属载体104b形成。 可以包含在管芯封装100、100b内的管芯102可以具有位于管芯102的第一侧S1上 的第一管芯接触部102C1以及位于管芯102的与管芯102的第一侧S1相对的第二侧S2上的第 二管芯接触部102C2。 所述过程流非常简单,其开始于制造将在其内嵌入管芯102的载体104(又称为芯 层)。在各种实施例中,所述方法可以包括提供具有至少一个通孔222(例如,多个通孔222) 的载体104。 图2的图块200a中所示的载体104、104a可以是绝缘载体104、104a,其具有布置在 其外侧上的形成金属连接结构112的金属层,如联系图1(顶部)所述。载体104可以(例如)是 简单的两面PCB板。作为载体104a的替代,可以使用具有从载体104a的一个主表面穿过载体 104a延伸到载体104a的相对主表面的金属连接结构112的绝缘载体104a,如上文联系图1 (中间)所述,或者可以使用由金属或者基本上由金属构成的载体104b,例如,由结构化Cu 片/箔构成的铜引线框架,因而此时整个载体104b形成了金属连接结构104b、112,如上文联 9 CN 111554648 A 说 明 书 6/11 页 系图1(底部)所述。在各种实施例中,可以使用上文描述的载体104的组合或变型。 不管载体104的类型如何,载体104都可以设有用于管芯102的开口或空腔222。由 于可能重要的是,所述开口要一直穿过载体104延伸,使得第一管芯接触部102C1在载体104 的第一侧S1上露出,并且第二管芯接触部102C2在载体104的第二侧S2上露出,因而开口/空 腔222可以被称为通孔222。 连接,即从载体104(例如,双面PCB板104a)的第一(在图2中为顶侧)侧S1到第二 (在图2中为底侧)侧S2的金属连接结构112可以(例如)被制造为(例如)镀覆通孔、镀覆通孔 (空腔)边缘、或者镀覆槽。 多个通孔22可以被作为通孔222的线性阵列或二维阵列(例如,按照类似于矩阵的 方式)布置到载体104当中。在图2的图块200a中示出了具有多个通孔222的载体104的截面 示意图。至少一个通孔222在载体104的水平平面内的形状可以是矩形(例如,方形)、椭圆形 (例如,圆形)或者任何其他适当形状。例如,可以针对要布置到通孔222内的管芯102对所述 至少一个通孔222的形状进行调整,例如,其方式是使得通孔222大于管芯102的水平二维尺 寸。例如,其方式是使得通孔222当中的载体104的侧壁与布置在通孔222当中的管芯102之 间的距离对于所有侧壁均保持恒定或基本恒定。通孔222的尺寸可以(例如)被配置为允许 每一管芯侧壁和其相对的通孔侧壁之间的距离处于(例如)大约5μm到大约500μm的范围内, 例如,从大约10μm到大约100μm。 在各种实施例中,如图块200b中所示,所述方法可以进一步包括将至少一个管芯 102布置到至少一个通孔222当中。换言之,至少一个管芯102可以被按照使载体104横向围 绕管芯102的方式布置到载体104的通孔222当中。 在各种实施例中,一个管芯102可以被布置到每一通孔222当中,即,一个通孔222 中一个管芯102,或者多个管芯102布置到多个通孔222当中,即每一通孔222一个管芯102。 在各种实施例中,每通孔222可以布置不止一个管芯102,例如,两个管芯102可以被布置到 单个通孔222中,并且这两个管芯102都具有朝向同一侧S2的第二管芯接触部102C2。 如图2的图块200b进一步所示,在将管芯102布置到通孔222中之前,载体104可以 被布置到临时载体220上。临时载体220可以(例如)包括支撑层220U和粘合剂层220A。载体 104可以被置于临时载体220上,从而接触粘合剂层220A(例如,胶带)。载体104可以被按照 某种方式置于临时载体220上,使得作为载体104的部分或者由载体104形成的金属连接结 构112的金属表面112S2与临时载体220直接接触。 所述至少一个管芯102可以被置于临时载体220上的通孔(例如,如上文所述的) 内。管芯102可以被置于临时载体220上,从而使第二管芯接触部102C2接触临时载体220(例 如,临时载体220的粘合剂层220A)。为了精确定位,可以使用临时载体220上的对准标记。 通过将载体104以其金属表面112S2置于临时载体220上并且将管芯102以其第二 管芯接触部102C2置于临时载体220上,可以确保在去除了临时载体220(如下文所述)之后, 金属表面112S2和第二管芯接触部102C2的金属表面处于同一高度上(即,形成公共平面), 并且被布置为与管芯102横向相邻,例如,处于管芯102和载体104之间的绝缘材料可以既不 延伸至金属结构112的金属表面112S2也不延伸至第二管芯接触部102C2的表面,这样做有 利于布置金属结构106。 所述方法可以进一步包括在放置管芯102之后将绝缘材料110布置为与管芯102横 10 CN 111554648 A 说 明 书 7/11 页 向相邻。图2的图块200c示出了其示例。绝缘材料110可以(例如)被布置为从所有侧面横向 围绕管芯102。绝缘材料110可以(例如)被布置到管芯102和载体104之间,例如,沿横向位于 管芯102的所有侧面上。 在图块200c所示的实施例中,绝缘材料110可以是通过将树脂箔(具有形成绝缘材 料110的树脂)连同Cu种子层222层压到管芯102和载体104的第一侧S1(顶侧)上来布置的。 树脂箔可以(例如)是ABF(或类似类型的箔,例如,来自Hitachi),或者其他有或没有填充颗 粒或增强剂的树脂箔,或者(例如)涂覆了树脂的铜(RCC)箔。在所述层压期间,可以围绕管 芯102挤压所述绝缘材料(例如,树脂),例如,挤压到管芯102和载体104之间的空间中。 如果不做层压,那么可以对绝缘材料110(例如,树脂)进行印刷、模制等,并且可以 (例如)溅射种子层222(例如,使用通常用于嵌入晶圆级球栅阵列(eWLB)的工艺)或者可以 通过化学镀覆工艺形成种子层222。种子层222又可以被称为另一金属层222。 在各种实施例中,例如,如图块200c中所示,绝缘材料110可以不仅被布置为与管 芯102横向相邻,还可以以如下方式被布置到管芯102的第一侧S1上以及载体104的第一侧 S1上:使得第一管芯接触部102C1与第三管芯接触部102C3电绝缘并且这两者均与金属连接 结构112电绝缘。 在各种实施例中,种子层222可以被结构化,由此形成结构化种子层222S。图2的图 块200c对此给出了图示。对于该示例而言,可以使用光刻和蚀刻从可以制造通往管芯102的 接触焊盘108P的区域224上去除用于种子层222的结构化(例如,铜)。其可以是位于第一管 芯接触部102C1之上的以及位于第三管芯接触部102C3(如果存在的话)之上的区域224,还 可以是位于载体104的金属连接结构112的金属表面112S1之上的可以通过其接触第二管芯 接触部102C2的区域224。 在第二侧S2上,可以去除临时载体220,例如,通过使临时载体220暴露至UV辐射之 下,和/或通过对临时载体220加热,或者通过其他适当手段。由此,可以露出第二管芯接触 部102C2和金属连接结构112的第二表面112S2,图2的图块200d也对此给出了图示。 在对种子层22结构化以形成结构化种子层222S之后,可以通过去除区域224之下 的区域226中的绝缘材料而完成对第一(和相应的第三)管芯接触102C1、102C3的开口,即, 使其露出。图2的图块200e对此给出了图示。对于这一过程而言,例如,可以通过使用结构化 种子层222S(例如,结构化铜种子层)作为掩模来采用喷水打磨或激光处理。在各种实施例 中,可以跳过对种子层222的结构化,并且可以(例如)直接对管芯接触部102C1、102C3激光 钻孔。在各种实施例中,可以跳过种子层222的形成(或者将其移到后面的阶段)。在该情况 下,可以将掩模(例如,金属掩模)与等离子体工艺结合使用,以去除绝缘材料110。之后可以 添加种子层222和/或化学镀覆层108P。在使用可光学限定的树脂系统(例如,Hitachi所推 出的)的情况下,作为替代可以使用光刻工艺和显影工艺。 在开口过程之后,可以分别在载体-管芯组合的两侧S1和S2上形成两个金属层 228S1、228S2(统称为金属层228;它们可以(例如)由铜(Cu)构成或者可以包括铜,或者更一 般地可以由与第二管芯接触部102S2中包含的相同的金属构成或者包含该金属,或者如果 为分层结构,那么可以由第二管芯接触部102S2的表面上露出的金属构成或者包含该金 属)。为此,可以使用溅射工艺或化学镀覆工艺和/或电化学工艺,例如,镀覆。典型地,可以 使用溅射和电化学工艺的结合或者化学镀覆工艺和电化学镀覆工艺的结合。图2的图块 11 CN 111554648 A 说 明 书 8/11 页 200f对此给出了图示。在使用电化学工艺的情况下,可以使用(例如,铜)种子层222作为第 一侧S1上的电化学镀覆工艺的种子层。 底部金属层228S2可以是金属结构106,其基本上直接接触管芯102的第二管芯接 触部102C2的整个表面。金属层228S2(因而金属结构106)可以横向延伸至载体104,以接触 金属连接结构112,由此在第二管芯接触部102C2和金属连接结构112之间形成导电连接,并 且因而连接至载体-管芯组合的第一(正)侧S1。 顶部金属层228S1可以形成管芯102的第一侧S1上的第一接触焊盘108P1,从而电 接触第一管芯接触部102C1。如果存在第三管芯接触部102C3,那么顶部金属层228S1还可以 形成管芯102的第一侧S1上的第三接触焊盘108P3,从而电接触第三管芯接触部102C3。此 外,顶部金属层228S1可以形成管芯102的第一侧S1上的第二接触焊盘108P2,其可以经由金 属结构106(并且经由金属连接结构112)电接触第二管芯接触部102C2。 在第一接触焊盘108P1和第二接触焊盘108P2被布置到同一侧S1上的情况下,可以 在共同的过程中形成第一接触焊盘108P1和第二接触焊盘108P2(以及第三接触焊盘108P3, 如果存在的话)。使用镀覆工艺(或者任何同时作用于顶侧和底侧的工艺),可以在共同的过 程中形成顶部金属层228S1和底部金属层228S2,前者形成了接触焊盘108P1、108P2、108P3, 后者形成了金属结构106。 在各种实施例中,如图2的图块200g所示,可以对金属层228S1、228S2结构化,从而 使金属层106与第一管芯接触部102C1电绝缘以及与第三管芯接触部102C3电绝缘,并且使 第一管芯接触部102C1与第三管芯接触部102C3绝缘,或者一般而言使管芯接触102C1和 102C2(以及102C3,如果存在的话)相互电绝缘。为此,可以使它们各自的接触焊盘108,即第 一接触焊盘108P1和第二接触焊盘108P2(以及第三接触焊盘108P3,如果存在的话)相互电 绝缘。可以通过在顶部金属层228S1当中形成一直向下延伸至绝缘材料110的开口232而实 现电绝缘。在水平平面当中,开口232可以形成闭合环(未必是圆的;它们可以具有任何闭合 于其自身的形状,比如闭环形状的矩形开口),或者可以连接金属层228S1的边缘上的两个 位置,或者可以具有任何其他允许使接触焊盘108P1、108P2、108P3相互电绝缘的形状。 此外,开口232可以被布置到顶(第一)侧S1上和底(第二)侧S2上的被预见为用于 将形成多封装的载体-管芯组合分割(例如,划片)成多个单独管芯封装100a的位置上。对于 所述结构化,可以使用常见工艺,比如光刻工艺和蚀刻工艺。例如,在将所述镀覆执行为图 案镀覆工艺(即,光掩模内电镀)的情况下,种子层222可以存在于划片区域(又称为划片路 径或截缝区)内和/或存在于可以通过蚀刻去除的接触焊盘之间。对于划片而言,可以使用 常见工艺,比如,锯切或激光处理。 在各种实施例中,提供了用以制造简化的、低成本、高性能的、基于层压板的功率 封装的制造工艺和结构。 图3示出了形成管芯封装的方法的流程图300。所述管芯封装可以包括管芯,所述 管芯具有位于该管芯的第一侧上的第一管芯接触部以及位于该管芯的与该管芯的第一侧 相对的第二侧上的第二管芯接触部。所述方法可以包括:布置与所述管芯横向相邻的绝缘 材料(在310中);使所述管芯的第二管芯接触部的整个表面与金属结构基本上直接接触,其 中,所述金属结构由与第二管芯接触部相同的材料制成(在320中);形成所述管芯的第一侧 上的与第一管芯接触部电接触的第一接触焊盘(在330中);以及形成所述管芯的第一侧上 12 CN 111554648 A 说 明 书 9/11 页 的经由所述金属结构与第二管芯接触部电接触的第二接触焊盘,其中,所述绝缘材料使所 述金属结构与第一管芯接触部电绝缘(在340中)。 在下文中将对各种示例进行举例说明: 示例1是一种管芯封装。所述管芯封装可以包括:管芯,该管芯具有位于该管芯的 第一侧上的第一管芯接触部以及位于该管芯的与该管芯的第一侧相对的第二侧上的第二 管芯接触部;与管芯横向相邻的绝缘材料;基本上直接接触管芯的第二管芯接触部的整个 表面的金属结构,其中,所述金属结构由与第二管芯接触部相同的材料制成;管芯的第一侧 上的与第一管芯接触部电接触的第一接触焊盘;以及管芯的第一侧上的经由所述金属结构 与第二管芯接触部电接触的第二接触焊盘;其中,所述绝缘材料使所述金属结构与第一管 芯接触部电绝缘。 示例2是一种管芯封装。所述管芯封装可以包括:管芯,该管芯具有位于该管芯的 第一侧上的第一管芯接触部以及位于该管芯的与该管芯的第一侧相对的第二侧上的第二 管芯接触部;与管芯横向相邻的绝缘材料;基本上直接接触管芯的第二管芯接触部的表面 的金属结构,其中,第二管芯接触部的所述表面没有绝缘材料,并且其中,所述金属结构由 与第一管芯接触部相同的材料制成;管芯的第一侧上的与第一管芯接触部电接触的第一接 触焊盘;以及管芯的第一侧上的经由所述金属结构与第二管芯接触部电接触的第二接触焊 盘;其中,所述绝缘材料使所述金属结构与第一管芯接触部电绝缘。 在示例3中,示例1或2的主题可以任选进一步包括横向围绕管芯的载体。 在示例4中,示例3的主题可以进一步包括:所述载体包括通孔,管芯被布置到所述 通孔中。 在示例5中,示例3或4的主题可以任选包括:所述金属结构横向延伸至所述载体。 在示例6中,示例3到5中的任何示例的主题可以任选包括:所述载体包括电绝缘体 块材料以及穿过和/或沿所述电绝缘体块材料延伸的金属连接结构,其中,所述金属连接结 构提供所述第二管芯接触部和所述金属结构之间的电连接。 在示例7中,示例6的主题可以任选包括:所述载体是印刷电路板。 在示例8中,示例4和示例6的主题可以任选包括:所述金属连接结构形成于所述通 孔的至少一个内侧壁上。 在示例9中,示例8的主题可以任选包括:所述金属连接结构形成于所述通孔的所 有内侧壁上。 在示例10中,示例8或9的主题可以任选包括:所述金属连接结构具有至少10μm,任 选处于10μm和100μm之间的厚度。 在示例11中,示例6或7的主题可以任选包括:所述金属连接结构是过孔,任选为微 过孔。 在示例12中,示例6或7的主题可以任选包括:所述金属连接结构是从所述载体的 第一侧到所述载体的与其第一侧相对的第二侧完全穿过所述绝缘体块材料延伸的金属块。 在示例13中,示例6到12中的任何示例的主题可以任选包括:所述金属连接结构由 与所述金属结构相同的材料制成。 在示例14中,示例3到5中的任何示例的主题可以任选包括:所述载体包括金属体 块材料,其中,所述金属体块材料形成提供第二管芯接触部和所述金属结构之间的电连接 13 CN 111554648 A 说 明 书 10/11 页 的金属连接结构。 在示例15中,示例13的主题可以任选包括:所述载体是引线框架。 在示例16中,示例14或15的主题可以任选包括:所述金属体块材料与所述金属结 构的材料相同。 在示例17中,前述示例中的任何示例的主题可以任选包括:所述管芯形成二极管, 其中,所述第一管芯接触部是二极管的阳极,并且所述第二管芯接触部是二极管的阴极,或 反之亦然。 在示例18中,前述示例中的任何示例的主题可以任选包括所述管芯的第一侧上的 第三管芯接触部以及所述管芯的第一侧上的与第三管芯接触部电接触的第三接触焊盘,其 中,所述绝缘材料使所述金属结构与所述第三管芯接触部电绝缘。 在示例19中,示例18的主题可以任选进一步包括使第一接触焊盘与第三接触焊盘 电绝缘的另一绝缘材料。 在示例20中,示例18或19的主题可以任选包括:所述管芯形成晶体管,其中,第三 管芯接触部是晶体管的控制端子,并且其中第一管芯接触部和第二管芯接触部是晶体管的 受控端子。 在示例21中,前述示例中的任何示例的主题可以任选包括:所述金属结构的材料 和所述第二管芯接触部的材料是一组材料中的至少一种,该组材料由铜、铝铜合金、镍铜合 金和镀铜的铝构成。 在示例22中,示例18到21中的任何示例的主题可以任选包括:第三管芯接触部和 第三接触焊盘由与第二管芯接触部及所述金属结构相同的材料制成。 在示例23中,前述示例中的任何示例的主题可以任选包括:所述管芯封装是功率 半导体器件。 示例24是一种形成管芯封装的方法。所述管芯封装可以包括管芯,该管芯具有位 于该管芯的第一侧上的第一管芯接触部以及位于该管芯的与该管芯的第一侧相对的第二 侧上的第二管芯接触部,并且所述方法可以包括:布置与所述管芯横向相邻的绝缘材料;使 所述管芯的第二管芯接触部的整个表面与金属结构基本上直接接触,其中,所述金属结构 由与第二管芯接触部相同的材料制成;在所述管芯的第一侧上形成与第一管芯接触部电接 触的第一接触焊盘;以及在所述管芯的第一侧上形成经由所述金属结构与第二管芯接触部 电接触的第二接触焊盘;其中,所述绝缘材料使所述金属结构与第一管芯接触部电绝缘。 在示例25中,示例24的主题可以任选进一步包括:在布置所述绝缘材料之前,布置 载体,所述载体具有通孔,使得所述载体横向围绕所述管芯。 在示例26中,示例25的主题可以任选进一步包括:将所述管芯布置在临时载体上, 其中,所述管芯被按照使所述第二管芯接触部接触所述临时载体的方式置于所述临时载体 上;其中,布置所述载体包括将所述载体布置在临时载体上,其中,所述载体被按照使所述 载体的金属表面接触所述临时载体的方式置于所述临时载体上。 在示例27中,示例26的主题可以任选进一步包括:在使所述管芯的第二管芯接触 部的整个表面与金属结构基本上直接接触之前,去除临时载体;其中,使所述管芯的第二管 芯接触部的整个表面与金属结构基本上直接接触包括在第二管芯接触部上形成金属层,其 中,所述金属层横向延伸至所述载体。 14 CN 111554648 A 说 明 书 11/11 页 在示例28中,根据示例27的主题可以任选包括:形成所述金属层包括化学镀覆或 电化学镀覆。 在示例29中,示例27或28的主题可以任选包括:第一接触焊盘和第二接触焊盘包 括金属,并且在共同的过程中执行所述金属层的形成以及用于第一接触焊盘的形成和第二 接触焊盘的形成的金属的布置。 在示例30中,示例24到29中的任何示例的主题可以任选包括:布置与管芯横向相 邻的绝缘材料包括对绝缘材料进行层压、印刷或模制。 在示例31中,示例24到30中的任何示例的主题可以任选进一步包括将另一金属层 布置在所述绝缘材料之上。 在示例32中,示例31的主题可以任选包括:将另一金属层布置在所述绝缘材料之 上包括溅射。 在示例33中,示例30和30的主题可以任选包括:在将包括所述绝缘材料和所述另 一金属层的箔层压到所述管芯上的共同过程中布置所述绝缘材料和所述另一金属层,使得 所述绝缘材料被布置为与所述管芯横向相邻。 在示例34中,示例30到33中的任何示例的主题可以任选包括:所述金属箔的金属 形成镀覆工艺的种子层,所述镀覆工艺用于形成所述第一接触焊盘以及用于形成所述第二 接触焊盘。 在示例35中,示例26结合示例31到34中的任何示例的主题可以任选包括:至少部 分地去除第一管芯接触部之上以及载体的金属表面之上的所述另一金属层和所述绝缘材 料,使得第一管芯接触部和载体的金属表面分别至少部分地露出。 在示例36中,示例35的主题可以任选包括:所述至少部分地去除所述另一金属层 包括光刻结构化。 在示例37中,示例35或36的主题可以任选包括:至少部分地去除所述绝缘材料包 括使用所述另一金属层作为掩模进行激光或等离子体结构化和/或喷水打磨。 在示例38中,示例24到37中的任何示例的主题可以任选包括:形成第一接触焊盘 和形成第二接触焊盘包括光刻结构化。 在示例38中,示例24到37中的任何示例的主题可以任选包括:所述载体和管芯是 多封装的部分,所述多封装包括多个整体形成的管芯封装,所述方法进一步包括将所述多 个整体形成的管芯封装分离成多个单独的管芯封装。 在示例39中,示例38的主题可以任选包括:所述分离包括划片。 尽管已经参考特定实施例具体示出并描述了本发明,但是本领域技术人员应当理 解,可以做出形式和细节方面的各种变化,而不脱离所附权利要求定义的本发明的实质和 范围。因而,本发明的范围由所附的权利要来指示,并因此意在涵盖属于权利要求的等价方 案的含义和范围内的所有变化。 15 CN 111554648 A 说 明 书 附 图 1/4 页 图1 16 CN 111554648 A 说 明 书 附 图 2/4 页 图2 17 CN 111554648 A 说 明 书 附 图 3/4 页 图2(续) 18 CN 111554648 A 说 明 书 附 图 4/4 页 图3 19












