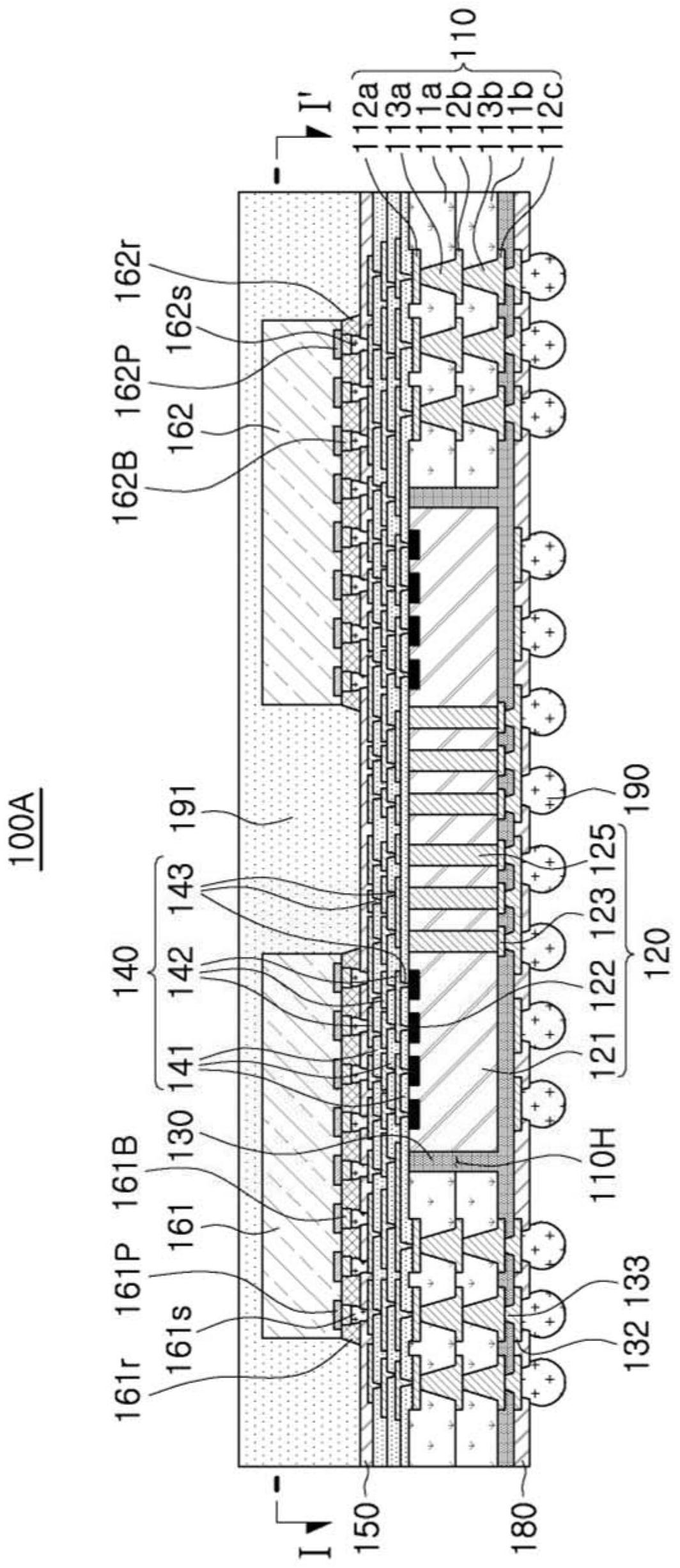
技术摘要:
本公开涉及一种半导体封装件,所述半导体封装件包括:第一半导体芯片,具有设置有第一连接焊盘的第一表面和设置有第二连接焊盘的第二表面,并且包括连接到所述第二连接焊盘的导通孔;连接结构,设置在所述第一表面上,并且包括第一重新分布层;第二重新分布层,设置在 全部
背景技术:
随着智能电子装置的近期发展,对于在这样的智能电子装置中使用的组件的需求 不断增长,以满足更先进的性能需求。例如,近年来,作为智能电子装置的核心组件之一的 应用处理器(AP)的性能规范已经大大提高。用于改善AP的性能的许多方法之一涉及按功能 将AP分区。例如,可通过按功能将裸片分区并通过适用于裸片的特性的优化工艺构造分区 的裸片并将其封装到半导体芯片中来制造AP,由此制造的AP与传统的单个AP相比可实现优 越的性能。然而,这样的AP的实现需要更先进的半导体封装技术。在这种情况下,有必要开 发一种能够封装多个分区的半导体芯片以具有最佳的信号特性和电力特性的封装结构。
技术实现要素:
本公开的一方面在于提供一种能够封装多个半导体芯片以具有最佳的信号特性 和电力特性的封装结构。 根据本公开的一方面,一种半导体封装件包括贯穿半导体芯片的导通孔,并且半 导体芯片的连接焊盘被构造为在彼此不同的方向上传输不同的信号。 本公开的一方面在于提供一种半导体封装件,所述半导体封装件包括:第一半导 体芯片,具有第一表面和与所述第一表面背对的第二表面,并且包括分别设置在所述第一 表面和所述第二表面上的第一连接焊盘和第二连接焊盘以及连接到所述第二连接焊盘的 导通孔;连接结构,设置在所述第一半导体芯片的所述第一表面上,并且包括电连接到所述 第一半导体芯片的所述第一连接焊盘的第一重新分布层;第二重新分布层,设置在所述第 一半导体芯片的所述第二表面上,并且电连接到所述第一半导体芯片的所述第二连接焊 盘;以及第二半导体芯片,设置在所述连接结构的与所述连接结构的其上设置有所述第一 半导体芯片的第四表面背对的第三表面上。所述第二半导体芯片的其上设置有所述第二半 导体芯片的第三连接焊盘的表面面对所述连接结构的所述第三表面。所述第一半导体芯片 的所述第一连接焊盘连接到所述第一重新分布层的信号图案,并且所述第一半导体芯片的 所述第二连接焊盘连接到所述第二重新分布层的电力图案和接地图案中的至少一者。 本公开的另一方面在于提供一种半导体封装件,所述一种半导体封装件包括:第 一半导体芯片,具有第一表面和与所述第一表面背对的第二表面,并且包括设置在所述第 一表面上用于发送并接收信号的第一连接焊盘、设置在所述第二表面上用于接收电力的第 二连接焊盘和连接到所述第二连接焊盘的导通孔;连接结构,设置在所述第一半导体芯片 的所述第一表面上,并且包括电连接到所述第一半导体芯片的所述第一连接焊盘的第一重 5 CN 111584476 A 说 明 书 2/16 页 新分布层;以及至少一个第二半导体芯片,设置在所述连接结构的与所述连接结构的设置 有所述第一半导体芯片的第四表面背对的第三表面上,并且所述第二半导体芯片的设置有 所述第二半导体芯片的第三连接焊盘的表面面对所述连接结构的所述第三表面。 附图说明 通过以下结合附图进行的详细描述,本公开的以上和其他方面、特征和优点将被 更清楚地理解,在附图中: 图1是示意性地示出电子装置系统的示例的框图; 图2是示意性地示出电子装置的示例的透视图; 图3A和图3B是示意性地示出扇入型半导体封装件在被封装之前和封装之后的截 面图; 图4是示意性地示出扇入型半导体封装件的封装工艺的截面图; 图5是示意性地示出扇入型半导体封装件安装在中介基板上并最终安装在电子装 置的主板上的情况的截面图; 图6是示意性地示出扇入型半导体封装件嵌在中介基板中并最终安装在电子装置 的主板上的情况的截面图; 图7是扇出型半导体封装件的示意性截面图; 图8是示意性地示出安装在电子装置的主板上的扇出型半导体封装件的截面图; 图9是示意性地示出半导体封装件的示例的截面图; 图10是沿着图9的线I-I′截取的图9的半导体封装件的平面图; 图11是示意性地示出半导体封装件的另一示例的截面图; 图12是示意性地示出半导体封装件的另一示例的截面图; 图13是示意性地示出半导体封装件的另一示例的截面图; 图14是示意性地示出半导体封装件的另一示例的截面图;以及 图15是示意性地示出半导体封装件的另一示例的截面图。












