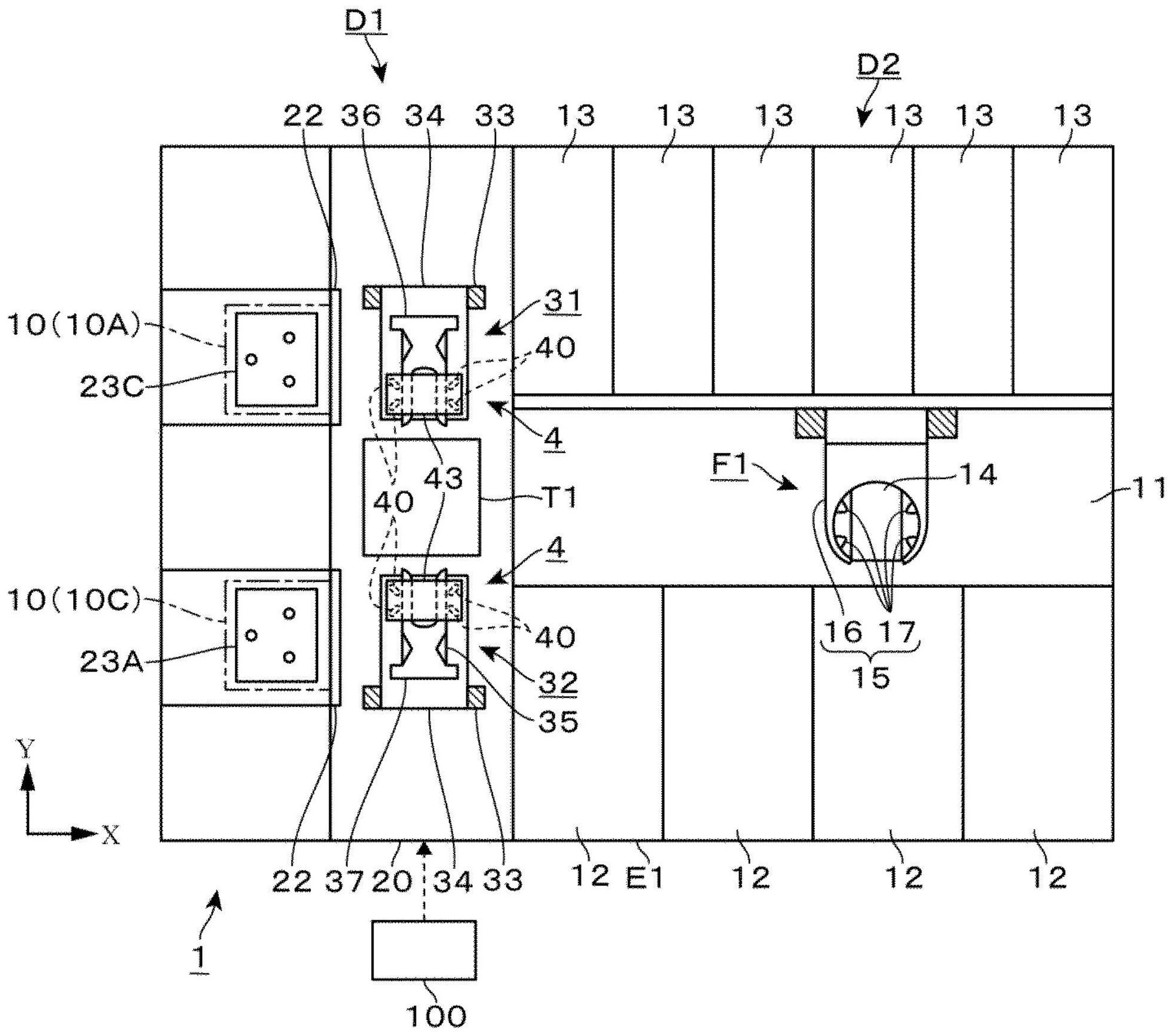
技术摘要:
本发明涉及基板处理装置和基板处理方法。提供能得到较高生产率且使基板的输送路径的设定自由度较高的技术。其包括:容器载置部,其载置收容多张基板的收容容器;多个基板处理部,其分别处理基板;第1基板输送机构,其具有移动自如的基台以及第1基板保持部和第2基板保持 全部
背景技术:
在半导体晶圆的制造工序中,对作为基板的半导体晶圆(以下记载为晶圆)进行液 体处理、加热处理等各种处理。作为对晶圆进行这样的各种处理的基板处理装置,具有设为 如下结构的情况:包括:处理模块,其设有对基板进行处理的各种处理组件;以及输送机构, 其在该处理模块与收纳多张晶圆的载体之间输送晶圆。 在专利文献1、2中,示出了这样的基板处理装置。该专利文献1的基板处理装置包 括:多个单位模块,其具有各个处理组件并且构成上述的处理模块;以及多个送入送出用的 组件,其用于相对于各单位模块分别进行晶圆的送入送出。而且,该基板处理装置的输送机 构具备形状互不相同的两个基板保持部,使用一个基板保持部在载体与送入送出用的组件 之间输送晶圆,使用另一基板保持部在送入送出用的组件之间输送晶圆。 专利文献1:日本特开2013-69916号公报 专利文献2:日本特开2013-69917号公报
技术实现要素:
发明要解决的问题 本公开关于基板处理装置,提供一种能够得到较高的生产率并且使基板的输送路 径的设定的自由度较高的技术。 用于解决问题的方案 本公开的基板处理装置包括: 容器载置部,其载置收容多张基板的收容容器; 多个基板处理部,其分别对所述基板进行处理; 第1基板输送机构,其具有移动自如的基台以及第1基板保持部和第2基板保持部, 该第1基板保持部和第2基板保持部设为在该基台上独立地前后移动自如,并且,以使所述 基板的左右方向上的缘部开放的方式自下方分别支承该基板的左右方向上的靠中央部的 位置,该第1基板保持部和第2基板保持部一起前进从而一齐相对于所述收容容器交接所述 基板;以及 互相层叠的多个第1基板载置部,其分别载置所述基板从而相对于各所述基板处 理部交接所述基板,所述第1基板保持部和第2基板保持部单独地在所述基台上前进来交接 所述基板。 对于上述基板处理装置,也可以是,该基板处理装置将多个单位模块互相层叠来 设置,该多个单位模块均具备所述基板处理部以及在该基板处理部与所述第1基板载置部 之间输送所述基板的第2基板输送机构, 所述第1基板载置部设于每个所述单位模块。 4 CN 111584392 A 说 明 书 2/14 页 对于上述基板处理装置,也可以是,所述第2基板输送机构包括第3基板保持部,该 第3基板保持部包括自侧方包围所述基板的包围部和设于该包围部的内周缘并支承所述基 板的下表面的爪部。 对于上述基板处理装置,也可以是,该基板处理装置包括第2基板载置部,该第2基 板载置部相对于所述第1基板载置部在纵向上排列设置,仅利用所述第1基板输送机构和所 述第2基板输送机构中的第2基板输送机构交接所述基板。 对于上述基板处理装置,也可以是,所述第2基板载置部为调整所述基板的温度的 温度调整部。 对于上述基板处理装置,也可以是,所述第1基板输送机构包括检测部,该检测部 用于检测保持于所述第1基板保持部和/或所述第2基板保持部的所述基板的位置。 对于上述基板处理装置,也可以是,所述检测部包括向所述基板的周缘部投射光 的光投射部和接收被所述光投射部投射而穿过该基板的侧方的光的光接收部, 所述基板处理装置设有检测机构,该检测机构基于由所述光接收部输出的检测信 号检测所述基板的周端的位置。 对于上述基板处理装置,也可以是,该基板处理装置设有位置调整部,该位置调整 部根据由所述检测部在所述第1基板保持部和所述第2基板保持部保持着所述基板时得到 的检测结果,为了利用该第1基板保持部和所述第2基板保持部重新保持各所述基板而临时 放置所述基板,并且调整临时放置的该基板的位置。 对于上述基板处理装置,也可以是,所述位置调整部相对于所述第1基板载置部在 纵向上排列设置。 对于上述基板处理装置,也可以是,该基板处理装置设有输出控制信号的控制部, 该控制部根据由所述检测部在所述第1基板保持部或所述第2基板保持部保持着 所述基板时得到的检测结果,输出所述控制信号,以调整相对于所述第1基板载置部交接所 述基板的位置。 对于上述基板处理装置,也可以是,所述控制部输出控制信号,以将所述第1基板 输送机构自所述收容容器收取的所述多张基板向多个所述第1基板载置部连续输送。 对于上述基板处理装置,也可以是,所述控制部输出控制信号,以使所述第1基板 输送机构自多个所述第1基板载置部连续收取所述基板并将收取的各基板向所述收容容器 输送。 对于上述基板处理装置,也可以是,该基板处理装置互相层叠多个单位模块来设 置,该多个单位模块具备所述基板处理部和输送所述基板的输送路径, 所述第1基板载置部设于每个所述单位模块, 所述控制部输出控制信号,以使所述第1基板输送机构自与一单位模块对应的多 个所述第1基板载置部连续收取所述基板,向与另一单位模块对应的多个所述第1基板载置 部连续输送该基板。 本公开的基板处理方法包括以下工序: 将收容多张基板的收容容器载置于容器载置部; 利用多个基板处理部分别对所述基板进行处理; 使构成第1基板输送机构的基台移动; 5 CN 111584392 A 说 明 书 3/14 页 使构成所述第1基板输送机构且设为在所述基台上独立地前后移动自如的第1基 板保持部和第2基板保持部自下方分别支承该基板的左右方向上的靠中央部的位置,从而 使所述基板的左右方向上的缘部开放; 使所述第1基板保持部和第2基板保持部一起前进,从而一齐相对于所述收容容器 交接所述基板; 在互相层叠起来的多个第1基板载置部分别载置基板; 将载置于所述多个第1基板载置部的基板分别相对于所述多个基板处理部交接; 以及 使所述第1基板保持部和第2基板保持部单独在所述基台上前进,相对于所述多个 第1基板载置部交接所述基板。 发明的效果 根据本公开,关于基板处理装置,能够得到较高的生产率并且使基板的输送路径 的设定的自由度较高。 附图说明 图1是本公开的第1实施方式的涂布装置的横剖俯视图。 图2是所述涂布装置的纵剖侧视图。 图3是构成所述涂布装置的载体模块的主视图。 图4是设于所述载体模块的输送机构的侧视图。 图5是所述输送机构的立体图。 图6是设于所述输送机构和涂布装置的交接组件的俯视图。 图7是向所述载体模块输送的输送容器的纵剖主视图。 图8是所述交接组件的立体图。 图9是设于所述涂布装置的温度调整组件的立体图。 图10是设于所述涂布装置的位置调整组件的立体图。 图11是用于说明所述晶圆的中心位置的检测方法的说明图。 图12是表示涂布装置处的晶圆的输送路径的说明图。 图13是表示所述载体模块处的晶圆的输送路径的说明图。 图14是表示所述载体模块处的晶圆的输送工序的工序图。 图15是表示所述载体模块处的晶圆的输送工序的工序图。 图16是表示所述载体模块处的晶圆的输送工序的工序图。 图17是表示所述载体模块处的晶圆的输送工序的工序图。 图18是表示所述载体模块处的晶圆的输送工序的工序图。 图19是表示所述载体模块处的晶圆的输送工序的工序图。 图20是表示所述载体模块处的晶圆的输送工序的工序图。 图21是表示所述载体模块处的晶圆的输送工序的工序图。 图22是表示所述载体模块处的晶圆的输送工序的工序图。 图23是表示所述载体模块处的晶圆的输送工序的工序图。 图24是表示所述载体模块处的晶圆的输送工序的工序图。 6 CN 111584392 A 说 明 书 4/14 页 图25是表示所述载体模块处的晶圆的输送工序的工序图。 图26是所述第3实施方式所涉及的涂布装置的概略图。 图27是表示所述第3涂布装置的输送路径的说明图。 图28是所述第5实施方式所涉及的涂布显影装置的横剖俯视图。 图29是所述涂布显影装置的纵剖侧视图。 图30是表示所述交接组件的另一结构例的立体图。 图31是输送机构的另一结构例的立体图。












