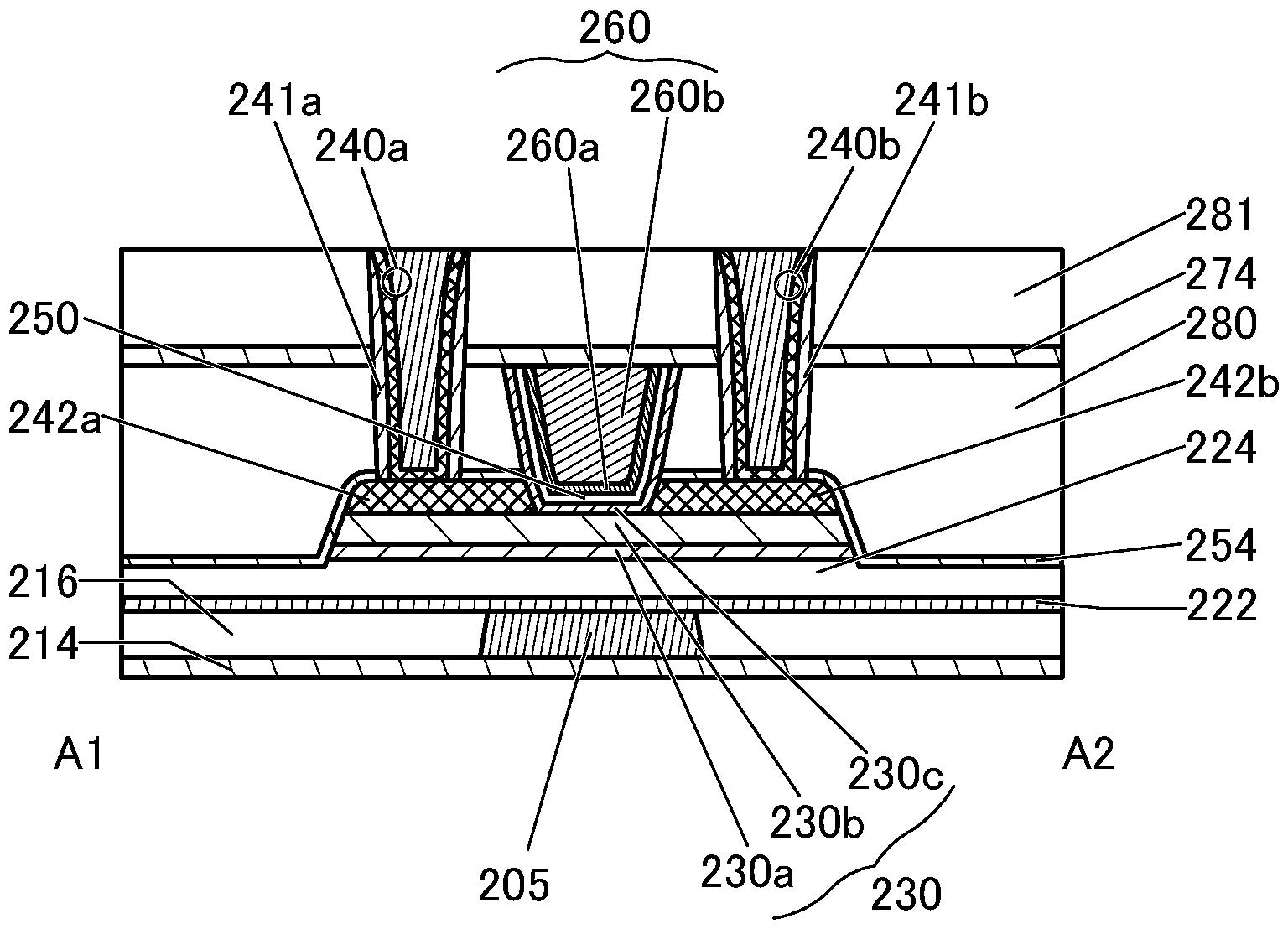
技术摘要:
提供一种通态电流大的半导体装置。一种半导体装置,包括:第一绝缘体;第一绝缘体上的第一氧化物;第一氧化物上的第二氧化物;第二氧化物上的第一导电体及第二导电体;第二氧化物上的第三氧化物;第三氧化物上的第二绝缘体;位于第二绝缘体上并与第三氧化物重叠的第三 全部
背景技术:
作为可以应用于晶体管的半导体薄膜,硅类半导体材料被广泛地周知。另外,作为 其他材料,氧化物半导体受到关注。作为氧化物半导体,例如,已知除了如氧化铟、氧化锌等 单元金属氧化物之外还有多元金属氧化物。在多元金属氧化物中,有关In-Ga-Zn氧化物(以 下也称为IGZO)的研究尤为火热。 通过对IGZO的研究,在氧化物半导体中,发现了既不是单晶也不是非晶的CAAC(c- axis aligned crystalline)结构及nc(nanocrystalline)结构(参照非专利文献1至非专 利文献3)。非专利文献1及非专利文献2中公开了一种使用具有CAAC结构的氧化物半导体制 造晶体管的技术。再者,非专利文献4及非专利文献5中公开了一种比CAAC结构及nc结构的 结晶性更低的氧化物半导体中也具有微小的结晶。 将IGZO用于活性层的晶体管具有极低的关态电流(参照非专利文献6),已知有利 用了该特性的LSI及显示器(参照非专利文献7及非专利文献8)。 [先行技术文献] [非专利文献] [非专利文献1]S.Yamazaki et al .“, SID Symposium Digest of Technical Papers”,2012,volume 43,issue 1,p.183-186 [非专利文献2]S.Yamazaki et al .“, Japanese Journal of Applied Physics”, 2014,volume 53,Number 4S,p.04ED18-1-04ED18-10 [非专利文献3]S .Ito et al .,“The Proceedings of AM-FPD’13Digest of Technical Papers”,2013,p.151-154 [非专利文献4]S.Yamazaki et al.“, ECS Journal of Solid State Science and Technology”,2014,volume 3,issue 9,p.Q3012-Q3022 [非专利文献5]S.Yamazaki“, ECS Transactions”,2014,volume 64,issue 10,p.155- 164 [非专利文献6]K.Kato et al.“, Japanese Journal of Applied Physics”,2012, 4 CN 111587491 A 说 明 书 2/40 页 volume 51,p.021201-1-021201-7 [非专利文献7]S.Matsuda et al.“, 2015Symposium on VLSI Technology Digest of Technical Papers”,2015,p.T216-T217 [非专利文献8]S.Amano et al.“, SID Symposium Digest of Technical Papers”, 2010,volume 41,issue 1,p.626-629
技术实现要素:
发明所要解决的技术问题 本发明的一个方式的目的之一是提供一种通态电流大的半导体装置。另外,本发 明的一个方式的目的之一是提供一种具有高频率特性的半导体装置。另外,本发明的一个 方式的目的之一是提供一种可靠性良好的半导体装置。另外,本发明的一个方式的目的之 一是提供一种能够进行微型化或高集成化的半导体装置。另外,本发明的一个方式的目的 之一是提供一种具有良好的电特性的半导体装置。另外,本发明的一个方式的目的之一是 提供一种生産率高的半导体装置。 本发明的一个方式的目的之一是提供一种能够长期间保持数据的半导体装置。本 发明的一个方式的目的之一是提供一种数据的写入速度快的半导体装置。本发明的一个方 式的目的之一是提供一种设计自由度高的半导体装置。本发明的一个方式的目的之一是提 供一种能够抑制功耗的半导体装置。本发明的一个方式的目的之一是提供一种新颖的半导 体装置。 注意,上述目的的记载不妨碍其他目的的存在。此外,本发明的一个方式并不需要 实现所有上述目的。另外,这些目的之外的目的根据说明书、附图、权利要求书等的记载来 看是自然明了的,可以从说明书、附图、权利要求书等的记载得出上述以外的目的。 解决技术问题的手段 本发明的一个方式是一种半导体装置,包括:第一绝缘体;第一绝缘体上的第一氧 化物;第一氧化物上的第二氧化物;第二氧化物上的第一导电体及第二导电体;第二氧化物 上的第三氧化物;第三氧化物上的第二绝缘体;位于第二绝缘体上并与第三氧化物重叠的 第三导电体;与第一绝缘体上、第一氧化物的侧面、第二氧化物的侧面、第一导电体的侧面、 第一导电体的顶面、第二导电体的侧面、第二导电体的顶面接触的第三绝缘体;以及第三导 电体、第二绝缘体、第三氧化物及第三绝缘体上的第四绝缘体,其中,第四绝缘体与第三导 电体、第二绝缘体及第三氧化物的每一个的顶面接触。 此外,第三绝缘体和第四绝缘体优选都比第一绝缘体难以使氧及氢中的一方或双 方透过。 此外,第三绝缘体和第四绝缘体优选都比第二绝缘体难以使氧及氢中的一方或双 方透过。 此外,第三绝缘体和第四绝缘体优选都是包含铝及铪中的一方或双方的氧化物。 此外,第三绝缘体和第四绝缘体优选都是氧化铝。 此外,第一至第三氧化物优选具有In、元素M(M是Al、Ga、Y或Sn)及Zn。 此外,本发明的一个方式是一种包括晶体管的半导体装置,其中,晶体管包括:第 一绝缘体;第一绝缘体上的第一氧化物;第一氧化物上的第二氧化物;第二氧化物上的第一 5 CN 111587491 A 说 明 书 3/40 页 导电体及第二导电体;第二氧化物上的第三氧化物;第三氧化物上的第二绝缘体;以及位于 第二绝缘体上并与第三氧化物重叠的第三导电体,在晶体管的沟道长度方向上的截面中, 以第一绝缘体的底面的高度为标准,与第二氧化物重叠的区域中的第三导电体的底面的高 度比第二导电体的顶面的高度低,并且,在晶体管的沟道宽度方向上的截面中,以第一绝缘 体的底面的高度为标准,不与第二氧化物重叠的区域中的第三导电体的底面的高度比第二 氧化物的底面的高度低。 此外,本发明的一个方式是一种半导体装置的制造方法,包括如下步骤:在衬底上 形成第一绝缘体;在第一绝缘体上依次形成第一氧化膜及第一导电膜;对第一氧化膜及第 一导电膜进行加工来形成第一氧化物及导电体层;以覆盖第一氧化物及导电体层的方式依 次形成第一绝缘膜及第二绝缘膜;通过在导电体层、第一绝缘膜及第二绝缘膜中形成使第 一氧化物露出的开口,形成第一导电体、第二导电体及第二绝缘体;进行第一加热处理形成 第二氧化膜;进行第二加热处理形成第三绝缘膜;形成第二导电膜;通过进行平坦化处理, 直到第二绝缘膜的一部分露出为止去除第二氧化膜、第三绝缘膜及第二导电膜,来形成第 二氧化物、第三绝缘体及第三导电体;以覆盖第二绝缘膜、第二氧化物、第三绝缘体及第三 导电体的方式形成第四绝缘膜;以及进行第三加热处理。 此外,优选在减压下依次进行第一加热处理及第二氧化膜的成膜。 此外,优选在减压下依次进行第二加热处理及第三绝缘膜的成膜。 此外,优选在含氮的气氛下进行第三加热处理。 此外,优选作为第四绝缘膜,通过采用溅射法形成包含铝的金属氧化物。 发明效果 通过本发明的一个方式,可以提供一种通态电流大的半导体装置。另外,通过本发 明的一个方式,可以提供一种具有高频率特性的半导体装置。另外,通过本发明的一个方 式,可以提供一种可靠性良好的半导体装置。另外,通过本发明的一个方式,可以提供一种 能够实现微型化或高集成化的半导体装置。另外,通过本发明的一个方式,可以提供一种具 有良好的电特性的半导体装置。另外,通过本发明的一个方式,可以提供一种生产率高的半 导体装置。 另外,可以提供一种能够长期间保持数据的半导体装置。另外,可以提供一种数据 的写入速度快的半导体装置。另外,可以提供一种设计自由度高的半导体装置。另外,可以 提供一种能够抑制功耗的半导体装置。另外,可以提供一种新颖的半导体装置。 注意,这些效果的记载不妨碍其他效果的存在。此外,本发明的一个方式并不需要 具有所有上述效果。另外,这些效果之外的效果根据说明书、附图、权利要求书等的记载来 看是自然明了的,可以从说明书、附图、权利要求书等的记载得出上述以外的效果。 附图简要说明 [图1]根据本发明的一个方式的半导体装置的俯视图及截面图。 [图2]根据本发明的一个方式的半导体装置的截面图。 [图3]根据本发明的一个方式的半导体装置的截面图。 [图4]示出根据本发明的一个方式的半导体装置的制造方法的俯视图及截面图。 [图5]示出根据本发明的一个方式的半导体装置的制造方法的俯视图及截面图。 [图6]示出根据本发明的一个方式的半导体装置的制造方法的俯视图及截面图。 6 CN 111587491 A 说 明 书 4/40 页 [图7]示出根据本发明的一个方式的半导体装置的制造方法的俯视图及截面图。 [图8]示出根据本发明的一个方式的半导体装置的制造方法的俯视图及截面图。 [图9]示出根据本发明的一个方式的半导体装置的制造方法的俯视图及截面图。 [图10]示出根据本发明的一个方式的半导体装置的制造方法的俯视图及截面图。 [图11]示出根据本发明的一个方式的半导体装置的制造方法的俯视图及截面图。 [图12]示出根据本发明的一个方式的存储装置的结构的截面图。 [图13]示出根据本发明的一个方式的存储装置的结构的截面图。 [图14]示出根据本发明的一个方式的存储装置的结构例子的框图。 [图15]示出根据本发明的一个方式的存储装置的结构例子的电路图。 [图16]根据本发明的一个方式的半导体装置的示意图。 [图17]根据本发明的一个方式的存储装置的示意图。 [图18]示出根据本发明的一个方式的电子设备的图。 [图19]示出实施例的晶体管的电特性的加热处理时间依赖性的图。 [图20]示出实施例的晶体管的电特性的加热处理时间依赖性的图。 [图21]示出实施例的氢浓度的测量结果的图。 [图22]示出实施例的截面TEM图像的图。 [图23]示出实施例的截面TEM图像的图。 实施发明的方式 下面,参照附图对实施方式进行说明。但是,所属技术领域的普通技术人员可以很 容易地理解一个事实,就是实施方式可以以多个不同形式来实施,其方式和详细内容可以 在不脱离本发明的宗旨及其范围的条件下被变换为各种各样的形式。因此,本发明不应该 被解释为仅限定在下面的实施方式所记载的内容中。 在附图中,为便于清楚地说明,有时夸大表示大小、层的厚度或区域。因此,本发明 并不一定限定于上述尺寸。此外,在附图中,示意性地示出理想的例子,因此本发明不局限 于附图所示的形状或数值等。例如,在实际的制造工序中,有时由于蚀刻等处理而层或抗蚀 剂掩模等非意图性地被减薄,但是为了便于理解有时不反映到附图。另外,在附图中,有时 在不同的附图之间共同使用相同的附图标记来表示相同的部分或具有相同功能的部分,而 省略其重复说明。此外,当表示具有相同功能的部分时有时使用相同的阴影线,而不特别附 加附图标记。 另外,尤其在俯视图(也称为平面图)或立体图等中,为了便于对发明的理解,有时 省略部分构成要素的记载。另外,有时省略部分隐藏线等的记载。 此外,在本说明书等中,为了方便起见,附加了第一、第二等序数词,而其并不表示 工序顺序或叠层顺序。因此,例如可以将“第一”适当地替换为“第二”或“第三”等来进行说 明。此外,本说明书等所记载的序数词与用于指定本发明的一个方式的序数词有时不一致。 在本说明书等中,为方便起见,使用了“上”、“下”等表示配置的词句,以参照附图 说明构成要素的位置关系。另外,构成要素的位置关系根据描述各构成要素的方向适当地 改变。因此,不局限于本说明书中所说明的词句,可以根据情况适当地更换。 例如,在本说明书等中,当明确地记载为“X与Y连接”时,意味着如下情况:X与Y电 连接;X与Y在功能上连接;X与Y直接连接。因此,不局限于规定的连接关系(例如,附图或文 7 CN 111587491 A 说 明 书 5/40 页 中所示的连接关系等),附图或文中所示的连接关系以外的连接关系也包含于附图或文中 所公开的内容中。 这里,X和Y为对象物(例如,装置、元件、电路、布线、电极、端子、导电膜及层等)。 另外,在使用极性不同的晶体管的情况或电路工作中的电流方向变化的情况等 下,源极及漏极的功能有时相互调换。因此,在本说明书等中,有时源极和漏极可以相互调 换。 另外,在本说明书中,根据晶体管的结构,有时形成沟道的区域中的实际上的沟道 宽度(以下,也称为“实效沟道宽度”)和晶体管的俯视图所示的沟道宽度(以下,也称为“外 观上的沟道宽度”)不同。例如,在栅电极覆盖半导体的侧面的情况下,有时因为实效沟道宽 度大于外观上的沟道宽度,所以不能忽略其影响。例如,在微型且栅电极覆盖半导体的侧面 的晶体管中,有时形成在半导体的侧面的沟道形成区域的比例增高。在此情况下,实效沟道 宽度大于外观上的沟道宽度。 在此情况下,有时难以通过实测估计实效沟道宽度。例如,要从设计值估算出实效 沟道宽度,需要假定半导体的形状是已知的。因此,当半导体的形状不清楚时,难以准确地 测量实效沟道宽度。 在本说明书中,在简单地描述为“沟道宽度”时,有时是指外观上的沟道宽度。或 者,在本说明书中,在简单地描述为“沟道宽度”时,有时是指实效沟道宽度。注意,通过对截 面TEM图像等进行分析等,可以决定沟道长度、沟道宽度、实效沟道宽度、外观上的沟道宽 度、围绕沟道宽度等的值。 注意,半导体的杂质例如是指半导体的主要成分之外的元素。例如,浓度小于0.1 原子%的元素可以说是杂质。有时由于包含杂质,例如造成半导体的DOS(Density of States:态密度)变高,结晶性降低等。当半导体是氧化物半导体时,作为改变半导体的特性 的杂质,例如有第1族元素、第2族元素、第13族元素、第14族元素、第15族元素以及除氧化物 半导体的主要成分外的过渡金属等。例如,有氢、锂、钠、硅、硼、磷、碳、氮等。在半导体是氧 化物半导体的情况下,有时水也作为杂质起作用。另外,在半导体是氧化物半导体时,有时 例如由于杂质的进入导致氧空位(也称为VO:oxygen vacancy)的产生。此外,在半导体是硅 时,作为改变半导体特性的杂质,例如有氧、除氢之外的第1族元素、第2族元素、第13族元 素、第15族元素等。 注意,在本说明书等中,氧氮化硅是指氧含量大于氮含量的膜。另外,氮氧化硅是 指氮含量大于氧含量的膜。 另外,在本说明书等中,可以将“绝缘体”换称为“绝缘膜”或“绝缘层”。另外,可以 将“导电体”换称为“导电膜”或“导电层”。另外,可以将“半导体”换称为“半导体膜”或“半导 体层”。 在本说明书等中,“平行”是指两条直线形成的角度为-10°以上且10°以下的状态。 因此,也包括该角度为-5°以上且5°以下的状态。“大致平行”是指两条直线形成的角度为- 30°以上且30°以下的状态。另外,“垂直”是指两条直线的角度为80°以上且100°以下的状 态。因此,也包括该角度为85°以上且95°以下的状态。“大致垂直”是指两条直线形成的角度 为60°以上且120°以下的状态。 注意,在本说明书中,阻挡膜是指具有抑制水、氢等杂质及氧的透过的功能的膜, 8 CN 111587491 A 说 明 书 6/40 页 在该阻挡膜具有导电性的情况下,有时被称为导电阻挡膜。 在本说明书等中,金属氧化物(metal oxide)是指广义上的金属的氧化物。金属氧 化物被分类为氧化物绝缘体、氧化物导电体(包括透明氧化物导电体)和氧化物半导体 (Oxide Semiconductor,也可以简称为OS)等。例如,在将金属氧化物用于晶体管的半导体 层的情况下,有时将该金属氧化物称为氧化物半导体。换言之,可以将OS FET或OS晶体管称 为包含氧化物或氧化物半导体的晶体管。 注意,在本说明书等中,常关闭是指:在不对栅极施加电位或者对栅极施加接地电 位时流过晶体管的每沟道宽度1μm的电流在室温下为1×10-20A以下,在85℃下为1×10-18A 以下,或在125℃下为1×10-16A以下。 (实施方式1) 下面说明包括根据本发明的一个方式的晶体管200的半导体装置的一个例子。 <半导体装置的结构例子> 图1A、图1B及图1C是根据本发明的一个方式的晶体管200及晶体管200的周围的俯视图 及截面图。 图1A是包括晶体管200的半导体装置的俯视图。图1B和图1C是该半导体装置的截 面图。在此,图1B是由图1A中的点划线A1-A2示出的部分的截面图,该截面图相当于晶体管 200的沟道长度方向上的截面图。图1C是由图1A中的点划线A3-A4示出的部分的截面图,该 截面图相当于晶体管200的沟道宽度方向上的截面图。注意,为了明确起见,在图1A的俯视 图中省略部分构成要素。 本发明的一个方式的半导体装置包括晶体管200、被用作层间膜的绝缘体214、绝 缘体274、绝缘体280及绝缘体281。另外,该半导体装置还包括与晶体管200电连接且被用作 插头的导电体240(导电体240a及导电体240b)。另外,与被用作插头的导电体240的侧面接 触地设置有绝缘体241(绝缘体241a及绝缘体241b)。 另外,以与绝缘体254、绝缘体274、绝缘体280及绝缘体281的开口的内壁接触的方 式设置有绝缘体241,以与其侧面接触的方式设置有导电体240的第一导电体,其内侧设置 有导电体240的第二导电体。在此,导电体240的顶面的高度与绝缘体281的顶面的高度可以 大致相同。另外,示出晶体管200层叠有导电体240的第一导电体与导电体240的第二导电体 的结构,但是本发明不局限于此。例如,导电体240也可以具有单层结构或者三层以上的叠 层结构。另外,在结构体具有叠层结构的情况下,有时按形成顺序赋予序数以进行区別。 [晶体管200] 如图1A至图1C所示,晶体管200包括配置在衬底(未图示)上的绝缘体214上的绝缘体 216、填埋于绝缘体216中地配置的导电体205、配置在绝缘体216及导电体205上的绝缘体 222、配置在绝缘体222上的绝缘体224、配置在绝缘体224上的氧化物230(氧化物230a、氧化 物230b及氧化物230c)、配置在氧化物230上的绝缘体250、配置在绝缘体250上的导电体260 (导电体260a及导电体260b)、与氧化物230的顶面的一部分接触的导电体242a及导电体 242b、与绝缘体224的顶面的一部分、氧化物230a的侧面、氧化物230b的侧面、导电体242a的 侧面、导电体242a的顶面、导电体242b的侧面及导电体242b的顶面接触地配置的绝缘体 254、配置在绝缘体254上的绝缘体280以及配置在绝缘体280上的绝缘体274。导电体260包 括导电体260a及导电体260b,包围导电体260b的底面及侧面地配置有导电体260a。在此,如 9 CN 111587491 A 说 明 书 7/40 页 图1B所示,导电体260的顶面以与绝缘体250的顶面及氧化物230c的顶面大致一致的方式配 置。此外,绝缘体274与导电体260、氧化物230c及绝缘体250的每一个的顶面接触。 另外,绝缘体222、绝缘体254及绝缘体274优选具有抑制氢(例如,氢原子、氢分子 等中的至少一个)的扩散的功能。此外,绝缘体222、绝缘体254及绝缘体274优选具有抑制氧 (例如,氧原子、氧分子等中的至少一个)的扩散的功能。例如,绝缘体222、绝缘体254及绝缘 体274的氧及氢中的一方或双方的透过性优选都比绝缘体224低。绝缘体222、绝缘体254及 绝缘体274的氧及氢中的一方或双方的透过性优选都比绝缘体250低。绝缘体222、绝缘体 254及绝缘体274的氧及氢中的一方或双方的透过性优选都比绝缘体280低。 如图1B、图1C所示,绝缘体254优选与导电体242a的顶面及侧面、导电体242b的顶 面及侧面、氧化物230a及氧化物230b的侧面以及绝缘体224的顶面接触。由此,绝缘体280与 绝缘体224及氧化物230由绝缘体254分开。 此外,氧化物230优选包括配置在绝缘体224上的氧化物230a、配置在氧化物230a 上的氧化物230b以及配置在氧化物230b上且其至少一部分与氧化物230b的顶面接触的氧 化物230c。 注意,在晶体管200中,在形成沟道的区域(以下,也称为沟道形成区域)及其附近 层叠有氧化物230a、氧化物230b及氧化物230c的三层,但是本发明不局限于此。例如,可以 设置氧化物230b的单层、氧化物230b与氧化物230a的两层结构、氧化物230b与氧化物230c 的两层结构或者四层以上的叠层结构。另外,在晶体管200中,导电体260具有两层的叠层结 构,但是本发明不局限于此。例如,导电体260也可以具有单层结构或三层以上的叠层结构。 在此,导电体260被用作晶体管的栅电极,导电体242a及导电体242b被用作源电极 或漏电极。晶体管200以被用作栅电极的导电体260填埋形成于绝缘体280、绝缘体254及导 电体242的开口的方式自对准地形成。通过如此形成导电体260,可以在导电体242a和导电 体242b之间的区域中无需对准并确实地配置导电体260。 另外,如图1A至图1C所示,导电体260优选包括导电体260a、配置在导电体260a上 的导电体260b。 此外,晶体管200优选包括配置在衬底(未图示)上的绝缘体214、配置在绝缘体214 上的绝缘体216、以填埋于绝缘体214及绝缘体216中的方式配置的导电体205以及配置在绝 缘体216及导电体205上的绝缘体222。再者,优选在绝缘体222上配置有绝缘体224。 另外,优选在晶体管200中将被用作氧化物半导体的金属氧化物(以下,有时称为 氧化物半导体)用于包含沟道形成区域的氧化物230(氧化物230a、氧化物230b及氧化物 230c)。 由于将氧化物半导体用于沟道形成区域的晶体管200在非导通状态下的泄漏电流 (关态电流)极小,所以可以提供低功耗的半导体装置。此外,由于氧化物半导体可以利用溅 射法等形成,所以可以用于构成高集成型半导体装置的晶体管200。 作为氧化物230优选使用In-M-Zn氧化物(元素M为选自铝、镓、钇、锡、铜、钒、铍、 硼、钛、铁、镍、锗、锆、钼、镧、铈、钕、铪、钽、钨和镁等中的一种或多种)等金属氧化物。特别 是,作为元素M可以使用铝、镓、钇或锡。此外,作为氧化物230也可以使用In-Ga氧化物、In- Zn氧化物。 此外,在使用氧化物半导体的晶体管中,如果氧化物半导体中的形成沟道的区域 10 CN 111587491 A 说 明 书 8/40 页 存在杂质及氧空位,电特性则容易变动,有时降低可靠性。另外,在氧化物半导体中的形成 沟道的区域包含氧空位的情况下,晶体管趋于具有常开启特性。因此,优选为尽可能降低形 成沟道的区域中的氧空位。例如,通过绝缘体250等对氧化物230供应氧,填充氧空位,即可。 由此,抑制电特性的变动,从而可以提供具有稳定的电特性且可靠性得到提高的晶体管。 另外,在包含在以与氧化物230上接触的方式设置并被用作源电极或漏电极的导 电体242(导电体242a及导电体242b)中的元素(例如,第二元素)具有吸收氧化物230的氧的 功能的情况下,可能在氧化物230和导电体242之间或氧化物230的表面附近部分地形成低 电阻区域。在此情况下,在该低电阻区域中,进入氧空位的杂质(氢、氮、或金属元素等)被用 作供体,载流子密度会增高。另外,下面有时将进入氧空位的氢称为VoH。 此外,图2A示出图1B所示的晶体管200的一部分的区域的放大图。如图2A所示,有 时以与氧化物230b上接触的方式设置有导电体242,在氧化物230b的与导电体242的界面及 其附近作为低电阻区域形成有区域243(区域243a及区域243b)。氧化物230包括被用作晶体 管200的沟道形成区域的区域234、包括区域243的一部分且被用作源区域或漏区域的区域 231(区域231a及区域231b)。另外,在下面的图面中,有时即使在放大图等中没有示出区域 243也形成有同样的区域243。 另外,虽然示出了在氧化物230b的导电体242附近,区域243a及区域243b以在深度 方向上扩散的方式设置的例子,但是本发明不局限于此。区域243a及区域243b根据所需要 的晶体管的电特性适当地形成,即可。在氧化物230中,有时难以明确地观察各区域的边界。 在各区域中检测出的元素的浓度不仅限于按每区域分阶段地变化,也可以在各区域中逐渐 地变化(也称为渐变(gradation))。 图2B是在绝缘体280和绝缘体274之间配置有绝缘体283的晶体管的一个例子,即 是绝缘体274和绝缘体250不接触的结构。通过采用这种结构,有时绝缘体280等所包含的氢 等杂质经过绝缘体283混入绝缘体250。有时混入绝缘体250的氢等杂质向沟道形成区域的 氧化物230扩散并给晶体管的电特性及晶体管的可靠性带来负面影响。 此外,如图2A所示,作为本发明的一个方式的晶体管200具有绝缘体274和绝缘体 250直接接触的结构。通过采用这种结构,可以抑制包含在绝缘体280等中的氢等杂质混入 绝缘体250,从而可以抑制给上述电特性及可靠性带来的负面影响。 此外,在图2A中,以绝缘体224的底面为标准,与区域234重叠的区域中的导电体 260的底面的高度优选比导电体242a及导电体242b的每一个的顶面的高度低。来自被用作 栅电极的导电体260的电场能够作用于沟道形成区域整体而晶体管进行良好的工作,所以 是优选的。在与区域243重叠的区域中的导电体260的底面的高度和导电体242a及导电体 242b的每一个的顶面的高度之间的差异为T1时,T1为0nm以上且30nm以下,优选为0nm以上 且15nm以下。 在此,图3示出图1C所示的晶体管200的一部分的区域的放大图。图3是晶体管200 的W宽度方向上的沟道形成区域的放大图。 如图3所示,以绝缘体224的底面为标准,氧化物230a及氧化物230b和导电体260不 重叠的区域中的导电体260的底面的高度优选比氧化物230b的底面的高度低。此外,在氧化 物230b和导电体260不重叠的区域中的导电体260的底面的高度和氧化物230b的底面的高 度之间的差异为T2时,T2为0nm以上且100nm以下,优选为3nm以上且50nm以下,更优选为5nm 11 CN 111587491 A 说 明 书 9/40 页 以上且20nm以下。 如此,采用被用作栅电极的导电体260隔着氧化物230c及绝缘体250覆盖沟道形成 区域的氧化物230b的侧面及顶面的结构,该结构容易使导电体260的电场作用于沟道形成 区域的氧化物230b整体。因此,可以增大晶体管200的通态电流并提高频率特性。 如上所述,可以提供包括通态电流大的晶体管的半导体装置。另外,可以提供包括 具有高频率特性的晶体管的半导体装置。另外,可以提供抑制电特性变动而实现具有稳定 的电特性并提高了可靠性的半导体装置。另外,可以提供包括关态电流小的晶体管的半导 体装置。 下面,说明包括本发明的一个方式的晶体管200的半导体装置的详细结构。 导电体205以与氧化物230及导电体260重叠的方式配置。另外,导电体205优选以 填埋于绝缘体214及绝缘体216中的方式设置。 在此,导电体260有时被用作第一栅(也称为顶栅极)电极。此外,导电体205有时被 用作第二栅(也称为底栅极)电极。在此情况下,通过独立地改变供应到导电体205的电位而 不使其与供应到导电体260的电位联动,可以控制晶体管200的Vth。尤其是,通过对导电体 205供应负电位,可以使晶体管200的Vth大于0V且可以减小关态电流。因此,与不对导电体 205施加负电位时相比,在对导电体205施加负电位的情况下,可以减小对导电体260供应的 电位为0V时的漏极电流。 另外,如图1A所示,导电体205优选比氧化物230中的区域234大。尤其是,如图1C所 示,导电体205优选延伸到与沟道宽度方向交叉的氧化物230中的区域234的端部的外侧的 区域。就是说,优选在氧化物230的沟道宽度方向的侧面的外侧,导电体205和导电体260隔 着绝缘体重叠。 通过具有上述结构,可以由被用作第一栅电极的导电体260的电场和被用作第二 栅电极的导电体205的电场电围绕区域234的沟道形成区域。在本说明书中,将由第一栅电 极及第二栅电极的电场电围绕沟道形成区域的晶体管的结构称为surrounded channel(S- channel:围绕沟道)结构。 此外,作为导电体205,优选使用以钨、铜或铝为主要成分的导电材料。在附图中, 以单层图示导电体205,但是导电体205也可以具有叠层结构,例如,可以采用钛、氮化钛和 上述导电材料的叠层结构。 绝缘体214优选被用作抑制水或氢等杂质从衬底一侧进入晶体管200的阻挡绝缘 膜。因此,作为绝缘体214优选使用具有抑制氢原子、氢分子、水分子、氮原子、氮分子、氧化 氮分子(N2O、NO、NO2等)、铜原子等杂质的扩散的功能(不容易使上述杂质透过)的绝缘材料。 另外,优选使用具有抑制氧(例如,氧原子、氧分子等中的至少一个)的扩散的功能(不容易 使上述氧透过)的绝缘材料。 例如,优选的是,作为绝缘体214使用氮化硅等。由此,可以抑制水或氢等杂质从与 绝缘体214相比更靠近衬底一侧扩散到晶体管200一侧。此外,可以抑制包含在绝缘体224等 中的氧扩散到与绝缘体214相比更靠近衬底一侧。 此外,绝缘体216、绝缘体280及绝缘体281的介电常数优选比绝缘体214低。通过将 介电常数低的材料作为层间膜,可以减少产生在布线之间的寄生电容。例如,作为绝缘体 216、绝缘体280及绝缘体281,适当地使用氧化硅、氧氮化硅、氮氧化硅、氮化硅、添加有氟的 12 CN 111587491 A 说 明 书 10/40 页 氧化硅、添加有碳的氧化硅、添加有碳及氮的氧化硅或具有空孔的氧化硅等。 绝缘体222及绝缘体224被用作栅极绝缘体。 在此,在与氧化物230接触的绝缘体224中,优选通过加热使氧脱离。在本说明书 中,有时将通过加热脱离的氧称为过剩氧。例如,作为绝缘体224适当地使用氧化硅或氧氮 化硅等,即可。通过以与氧化物230接触的方式设置上述包含过剩氧的绝缘体,可以减少氧 化物230中的氧空位,从而可以提高晶体管200的可靠性。 具体而言,作为绝缘体224,优选使用通过加热使一部分的氧脱离的氧化物材料。 通过加热使氧脱离的氧化物是指在TDS(Thermal Desorption Spectroscopy:热脱附谱)分 析中换算为氧原子的氧的脱离量为1.0×1018atoms/cm3以上,优选为1.0×1019atoms/cm3以 上,进一步优选为2.0×1019atoms/cm3以上,或者3.0×1020atoms/cm3以上的氧化物膜。另 外,进行上述TDS分析时的膜的表面温度优选在100℃以上且700℃以下,或者100℃以上且 400℃以下的范围内。 此外,如图1C所示,有时在绝缘体224中不与绝缘体254重叠并不与氧化物230b重 叠的区域的厚度比其他区域的厚度薄。在绝缘体224中,不与绝缘体254重叠并不与氧化物 230b重叠的区域优选具有足够使上述氧扩散的厚度。 绝缘体222优选被用作抑制水或氢等杂质从衬底一侧混入晶体管200的阻挡绝缘 膜。例如,绝缘体222的氧透过性优选比绝缘体224低。通过由绝缘体222及绝缘体254围绕绝 缘体224及氧化物230等,可以抑制水或氢等杂质从外部侵入晶体管200。 再者,绝缘体222优选具有抑制氧(例如,氧原子、氧分子等中的至少一个)的扩散 的功能(不容易使上述氧透过)。例如,绝缘体222的氧透过性优选比绝缘体224低。通过使绝 缘体222具有抑制氧或杂质的扩散的功能,可以减少氧化物230所具有的氧能够扩散到绝缘 体220一侧,所以是优选的。此外,可以抑制导电体205与绝缘体224及氧化物230所具有的氧 起反应。 绝缘体222作为绝缘材料的包含铝和铪中的一方或双方的氧化物的绝缘体。作为 包含铝和铪中的一方或双方的氧化物的绝缘体,优选使用氧化铝、氧化铪、包含铝及铪的氧 化物(铝酸铪)等。当使用这种材料形成绝缘体222时,绝缘体222被用作抑制氧从氧化物230 释放或氢等杂质从晶体管200的周围部进入氧化物230的层。 或者,例如也可以对上述绝缘体添加氧化铝、氧化铋、氧化锗、氧化铌、氧化硅、氧 化钛、氧化钨、氧化钇、氧化锆。此外,也可以对上述绝缘体进行氮化处理。还可以在上述绝 缘体上层叠氧化硅、氧氮化硅或氮化硅。 此外,作为绝缘体222,例如也可以以单层或叠层使用包含氧化铝、氧化铪、氧化 钽、氧化锆、锆钛酸铅(PZT)、钛酸锶(SrTiO3)或(Ba,Sr)TiO3(BST)等所谓的high-k材料的绝 缘体。当进行晶体管的微型化及高集成化时,由于栅极绝缘体的薄膜化,有时发生泄漏电流 等问题。通过作为被用作栅极绝缘体的绝缘体使用high-k材料,可以在保持物理厚度的同 时降低晶体管工作时的栅极电位。 另外,绝缘体222及绝缘体224也可以具有两层以上的叠层结构。此时,不局限于使 用相同材料构成的叠层结构,也可以是使用不同材料构成的叠层结构。 氧化物230包括氧化物230a、氧化物230a上的氧化物230b及氧化物230b上的氧化 物230c。当在氧化物230b下设置有氧化物230a时,可以抑制杂质从形成在氧化物230a下的 13 CN 111587491 A 说 明 书 11/40 页 结构物扩散到氧化物230b。当在氧化物230b上设置有氧化物230c时,可以抑制杂质从形成 在氧化物230c的上方的结构物扩散到氧化物230b。 另外,氧化物230优选具有各金属原子的原子个数比互不相同的氧化物的叠层结 构。具体而言,在用于氧化物230a的金属氧化物中,构成元素中的元素M的原子个数比优选 大于用于氧化物230b的金属氧化物的构成元素中的元素M的原子个数比。另外,在用于氧化 物230a的金属氧化物中,相对于In的元素M的原子个数比优选大于用于氧化物230b的金属 氧化物中的相对于In的元素M的原子个数比。另外,在用于氧化物230b的金属氧化物中,相 对于元素M的In的原子个数比优选大于用于氧化物230a的金属氧化物中的相对于元素M的 In的原子个数比。另外,氧化物230c可以使用可用于氧化物230a或氧化物230b的金属氧化 物。 另外,氧化物230b优选具有结晶性。例如,优选使用下述CAAC-OS(c-axis aligned crystalline oxide semiconductor)。CAAC-OS等的具有结晶性的氧化物具有杂质及缺陷 (氧缺陷等)少的结晶性高且致密的结构。因此,可以抑制源电极或漏电极从氧化物230b抽 出氧。因此,即使进行加热处理也可以减少从氧化物230b被抽出的氧,所以晶体管200对制 造工序中的高温度(所谓热积存;thermal budget)也很稳定。 优选的是,使氧化物230a及氧化物230c的导带底的能量高于氧化物230b的导带底 的能量。换言之,氧化物230a及氧化物230c的电子亲和势优选小于氧化物230b的电子亲和 势。 在此,在氧化物230a、氧化物230b及氧化物230c的接合部中,导带底的能级平缓地 变化。换言之,也可以将上述情况表达为氧化物230a、氧化物230b及氧化物230c的接合部的 导带底的能级连续地变化或者连续地接合。为此,优选降低形成在氧化物230a与氧化物 230b的界面以及氧化物230b与氧化物230c的界面的混合层的缺陷态密度。 具体而言,作为氧化物230a使用In:Ga:Zn=1:3:4[原子个数比]或1:1:0.5[原子 个数比]的金属氧化物,即可。此外,作为氧化物230b使用In:Ga:Zn=4:2:3[原子个数比]或 3:1:2[原子个数比]的金属氧化物,即可。此外,作为氧化物230c使用In:Ga:Zn=1:3:4[原 子个数比]、In:Ga:Zn=4:2:3[原子个数比]、Ga:Zn=2:1[原子个数比]或Ga:Zn=2:5[原子 个数比]的金属氧化物,即可。此外,作为氧化物230c具有叠层结构的情况下的具体例子,可 以举出In:Ga:Zn=4:2:3[原子个数比]和Ga:Zn=2:1[原子个数比]的叠层结构、In:Ga:Zn =4:2:3[原子个数比]和Ga:Zn=2:5[原子个数比]的叠层结构、In:Ga:Zn=4:2:3[原子个 数比]和氧化镓的叠层结构等。 此时,载流子的主要路径为氧化物230b。通过使氧化物230a及氧化物230c具有上 述结构,可以降低氧化物230a与氧化物230b的界面及氧化物230b与氧化物230c的界面的缺 陷态密度。因此,界面散射对载流子传导的影响减少,从而晶体管200可以得到高通态电流 及高频率特性。另外,在氧化物230c具有叠层结构时,被期待降低上述氧化物230b和氧化物 230c之间的界面的缺陷态密度的效果及抑制氧化物230c所具有的构成元素扩散到绝缘体 250一侧的效果。更具体而言,在氧化物230c具有叠层结构时,因为使不包含In的氧化物位 于叠层结构的上方,所以可以抑制会扩散到绝缘体250一侧的In。由于绝缘体250被用作栅 极绝缘体,因此在In扩散在其中的情况下导致晶体管的特性不良。由此,通过使氧化物230c 具有叠层结构,可以提供可靠性高的半导体装置。 14 CN 111587491 A 说 明 书 12/40 页 作为氧化物230优选使用被用作氧化物半导体的金属氧化物。例如,作为成为区域 234的金属氧化物,优选使用其带隙为2eV以上,优选为2.5eV以上的金属氧化物。如此,通过 使用带隙较宽的金属氧化物,可以减小晶体管的关态电流。通过采用这种晶体管,可以提供 低功耗的半导体装置。 在氧化物230b上设置被用作源电极及漏电极的导电体242(导电体242a及导电体 242b)。导电体242的厚度例如为1nm以上且50nm以下,优选为2nm以上且25nm以下,即可。 作为导电体242,优选使用选自铝、铬、铜、银、金、铂、钽、镍、钛、钼、钨、铪、钒、铌、 锰、镁、锆、铍、铟、钌、铱、锶和镧中的金属元素、以上述金属元素为成分的合金或者组合上 述金属元素的合金等。例如,优选使用氮化钽、氮化钛、钨、包含钛和铝的氮化物、包含钽和 铝的氮化物、氧化钌、氮化钌、包含锶和钌的氧化物、包含镧和镍的氧化物等。另外,氮化钽、 氮化钛、包含钛和铝的氮化物、包含钽和铝的氮化物、氧化钌、氮化钌、包含锶和钌的氧化 物、包含镧和镍的氧化物是不容易氧化的导电材料或者吸收氧也维持导电性的材料,所以 是优选的。 绝缘体254与绝缘体214等同样地优选被用作抑制水或氢等杂质从绝缘体280一侧 混入晶体管200的阻挡绝缘膜。例如,绝缘体254的氢透过性优选比绝缘体224低。再者,如图 1B所示,绝缘体254优选与导电体242a的顶面及侧面、导电体242b的顶面及侧面、氧化物 230a及氧化物230b的侧面以及绝缘体224的顶面接触。通过采用这种结构,可以抑制绝缘体 280所包含的氢从导电体242a、导电体242b、氧化物230a、氧化物230b及绝缘体224的顶面或 侧面侵入氧化物230。 再者,绝缘体254还具有抑制氧(例如,氧原子、氧分子等中的至少一个)的扩散的 功能(不容易使上述氧透过)。例如,绝缘体254的氧透过性优选比绝缘体224低。 绝缘体254优选通过溅射法形成。通过在包含氧的气氛下使用溅射法形成绝缘体 254,可以对绝缘体224与绝缘体254接触的区域附近添加氧。由此,可以将氧从该区域通过 绝缘体224供应到氧化物230中。在此,通过使绝缘体254具有抑制扩散到上方的氧的功能, 可以防止氧从氧化物230扩散到绝缘体280。此外,通过使绝缘体222具有抑制扩散到下方的 氧的功能,可以防止氧从氧化物230扩散到绝缘体216。如此,对氧化物230中的被用作沟道 形成区域的区域234供应氧。由此,可以减少氧化物230的氧空位并抑制晶体管的常开启化。 此外,绝缘体254可以具有两层以上的多层结构。例如,作为绝缘体254,可以在包 含氧的气氛下使用溅射法形成第一层,然后使用ALD法形成第二层,来形成两层结构。因为 ALD法是覆盖性良好的成膜方法,所以可以防止因第一层的凹凸而产生断开等。 作为绝缘体254,例如可以形成包含铝及铪中的一个或多个的氧化物的绝缘体。注 意,作为包含铝和铪中的一方或双方的氧化物的绝缘体,优选使用氧化铝、氧化铪、包含铝 及铪的氧化物(铝酸铪)等。 绝缘体250被用作栅极绝缘体。绝缘体250优选与氧化物230c的顶面接触地配置。 绝缘体250可以使用氧化硅、氧氮化硅、氮氧化硅、氮化硅、添加有氟的氧化硅、添加有碳的 氧化硅、添加有碳及氮的氧化硅、具有空孔的氧化硅。尤其是,氧化硅及氧氮化硅具有热稳 定性,所以是优选的。 与绝缘体224同样地,绝缘体250优选使用通过加热释放氧的绝缘体形成。通过作 为绝缘体250以与氧化物230c的顶面接触的方式设置通过加热释放氧的绝缘体,可以高效 15 CN 111587491 A 说 明 书 13/40 页 地对氧化物230b的区域234供应氧。与绝缘体224同样,优选降低绝缘体250中的水或氢等杂 质的浓度。绝缘体250的厚度优选为1nm以上且20nm以下。 另外,也可以在绝缘体250与导电体260之间设置绝缘体272。该金属氧化物优选抑 制从绝缘体250扩散到导电体260的氧。通过设置抑制氧的扩散的金属氧化物,从绝缘体250 扩散到导电体260的氧被抑制。换言之,可以抑制供应到氧化物230的氧量的减少。另外,可 以抑制因绝缘体250中的氧所导致的导电体260的氧化。 另外,该金属氧化物有时被用作栅极绝缘体的一部分。因此,在将氧化硅或氧氮化 硅等用于绝缘体250的情况下,作为该金属氧化物优选使用作为相对介电常数高的high-k 材料的金属氧化物。通过使栅极绝缘体具有绝缘体250与该金属氧化物的叠层结构,可以形 成具有热稳定性且相对介电常数高的叠层结构。因此,可以在保持栅极绝缘体的物理厚度 的同时降低在晶体管工作时施加的栅极电位。另外,可以减少被用作栅极绝缘体的绝缘体 的等效氧化物厚度(EOT)。 具体而言,可以使用包含选自铪、铝、镓、钇、锆、钨、钛、钽、镍、锗和镁等中的一种 或两种以上的金属氧化物。特别是,优选使用作为包含铝及铪中的一方或双方的氧化物的 绝缘体的氧化铝、氧化铪、包含铝及铪的氧化物(铝酸铪)等。 虽然在图1A至图1C中,导电体260具有两层结构,但是也可以具有单层结构或三层 以上的叠层结构。 作为导电体260a优选使用具有抑制氢原子、氢分子、水分子、氮原子、氮分子、氧化 氮分子(N2O、NO、NO2等)、铜原子等杂质的扩散的功能的导电材料。另外,优选使用具有抑制 氧(例如,氧原子、氧分子等中的至少一个)的扩散的功能的导电材料。 此外,当导电体260a具有抑制氧的扩散的功能时,可以抑制绝缘体250所包含的氧 使导电体260b氧化而导致导电率的下降。作为具有抑制氧的扩散的功能的导电材料,例如, 优选使用钽、氮化钽、钌或氧化钌等。 此外,作为导电体260b优选使用以钨、铜或铝为主要成分的导电材料。另外,由于 导电体260还被用作布线,所以优选使用导电性高的导电体。例如,可以使用以钨、铜或铝为 主要成分的导电材料。另外,导电体260b可以具有叠层结构,例如可以具有钛、氮化钛与上 述导电材料的叠层结构。 像这样,通过由对氢具有阻挡性的绝缘体254覆盖绝缘体224及氧化物230,绝缘体 280由绝缘体254与绝缘体224及氧化物230分开。由此,可以抑制从晶体管200的外部侵入的 氢等杂质,从而可以对晶体管200赋予良好的电特性及可靠性。 绝缘体280优选隔着绝缘体254设置在绝缘体224、氧化物230及导电体242上。例 如,作为绝缘体280,优选具有氧化硅、氧氮化硅、氮氧化硅、添加有氟的氧化硅、添加有碳的 氧化硅、添加有碳及氮的氧化硅或具有空孔的氧化硅等。尤其是,氧化硅及氧氮化硅具有热 稳定性,所以是优选的。特别是,因为氧化硅、氧氮化硅、具有空孔的氧化硅等的材料容易形 成包含通过加热脱离的氧的区域,所以是优选的。 另外,优选绝缘体280中的水或氢等杂质的浓度得到降低。此外,绝缘体280的顶面 也可以被平坦化。 绝缘体274优选与绝缘体214等同样地被用作抑制水或氢等杂质从上方混入到绝 缘体280的阻挡绝缘膜。作为绝缘体274,例如可以使用能够用于绝缘体214、绝缘体254等的 16 CN 111587491 A 说 明 书 14/40 页 绝缘体。 另外,优选在绝缘体274上设置被用作层间膜的绝缘体281。与绝缘体224等同样, 优选绝缘体281中的水或氢等杂质的浓度得到降低。 另外,在形成于绝缘体281、绝缘体274、绝缘体280及绝缘体254中的开口中配置导 电体240a及导电体240b。导电体240a及导电体240b以中间夹着导电体260的方式设置。另 外,导电体240a及导电体240b的顶面的高度与绝缘体281的顶面可以位于同一平面上。 另外,以与绝缘体281、绝缘体274、绝缘体280及绝缘体254的开口的内壁接触的方 式设置有绝缘体241a,以与其侧面接触的方式形成有导电体240a的第一导电体。导电体 242a位于该开口的底部的至少一部分,导电体240a与导电体242a接触。同样,以与绝缘体 281、绝缘体274、绝缘体280及绝缘体254的开口的内壁接触的方式设置有绝缘体241b,以与 其侧面接触的方式形成有导电体240b的第一导电体。导电体242b位于该开口的底部的至少 一部分,导电体240b与导电体242b接触。 导电体240a及导电体240b优选使用以钨、铜或铝为主要成分的导电材料。此外,导 电体240a及导电体240b也可以具有叠层结构。 当作为导电体240采用叠层结构时,作为与氧化物230a、氧化物230b、导电体242、 绝缘体254、绝缘体280、绝缘体274及绝缘体281接触的导电体优选使用具有抑制水或氢等 杂质的透过的功能的导电材料。例如,优选使用钽、氮化钽、钛、氮化钛、钌或氧化钌等。可以 以单层或叠层使用具有抑制水或氢等杂质的透过的功能的导电材料。通过使用该导电材 料,可以防止添加到绝缘体280的氧被吸收到导电体240a及导电体240b。此外,可以防止水 或氢等杂质从绝缘体281的上方的层通过导电体240a及导电体240b进入氧化物230。 作为绝缘体241a及绝缘体241b,例如使用能够用于绝缘体254等的绝缘体,即可。 因为绝缘体241a及绝缘体241b与绝缘体254接触地设置,所以可以抑制从绝缘体280等水或 氢等杂质经过导电体240a及导电体240b混入氧化物230。此外,可以防止绝缘体280所包含 的氧被导电体240a及导电体240b吸收。 虽然未图示,但是可以以与导电体240a的顶面及导电体240b的顶面接触的方式配 置被用作布线的导电体。被用作布线的导电体优选使用以钨、铜或铝为主要成分的导电材 料。另外,该导电体可以具有叠层结构,例如,可以具有钛、氮化钛与上述导电材料的叠层结 构。另外,该导电体可以填埋于绝缘体的开口中。 <半导体装置的构成材料> 以下,说明可用于半导体装置的构成材料。 <衬底> 作为形成晶体管200的衬底例如可以使用绝缘体衬底、半导体衬底或导电体衬底。作为 绝缘体衬底,例如可以举出玻璃衬底、石英衬底、蓝宝石衬底、稳定氧化锆衬底(氧化钇稳定 氧化锆衬底等)、树脂衬底等。另外,作为半导体衬底,例如可以举出由硅或锗等构成的半导 体衬底、或者由碳化硅、硅锗、砷化镓、磷化铟、氧化锌或氧化镓等构成的化合物半导体衬底 等。再者,还可以举出在上述半导体衬底内部具有绝缘体区域的半导体衬底,例如有SOI (Silicon On Insulator;绝缘体上硅)衬底等。作为导电体衬底,可以举出石墨衬底、金属 衬底、合金衬底、导电树脂衬底等。或者,可以举出包含金属氮化物的衬底、包含金属氧化物 的衬底等。再者,还可以举出设置有导电体或半导体的绝缘体衬底、设置有导电体或绝缘体 17 CN 111587491 A 说 明 书 15/40 页 的半导体衬底、设置有半导体或绝缘体的导电体衬底等。或者,也可以使用在这些衬底上设 置有元件的衬底。作为设置在衬底上的元件,可以举出电容器、电阻器、开关元件、发光元 件、存储元件等。 <绝缘体> 作为绝缘体,有具有绝缘性的氧化物、氮化物、氧氮化物、氮氧化物、金属氧化物、金属 氧氮化物以及金属氮氧化物等。 例如,当进行晶体管的微型化及高集成化时,由于栅极绝缘体的薄膜化,有时发生 泄漏电流等的问题。通过作为被用作栅极绝缘体的绝缘体使用high-k材料,可以在保持物 理厚度的同时实现晶体管工作时的低电压化。另一方面,通过将相对介电常数较低的材料 用于被用作层间膜的绝缘体,可以减少产生在布线之间的寄生电容。因此,优选根据绝缘体 的功能选择材料。 此外,作为相对介电常数较高的绝缘体,可以举出氧化镓、氧化铪、氧化锆、含有铝 及铪的氧化物、含有铝及铪的氧氮化物、含有硅及铪的氧化物、含有硅及铪的氧氮化物或者 含有硅及铪的氮化物等。 另外,作为相对介电常数较低的绝缘体,可以举出氧化硅、氧氮化硅、氮氧化硅、氮 化硅、添加有氟的氧化硅、添加有碳的氧化硅、添加有碳及氮的氧化硅、具有空孔的氧化硅 或树脂等。 此外,通过由具有抑制氢等杂质及氧的透过的功能的绝缘体(绝缘体214、绝缘体 222、绝缘体254及绝缘体274等)围绕使用氧化物半导体的晶体管,可以使晶体管的电特性 稳定。作为具有抑制氢等杂质及氧的透过的功能的绝缘体,例如可以以单层或叠层使用包 含硼、碳、氮、氧、氟、镁、铝、硅、磷、氯、氩、镓、锗、钇、锆、镧、钕、铪或钽的绝缘体。具体而言, 作为具有抑制氢等杂质及氧的透过的功能的绝缘体,可以使用氧化铝、氧化镁、氧化镓、氧 化锗、氧化钇、氧化锆、氧化镧、氧化钕、氧化铪或氧化钽等金属氧化物、氮化铝、氮化铝钛、 氮化钛、氮氧化硅或氮化硅等金属氮化物。 此外,被用作栅极绝缘体的绝缘体优选为具有包含通过加热脱离的氧的区域的绝 缘体。例如,通过采用将具有包含通过加热脱离的氧的区域的氧化硅或者氧氮化硅接触于 氧化物230的结构,可以填补氧化物230所包含的氧空位。 <导电体> 作为导电体,优选使用选自铝、铬、铜、银、金、铂、钽、镍、钛、钼、钨、铪、钒、铌、锰、镁、 锆、铍、铟、钌、铱、锶和镧等中的金属元素、以上述金属元素为成分的合金或者组合上述金 属元素的合金等。例如,优选使用氮化钽、氮化钛、钨、包含钛和铝的氮化物、包含钽和铝的 氮化物、氧化钌、氮化钌、包含锶和钌的氧化物、包含镧和镍的氧化物等。另外,氮化钽、氮化 钛、包含钛和铝的氮化物、包含钽和铝的氮化物、氧化钌、氮化钌、包含锶和钌的氧化物、包 含镧和镍的氧化物是不容易氧化的导电材料或者吸收氧也维持导电性的材料,所以是优选 的。另外,也可以使用以包含磷等杂质元素的多晶硅为代表的导电率高的半导体以及镍硅 化物等硅化物。 另外,也可以层叠多个由上述材料形成的导电层。例如,也可以采用组合包含上述 金属元素的材料和包含氧的导电材料的叠层结构。另外,也可以采用组合包含上述金属元 素的材料和包含氮的导电材料的叠层结构。另外,也可以采用组合包含上述金属元素的材 18 CN 111587491 A 说 明 书 16/40 页 料、包含氧的导电材料和包含氮的导电材料的叠层结构。 此外,在将氧化物用于晶体管的沟道形成区域的情况下,作为被用作栅电极的导 电体优选采用组合包含上述金属元素的材料和包含氧的导电材料的叠层结构。在此情况 下,优选将包含氧的导电材料设置在沟道形成区域一侧。通过将包含氧的导电材料设置在 沟道形成区域一侧,从该导电材料脱离的氧容易被供应到沟道形成区域。 尤其是,作为被用作栅电极的导电体,优选使用含有包含在形成沟道的金属氧化 物中的金属元素及氧的导电材料。此外,也可以使用含有上述金属元素及氮的导电材料。例 如,也可以使用氮化钛、氮化钽等包含氮的导电材料。此外,可以使用铟锡氧化物、包含氧化 钨的铟氧化物、包含氧化钨的铟锌氧化物、包含氧化钛的铟氧化物、包含氧化钛的铟锡氧化 物、铟锌氧化物、添加有硅的铟锡氧化物。此外,也可以使用包含氮的铟镓锌氧化物。通过使 用上述材料,有时可以俘获形成沟道的金属氧化物所包含的氢。或者,有时可以俘获从外方 的绝缘体等进入的氢。 <金属氧化物> 作为氧化物230,优选使用被用作氧化物半导体的金属氧化物。以下,将说明可用于根 据本发明的氧化物230的金属氧化物。 金属氧化物优选至少包含铟或锌。尤其优选包含铟及锌。另外,除此之外,优选还 包含铝、镓、钇或锡等。或者,也可以包含硼、钛、铁、镍、锗、锆、钼、镧、铈、钕、铪、钽、钨或镁 等中的一种或多种。 在此,考虑金属氧化物是包含铟、元素M及锌的In-M-Zn氧化物的情况。注意,元素M 为铝、镓、钇或锡等。作为可用作元素M的其他元素,有硼、钛、铁、镍、锗、锆、钼、镧、铈、钕、 铪、钽、钨、镁等。注意,作为元素M有时也可以组合多个上述元素。 注意,在本说明书等中,有时将包含氮的金属氧化物也称为金属氧化物(metal oxide)。此外,也可以将包含氮的金属氧化物称为金属氧氮化物(metal oxynitride)。 [金属氧化物的结构] 氧化物半导体(金属氧化物)被分为单晶氧化物半导体和非单晶氧化物半导体。作为非 单晶氧化物半导体例如有CAAC - O S (c -a x i s a l ig n ed c ry s ta l l i n e o x id e semiconductor)、多晶氧化物半导体、nc-OS(nanocrystalline oxide semiconductor)、a- like OS(amorphous-like oxide semiconductor)及非晶氧化物半导体等。 CAAC-OS具有c轴取向性,其多个纳米晶在a-b面方向上连结而结晶结构具有畸变。 注意,畸变是指在多个纳米晶连结的区域中晶格排列一致的区域与其他晶格排列一致的区 域之间的晶格排列的方向变化的部分。 虽然纳米晶基本上是六角形,但是并不局限于正六角形,有不是正六角形的情况。 此外,在畸变中有时具有五角形或七角形等晶格排列。另外,在CAAC-OS中,即使在畸变附近 也观察不到明确的晶界(也称为grain boundary)。即,可知由于晶格排列畸变,可抑制晶界 的形成。这是由于CAAC-OS因为a-b面方向上的氧原子排列的低密度或因金属元素被取代而 使原子间的键合距离产生变化等而能够包容畸变。 此外,CAAC-OS趋向于具有层叠有包含铟及氧的层(下面称为In层)和包含元素M、 锌及氧的层(下面称为(M,Zn)层)的层状结晶结构(也称为层状结构)。另外,铟和元素M彼此 可以取代,在用铟取代(M,Zn)层中的元素M的情况下,也可以将该层表示为(In,M,Zn)层。另 19 CN 111587491 A 说 明 书 17/40 页 外,在用元素M取代In层中的铟的情况下,也可以将该层表示为(In,M)层。 CAAC-OS是结晶性高的金属氧化物。另一方面,在CAAC-OS中不容易观察明确的晶 界,因此可以说不容易发生起因于晶界的电子迁移率的下降。此外,金属氧化物的结晶性有 时因杂质的进入或缺陷的生成等而降低,因此可以说CAAC-OS是杂质或缺陷(氧空位等)少 的金属氧化物。因此,包含CAAC-OS的金属氧化物的物理性质稳定。因此,包含CAAC-OS的金 属氧化物具有高耐热性及高可靠性。 在nc-OS中,微小的区域(例如1nm以上且10nm以下的区域,特别是1nm以上且3nm以 下的区域)中的原子排列具有周期性。另外,nc-OS在不同的纳米晶之间观察不到结晶取向 的规律性。因此,在膜整体中观察不到取向性。所以,有时nc-OS在某些分析方法中与a-like OS或非晶氧化物半导体没有差别。 另外,在包含铟、镓和锌的金属氧化物的一种的铟-镓-锌氧化物(以下,IGZO)是上 述纳米晶时可能具有稳定的结构。尤其是,IGZO有在大气中不容易进行晶体生长的倾向,所 以与在IGZO是大结晶(在此,几mm的结晶或者几cm的结晶)时相比在IGZO是小结晶(例如,上 述纳米结晶)时可能在结构上稳定。 a-like OS是具有介于nc-OS与非晶氧化物半导体之间的结构的金属氧化物。a- like OS包含空洞或低密度区域。也就是说,a-like OS的结晶性比nc-OS及CAAC-OS的结晶 性低。 氧化物半导体(金属氧化物)具有各种结构及各种特性。本发明的一个方式的氧化 物半导体也可以包括非晶氧化物半导体、多晶氧化物半导体、a-like OS、nc-OS、CAAC-OS中 的两种以上。 [杂质] 在此,说明金属氧化物中的各杂质的影响。 另外,当金属氧化物包含碱金属或碱土金属时,有时形成缺陷态而形成载流子。因 此,作为沟道形成区域使用包含碱金属或碱土金属的金属氧化物的晶体管容易具有常开启 特性。由此,优选减少金属氧化物中的碱金属或碱土金属的浓度。具体而言,使通过SIMS测 得的金属氧化物中的碱金属或碱土金属的浓度(通过二次离子质谱分析法(SIMS: Secondary Ion Mass Spectrometry)测得的浓度)为1×1018atoms/cm3以下,优选为2× 1016atoms/cm3以下。 包含在金属氧化物中的氢与键合于金属原子的氧起反应生成水,因此有时形成氧 空位。当氢进入该氧空位时,有时产生作为载流子的电子。另外,有时由于氢的一部分与键 合于金属原子的氧键合,产生作为载流子的电子。因此,使用包含氢的金属氧化物的晶体管 容易具有常开启特性。 由此,优选尽可能减少金属氧化物中的氢。具体而言,在金属氧化物中,将利用 SIMS测得的氢浓度设定为低于1×1020atoms/cm3,优选低于1×1019atoms/cm3,更优选低于5 ×1018atoms/cm3,进一步优选低于1×1018atoms/cm3。通过将杂质被充分降低的金属氧化物 用于晶体管的沟道形成区域,可以使晶体管具有稳定的电特性。 作为用于晶体管的半导体的金属氧化物,优选使用结晶性高的薄膜。通过使用该 薄膜可以提高晶体管的稳定性或可靠性。作为该薄膜,例如,可以举出单晶金属氧化物薄膜 或多晶金属氧化物薄膜。但是,在衬底上形成单晶金属氧化物薄膜或多晶金属氧化物薄膜 20 CN 111587491 A 说 明 书 18/40 页 需要进行高温或激光加热的工序。因此,制造工序的成本变高且处理量下降。 非专利文献1及非专利文献2中报告了2009年发现了具有CAAC结构的In-Ga-Zn氧 化物(也称为CAAC-IGZO)。在非专利文献1及非专利文献2中,报告了CAAC-IGZO具有c轴取向 性、晶界不明确、可以低温形成在衬底上。另外,还报告了使用CAAC-IGZO的晶体管具有优良 的电特性及可靠性。 另外,2013年发现了具有nc结构的In-Ga-Zn氧化物(称为nc-IGZO)(参照非专利文 献3)。在此报告了nc-IGZO在微小的区域(例如,1nm以上且3nm以下的区域)中的原子排列具 有周期性,在不同区域间观察不到结晶取向的规律性。 非专利文献4及非专利文献5示出分别对上述CAAC-IGZO、nc-IGZO及结晶性低的 IGZO的薄膜照射电子束时的平均结晶尺寸的推移。在结晶性低的IGZO薄膜中,在对其照射 电子束之前就能够观察到1nm左右的结晶性IGZO。因此,在此报告了在IGZO中没能确认到完 全的非晶结构(completely amorphous structure)的存在。再者,公开了与结晶性低的 IGZO薄膜相比CAAC-IGZO薄膜及nc-IGZO薄膜的相对于电子束照射的稳定性较高。因此,作 为晶体管的半导体优选使用CAAC-IGZO薄膜或nc-IGZO薄膜。 非专利文献6公开了使用金属氧化物的晶体管在非导通状态下的泄漏电流极低, 具体而言,晶体管的每沟道宽度1μm的关态电流为yA/μm(10-24A/μm)等级(order)。例如,已 公开了一种应用了使用金属氧化物的晶体管的泄漏电流低这一特性的低功耗CPU等(参照 非专利文献7)。 另外,还有利用使用金属氧化物的晶体管的泄漏电流低这一特性将该晶体管应用 于显示装置的报告(参照非专利文献8)。在显示装置中,显示图像在1秒间被切换数十次。每 1秒钟的图像切换次数被称为刷新频率。另外,刷新频率有时被称为驱动频率。这样的人眼 难以识别的高速画面切换被认为是导致眼睛疲劳的原因。于是,提出了降低显示装置的刷 新频率以减少图像改写次数的技术。另外,刷新频率得到降低的驱动可以降低显示装置的 功耗。将该驱动方法称为空转停止(IDS)驱动。 CAAC结构及nc结构的发现有助于使用CAAC结构或具有nc结构的金属氧化物的晶 体管的电特性及可靠性的提高、制造工序的成本的降低以及处理量的提高。另外,已进行利 用上述晶体管的泄漏电流低这一特性将该晶体管应用于显示装置及LSI的研究。 <半导体装置的制造方法> 接着,参照图4A至图11C说明图1A至图1C所示的包括根据本发明的晶体管200的半导体 装置的制造方法。在图4A至图11C中,每个附图中的A示出俯视图。另外,每个附图中的B示出 沿着A中的点划线A1-A2的部分的截面图,该截面图相当于晶体管200的沟道长度方向上的 截面图。每个附图中的C示出沿着A中的点划线A3-A4的部分的截面图,该截面图相当于晶体 管200的沟道宽度方向上的截面图。为了明确起见,在每个附图中的A的俯视图中省略部分 构成要素。 首先,准备衬底(未图示),在该衬底上形成绝缘体214。绝缘体214可以利用溅射 法、化学气相沉积(CVD:Chemical Vapor Deposition)法、分子束外延(MBE:Molecular Beam Epitaxy)法、脉冲激光沉积(PLD:Pulsed Laser Deposition)法或ALD(原子层沉积: Atomic Layer Deposition)法等形成。 注意,CVD法可以分为利用等离子体的等离子体CVD(PECVD:Plasma Enhanced 21 CN 111587491 A 说 明 书 19/40 页 CVD)法、利用热的热CVD(TCVD:Thermal CVD)法、利用光的光CVD(Photo CVD)法等。再者, CVD法可以根据使用的源气体分为金属CVD(MCVD:Metal CVD)法及有机金属CVD(MOCVD: Metal Organic CVD)法。 通过利用等离子体CVD法,可以以较低的温度得到高品质的膜。另外,因为不使用 等离子体,热CVD法是能够减少对被处理物造成的等离子体损伤的成膜方法。例如,包括在 半导体装置中的布线、电极、元件(晶体管、电容器等)等有时因从等离子体接收电荷而会产 生电荷积聚(charge up)。此时,有时由于所累积的电荷而使包括在半导体装置中的布线、 电极、元件等受损伤。另一方面,因为在不使用等离子体的热CVD法的情况下不产生上述等 离子体损伤,所以能够提高半导体装置的成品率。另外,在热CVD法中,不产生成膜时的等离 子体损伤,因此能够得到缺陷较少的膜。 另外,ALD法可以利用作为原子的性质的自调节性来沉积每一层的原子,从而发挥 能够形成极薄的膜、能够对纵横比高的结构形成膜、能够以针孔等的缺陷少的方式形成膜、 能够形成覆盖性优良的膜及能够在低温下形成膜等的效果。此外,ALD法还包括利用等离子 体的成膜方法(PEALD(Plasma Enhanced ALD)法)。通过利用等离子体,可以在更低温下进 行成膜,所以有时是优选的。注意,ALD法中使用的前驱物有时包含碳等杂质。因此,利用ALD 法形成的膜有时与利用其他的成膜方法形成的膜相比包含更多的碳等杂质。另外,杂质的 定量可以利用X射线光电子能谱(XPS:X-ray Photoelectron Spectroscopy)进行。 不同于使从靶材等中被释放的粒子沉积的成膜方法,CVD法及ALD法是因被处理物 表面的反应而形成膜的成膜方法。因此,通过CVD法及ALD法形成的膜不易受被处理物的形 状的影响而具有良好的台阶覆盖性。尤其是,利用ALD法形成的膜具有良好的台阶覆盖性和 厚度均匀性,所以ALD法适合用于要覆盖纵横比高的开口的表面的情况等。注意,ALD法的成 膜速度比较慢,所以有时优选与CVD法等成膜速度快的其他成膜方法组合而使用。 CVD法及ALD法可以通过调整源气体的流量比控制所得到的膜的组成。例如,当使 用CVD法或ALD法时,可以通过调整源气体的流量比形成任意组成的膜。此外,例如,当使用 CVD法及ALD法时,可以通过一边形成膜一边改变源气体的流量比来形成其组成连续变化的 膜。在一边改变源气体的流量比一边形成膜时,因为不需要传送及调整压力所需的时间,所 以与使用多个成膜室进行成膜的情况相比可以缩短成膜时间。因此,有时可以提高半导体 装置的生产率。 在本实施方式中,作为绝缘体214利用CVD法形成氮化硅。如此,通过作为绝缘体 214使用氮化硅等不容易使铜透过的绝缘体,即使作为绝缘体214的下方的层(未图示)的导 电体使用铜等容易扩散的金属,也可以抑制该金属扩散到绝缘体214的上方的层。 接着,在绝缘体214上形成成为导电体205的导电膜。成为导电体205的导电膜的成 膜使用溅射法、CVD法、MBE法、PLD法或ALD法等进行。此外,成为导电体205的导电膜可以为 多层膜。在本实施方式中,作为成为导电体205的导电膜,形成钨。 接着,使用光刻法对成为导电体205的导电膜进行加工来形成导电体205。 另外,在光刻法中,首先通过掩模对抗蚀剂进行曝光。接着,使用显影液去除或留 下所曝光的区域而形成抗蚀剂掩模。接着,隔着该抗蚀剂掩模进行蚀刻处理来将导电体、半 导体或绝缘体等加工为所希望的形状。例如,使用KrF受激准分子激光、ArF受激准分子激 光、EUV(Extreme Ultraviolet:极紫外)光等对抗蚀剂进行曝光来形成抗蚀剂掩模,即可。 22 CN 111587491 A 说 明 书 20/40 页 此外,也可以利用在衬底和投影透镜之间填满液体(例如,水)的状态下进行曝光的液浸技 术。另外,也可以使用电子束或离子束代替上述光。注意,当使用电子束或离子束时不需要 掩模。另外,在去除抗蚀剂掩模时,可以进行灰化处理等干蚀刻处理或湿蚀刻处理,也可以 在进行干蚀刻处理之后进行湿蚀刻处理,又可以在进行湿蚀刻处理之后进行干蚀刻处理。 或者,可以使用由绝缘体或导电体构成的硬掩模代替抗蚀剂掩模。当使用硬掩模 时,可以在成为导电体205的导电膜上形成成为硬掩模材料的绝缘膜或导电膜且在其上形 成抗蚀剂掩模,然后对硬掩模材料进行蚀刻来形成所希望的形状的硬掩模。对成为导电体 205的导电膜进行的蚀刻既可以在去除抗蚀剂掩模后进行,又可以不去除抗蚀剂掩模进行。 在采用后者的情况下,进行蚀刻时有时抗蚀剂掩模消失。也可以在成为导电体205的导电膜 的蚀刻之后,通过蚀刻去除硬掩模。另一方面,在硬掩模材料没有影响到后工序或者可以在 后工序中使用的情况下,不一定要去除硬掩模。 作为干蚀刻装置,可以使用包括平行平板型电极的电容耦合型等离子体(CCP: Capacitively Coupled Plasma)蚀刻装置。包括平行平板型电极的电容耦合型等离子体蚀 刻装置也可以采用对平行平板型电极中的一个施加高频功率的结构。或者,也可以采用对 平行平板型电极中的一个施加不同的多个高频功率的结构。或者,也可以采用对平行平板 型电极的各个施加频率相同的高频功率的结构。或者,也可以采用对平行平板型电极的各 个施加频率不同的高频功率的结构。或者,也可以利用具有高密度等离子体源的干蚀刻装 置。例如,作为具有高密度等离子体源的干蚀刻装置,可以使用感应耦合等离子体(ICP: Inductively Coupled Plasma)蚀刻装置等。 接着,在绝缘体214、导电体205上形成成为绝缘体216的绝缘膜。绝缘体216可以利 用溅射法、CVD法、MBE法、PLD法或ALD法等形成。在本实施方式中,作为成为绝缘体216的绝 缘膜利用CVD法形成氧化硅。 在此,成为绝缘体216的绝缘膜的厚度优选为导电体205的厚度以上。例如,当导电 体205厚度为1时,成为绝缘体216的绝缘膜的厚度为1以上且3以下。在本实施方式中,导电 体205的厚度为150nm,成为绝缘体216的绝缘膜的厚度为350nm。 接着,通过对成为绝缘体216的绝缘膜进行CMP (Chemical Mechanical Polishing:化学机械抛光)处理去除成为绝缘体216的绝缘膜的一部分,使导电体205的表 面露出。由此,可以形成其顶面平坦的导电体205及绝缘体216(参照图4A至图4C)。 以下,将说明与上述内容不同的导电体205的形成方法。 在绝缘体214上形成绝缘体216。可以利用溅射法、CVD法、MBE法、PLD法或ALD法等 形成绝缘体216。 接着,在绝缘体216中形成到达绝缘体214的开口。开口例如包括槽或狭缝等。此 外,有时将形成有开口的区域称为开口部。在形成该开口时,可以使用湿蚀刻法,但是对微 型加工来说干蚀刻法是优选的。作为绝缘体214,优选选择在对绝缘体216进行蚀刻以形成 槽时用作蚀刻停止膜的绝缘体。例如,当作为形成槽的绝缘体216使用氧化硅膜时,绝缘体 214优选使用氮化硅膜、氧化铝膜、氧化铪膜。 在形成开口后,形成成为导电体205的导电膜。该导电膜优选包含具有抑制氧的透 过的功能的导电体。例如,可以使用氮化钽、氮化钨、氮化钛等。或者,可以使用该导电体与 钽、钨、钛、钼、铝、铜或钼钨合金的叠层膜。成为导电体205的导电膜可以利用溅射法、CVD 23 CN 111587491 A 说 明 书 21/40 页 法、MBE法、PLD法或ALD法等形成。 在本实施方式中,作为成为导电体205的导电膜,采用多层结构。首先,利用溅射法 进行氮化钽的成膜,在该氮化钽上层叠氮化钛。通过将这种金属氮化物用于成为导电体205 的导电膜的下层,即使作为后面说明的成为导电体205的导电膜的上层的导电膜使用铜等 容易扩散的金属,也可以抑制该金属从导电体205扩散到外部。 接着,形成成为导电体205的导电膜的上层的导电膜。该导电膜可以使用镀敷法、 溅射法、CVD法、MBE法、PLD法或ALD法等形成。在本实施方式中,作为成为导电体205的导电 膜的上层的导电膜,形成铜等低电阻导电材料。 接着,通过进行CMP处理,去除成为导电体205的导电膜的上层以及成为导电体205 的导电膜的下层的一部分,使绝缘体216露出。其结果是,只在开口残留成为导电体205的导 电膜。由此,可以形成其顶面平坦的导电体205。注意,有时由于该CMP处理而绝缘体216的一 部分被去除。以上是与上述内容不同的导电体205的形成方法。 接着,在绝缘体216及导电体205上形成绝缘体222。作为绝缘体222,优选形成包含 铝和铪中的一方或双方的氧化物的绝缘体。另外,作为包含铝和铪中的一方或双方的氧化 物的绝缘体,优选使用氧化铝、氧化铪、包含铝及铪的氧化物(铝酸铪)等。包含铝和铪中的 一方或双方的氧化物的绝缘体对氧、氢及水具有阻挡性。当绝缘体222对氢及水具有阻挡性 时,可以抑制晶体管200的周围的结构体所包含的氢及水通过绝缘体222扩散到晶体管200 的内侧,从而可以抑制氧化物230中的氧空位的生成。 绝缘体222可以通过溅射法、CVD法、MBE法、PLD法或ALD法等形成。 接着,在绝缘体222上形成成为绝缘体224的绝缘膜。成为绝缘体224的绝缘膜可以 通过溅射法、CVD法、MBE法、PLD法或ALD法等形成。 接着,优选进行加热处理。加热处理以250℃以上且650℃以下,优选以300℃以上 且500℃以下,更优选以320℃以上且450℃以下进行即可。加热处理在氮或惰性气体气氛或 者包含10ppm以上、1%以上或10%以上的氧化性气体的气氛下进行。加热处理也可以在减 压状态下进行。或者,加热处理也可以在氮或惰性气体气氛下进行加热处理,然后为了填补 脱离了的氧在包含10ppm以上、1%以上或10%以上的氧化性气体的气氛下进行加热处理。 在本实施方式中,在氮气氛下以400℃的温度进行1小时的处理,接下来连续地在 氧气氛下以400℃的温度进行1小时的处理。通过进行该加热处理,可以去除绝缘体224所包 含的水、氢等杂质。 另外,也可以在形成绝缘体222之后进行加热处理。该加热处理可以采用上述加热 处理的条件。 在此,为了在绝缘体224中形成过剩氧区域,也可以在减压状态下进行包含氧的等 离子体处理。包含氧的等离子体处理例如优选采用包括用来产生使用微波的高密度等离子 体的电源的装置。或者,也可以包括对衬底一侧施加RF(Radio Frequency:射频)的电源。通 过使用高密度等离子体可以生成高密度氧自由基,且通过对衬底一侧施加RF可以将由高密 度等离子体生成的氧自由基高效地导入绝缘体224中。或者,也可以在使用这种装置进行包 含惰性气体的等离子体处理之后,为填补脱离的氧而进行包含氧的等离子体处理。另外,通 过适当地选择该等离子体处理的条件,可以去除绝缘体224所包含的水、氢等杂质。此时,也 可以不进行加热处理。 24 CN 111587491 A 说 明 书 22/40 页 在此,也可以在绝缘体224上例如通过溅射法进行氧化铝的成膜,并对该氧化铝进 行CMP处理直到到达绝缘体224为止。通过进行该CMP,可以进行绝缘体224表面的平坦化及 绝缘体224表面的平滑化。通过将该氧化铝配置于绝缘体224上进行CMP,容易检测出CMP的 终点。此外,有时由于绝缘体224的一部分通过CMP被抛光而绝缘体224的厚度变薄,但是在 绝缘体224的成膜时调整厚度,即可。通过进行绝缘体224表面的平坦化及平滑化,有时可以 防止下面进行成膜的氧化物的覆盖率的降低并防止半导体装置的成品率的降低。此外,通 过在绝缘体224上利用溅射法进行氧化铝的成膜,可以对绝缘体224添加氧,所以是优选的。 接着,在绝缘体224上依次形成成为氧化物230a的氧化膜230A以及成为氧化物 230b的氧化膜230B(参照图4A至图4C)。优选在不暴露于大气环境的情况下连续地形成上述 氧化膜。通过以不暴露于大气的方式形成氧化膜,可以防止来自大气环境的杂质或水分附 着于氧化膜230A及氧化膜230B,所以可以保持氧化膜230A与氧化膜230B的界面附近的清 洁。 氧化膜230A及氧化膜230B可以利用溅射法、CVD法、MBE法、PLD法或ALD法等形成。 例如,在利用溅射法形成氧化膜230A以及氧化膜230B的情况下,作为溅射气体使 用氧或者氧和稀有气体的混合气体。通过增高溅射气体所包含的氧的比率,可以增加在形 成的氧化膜中的过剩氧。另外,在利用溅射法形成上述氧化膜的情况下,例如可以使用上述 In-M-Zn氧化物靶材。 尤其是,在形成氧化膜230A时,有时溅射气体所包含的氧的一部分供应给绝缘体 224。因此,氧化膜230A的溅射气体所包含的氧的比率可以为70%以上,优选为80%以上,更 优选为100%。 此外,在利用溅射法形成氧化膜230B的情况下,当在溅射气体所包含的氧的比率 设定为1%以上且30%以下,优选为5%以上且20%以下的状态下进行成膜时,形成氧缺乏 型氧化物半导体。将氧缺乏型氧化物半导体用于沟道形成区域的晶体管可以具有较高的场 效应迁移率。 在本实施方式中,利用溅射法使用In:Ga:Zn=1:1:0.5[原子个数比](2:2:1[原子 个数比])或1:3:4[原子个数比]的靶材形成氧化膜230A。另外,利用溅射法使用In:Ga:Zn= 4:2:4.1[原子个数比]的靶材形成氧化膜230B。上述氧化膜可以根据氧化物230所需的特性 适当地选择成膜条件及原子个数比来形成。 接着,也可以进行加热处理。作为加热处理的条件,可以利用上述加热处理条件。 通过进行加热处理,可以去除氧化膜230A以及氧化膜230B中的水、氢等杂质。在本实施方式 中,在氮气氛下以400℃的温度进行1小时的处理,接下来连续地在氧气氛下以400℃的温度 进行1小时的处理。 [0200] 接着,在氧化膜230B上形成导电膜242A。可以利用溅射法、CVD法、MBE法、PLD法或 ALD法等形成导电膜242A(参照图4A至图4C)。 [0201] 接着,将氧化膜230A、氧化膜230B及导电膜242A加工为岛状,来形成氧化物230a、 氧化物230b及导电体层242B。另外,在该工序中,有时绝缘体224中的不与氧化物230a重叠 的区域的厚度变薄(参照图5A至图5C)。 [0202] 在此,氧化物230a、氧化物230b及导电体层242B以其至少一部分与导电体205重叠 的方式形成。此外,氧化物230a、氧化物230b及导电体层242B的侧面优选对绝缘体222的顶 25 CN 111587491 A 说 明 书 23/40 页 面大致垂直。在氧化物230a、氧化物230b及导电体层242B的侧面对绝缘体222的顶面大致垂 直时,当设置多个晶体管200时能够实现小面积化、高密度化。或者,也可以采用氧化物 230a、氧化物230b及导电体层242B与绝缘体222的顶面所形成的角度较低的结构。在此情况 下,氧化物230a、氧化物230b及导电体层242B的侧面与绝缘体222的顶面所形成的角度优选 为60°以上且低于70°。通过采用这种形状,在下面的工序中提高绝缘体273等的覆盖性,并 可以减少空洞等缺陷。 [0203] 此外,在导电体层242B的侧面与导电体层242B的顶面之间具有弯曲面。就是说,侧 面的端部和顶面的端部优选弯曲(以下,也称为圆形)。例如,在导电体层242B的端部,该弯 曲面具有3nm以上且10nm以下,更优选为5nm以上且6nm以下的曲率半径。当端部不具有角部 时,可以提高后面的成膜工序中的膜的覆盖性。 [0204] 另外,该氧化膜及导电膜的加工可以利用光刻法进行。另外,作为该加工可以利用 干蚀刻法或湿蚀刻法。利用干蚀刻法的加工适用于微型加工。 [0205] 接着,在绝缘体224、氧化物230a、氧化物230b及导电体层242B上形成绝缘膜254A (参照图6A至图6C)。 [0206] 作为绝缘膜254A,优选使用具有抑制氧的透过的功能的绝缘膜。例如,优选通过溅 射法形成氧化铝膜。通过采用溅射法并使用包含氧的气体形成氧化铝膜,可以对绝缘体224 中引入氧。换言之,绝缘体224可以具有过剩氧。 [0207] 接着,在绝缘膜254A上形成成为绝缘体280的绝缘膜。成为绝缘体280的绝缘膜可 以利用溅射法、CVD法、MBE法、PLD法或ALD法等形成。接着,对成为绝缘体280的绝缘膜进行 CMP处理来形成顶面平坦的绝缘体280(参照图6A至图6C)。 [0208] 接着,对绝缘体280的一部分、绝缘膜254A的一部分及导电体层242B的一部分进行 加工来形成到达氧化物230b的开口。该开口优选以与导电体205重叠的方式形成。由该开口 形成导电体242a、导电体242b及绝缘体254(参照图7A至图7C)。 [0209] 此外,也可以以不同的条件对绝缘体280的一部分、绝缘膜254A的一部分及导电体 的一部分进行加工。例如,也可以通过干蚀刻法对绝缘体280的一部分进行加工,通过湿蚀 刻法对绝缘膜254A的一部分进行加工,并通过干蚀刻法对导电体层242B的一部分进行加 工。 [0210] 通过进行上述干蚀刻等的处理,有时起因于蚀刻气体等的杂质附着于或扩散于氧 化物230a及氧化物230b等的表面或内部。作为杂质,例如有氟或氯等。 [0211] 为了去除上述杂质等,进行洗涤。作为洗涤方法,有使用洗涤液等的湿式洗涤、使 用等离子体的等离子处理以及使用加热处理的洗涤等,也可以适当地组合上述洗涤。 [0212] 作为湿式洗涤,可以使用用碳酸水或纯水稀释草酸、磷酸或氢氟酸等而成的水溶 液进行洗涤处理。或者,可以使用纯水或碳酸水进行超声波洗涤。 [0213] 接着,也可以进行加热处理。加热处理也可以在减压下进行,并其中以不暴露于大 气的方式连续地形成氧化膜230C。通过进行这种处理,可以去除附着于氧化物230b的表面 等的水分及氢,而且减少氧化物230a及氧化物230b中的水分浓度及氢浓度。加热处理的温 度优选为100℃以上且400℃以下。在本实施方式中,加热处理的温度为200℃(参照图8A至 图8C)。 [0214] 氧化膜230C可以使用溅射法、CVD法、MBE法、PLD法或ALD法等形成。成为氧化膜 26 CN 111587491 A 说 明 书 24/40 页 230C的氧化膜可以根据氧化膜230C所需的特性利用与氧化膜230A或氧化膜230B相同的成 膜方法形成。在本实施方式中,利用溅射法使用In:Ga:Zn=1:3:4[原子个数比]或4:2:4.1 [原子个数比]的靶材形成氧化膜230C。 [0215] 尤其是,在形成氧化膜230C时,有时溅射气体所包含的氧的一部分供应给氧化物 230a及氧化物230b。因此,氧化膜230C的溅射气体所包含的氧的比率可以为70%以上,优选 为80%以上,更优选为100%。 [0216] 接着,也可以进行加热处理。加热处理也可以在减压下进行,并其中以不暴露于大 气的方式连续地形成绝缘膜250A。通过进行这种处理,可以去除附着于氧化膜230C的表面 等的水分及氢,而且减少氧化物230a、氧化物230b及氧化膜230C中的水分浓度及氢浓度。加 热处理的温度优选为100℃以上且400℃以下(参照图9A至图9C)。 [0217] 绝缘膜250A可以利用溅射法、CVD法、MBE法、PLD法或ALD法等形成。作为绝缘膜 250A,优选利用CVD法形成氧氮化硅。形成绝缘膜250A时的成膜温度优选为350℃以上且低 于450℃,尤其优选为400℃左右。通过以400℃的温度形成绝缘膜250A,可以形成杂质少的 绝缘体。 [0218] 接着,形成导电膜260Aa及导电膜260Ab。可以利用溅射法、CVD法、MBE法、PLD法或 ALD法等形成导电膜260Aa及导电膜260Ab。例如,优选利用CVD法。在本实施方式中,利用ALD 法形成导电膜260Aa,利用CVD法形成导电膜260Ab(参照图10A至图10C)。 [0219] 接着,通过利用CMP处理直到绝缘体280露出为止对氧化膜230C、绝缘膜250A、导电 膜260Aa及导电膜260Ab进行抛光,形成氧化物230c、绝缘体250及导电体260(导电体260a及 导电体260b)(参照图11A至图11C)。 [0220] 接着,也可以进行加热处理。在本实施方式中,在氮气氛下以400℃的温度进行1小 时的处理。通过该加热处理,可以减少绝缘体250及绝缘体280中的水分浓度及氢浓度。 [0221] 接着,也可以在绝缘体280上形成成为绝缘体274的绝缘膜。可以利用溅射法、CVD 法、MBE法、PLD法、或ALD法等形成成为绝缘体274的绝缘膜。作为成为绝缘体274的绝缘膜, 例如,优选通过溅射法形成氧化铝膜。通过利用溅射法形成氧化铝膜,有时可以抑制绝缘体 280所具有的氢扩散到绝缘体250及氧化物230(参照图11A至图11C)。 [0222] 接着,也可以进行加热处理。在本实施方式中,在氮气氛下以400℃的温度进行1小 时的处理。通过进行该加热处理,可以将通过绝缘体274的成膜添加的氧注入到绝缘体250 及绝缘体280中。 [0223] 接着,也可以在绝缘体274上形成成为绝缘体281的绝缘体。可以通过溅射法、CVD 法、MBE法、PLD法或ALD法等形成成为绝缘体281的绝缘膜(参照图11A至图11C)。 [0224] 接着,在绝缘体254、绝缘体280、绝缘体274及绝缘体281中形成到达导电体242a及 导电体242b的开口。使用光刻法形成该开口,即可。 [0225] 接着,形成成为绝缘体241的绝缘膜,并对该绝缘膜进行各向异性蚀刻来形成绝缘 体241。可以利用溅射法、CVD法、MBE法、PLD法或ALD法等形成该绝缘膜。作为成为绝缘体241 的绝缘膜,优选使用具有抑制氧的透过的功能的绝缘膜。例如,优选通过ALD法形成氧化铝 膜。此外,作为各向异性蚀刻,例如进行干蚀刻法等,即可。通过使开口的侧壁部具有这种结 构,可以抑制来自外部的氧的透过,并防止接下来要形成的导电体240a及导电体240b的氧 化。此外,可以防止水、氢等杂质从导电体240a及导电体240b扩散到外部。 27 CN 111587491 A 说 明 书 25/40 页 [0226] 接着,形成成为导电体240a及导电体240b的导电膜。成为导电体240a及导电体 240b的导电膜优选是包含具有抑制水、氢等杂质的透过的功能的导电体的叠层结构。例如, 可以是氮化钽、氮化钛等和钨、钼、铜等的叠层。成为导电体240的导电膜可以利用溅射法、 CVD法、MBE法、PLD法或ALD法等形成。 [0227] 接着,通过进行CMP处理,去除成为导电体240a及导电体240b的导电膜的一部分, 使绝缘体281露出。其结果是,只在上述开口残留该导电膜,由此可以形成其顶面平坦的导 电体240a及导电体240b(参照图1A至图1C)。注意,有时由于该CMP处理而绝缘体281的一部 分被去除。 [0228] 通过上述工序,可以制造包括图1A至图1C所示的晶体管200的半导体装置。如图4A 至图11C所示,通过使用本实施方式所示的半导体装置的制造方法可以制造晶体管200。 [0229] 通过本发明的一个方式,可以提供一种通态电流大的半导体装置。另外,通过本发 明的一个方式,可以提供一种具有高频率特性的半导体装置。另外,通过本发明的一个方 式,可以提供一种可靠性良好的半导体装置。另外,通过本发明的一个方式,可以提供一种 能够实现微型化或高集成化的半导体装置。另外,通过本发明的一个方式,可以提供一种具 有良好的电特性的半导体装置。另外,通过本发明的一个方式,可以提供关态电流小的半导 体装置。另外,通过本发明的一个方式,可以提供功耗得到降低的半导体装置。另外,通过本 发明的一个方式,可以提供一种生产率高的半导体装置。 [0230] 以上,本实施方式所示的结构、方法等可以与其他实施方式所示的结构、方法等适 当地组合而实施。 [0231] (实施方式2) 在本实施方式中,参照图12及图13说明半导体装置的一个方式。 [0232] [存储装置1] 图12示出使用作为本发明的一个方式的电容器的半导体装置(存储装置)的一个例子。 在本发明的一个方式的半导体装置中,晶体管200设置在晶体管300的上方,电容器100设置 在晶体管300及晶体管200的上方。此外,作为晶体管200,可以使用上述实施方式所说明的 晶体管200。 [0233] 晶体管200是其沟道形成在包含氧化物半导体的半导体层中的晶体管。因为晶体 管200的关态电流小,所以通过将其用于存储装置,可以长期保持存储内容。换言之,由于不 需要刷新工作或刷新工作的频度极低,所以可以充分降低存储装置的功耗。 [0234] 在图12所示的半导体装置中,布线1001与晶体管300的源极电连接,布线1002与晶 体管300的漏极电连接。另外,布线1003与晶体管200的源极和漏极中的一个电连接,布线 1004与晶体管200的第一栅极电连接,布线1006与晶体管200的第二栅极电连接。再者,晶体 管300的栅极及晶体管200的源极和漏极中的另一个与电容器100的一个电极电连接,布线 1005与电容器100的另一个电极电连接。 [0235] 此外,通过将图12所示的存储装置配置为矩阵状,可以构成存储单元阵列。 [0236] <晶体管300> 晶体管300设置在衬底311上,并包括:用作栅电极的导电体316、用作栅电极的绝缘体 315、由衬底311的一部分构成的半导体区域313;以及用作源区域或漏区域的低电阻区域 314a及低电阻区域314b。晶体管300可以是p沟道型或n沟道型。 28 CN 111587491 A 说 明 书 26/40 页 [0237] 在此,在图12所示的晶体管300中,形成沟道的半导体区域313(衬底311的一部分) 具有凸形状。另外,以隔着绝缘体315覆盖半导体区域313的侧面及顶面的方式设置导电体 316。另外,导电体316可以使用调整功函数的材料。因为利用半导体衬底的凸部,所以这种 晶体管300也被称为FIN型晶体管。另外,也可以以与凸部的上表面接触的方式具有用来形 成凸部的掩模的绝缘体。此外,虽然在此示出对半导体衬底的一部分进行加工来形成凸部 的情况,但是也可以对SOI衬底进行加工来形成具有凸部的半导体膜。 [0238] 注意,图12所示的晶体管300的结构只是一个例子,不局限于上述结构,根据电路 结构或驱动方法使用适当的晶体管即可。 [0239] <电容器100> 在电容器100设置在晶体管200的上方。电容器100包括用作第一电极的导电体110、用 作第二电极的导电体120及用作介电质的绝缘体130。 [0240] 此外,例如,也可以同时形成设置在导电体246上的导电体112及导电体110。另外, 导电体112用作与电容器100、晶体管200或晶体管300电连接的插头或者布线。 [0241] 在图12中,导电体112及导电体110具有单层结构,但是不局限于该结构,也可以具 有两层以上的叠层结构。例如,也可以在具有阻挡性的导电体与导电性高的导电体之间形 成与具有阻挡性的导电体以及导电性高的导电体之间的紧密性高的导电体。 [0242] 此外,绝缘体130例如可以使用氧化硅、氧氮化硅、氮氧化硅、氮化硅、氧化铝、氧氮 化铝、氮氧化铝、氮化铝、氧化铪、氧氮化铪、氮氧化铪、氮化铪等,并以叠层或单层设置。 [0243] 例如,绝缘体130优选使用氧氮化硅等介电强度高的材料和高介电常数(high-k) 材料的叠层结构。通过采用该结构,电容器100可以包括高介电常数(high-k)的绝缘体来确 保充分的电容,并可以包括介电强度高的绝缘体来提高介电强度,从而可以抑制电容器100 的静电破坏。 [0244] 注意,作为高介电常数(high-k)材料(相对介电常数高的材料)的绝缘体,有氧化 镓、氧化铪、氧化锆、具有铝及铪的氧化物、具有铝及铪的氧氮化物、具有硅及铪的氧化物、 具有硅及铪的氧氮化物或具有硅及铪的氮化物等。 [0245] 另一方面,作为介电强度高的材料(相对介电常数低的材料),有氧化硅、氧氮化 硅、氮氧化硅、氮化硅、添加有氟的氧化硅、添加有碳的氧化硅、添加有碳及氮的氧化硅、具 有空孔的氧化硅或树脂等。 [0246] <布线层> 在各结构体之间也可以设置有包括层间膜、布线及插头等的布线层。此外,布线层可以 根据设计而设置为多个层。在此,在具有插头或布线的功能的导电体中,有时使用同一附图 标记表示多个结构。此外,在本说明书等中,布线、与布线电连接的插头也可以是一个构成 要素。就是说,导电体的一部分有时被用作布线,并且导电体的一部分有时被用作插头。 [0247] 例如,在晶体管300上,作为层间膜依次层叠地设置有绝缘体320、绝缘体322、绝缘 体324及绝缘体326。此外,与电容器100或晶体管200电连接的导电体328及导电体330等填 埋于绝缘体320、绝缘体322、绝缘体324及绝缘体326中。另外,导电体328及导电体330被用 作插头或布线。 [0248] 此外,用作层间膜的绝缘体可以被用作覆盖其下方的凹凸形状的平坦化膜。例如, 为了提高绝缘体322的顶面的平坦性,也可以通过利用化学机械抛光(CMP)法等的平坦化处 29 CN 111587491 A 说 明 书 27/40 页 理实现平坦化。 [0249] 也可以在绝缘体326及导电体330上设置布线层。例如,在图12中,依次层叠有绝缘 体350、绝缘体352及绝缘体354。另外,在绝缘体350、绝缘体352及绝缘体354中形成有导电 体356。导电体356用作插头或布线。 [0250] 同样地,在绝缘体210、绝缘体212、绝缘体214及绝缘体216中填充有导电体218及 构成晶体管200的导电体(导电体205)等。此外,导电体218用作与电容器100或晶体管300电 连接的插头或布线。再者,导电体120及绝缘体130上设置有绝缘体150。 [0251] 作为能够用作层间膜的绝缘体,有具有绝缘性的氧化物、氮化物、氧氮化物、氮氧 化物、金属氧化物、金属氧氮化物、金属氮氧化物等。 [0252] 例如,通过将相对介电常数低的材料用于用作层间膜的绝缘体,可以减少产生在 布线之间的寄生电容。因此,优选根据绝缘体的功能选择材料。 [0253] 例如,优选将相对介电常数低的绝缘体用于绝缘体150、绝缘体212、绝缘体352及 绝缘体354等。例如,该绝缘体优选含有氧化硅、氧氮化硅、氮氧化硅、氮化硅、添加有氟的氧 化硅、添加有碳的氧化硅、添加有碳及氮的氧化硅、具有空孔的氧化硅或树脂等。或者,该绝 缘体优选具有氧化硅、氧氮化硅、氮氧化硅、氮化硅、添加有氟的氧化硅、添加有碳的氧化 硅、添加有碳及氮的氧化硅或具有空孔的氧化硅和树脂的叠层结构。由于氧化硅及氧氮化 硅具有热稳定性,因此通过将其与树脂组合,可以实现具有热稳定性且相对介电常数低的 叠层结构。作为树脂,例如可以举出聚酯、聚烯烃、聚酰胺(尼龙、芳族聚酰胺等)、聚酰亚胺、 聚碳酸酯或丙烯酸等。 [0254] 此外,通过由具有抑制氢等杂质及氧透过的功能的绝缘体围绕使用氧化物半导体 的晶体管,可以使晶体管的电特性稳定。因此,作为绝缘体210及绝缘体350等,使用具有抑 制氢等杂质及氧的透过的功能的绝缘体,即可。 [0255] 作为具有抑制氢等杂质及氧透过的功能的绝缘体,例如可以以单层或叠层使用包 含硼、碳、氮、氧、氟、镁、铝、硅、磷、氯、氩、镓、锗、钇、锆、镧、钕、铪或钽的绝缘体。具体而言, 作为具有抑制氢等杂质及氧透过的功能的绝缘体,可以使用氧化铝、氧化镁、氧化镓、氧化 锗、氧化钇、氧化锆、氧化镧、氧化钕、氧化铪或氧化钽等金属氧化物、氮氧化硅或氮化硅等。 [0256] 作为能够用于布线、插头的导电体优选使用包含选自铝、铬、铜、银、金、铂、钽、镍、 钛、钼、钨、铪、钒、铌、锰、镁、锆、铍、铟、以及钌等的金属元素中的一种以上的材料。此外,也 可以使用以包含磷等杂质元素的多晶硅为代表的导电率高的半导体以及镍硅化物等硅化 物。 [0257] 例如,作为导电体328、导电体330、导电体356、导电体218及导电体112等,可以以 单层或叠层使用由上述材料形成的金属材料、合金材料、金属氮化物材料或金属氧化物材 料等的导电材料。优选使用兼具耐热性和导电性的钨或钼等高熔点材料,尤其优选使用钨。 或者,优选使用铝或铜等低电阻导电材料形成。通过使用低电阻导电材料可以降低布线电 阻。 [0258] 《设置有氧化物半导体的层的布线或插头》 注意,在将氧化物半导体用于晶体管200时,有时在氧化物半导体附近设置具有过剩氧 区域的绝缘体。在此情况下,优选在该具有过剩氧区域的绝缘体和设置于该具有过剩氧区 域的绝缘体的导电体之间设置具有阻挡性的绝缘体。 30 CN 111587491 A 说 明 书 28/40 页 [0259] 例如,在图12中,优选在具有过剩氧的绝缘体224和导电体246之间设置绝缘体 276。通过使绝缘体276和绝缘体222及绝缘体274接触地设置,绝缘体224及晶体管200可以 具有由具有阻挡性的绝缘体密封的结构。再者,绝缘体276优选与绝缘体280接触。在绝缘体 276延伸到绝缘体280时,可以进一步抑制氧及杂质的扩散。 [0260] 也就是说,通过设置绝缘体276,可以抑制绝缘体224所具有的过剩氧被导电体246 吸收。此外,通过具有绝缘体276,可以抑制作为杂质的氢经过导电体246扩散到晶体管200。 [0261] 另外,作为绝缘体276,优选使用具有抑制水或氢等的杂质及氧的扩散的功能的绝 缘性材料。例如,优选使用氧化铝或氧化铪等。此外,例如还可以使用氧化镁、氧化镓、氧化 锗、氧化钇、氧化锆、氧化镧、氧化钕或氧化钽等的金属氧化物、氮氧化硅或氮化硅等。 [0262] 以上是对结构例子的说明。通过采用本结构,可以在使用具有包含氧化物半导体 的晶体管的半导体装置中抑制电特性变动的同时提高可靠性。另外,可以提供一种包含通 态电流大的氧化物半导体的晶体管。此外,可以提供一种包含关态电流小的氧化物半导体 的晶体管。另外,可以提供一种功耗得到降低的半导体装置。 [0263] [存储装置2] 图13示出使用作为本发明的一个方式的半导体装置的存储装置的一个例子。图13所示 的存储装置除了包括图12所示的晶体管200、晶体管300及电容器100的半导体装置以外还 包括晶体管400。 [0264] 晶体管400可以控制晶体管200的第二栅极电压。例如,采用晶体管400的第一栅极 及第二栅极与源极二极管连接并且晶体管400的源极与晶体管200的第二栅极连接的结构。 当在该结构中保持晶体管200的第二栅极的负电位时,晶体管400的第一栅极与源极间的电 压及第二栅极与源极间的电压成为0V。在晶体管400中,由于第二栅极电压及第一栅极电压 为0V时的漏极电流非常小,所以即使没有向晶体管200及晶体管400供应电源,也可以长时 间保持晶体管200的第二栅极的负电位。由此,包括晶体管200及晶体管400的存储装置可以 长期间保持存储内容。 [0265] 因此,在图13中,布线1001与晶体管300的源极电连接,布线1002与晶体管300的漏 极电连接。另外,布线1003与晶体管200的源极和漏极中的一个电连接,布线1004与晶体管 200的栅极电连接,布线1006与晶体管200的背栅极电连接。再者,晶体管300的栅极及晶体 管200的源极和漏极中的另一个与电容器100的一个电极电连接,布线1005与电容器100的 另一个电极电连接。布线1007与晶体管400的源极电连接,布线1008与晶体管400的第一栅 极电连接,布线1009与晶体管400的背栅极电连接,布线1010与晶体管400的漏极电连接。在 此,布线1006、布线1007、布线1008及布线1009电连接。 [0266] 此外,通过将图13所示的存储装置与图12所示的存储装置同样地配置为矩阵状, 可以构成存储单元阵列。注意,一个晶体管400可以控制多个晶体管200的第二栅极电压。因 此,优选使晶体管400的个数少于晶体管200。 [0267] <晶体管400> 晶体管400形成在与晶体管200相同的层上,由此可以同时制造它们。晶体管400包括: 用作第一栅电极的导电体460(导电体460a及导电体460b);用作第二栅电极的导电体405 (导电体405a及导电体405b);用作栅极绝缘层的绝缘体220、绝缘体222、绝缘体224及绝缘 体450;包括形成沟道的区域的氧化物430c;用作源极和漏极中的一个的导电体442a、氧化 31 CN 111587491 A 说 明 书 29/40 页 物431a及氧化物431b;用作源极和漏极中的另一个的导电体442b、氧化物432a及氧化物 432b;以及导电体440(导电体440a及导电体440b)。 [0268] 在晶体管400中,导电体405与导电体205是相同的层。氧化物431a及氧化物432a与 氧化物230a是相同的层,氧化物431b及氧化物432b与氧化物230b是相同的层。导电体442与 导电体240是相同的层。氧化物430c与氧化物230c是相同的层。绝缘体450与绝缘体250是相 同的层。导电体460与导电体260是相同的层。 [0269] 注意,形成在相同的层中的结构体可以同时形成。例如,氧化物430c可以通过对成 为氧化物230c的氧化膜进行加工来形成。 [0270] 与氧化物230等同样,在用作晶体管400的活性层的氧化物430c中,减少了氧空位 和氢或水等杂质。因此,可以使晶体管400的阈值电压大于0V,减少关态电流,并使第二栅极 电压及第一栅极电压为0V时的漏极电流非常小。 [0271] <切割线> 下面,对当将大面积衬底按每个半导体元件分割而得到芯片形状的多个半导体装置时 设置的切割线(也称为分割线、分断线或截断线)进行说明。作为分割方法,例如,有时,首先 在衬底中形成用来分断半导体元件的槽(切割线)之后,在切割线处截断,得到被分断(被分 割)的多个半导体装置。 [0272] 在此,例如,如图13所示,优选以与绝缘体254和绝缘体222接触的区域成为切割线 的方式进行设计。也就是说,在设置在包括多个晶体管200的存储单元及晶体管400的边缘 的成为切割线的区域附近,在绝缘体224中设置开口。此外,以覆盖绝缘体224的侧面的方式 设置绝缘体254。 [0273] 也就是说,在设置在上述绝缘体224的开口中,绝缘体222与绝缘体254接触。例如, 此时,也可以使用相同的材料及相同的方法形成绝缘体222和绝缘体254。通过使用相同的 材料及相同的方法形成绝缘体222和绝缘体254,可以提高紧密性。例如,优选使用氧化铝。 [0274] 通过采用该结构,可以使绝缘体222及绝缘体254包围绝缘体224、晶体管200及晶 体管400。绝缘体222及绝缘体254由于具有抑制氧、氢及水的扩散的功能,所以即使如本实 施方式所示那样按形成有半导体元件的电路区域将衬底分割加工为多个芯片,也可以防止 氢或水等杂质从截断的衬底的侧面方向混入并扩散到晶体管200或晶体管400。 [0275] 通过采用该结构,可以防止绝缘体224中的过剩氧扩散到绝缘体254及绝缘体222 的外部。因此,绝缘体224中的过剩氧高效地被供应到晶体管200或晶体管400中形成沟道的 氧化物中。通过该氧,可以减少晶体管200或晶体管400中的形成沟道的氧化物的氧空位。由 此,可以使晶体管200或晶体管400中的形成沟道的氧化物成为缺陷态密度低且具有稳定的 特性的氧化物半导体。也就是说,可以在抑制晶体管200或晶体管400的电特性变动的同时 提高可靠性。 [0276] 本实施方式可以与其他实施方式及实施例等所记载的结构适当地组合而实施。 [0277] (实施方式3) 在本实施方式中,参照图14A至图15H,对根据本发明的一个方式的使用将氧化物用于 半导体的晶体管(以下有时称为OS晶体管)及电容器的存储装置(以下有时称为OS存储装 置)进行说明。OS存储装置是至少包括电容器和控制该电容器的充放电的OS晶体管的存储 装置。因OS晶体管的关态电流极小所以OS存储装置具有优良的保持特性,从而可以被用作 32 CN 111587491 A 说 明 书 30/40 页 非易失性存储器。 [0278] <存储装置的结构例子> 图14A示出OS存储装置的结构的一个例子。存储装置1400包括外围电路1411及存储单 元阵列1470。外围电路1411包括行电路1420、列电路1430、输出电路1440、控制逻辑电路 1460。 [0279] 列电路1430例如包括列译码器、预充电电路、读出放大器及写入电路等。预充电电 路具有对布线进行预充电的功能。读出放大器具有放大从存储单元读出的数据信号的功 能。注意,上述布线是连接到存储单元阵列1470所包括的存储单元的布线,下面描述其详细 内容。被放大的数据信号作为数据信号RDATA通过输出电路1440输出到存储装置1400的外 部。此外,行电路1420例如包括行译码器、字线驱动器电路等,并可以选择要存取的行。 [0280] 对存储装置1400从外部供应作为电源电压的低电源电压(VSS)、外围电路1411用 高电源电压(VDD)及存储单元阵列1470用高电源电压(VIL)。此外,对存储装置1400从外部 输入控制信号(CE、WE、RE)、地址信号ADDR及数据信号WDATA。地址信号ADDR被输入到行译码 器及列译码器,WDATA被输入到写入电路。 [0281] 控制逻辑电路1460对来自外部的输入信号(CE、WE、RE)进行处理来生成行译码器 及列译码器的控制信号。CE是芯片使能信号,WE是写入使能信号,并且RE是读出使能信号。 控制逻辑电路1460所处理的信号不局限于此,根据需要而输入其他控制信号即可。 [0282] 存储单元阵列1470包括配置为行列状的多个存储单元MC及多个布线。注意,连接 存储单元阵列1470和行电路1420的布线的数量取决于存储单元MC的结构、包括在一个列中 的存储单元MC的数量等。此外,连接存储单元阵列1470和列电路1430的布线的数量取决于 存储单元MC的结构、包括在一个行中的存储单元MC的数量等。 [0283] 另外,虽然在图14A中示出在同一平面上形成外围电路1411和存储单元阵列1470 的例子,但是本实施方式不局限于此。例如,如图14B所示,也可以以重叠于外围电路1411的 一部分上的方式设置存储单元阵列1470。例如,也可以采用以重叠于存储单元阵列1470下 的方式设置读出放大器的结构。 [0284] 在图15A至图15H中说明能够适用于上述存储单元MC的存储单元的结构例子。 [0285] [DOSRAM] 图15A至图15C示出DRAM的存储单元的电路结构例子。在本说明书等中,有时将使用1OS 晶体管1电容器型存储单元的DRAM称为DOSRAM(Dynamic Oxide Semiconductor Random Access Memory)。图15A所示的存储单元1471包括晶体管M1及电容器CA。另外,晶体管M1包 括栅极(有时称为前栅极)及背栅极。 [0286] 晶体管M1的第一端子与电容器CA的第一端子连接,晶体管M1的第二端子与布线 BIL连接,晶体管M1的栅极与布线WOL连接,晶体管M1的背栅极与布线BGL连接。电容器CA的 第二端子与布线CAL连接。 [0287] 布线BIL被用作位线,布线WOL被用作字线。布线CAL被用作用来对电容器CA的第二 端子施加指定的电位的布线。在数据的写入及读出时,优选对布线CAL施加低电平电位。布 线BGL被用作用来对晶体管M1的背栅极施加电位的布线。通过对布线BGL施加任意电位,可 以增加或减少晶体管M1的阈值电压。 [0288] 此外,存储单元MC不局限于存储单元1471,而可以改变其电路结构。例如,存储单 33 CN 111587491 A 说 明 书 31/40 页 元MC也可以采用如图15B所示的存储单元1472那样的晶体管M1的背栅极不与布线BGL连接, 而与布线WOL连接的结构。另外,例如,存储单元MC也可以是如图15C所示的存储单元1473那 样的由单栅极结构的晶体管,即不包括背栅极的晶体管M1构成的存储单元。 [0289] 在将上述实施方式所示的半导体装置用于存储单元1471等的情况下,作为晶体管 M1可以使用晶体管200,作为电容器CA可以使用电容器100。通过作为晶体管M1使用OS晶体 管,可以使晶体管M1的泄漏电流为极低。换言之,因为可以由晶体管M1长时间保持写入的数 据,所以可以降低存储单元的刷新频率。此外,还可以不进行存储单元的刷新工作。此外,由 于泄漏电流极低,因此可以将多值数据或模拟数据保持在存储单元1471、存储单元1472、存 储单元1473中。 [0290] 此外,在DOSRAM中,在如上所述那样地采用以重叠于存储单元阵列1470下的方式 设置读出放大器的结构时,可以缩短位线。由此,位线电容减小,从而可以减少存储单元的 存储电容。 [0291] [NOSRAM] 图15D至图15H示出2晶体管1电容器的增益单元型存储单元的电路结构例子。图15D所 示的存储单元1474包括晶体管M2、晶体管M3、电容器CB。另外,晶体管M2包括前栅极(有时简 称为栅极)及背栅极。在本说明书等中,有时将包括将OS晶体管用于晶体管M2的增益单元型 存储单元的存储装置称为NOSRAM(Nonvolatile Oxide Semiconductor RAM)。 [0292] 晶体管M2的第一端子与电容器CB的第一端子连接,晶体管M2的第二端子与布线 WBL连接,晶体管M2的栅极与布线WOL连接,晶体管M2的背栅极与布线BGL连接。电容器CB的 第二端子与布线CAL连接。晶体管M3的第一端子与布线RBL连接,晶体管M3的第二端子与布 线SL连接,晶体管M3的栅极与电容器CB的第一端子连接。 [0293] 布线WBL被用作写入位线,布线RBL被用作读出位线,布线WOL被用作字线。布线CAL 被用作用来对电容器CB的第二端子施加指定的电位的布线。在数据的写入、保持及读出时, 优选对布线CAL施加低电平电位。布线BGL被用作用来对晶体管M2的背栅极施加电位的布 线。通过对布线BGL施加任意电位,可以增加或减少晶体管M2的阈值电压。 [0294] 此外,存储单元MC不局限于存储单元1474,而可以适当地改变其电路结构。例如, 存储单元MC也可以采用如图15E所示的存储单元1475那样的晶体管M2的背栅极不与布线 BGL连接,而与布线WOL连接的结构。另外,例如,存储单元MC也可以是如图15F所示的存储单 元1476那样的由单栅极结构的晶体管,即不包括背栅极的晶体管M2构成的存储单元。此外, 例如,存储单元MC也可以具有如图15G所示的存储单元1477那样的将布线WBL和布线RBL组 合为一个布线BIL的结构。 [0295] 在将上述实施方式所示的半导体装置用于存储单元1474等的情况下,作为晶体管 M2可以使用晶体管200,作为晶体管M3可以使用晶体管300,作为电容器CB可以使用电容器 100。通过作为晶体管M2使用OS晶体管,可以使晶体管M2的泄漏电流为极低。由此,因为可以 由晶体管M2长时间保持写入的数据,所以可以降低存储单元的刷新频率。此外,还可以不进 行存储单元的刷新工作。此外,由于泄漏电流极低,因此可以将多值数据或模拟数据保持在 存储单元1474中。存储单元1475至1477也是同样的。 [0296] 另外,晶体管M3也可以是在沟道形成区域中包含硅的晶体管(以下有时称为Si晶 体管)。Si晶体管的导电型可以是n沟道型或p沟道型。Si晶体管的场效应迁移率有时比OS晶 34 CN 111587491 A 说 明 书 32/40 页 体管高。因此,作为用作读出晶体管的晶体管M3,也可以使用Si晶体管。此外,通过将Si晶体 管用于晶体管M3,可以层叠于晶体管M3上地设置晶体管M2,从而可以减少存储单元的占有 面积,并可以实现存储装置的高集成化。 [0297] 此外,晶体管M3也可以是OS晶体管。在将OS晶体管用于晶体管M2、M3时,在存储单 元阵列1470中可以只使用n型晶体管构成电路。 [0298] 另外,图15H示出3晶体管1电容器的增益单元型存储单元的一个例子。图15H所示 的存储单元1478包括晶体管M4至M6及电容器CC。电容器CC可以适当地设置。存储单元1478 与布线BIL、RWL、WWL、BGL及GNDL电连接。布线GNDL是供应低电平电位的布线。另外,也可以 将存储单元1478电连接到布线RBL、WBL,而不与布线BIL电连接。 [0299] 晶体管M4是包括背栅极的OS晶体管,该背栅极与布线BGL电连接。另外,也可以使 晶体管M4的背栅极和栅极互相电连接。或者,晶体管M4也可以不包括背栅极。 [0300] 另外,晶体管M5、M6各自可以是n沟道型Si晶体管或p沟道型Si晶体管。或者,晶体 管M4至M6都是OS晶体管。在此情况下,可以在存储单元阵列1470中只使用n型晶体管构成电 路。 [0301] 在将上述实施方式所示的半导体装置用于存储单元1478时,作为晶体管M4可以使 用晶体管200,作为晶体管M5、M6可以使用晶体管300,作为电容器CC可以使用电容器100。通 过作为晶体管M4使用OS晶体管,可以使晶体管M4的泄漏电流为极低。 [0302] 注意,本实施方式所示的外围电路1411及存储单元阵列1470等的结构不局限于上 述结构。也可以根据需要改变,去除或追加这些电路及连接到该电路的布线、电路元件等的 配置或功能。 [0303] 本实施方式可以与其他实施方式及实施例等所记载的结构适当地组合而实施。 [0304] (实施方式4) 在本实施方式中,参照图16A和图16B说明安装有本发明的半导体装置的芯片1200的一 个例子。在芯片1200上安装有多个电路(系统)。如此,在一个芯片上集成有多个电路(系统) 的技术有时被称为系统芯片(System on Chip:SoC)。 [0305] 如图16A所示,芯片1200包括中央处理器(CPU)1211、图形处理器(GPU)1212、一个 或多个模拟运算部1213、一个或多个存储控制器1214、一个或多个接口1215、一个或多个网 络电路1216等。 [0306] 在芯片1200上设置有凸块(未图示),该凸块如图16B所示那样与印刷线路板(PCB) 1201的第一面连接。此外,在PCB1201的第一面的背面设置有多个凸块1202,该凸块1202与 母板1203连接。 [0307] 此外,也可以在母板1203上设置有DRAM1221、闪存1222等的存储装置。例如,可以 将上述实施方式所示的DOSRAM应用于DRAM1221。此外,例如,可以将上述实施方式所示的 NOSRAM应用于闪存1222。 [0308] CPU1211优选具有多个CPU核。此外,GPU1212优选具有多个GPU核。此外,CPU1211和 GPU1212可以分别具有暂时储存数据的存储器。或者,也可以在芯片1200上设置有CPU1211 和GPU1212共同使用的存储器。可以将上述NOSRAM或DOSRAM应用于该存储器。此外,GPU1212 适合用于多个数据的并行计算,其可以用于图像处理或积和运算。通过作为GPU1212设置使 用本发明的氧化物半导体的图像处理电路或积和运算电路,可以以低耗电量执行图像处理 35 CN 111587491 A 说 明 书 33/40 页 及积和运算。 [0309] 此外,因为在同一芯片上设置有CPU1211和GPU1212,所以可以缩短CPU1211和 GPU1212之间的布线,并可以以高速进行从CPU1211到GPU1212的数据传送、CPU1211及 GPU1212所具有存储器之间的数据传送以及GPU1212中的运算结束之后的从GPU1212到 CPU1211的运算结果传送。 [0310] 模拟运算部1213具有模拟/数字(A/D)转换电路和数字/模拟(D/A)转换电路中的 一方或双方。此外,也可以在模拟运算部1213中设置上述积和运算电路。 [0311] 存储控制器1214具有用作DRAM1221的控制器的电路及用作闪存1222的接口的电 路。 [0312] 接口1215具有与如显示装置、扬声器、麦克风、影像拍摄装置、控制器等外部连接 设备之间的接口电路。控制器包括鼠标、键盘、游戏机用控制器等。作为上述接口,可以使用 通用串行总线(USB)、高清晰度多媒体接口(HDMI)(注册商标)等。 [0313] 网络电路1216具有局域网(LAN)等网络电路。此外,还可以具有网络安全用电路。 [0314] 上述电路(系统)可以经同一制造工序形成在芯片1200上。由此,即使芯片1200所 需的电路个数增多,也不需要增加制造工序,可以以低成本制造芯片1200。 [0315] 可以将包括设置有具有GPU1212的芯片1200的PCB1201、DRAM1221以及闪存1222的 母板1203称为GPU模块1204。 [0316] GPU模块1204因具有使用SoC技术的芯片1200而可以减少其尺寸。此外,GPU模块 1204因具有高图像处理能力而适合用于智能手机、平板终端、膝上型个人计算机、便携式 (可携带)游戏机等便携式电子设备。此外,通过利用使用GPU1212的积和运算电路,可以执 行深度神经网络(DNN)、卷积神经网络(CNN)、递归神经网络(RNN)、自动编码器、深度玻尔兹 曼机(DBM)、深度置信网络(DBN)等运算,由此可以将芯片1200用作AI芯片,或者,可以将GPU 模块用作AI系统模块。 [0317] 本实施方式所示的结构可以与其他实施方式所示的结构适当地组合而实施。 [0318] (实施方式5) 在本实施方式中,说明使用上述实施方式所示的半导体装置的存储装置的应用例子。 上述实施方式所示的半导体装置例如可以应用于各种电子设备(例如,信息终端、计算机、 智能手机、电子书阅读器终端、数码相机(也包括摄像机)、录像再现装置、导航系统等)的存 储装置。注意,在此,计算机包括平板电脑、笔记型计算机、台式计算机以及大型计算机诸如 服务器系统。或者,上述实施方式所示的半导体装置应用于存储器卡(例如,SD卡)、USB存储 器、SSD(固态硬盘)等各种可移动存储装置。图17A至图17E示意性地示出可移动存储装置的 几个结构例子。例如,上述实施方式所示的半导体装置加工为被封装的存储器芯片并用于 各种存储装置或可移动存储器。 [0319] 图17A是USB存储器的示意图。USB存储器1100包括外壳1101、盖子1102、USB连接器 1103及衬底1104。衬底1104被容纳在外壳1101中。例如,衬底1104上安装有存储器芯片1105 及控制器芯片1106。可以将上述实施方式所示的半导体装置组装于衬底1104上的存储器芯 片1105等。 [0320] 图17B是SD卡的外观示意图,图17C是SD卡的内部结构的示意图。SD卡1110包括外 壳1111、连接器1112及衬底1113。衬底1113被容纳在外壳1111中。例如,衬底1113上安装有 36 CN 111587491 A 说 明 书 34/40 页 存储器芯片1114及控制器芯片1115。通过在衬底1113的背面一侧也设置存储器芯片1114, 可以增大SD卡1110的容量。此外,也可以将具有无线通信功能的无线芯片设置于衬底1113。 由此,通过主机装置与SD卡1110之间的无线通信,可以进行存储器芯片1114的数据的读出 及写入。可以将上述实施方式所示的半导体装置组装于衬底1113上的存储器芯片1114等。 [0321] 图17D是SSD的外观示意图,图17E是SSD的内部结构的示意图。SSD1150包括外壳 1151、连接器1152及衬底1153。衬底1153被容纳在外壳1151中。例如,衬底1153上安装有存 储器芯片1154、存储器芯片1155及控制器芯片1156。存储器芯片1155为控制器芯片1156的 工作存储器,例如,可以使用DOSRAM芯片。通过在衬底1153的背面一侧也设置存储器芯片 1154,可以增大SSD1150的容量。可以将上述实施方式所示的半导体装置组装于衬底1153上 的存储器芯片1154等。 [0322] 本实施方式可以与其他的实施方式及实施例等所记载的结构适当地组合而实施。 [0323] (实施方式6) 根据本发明的一个方式的半导体装置可以应用于如CPU、GPU等处理器或芯片。图18A至 图18D、图18E1、图18E2以及图18F示出具有根据本发明的一个方式的如CPU、GPU等处理器或 芯片的电子设备的具体例子。 [0324] <电子设备及系统> 根据本发明的一个方式的GPU或芯片可以安装在各种各样的电子设备。作为电子设备 的例子,例如除了电视装置、台式或笔记本型个人计算机、用于计算机等的显示器、数字标 牌(Digital Signage)、弹珠机等大型游戏机等具有较大的屏幕的电子设备以外,还可以举 出数码相机、数码摄像机、数码相框、移动电话机、便携式游戏机、便携式信息终端、声音再 现装置等。此外,通过将根据本发明的一个方式的集成电路或芯片设置在电子设备中,可以 使电子设备具备人工智能。 [0325] 本发明的一个方式的电子设备也可以包括天线。通过由天线接收信号,可以在显 示部上显示影像或信息等。此外,在电子设备包括天线及二次电池时,可以将天线用于非接 触电力传送。 [0326] 本发明的一个方式的电子设备也可以包括传感器(该传感器具有测定如下因素的 功能:力、位移、位置、速度、加速度、角速度、转速、距离、光、液、磁、温度、化学物质、声音、时 间、硬度、电场、电流、电压、电力、辐射线、流量、湿度、倾斜度、振动、气味或红外线)。 [0327] 本发明的一个方式的电子设备可以具有各种功能。例如,可以具有如下功能:将各 种信息(静态图像、动态图片、文字图像等)显示在显示部上的功能;触控面板的功能;显示 日历、日期或时间等的功能;执行各种软件(程序)的功能;进行无线通信的功能;读出储存 在存储介质中的程序或数据的功能;等。图18A至图18D、图18E1、图18E2以及图18F示出电子 设备的例子。 [0328] [移动电话机] [0329] 图18A示出信息终端之一的移动电话机(智能手机)。信息终端5500包括框体5510 及显示部5511,作为输入界面在显示部5511中具备触控面板,并且在框体5510上设置有按 钮。 [0330] 通过将本发明的一个方式的芯片应用于信息终端5500,可以执行利用人工智能的 应用程序。作为利用人工智能的应用程序,例如,可以举出识别会话来将该会话的内容显示 37 CN 111587491 A 说 明 书 35/40 页 在显示部5511上的应用程序、识别由使用者输入到显示部5511所具备的触控面板的文字或 图形等来将该文字或该图形显示在显示部5511上的应用程序、执行指纹或声纹等的生物识 别的应用程序等。 [0331] [信息终端1] 图18B示出台式信息终端5300。台式信息终端5300包括信息终端主体5301、显示器5302 及键盘5303。 [0332] 与上述信息终端5500同样,通过将本发明的一个方式的芯片应用于台式信息终端 5300,可以执行利用人工智能的应用程序。作为利用人工智能的应用程序,例如,可以举出 设计支援软件、文章校对软件、菜单自动生成软件等。此外,通过使用台式信息终端5300,可 以研发新颖的人工智能。 [0333] 注意,在上述例子中,图18A及图18B示出智能手机及台式信息终端作为电子设备 的例子,但是也可以应用智能手机及台式信息终端以外的信息终端。作为智能手机及台式 信息终端以外的信息终端,例如可以举出PDA(Personal Digital Assistant:个人数码助 理)、笔记本式信息终端、工作站等。 [0334] [电器产品] 图18C示出电器产品的一个例子的电冷藏冷冻箱5800。电冷藏冷冻箱5800包括外壳 5801、冷藏室门5802及冷冻室门5803等。 [0335] 通过将本发明的一个方式的芯片应用于电冷藏冷冻箱5800,可以实现具备人工智 能的电冷藏冷冻箱5800。通过利用人工智能,可以使电冷藏冷冻箱5800具有基于储存在电 冷藏冷冻箱5800中的食品或该食品的消费期限等自动生成菜单的功能、根据所储存的食品 自动调整电冷藏冷冻箱5800的温度的功能。 [0336] 在上述例子中,作为电器产品说明了电冷藏冷冻箱,但是作为其他电器产品,例如 可以举出吸尘器、微波炉、电烤箱、电饭煲、热水器、IH炊具、饮水机、包括空气调节器的冷暖 空調机、洗衣机、干衣机、视听设备等。 [0337] [游戏机] [0338] 图18D示出游戏机的一个例子的便携式游戏机5200。便携式游戏机包括外壳5201、 显示部5202及按钮5203等。 [0339] 通过将本发明的一个方式的GPU或芯片应用于便携式游戏机5200,可以实现低功 耗的便携式游戏机5200。此外,借助于低功耗,可以降低来自电路的发热,由此可以减少因 发热而给电路本身、外围电路以及模块带来的负面影响。 [0340] 此外,通过将本发明的一个方式的GPU或芯片应用于便携式游戏机5200,可以实现 具备人工智能的便携式游戏机5200。 [0341] 游戏的进展、游戏中出现的生物的言行、游戏上发生的现象等的表现本来是由该 游戏所具有的程序规定的,但是通过将人工智能应用于便携式游戏机5200,可以实现不局 限于游戏的程序的表现。例如,可以实现游戏玩者提问的内容、游戏的进展情况、时间、游戏 上出现的人物的言行变化等的表现。 [0342] 此外,当使用便携式游戏机5200玩需要多个人玩的游戏时,可以利用人工智能构 成拟人的游戏玩者,由此可以将人工智能的游戏玩者当作对手,一个人也可以玩多个人玩 的游戏。 38 CN 111587491 A 说 明 书 36/40 页 [0343] 虽然图18D示出便携式游戏机作为游戏机的一个例子,但是应用本发明的一个方 式的GPU或芯片的游戏机不局限于此。作为应用本发明的一个方式的GPU或芯片的游戏机, 例如可以举出家用固定式游戏机、设置在娱乐设施(游戏中心,游乐园等)的街机游戏机、设 置在体育设施的击球练习用投球机等。 [0344] [移动体] 本发明的一个方式的GPU或芯片可以应用于作为移动体的汽车及汽车的驾驶席周边。 [0345] 图18E1是示出移动体的一个例子的汽车5700的图,图18E2是示出汽车室内的前挡 风玻璃周边的图。图18E2示出安装在仪表盘的显示面板5701、显示面板5702、显示面板5703 以及安装在支柱的显示面板5704。 [0346] 显示面板5701至显示面板5703可以提供速度表、转速计、行驶距离、加油量、排档 状态、空调的设定以及其他各种信息。此外,使用者可以根据喜好适当地改变显示面板所显 示的显示内容及布局等,可以提高设计性。显示面板5701至显示面板5703还可以用作照明 装置。 [0347] 通过将由设置在汽车5700的摄像装置(未图示)拍摄的影像显示在显示面板5704 上,可以补充被支柱遮挡的视野(死角)。也就是说,通过显示由设置在汽车5700外侧的摄像 装置拍摄的影像,可以补充死角,从而可以提高安全性。此外,通过显示补充看不到的部分 的影像,可以更自然、更舒适地确认安全。显示面板5704还可以用作照明装置。 [0348] 因为可以将本发明的一个方式的GPU或芯片用作人工智能的构成要素,例如可以 将该芯片用于汽车5700的自动驾驶系统。该芯片也可以用于进行导航、危险预测等的系统。 此外,可以在显示面板5701至显示面板5704上显示导航、危险预测等信息。 [0349] 虽然在上述例子中作为移动体的一个例子说明了汽车,但是移动体不局限于汽 车。例如,作为移动体,也可以举出电车、单轨铁路、船舶、飞行物(直升机、无人驾驶飞机(无 人机)、飞机、火箭)等,可以对这些移动体应用本发明的一个方式的芯片,以提供利用人工 智能的系统。 [0350] [广播电视系统] 本发明的一个方式的GPU或芯片可以应用于广播电视系统。 [0351] 图18F示意性地示出广播电视系统中的数据传送。具体而言,图18F示出从广播电 视台5680发送的电波(广播电视信号)到达每个家庭的电视接收机(TV)5600的路径。TV5600 具备接收机(未图示),由此天线5650所接收的广播电视信号通过该接收机输入TV5600。 [0352] 虽然在图18F中示出超高频率(UHF)天线作为天线5650,但是可以使用BS及110度 CS天线、CS天线等作为天线5650。 [0353] 电波5675A及电波5675B为地面广播电视信号,电波塔5670放大所接收的电波 5675A并发送电波5675B。各家庭通过用天线5650接收电波5675B,就可以用TV5600收看地面 TV播放。此外,广播电视系统可以为利用人造卫星的卫星广播电视、利用光路线的数据广播 电视等而不局限于图18F所示的地面广播电视。 [0354] 此外,也可以将本发明的一个方式的芯片应用于上述广播电视系统,以形成利用 人工智能的广播电视系统。当从广播电视台5680向每个家庭的TV5600发送广播电视数据 时,利用编码器进行广播电视数据的压缩;当天线5650接收该广播电视数据时,利用包括在 TV5600中的接收机的解码器进行该广播电视数据的恢复。通过利用人工智能,例如可以在 39 CN 111587491 A 说 明 书 37/40 页 编码器的压缩方法之一的变动补偿预测中识别包含在显示图像中的显示模型。此外,也可 以进行利用人工智能的帧内预测等。例如,当TV5600接收低分辨率的广播电视数据而进行 高分辨率的显示时,可以在解码器所进行的广播电视数据的恢复中进行上转换等图像的补 充处理。 [0355] 上述利用人工智能的广播电视系统适合用于广播电视数据量增大的超高清晰度 电视(UHDTV:4K、8K)播放。 [0356] 此外,作为TV5600一侧的人工智能的应用,例如,可以在TV5600内设置具备人工智 能的录像装置。通过采用这种结构,可以使该具备人工智能的录像装置学习使用者的爱好, 而可以自动对符合使用者的爱好的电视节目录像。 [0357] 在本实施方式中说明的电子设备、该电子设备的功能、人工智能的应用例子以及 其效果等可以与其他的电子设备的记载适当地组合而实施。 [0358] 本实施方式可以与其他的实施方式及实施例等所记载的结构适当地组合而实施。 [实施例1] [0359] 在本实施例中,作为样品A,制造包括作为本发明的一个方式的图1A至图1C所示的 晶体管200的半导体装置。此外,作为样品B,制造包括如图2B所示的在绝缘体274和导电体 260之间配置有绝缘体283的晶体管的半导体装置。作为绝缘体283,通过CVD法以40nm的厚 度形成氧氮化硅膜。关于其他制造工序,样品A和样品B通过同一工序制造。 [0360] 测量样品A及样品B的晶体管的电特性,然后进行追加的加热处理,评价加热处理 时间给电特性带来的影响。注意,被进行评价的晶体管的沟道长度为0.38μm,沟道宽度为 0.23μm。此外,晶体管以0.147个/μm2的密度配置。 [0361] <样品的制造方法> 以下,说明样品A及样品B的制造方法。 [0362] 作为导电体205,使用钨膜。此外,作为被用作第二栅极绝缘体的绝缘体222及绝缘 体224,分别使用氧化铝膜及氧氮化硅膜。另外,在形成绝缘体224之后进行CMP处理来对绝 缘体224的表面进行平坦化及平滑化。 [0363] 作为成为氧化物230a的第一氧化物,通过采用溅射法并使用In:Ga:Zn=1:3:4[原 子个数比]的靶材来形成In-Ga-Zn氧化物。接着,作为成为氧化物230b的第二氧化物,在第 一氧化物上通过采用溅射法并In:Ga:Zn=4:2:4.1[原子个数比]的靶材来形成In-Ga-Zn氧 化物。另外,连续形成第一氧化物和第二氧化物。 [0364] 接着,在第二氧化物上形成成为导电体240的氮化钽膜。然后,对该氮化钽膜、第二 氧化物及第一氧化物进行加工来形成氧化物230a、氧化物230b、导电体层242B。 [0365] 接着,作为绝缘体254形成氧化铝膜,然后作为绝缘体280形成氧氮化硅膜。接下 来,进行CMP处理来对绝缘体280的顶面进行平坦化。 [0366] 接着,在导电体层242B、绝缘体254及绝缘体280中形成到达氧化物230b的开口来 形成导电体242a、导电体242b。 [0367] 接着,作为成为氧化物230c的第三氧化物,通过采用溅射法并使用In:Ga:Zn=4: 2:4.1[原子个数比]的靶材来形成In-Ga-Zn氧化物。 [0368] 接着,形成成为绝缘体250的氧氮化硅膜。 [0369] 接着,作为成为导电体260a的导电膜,在成为绝缘体250的氧氮化硅膜上形成氮化 40 CN 111587491 A 说 明 书 38/40 页 钛膜。然后,作为成为导电体260b的导电膜,形成钨膜。另外,通过连续成膜,形成氮化钛膜 及钨膜。 [0370] 接着,通过CMP处理,直到绝缘体280露出为止对成为氧化物230c的氧化膜、成为绝 缘体250的绝缘膜、成为导电体260的导电膜进行抛光,在开口中形成氧化物230c、绝缘体 250及导电体260。 [0371] 接着,关于样品A,在氮气氛下以400℃进行加热处理,然后作为绝缘体274形成氧 化铝膜。 [0372] 关于样品B,作为绝缘体283,通过CVD法形成氧氮化硅膜,在氮气氛下以400℃进行 加热处理,然后作为绝缘体274,形成氧化铝膜。 [0373] 接着,在氮气氛下以400℃对样品A及样品B进行加热处理。 [0374] 通过上述工序制造样品A及样品B。 [0375] <晶体管的电特性> 接着,作为样品A及样品B的电特性,测量Id-Vg特性。 [0376] 注意,在Id-Vg特性的测量中,测量使施加到被用作晶体管的第一栅电极的导电体 260的电位(下面也称为栅极电位(Vg))从第一值变为第二值时的被用作源电极的导电体 240a和被用作漏电极的导电体240b之间的电流(下面也称为漏极电流(Id))的变化。 [0377] 在此,测量将施加到导电体240a的电位(下面也称为源极电位Vs)和施加到导电体 240b的电位(下面也称为漏极电位Vd)之差的电压(下面也称为漏极电压)设定为 0.1V或 1.2V,并使作为源极电位和栅极电位之差的电压(下面也称为栅极电压)从-3.3V变为 3.3V 时的漏极电流(Id)的变化。 [0378] 注意,在本测量中,将被用作第二栅电极(背栅极)的导电体205的电位(下面也称 为背栅极电位(Vbg))设定为0.00V。 [0379] 关于样品A及样品B,评价热所引起的晶体管特性的变动。首先,在加热处理之前进 行测量,在氮气氛下以400℃的温度进行加热处理。加热处理时间总共为4小时,每1小时进 行晶体管特性的测量。换言之,在加热处理前、1小时的加热处理后、2小时的加热处理的后、 3小时的加热处理后及4小时的加热处理后,分别进行晶体管特性的测量。图19共同示出对 样品A及样品B中的每6个晶体管进行Id-Vg特性的测量的结果。另外,还示出根据Id-Vg特 性、晶体管的沟道长度、沟道宽度、栅极绝缘体的厚度及栅极绝缘体的介电常数求得场效应 迁移率(μFE)的结果。每个图中的左侧的纵轴表示Id,而右侧的纵轴表示μFE。 [0380] 由图19所示的结果可知,在样品A中,加热处理时间所引起的晶体管特性(Id-Vg、μ FE)的变动小。在样品B中,在2小时的加热处理后Id-Vg向负方向变动,而在3小时的加热处 理以上后,具有所谓的导通特性,不能得到晶体管特性。 [0381] 此外,图20A至图20D示出样品A及样品B的Ion、μFE、Vsh及S值的加热处理时间依赖 性的散点图。图20A是示出Ion的加热处理时间依赖性的散点图,图20B是示出μFE的加热处 理时间依赖性的散布图,图20C是示出Vsh的加热处理时间依赖性的散点图,而图20D是示出 S值的加热处理时间依赖性的散点图。 [0382] 另外,在Vd=1.2V的Id-Vg特性中,Ion是Vg=3.3V时的Id值。在Vd=1.2V的Id-Vg 特性中,Vsh是Id-Vg曲线的最大倾斜度的切线与Id=1.0×10-12(A)交叉的点的Vg值。S值是 在亚阈值区域中Id变化一位数时所需要的Vg值。 41 CN 111587491 A 说 明 书 39/40 页 [0383] 由图20A至图20D所示的结果可知,在样品A中,Ion、μFE、Vsh及S值的加热处理时间 所引起的变动都小,而其加热处理时间依赖性小。另一方面,在样品B中,加热处理时间所引 起的Ion、μFE、Vsh及S值的变动都大,而其加热处理时间依赖性大。特别是,加热处理2小时 以上后的变动大。由上述结果可知,作为本发明的一个方式的晶体管200的结构对加热处理 具有优良的耐性。 [0384] 本实施例的至少一部分可以与本说明书所记载的其他实施方式适当地组合而实 施。 [实施例2] [0385] 在上述实施例所示的晶体管200及图2B所示的晶体管中,进行被用作栅极绝缘膜 的绝缘体250中的氢浓度的测量。作为氢浓度的测量使用二次离子质谱分析法(SIMS: Secondary Ion Mass Spectrometry)。此外,对位于被用作沟道形成区域的区域234和被用 作栅电极的导电体260之间的绝缘体250进行氢浓度的测量。此时,从区域234一侧,即衬底 一侧向导电体260进行测量。 [0386] 此外,对在形成晶体管200后不进行加热处理的样品1、在形成晶体管200后在氮气 氛中以400℃进行4小时的加热处理的样品2、在形成图2B所示的晶体管后不进行加热处理 的样品3及在形成图2B所示的晶体管后在氮气氛中以400℃进行4小时的加热处理的样品4 进行氢浓度的测量。另外,在样品1至样品4的测量中使用没有设置被用作第二栅电极的导 电体205的晶体管。 [0387] 图21示出上述样品的氢浓度的测量结果。图21的横轴表示测量深度(nm),纵轴表 示氢浓度(atoms/cm3)。在图21中,由虚线围绕的区域相当于被用作栅极绝缘膜的绝缘体 250。不进行加热处理的样品1的绝缘体250中的氢浓度的峰值为1.13×1021atoms/cm3,而进 行上述加热处理的样品2的绝缘体250中的氢浓度的峰值为1.12×1021atoms/cm3。此外,不 进行加热处理的样品3的绝缘体250中的氢浓度的峰值为2.70×1021atoms/cm3,进行上述加 热处理的样品4的绝缘体250中的氢浓度的峰值为2.20×1021atoms/cm3。在晶体管200(样品 1及样品2)及图2B所示的晶体管(样品3及样品4)中都不观察到在绝缘体250中由于加热处 理的有无产生的氢浓度的明显差异。另一方面,还可知图2B所示的晶体管(样品3及样品4) 的绝缘体250中的氢浓度比晶体管200(样品1及样品2)的绝缘体250中的氢浓度高。 [0388] 作为在绝缘体283设置在导电体260、绝缘体250、氧化物230c及绝缘体280和绝缘 体274之间的图2B所示的晶体管中绝缘体250的氢浓度较高的原因,可以考虑到在形成绝缘 体283时氢混入绝缘体250中、绝缘体283所包含的氢扩散到绝缘体250或者绝缘体280所包 含的氢经过绝缘体283扩散到绝缘体250等。 [0389] 为了进一步减少向绝缘体250中混入或扩散的氢,可以认为优选以与导电体260、 绝缘体250、氧化物230c及绝缘体280的顶面接触的方式设置绝缘体274。 [实施例3] [0390] 使用透射电子显微镜(日本电子制造的JEM-ARM200F)进行在实施例1中评价电特 性的晶体管200(样品A)的截面观察。 [0391] 图22A示出样品A的沟道长度方向上的截面照片。图22B是放大在图22A中由白框围 绕的部分附近的截面照片。由图22B所示的结果可知,以绝缘体224的底面为标准,氧化物 230b上的导电体260的底面的高度比导电体242b的顶面的高度低,且在导电体260的底面的 42 CN 111587491 A 说 明 书 40/40 页 高度和导电体242b的顶面的高度之间的差异为T1时,T1大致为15nm。 [0392] 图23示出样品A的沟道宽度方向上的截面照片。由图23所示的结果可知,以绝缘体 224的底面为标准,氧化物230a及氧化物230b和导电体260不重叠的区域中的导电体260的 底面的高度优选比氧化物230b的底面的高度低。在氧化物230b和导电体260不重叠的区域 中的导电体260的底面的高度和氧化物230b的底面的高度之间的差异为T2时,T2大致为 10nm。由此确认到样品A根据作为本发明的一个方式的晶体管200的结构良好地制造。 [0393] 本实施例的至少一部分可以与本说明书所记载的其他实施方式适当地组合而实 施。 [符号说明] [0394] 100:电容器、110:导电体、112:导电体、120:导电体、130:绝缘体、150:绝缘体、 200:晶体管、205:导电体、210:绝缘体、212:绝缘体、214:绝缘体、216:绝缘体、218:导电体、 220:绝缘体、222:绝缘体、224:绝缘体、230:氧化物、230a:氧化物、230A:氧化膜、230b:氧化 物、230B:氧化膜、230c:氧化物、230C:氧化膜、231:区域、231a:区域、231b:区域、234:区域、 240:导电体、240a:导电体、240b:导电体、241:绝缘体、241a:绝缘体、241b:绝缘体、242:导 电体、242a:导电体、242A:导电膜、242b:导电体、242B:导电体层、243:区域、243a:区域、 243b:区域、246:导电体、250:绝缘体、250A:绝缘膜、254:绝缘体、254A:绝缘膜、260:导电 体、260a:导电体、260Aa:导电膜、260Ab:导电膜、260b:导电体、273:绝缘体、274:绝缘体、 276:绝缘体、280:绝缘体、281:绝缘体、283:绝缘体、300:晶体管、311:衬底、313:半导体区 域、314a:低电阻区域、314b:低电阻区域、315:绝缘体、316:导电体、320:绝缘体、322:绝缘 体、324:绝缘体、326:绝缘体、328:导电体、330:导电体、350:绝缘体、352:绝缘体、354:绝缘 体、356:导电体、400:晶体管、405:导电体、405a:导电体、405b:导电体、430c:氧化物、431a: 氧化物、431b:氧化物、432a:氧化物、432b:氧化物、440:导电体、440a:导电体、440b:导电 体、442:导电体、442a:导电体、442b:导电体、450:绝缘体、460:导电体、460a:导电体、460b: 导电体、1001:布线、1002:布线、1003:布线、1004:布线、1005:布线、1006:布线、1007:布线、 1008:布线、1009:布线、1010:布线、1100:USB存储器、1101:框体、1102:盖子、1103:USB连接 器、1104:衬底、1105:存储器芯片、1106:控制器芯片、1110:SD卡、1111:框体、1112:连接器、 1113:衬底、1114:存储器芯片、1115:控制器芯片、1150:SSD、1151:框体、1152:连接器、 1153:衬底、1154:存储器芯片、1155:存储器芯片、1156:控制器芯片、1200:芯片、1201:PCB、 1202:凸块、1203:母板、1204:GPU模块、1211:CPU、1212:GPU、1213:模拟运算部、1214:存储 器控制器、1215:接口、1216:网络电路、1221:DRAM、1222:快闪存储器、1400:存储装置、 1411:外围电路、1420:行电路、1430:列电路、1440:输出电路、1460:控制逻辑电路、1470:存 储单元阵列、1471:存储单元、1472:存储单元、1473:存储单元、1474:存储单元、1475:存储 单元、1476:存储单元、1477:存储单元、1478:存储单元、5200:便携式游戏机、5201:框体、 5202:显示部、5203:按钮、5300:台式信息终端、5301:主体、5302:显示器、5303:键盘、5500: 信息终端、5510:框体、5511:显示部、5600:TV、5650:天线、5670:电波塔、5675A:电波、 5675B:电波、5680:广播电视台、5700:汽车、5701:显示面板、5702:显示面板、5703:显示面 板、5704:显示面板、5800:电冷藏冷冻箱、5801:框体、5802:冷藏室门、5803:冷冻室门 43 CN 111587491 A 说 明 书 附 图 1/31 页 44 CN 111587491 A 说 明 书 附 图 2/31 页 图2A 图2B 45 CN 111587491 A 说 明 书 附 图 3/31 页 图3 图4A 46 CN 111587491 A 说 明 书 附 图 4/31 页 图4B 图4C 47 CN 111587491 A 说 明 书 附 图 5/31 页 图5A 图5B 48 CN 111587491 A 说 明 书 附 图 6/31 页 图5C 图6A 49 CN 111587491 A 说 明 书 附 图 7/31 页 图6B 图6C 50 CN 111587491 A 说 明 书 附 图 8/31 页 图7A 图7B 51 CN 111587491 A 说 明 书 附 图 9/31 页 图7C 图8A 52 CN 111587491 A 说 明 书 附 图 10/31 页 图8B 图8C 53 CN 111587491 A 说 明 书 附 图 11/31 页 图9A 图9B 54 CN 111587491 A 说 明 书 附 图 12/31 页 图9C 图10A 55 CN 111587491 A 说 明 书 附 图 13/31 页 图10B 图10C 56 CN 111587491 A 说 明 书 附 图 14/31 页 57 CN 111587491 A 说 明 书 附 图 15/31 页 图12 58 CN 111587491 A 说 明 书 附 图 16/31 页 图13 59 CN 111587491 A 说 明 书 附 图 17/31 页 图14A 60 CN 111587491 A 说 明 书 附 图 18/31 页 图14B 图15A 图15B 61 CN 111587491 A 说 明 书 附 图 19/31 页 图15C 图15D 图15E 62 CN 111587491 A 说 明 书 附 图 20/31 页 图15F 图15G 图15H 63 CN 111587491 A 说 明 书 附 图 21/31 页 图16A 图16B 64 CN 111587491 A 说 明 书 附 图 22/31 页 图17A 65 CN 111587491 A 说 明 书 附 图 23/31 页 图18A 66 CN 111587491 A 说 明 书 附 图 24/31 页 图18B 图18C 图18D 67 CN 111587491 A 说 明 书 附 图 25/31 页 图18E1 图18E2 图18F 68 CN 111587491 A 说 明 书 附 图 26/31 页 图19 69 CN 111587491 A 说 明 书 附 图 27/31 页 图20A 图20B 图20C 70 CN 111587491 A 说 明 书 附 图 28/31 页 图20D 71 CN 111587491 A 说 明 书 附 图 29/31 页 图21 72 CN 111587491 A 说 明 书 附 图 30/31 页 图22A 图22B 73 CN 111587491 A 说 明 书 附 图 31/31 页 图23 74












