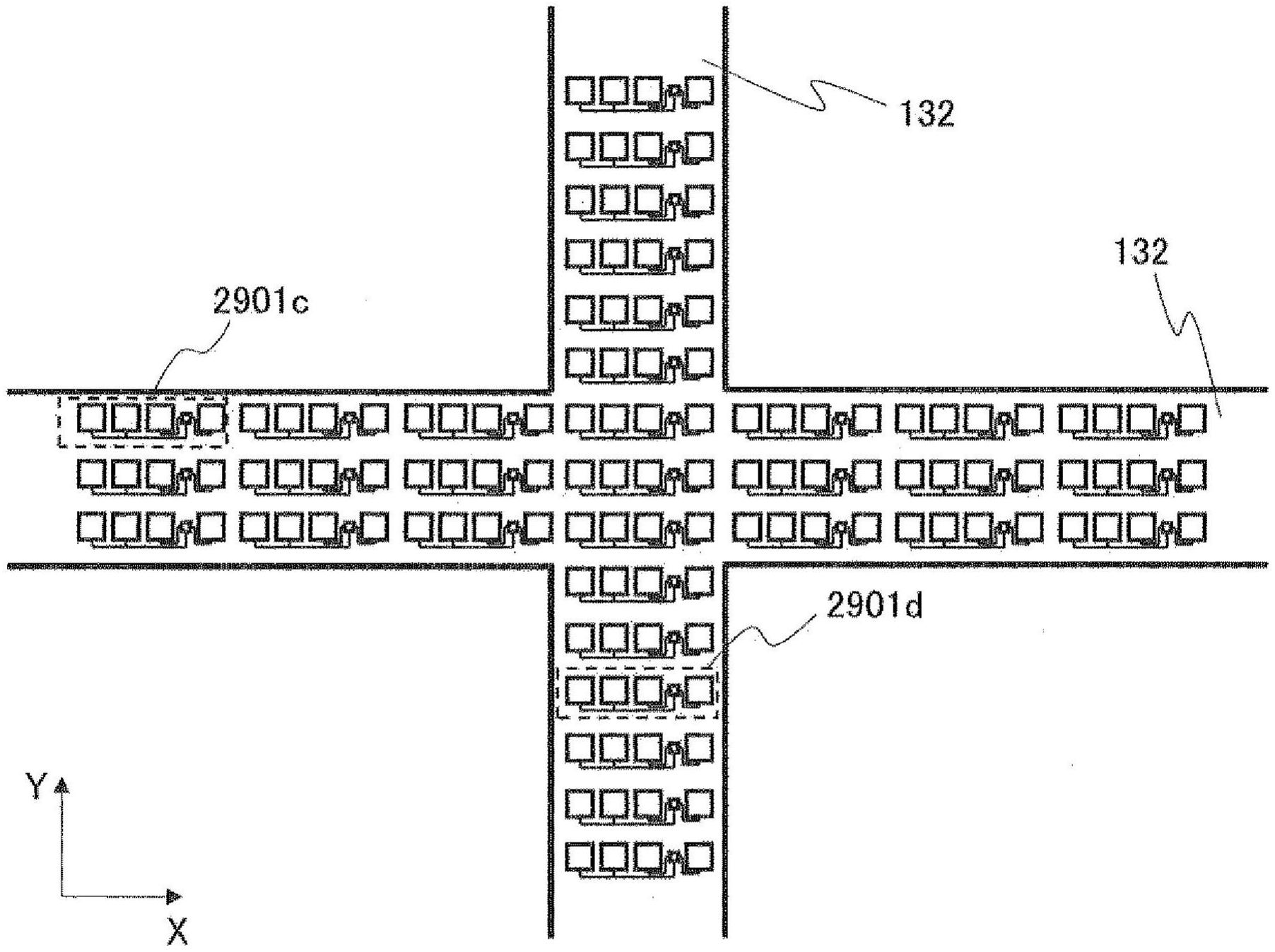
技术摘要:
随着半导体器件的微细化而具有晶圆上的划线区域也减少的倾向。因此,划线区域所配置的TEG也需要减小,并且需要高效地配置供探针接触用的电极焊垫。因此,需要使电极焊垫的高效布局与探针对应。本发明的目的是提供一种使容易进行电气特性评价的TEG的电极焊垫的布局、与 全部
背景技术:
在半导体装置的制造中,制造工序的管理技术对于提高产品的成品率、产量是很 重要的。在用于工序管理的检查装置中,有使探针直接接触试样来进行电气特性评价的装 置。 专利文献1公开了一种技术:对在半导体晶圆的划线区域上配置的多个用于评价 的试样(Test Element Group:测试元件组,以下称为TEG)进行测定,从而能够提高半导体 装置的成品率。专利文献2公开了一种技术:具备与试样室连接并暂时贮存试样的试样交换 室、以及在试样交换室与试样室之间输送试样的输送单元,将探针粗图像获取装置与电子 光学系统装置并列设置,并使试样载台和探针组件在探针粗图像获取装置的垂直方向的位 置与电子光学系统装置的垂直方向的位置之间沿着水平方向移动。专利文献3公开了一种 半导体检查装置,其构成为包括:向试样晶圆照射带电粒子束的带电粒子光学系统装置;在 试样室内自由地进行移动的试样载台;安装了设置有探针的探测器并在试样室内自由地进 行移动的探测器载台;当粗略接近探测器的位置时获取试样晶圆的光学图像的粗图像获取 组件;基于在使带电粒子束一边进行扫描一边进行照射时从试样晶圆放出的二次带电粒子 的检测信号来获取带电粒子图像的带电粒子图像获取组件;对从探针得到的电流或电压进 行检测的电流电压检测组件;以及控制计算机。 现有技术文献 专利文献 专利文献1:日本特开2002-217258号公报 专利文献2:日本特开2005-189239号公报 专利文献3:日本特开2013-187510号公报
技术实现要素:
发明所要解决的课题 伴随着半导体器件的微细化而具有晶圆上的划线区域也减少的倾向。因此,划线 区域所配置的TEG也需要减小,并需要有效地配置供探针接触用的电极焊垫。因此,需要使 探针与电极焊垫的有效布局对应。就专利文献1~3公开的技术而言,由于独立地安装各探 针而需要时间来进行使各探针与电极焊垫接触的控制。 本发明的目的在于,提供一种使易于进行电气特性评价的TEG的电极焊垫的布局 与探针对应的技术。 用于解决课题的方案 在本发明的半导体装置的制造方法中,通过呈扇状排列的多个探针、或者与采用 MEMS(Micro Electro Mechanical Systems:微机电系统)技术制造的探针对应的TEG的电 3 CN 111557041 A 说 明 书 2/16 页 极焊垫的布局来解决上述课题。 发明的效果 根据本发明,能够使易于进行电气特性评价的TEG的电极焊垫的布局与探针对应。 进而能够提高半导体装置制造的前工序的生产率。 附图说明 图1是本发明实施例的电气特性评价装置的概要图。 图2是本发明实施例的探针模块的概要图。 图3是试样例的半导体晶圆的概要图。 图4(a)是表示划线区域上的FETTEG的电极焊垫配置例的图。 图4(b)是表示划线区域上的微小FETTEG的电极焊垫配置例的图。 图5是表示探针模块的配置的一例的图。 图6(a)是表示划线区域上的FETTEG的电极焊垫配置例的图。 图6(b)是表示划线区域上的FETTEG的电极焊垫配置的变形例的图。 图6(c)是表示划线区域上的FETTEG的电极焊垫配置的变形例的图。 图7(a)是概要表示本发明实施例的安装了MEMS探针的探针模块的立体图。 图7(b)是概要表示本发明实施例的安装了MEMS探针的探针模块的俯视图。 图8(a)是本发明实施例的探针盒的与面向试样侧的相反侧的立体图。 图8(b)是本发明实施例的探针盒的面向试样侧的立体图。 图8(c)是本发明实施例的探针盒的面向试样侧的立体图。 图9是本发明实施例的MEMS探针的整体立体图。 图10是本发明实施例的MEMS探针的悬臂的立体图。 图11是本发明实施例的MEMS探针的俯视图。 图12是本发明实施例的MEMS探针的剖视图。 图13是本发明实施例的MEMS探针的制造流程图。 图14(a)是说明本发明实施例的MEMS探针的制造工序的图。 图14(b)是说明本发明实施例的MEMS探针的制造工序的图。 图14(c)是说明本发明实施例的MEMS探针的制造工序的图。 图14(d)是说明本发明实施例的MEMS探针的制造工序的图。 图14(e)是说明本发明实施例的MEMS探针的制造工序的图。 图14(f)是说明本发明实施例的MEMS探针的制造工序的图。 图14(g)是说明本发明实施例的MEMS探针的制造工序的图。 图14(h)是说明本发明实施例的MEMS探针的制造工序的图。 图14(i)是说明本发明实施例的MEMS探针的制造工序的图。 图14(j)是说明本发明实施例的MEMS探针的制造工序的图。 图14(k)是说明本发明实施例的MEMS探针的制造工序的图。 图14(l)是说明本发明实施例的MEMS探针的制造工序的图。 图14(m)是说明本发明实施例的MEMS探针的制造工序的图。 图15是本发明实施例的MEMS探针的俯视图。 4 CN 111557041 A 说 明 书 3/16 页 图16是本发明实施例的MEMS探针的俯视图。 图17是本发明实施例的MEMS探针的俯视图。 图18是本发明实施例的MEMS探针的俯视图。 图19是本发明实施例的MEMS探针的悬臂的立体图。 图20是本发明实施例的MEMS探针的悬臂的立体图。 图21是本发明实施例的MEMS探针的剖视图。 图22是本发明实施例的MEMS探针的整体立体图。 图23是本发明实施例的MEMS探针的俯视图。 图24是本发明实施例的MEMS探针的剖视图。 图25是本发明实施例的MEMS探针的剖视图。 图26是本发明实施例的MEMS探针的制造流程图。 图27(a)是说明本发明实施例的MEMS探针的制造工序的图。 图27(b)是说明本发明实施例的MEMS探针的制造工序的图。 图27(c)是说明本发明实施例的MEMS探针的制造工序的图。 图27(d)是说明本发明实施例的MEMS探针的制造工序的图。 图27(e)是说明本发明实施例的MEMS探针的制造工序的图。 图27(f)是说明本发明实施例的MEMS探针的制造工序的图。 图27(g)是说明本发明实施例的MEMS探针的制造工序的图。 图27(h)是说明本发明实施例的MEMS探针的制造工序的图。 图28(a)是表示探针与TEG的电极焊垫接触时的状态的概要图。 图28(b)是表示探针与TEG的电极焊垫接触时的状态的概要图。 图29(a)是表示划线区域上的FETTEG配置例的图。 图29(b)是表示划线区域上的FETTEG配置例的图。 图30是用于确认探针盒的各探针正常度的电极焊垫例的概要图。 图31是利用探针盒进行电气特性评价的流程图的例子的图。 图32(a)是表示照射带电粒子束来进行电气特性测定的例子的图。 图32(b)是表示以不照射带电粒子束的状态来进行电气特性测定的例子的图。 图33是表示吸收电流图像的例子的图。 图34是表示半导体装置制造工序中的前工序流程的例子的图。 图35是表示本发明的半导体装置的制造工序的例子的图。












