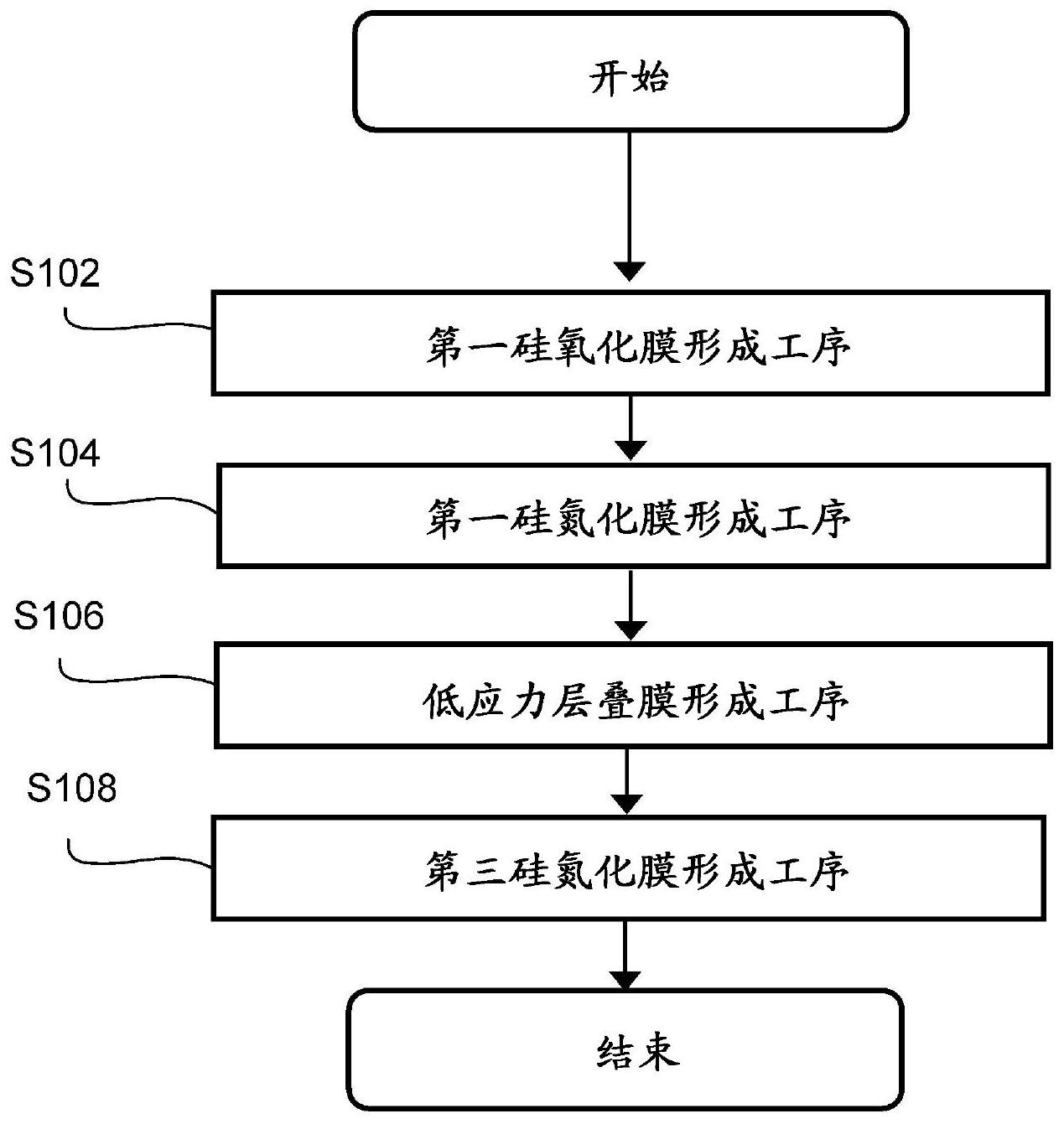
技术摘要:
本发明涉及半导体器件的制造方法、衬底处理装置及记录介质。本发明的课题在于针对构成为具有振动的膜的半导体器件,提供使该膜对振动的耐受性提高的技术。作为形成可振动绝缘膜的工序,至少具备形成第一硅氧化膜的工序、形成第一硅氮化膜的工序、形成第二硅氧化膜的工 全部
背景技术:
近年来,用超声波对人体内进行诊断的超声波诊断装置正被使用。超声波诊断装 置中,使用作为超声波换能器发挥功能的CMUT(电容式微机械超声波换能器,Capacitive Micromachined Ultrasonic Transducer)器件。就CMUT器件而言,其利用作为半导体制造 技术的一种的MEMS(微机电系统,Micro Electro Mechanical System)技术而形成,且构成 为:具有薄膜结构(membrane structure)的振动膜,通过使该振动膜振动,从而向外部发射 超声波或者检测来自外部的超声波(例如,参见专利文献1)。 现有技术文献 专利文献 专利文献1:日本特开2016-072661号公报
技术实现要素:
发明要解决的课题 CMUT器件中,振动膜反复振动很多次,因而支撑该振动膜的薄膜结构可能劣化。薄 膜结构的劣化会导致例如对置电极彼此的接触(其由振动膜的弯曲带来)等,因而可能导致 产生CMUT器件的不良情况。 本发明针对如CMUT器件这样构成为具有振动的膜的半导体器件,提供使该膜对振 动的耐受性提高的技术。 用于解决课题的手段 根据一个方式,提供下述技术,其为涉及制造具有可振动绝缘膜的半导体器件的 技术,其中, 作为形成上述绝缘膜的工序,至少具备形成第一硅氧化膜的工序、形成第一硅氮 化膜的工序、形成第二硅氧化膜的工序、和形成第二硅氮化膜的工序, 使用下述衬底处理装置进行上述各工序,所述衬底处理装置构成为对具有上部电 极及下部电极的处理室进行气体供给,并且构成为利用开关切换来来选择性地对上述上部 电极和上述下部电极中的各自供给高频电力或低频电力中的任意, 在上述形成第一硅氧化膜的工序中,对上述处理室供给含硅气体和含氧气体,并 且以对上述上部电极供给高频电力且对上述下部电极供给低频电力的方式进行开关切换, 在上述形成第一硅氮化膜的工序中,对上述处理室供给含硅气体和含氮气体,并 且以对上述上部电极供给高频电力且对上述下部电极供给低频电力的方式进行开关切换, 在上述形成第二硅氧化膜的工序中,对上述处理室供给含硅气体和含氧气体,并 且以对上述上部电极供给低频电力且对上述下部电极供给高频电力的方式进行开关切换, 在上述形成第二硅氮化膜的工序中,对上述处理室供给含硅气体和含氮气体,并 5 CN 111593323 A 说 明 书 2/16 页 且以对上述上部电极供给低频电力且对上述下部电极供给高频电力的方式进行开关切换。 发明的效果 根据本发明涉及的技术,针对构成为具有振动的膜的半导体器件,能够使该膜对 振动的耐受性提高。 附图说明 [图1]为示出作为半导体器件的一种的CMUT器件的构成例的截面图。 [图2]为示意性地示出本发明的一个实施方式涉及的衬底处理装置的概略构成例 的侧截面图。 [图3]为示意性地示出本发明的一个实施方式涉及的衬底处理装置所具有的气体 供给部的构成例的框图。 [图4]为示意性地示出本发明的一个实施方式涉及的衬底处理装置所具有的控制 器的构成例的框图。 [图5]为示出通过本发明的一个实施方式涉及的衬底处理装置进行的成膜工序的 基本步骤的流程图。 [图6]为示出通过本发明的一个实施方式涉及的衬底处理装置进行的部分成膜工 序的详细步骤的流程图。 [图7]为示出通过本发明的一个实施方式涉及的衬底处理装置进行的成膜工序时 实施的开关切换的具体方式的说明图。 [图8]为示意性地示出由通过本发明的一个实施方式涉及的衬底处理装置进行的 成膜工序所形成的绝缘膜的构成例的侧截面图。 附图标记说明 100...衬底、104...下部电极、107...空洞部、106、109、110...绝缘膜、108...上 部电极、111...SiO膜(第一硅氧化膜)、112...SiN膜(第一硅氮化膜)、113...SiO膜(第二硅 氧化膜)、114...SiN膜(第二硅氮化膜)、115...低应力层叠膜、116...SiN膜(第三硅氮化 膜)、130...孔部、200...衬底处理装置、201...处理室、215...下部电极、230...簇射头(上 部电极)、240...第一气体供给部、250...第二气体供给部、260...第三气体供给部、287、 288...开关切换部、291...低频电力供给部、292...高频电力供给部、400...控制器












