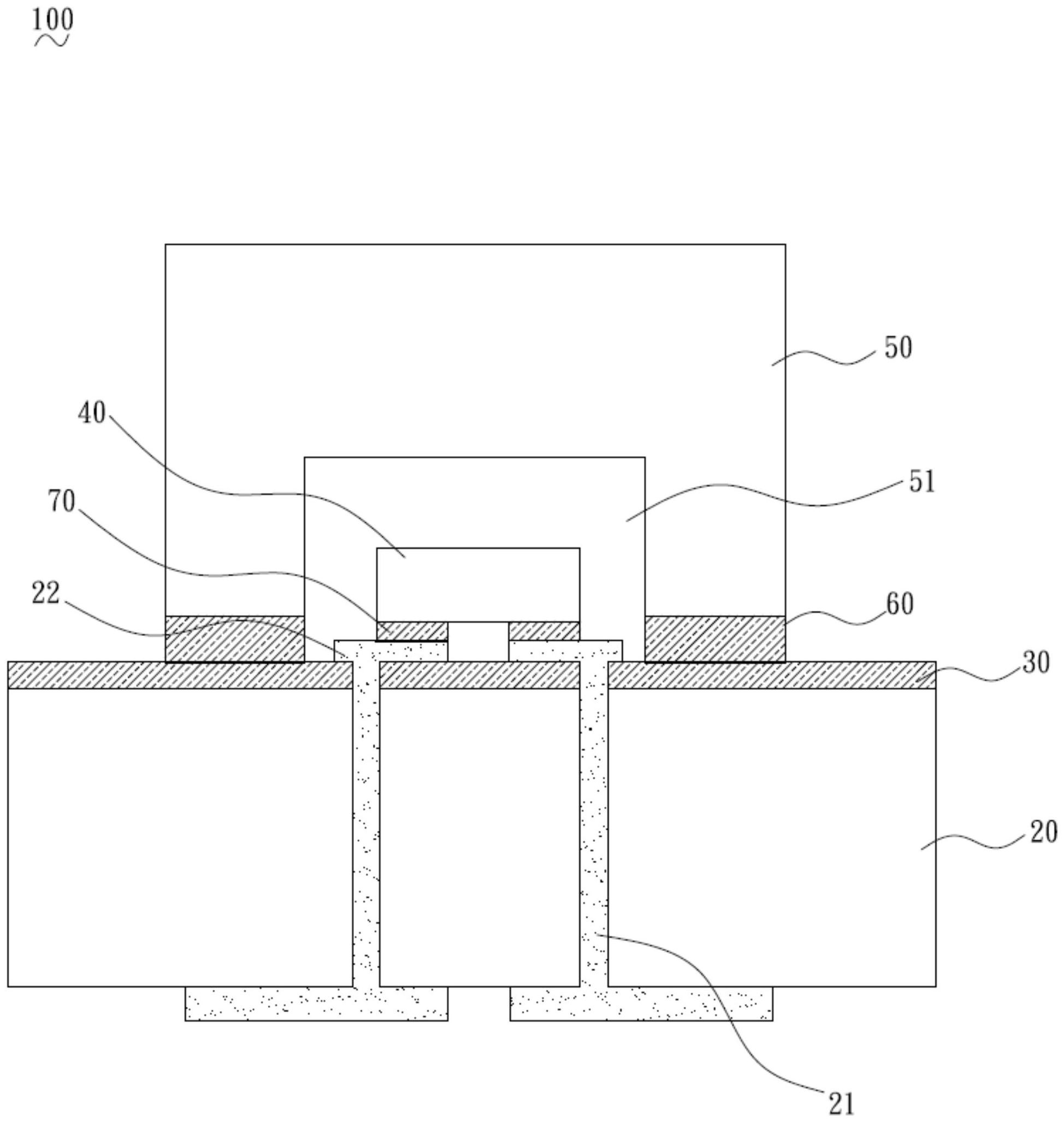
技术摘要:
本发明涉及LED封装技术领域,具体涉及LED光源的封装结构及封装方法,LED光源的封装结构包括基板、附着于基板一侧的基板金锡合金层、安装于基板上的LED芯片、连接基板的透明碗杯及附着于透明碗杯的碗杯金锡合金层,碗杯金锡合金层位于透明碗杯靠近基板金锡合金层的一侧 全部
背景技术:
UV-LED(紫外LED)光源相对于传统UV光源具有环保、低功耗和波段可选等优势,主 要应用在生物医疗、防伪鉴定、净化(水、空气等)领域、杀菌消毒、计算机数据存储和军事等 方面,通常会面临多方面的挑战,其中可靠性问题尤为突出。UV-LED器件的气密性高低受制 于封装材料的透湿透氧率和封装工艺水平等。如果封装材料的透湿透氧率高,则器件的气 密性就差,外界环境中的有害物质容易透过封装材料侵入器件内部而导致器件失效。光源 器件的气密性差将会引发各种可靠性问题,而气密性差的缺陷取决于透镜的气密性焊接材 料的好与坏。 传统技术中,一般采用有机材料封装UV-LED光源,但有机材料具有抗UV性能差和 透湿透氧率高的特性,其性能的劣化会大幅降低UV-LED的可靠性。而且,有机材料长时间受 UV照射会发生光降解(有氧环境下发生光氧化),出现老化和黄化现象,严重的甚至出现开 裂,使得器件的光效和可靠性大幅下降,最终导致失效,这种现象在深紫外波段尤其严重。
技术实现要素:
基于此,有必要针对目前传统技术的问题,提供一种LED光源的封装结构,,无需有 机胶进行化学键合粘接工艺,实现了无机气密封装焊接,提高了LED光源的可靠性,延长了 起见的使用寿命。 本发明还提供了上述LED光源的封装结构的制备方法,即该LED光源的封装方法。 一种LED光源的封装结构,包括基板、附着于基板一侧的基板金锡合金层、安装于 基板上的LED芯片、连接基板的透明碗杯及附着于透明碗杯的碗杯金锡合金层,碗杯金锡合 金层位于透明碗杯靠近基板金锡合金层的一侧,透明碗杯的中部开设有内腔,内腔具有腔 口,内腔开口朝向基板,透明碗杯罩设于LED芯片的外周,且LED芯片位于内腔内,透明碗杯 通过基板金锡合金层与碗杯金锡合金层的共晶焊接连接基板。 本发明LED光源的封装结构的有益效果为:采用基板金锡合金层与碗杯金锡合金 层通过共晶焊接进行无缝物理键合,无需有机胶进行化学键合粘接,从而实现无机气密封 装焊接,金锡合金具有高耐腐蚀性、高抗蠕变性及抗UV性,透湿透氧率低,有效密封LED光源 的内部结构,提高了LED光源的可靠性,及延长了起见的使用寿命,可应用于普通LED光源和 紫外LED光源,尤其深紫外LED光源。 对上述方案的进一步改进为,基板金锡合金层与碗杯金锡合金层的厚度分别为10 ~30μm。 对上述方案的进一步改进为,透明碗杯为石英玻璃或蓝宝石材质。 对上述方案的进一步改进为,基板为氮化铝材质。 对上述方案的进一步改进为,LED光源的封装结构还包括附着于LED芯片一侧的芯 3 CN 111584702 A 说 明 书 2/6 页 片金锡合金层。 对上述方案的进一步改进为,基板具有导电线路,导电线路具有线路电极,LED芯 片通过芯片金锡合金层与线路电极的焊接连接导电线路。 一种LED光源的封装方法,包括以下步骤: 提供基板,基板具有导电线路,导电线路具有线路电极,于基板的一侧加工形成基 板金锡合金层,并使线路电极的端部突出基板金锡合金层的外部; 将LED芯片安装于基板上,并连接线路电极; 提供透明材料,于透明材料的一侧加工形成碗杯金锡合金层; 进行光学透明碗杯设计,自碗杯金锡合金层所在的一侧开始对透明材料进行加 工,于透明材料的中间部分加工形成内腔,获得透明碗杯; 通过基板金锡合金层与碗杯金锡合金层的焊接将透明碗杯连接基板,并将LED芯 片包围于透明碗杯与基板之间。 本发明LED光源的封装方法的有益效果为:根据封装结构及封装材料的特性,优化 了工序,操作简易,易于调控产品质量。 对上述方案的进一步改进为,将LED芯片安装于所述基板上,并连接所述线路电极 的具体操作为:提供LED芯片,于所述LED芯片的一侧加工形成芯片金锡合金层;将所述芯片 金锡合金层的位置对应所述线路电极,并焊接所述线路电极。 对上述方案的进一步改进为,在提供基板,基板具有导电线路,导电线路具有线路 电极,在基板的一侧加工形成基板金锡合金层,并使线路电极的端部突出基板金锡合金层 的外部的步骤中,加工形成基板金锡合金层的方法为磁控溅射或电镀。 对上述方案的进一步改进为,在将芯片金锡合金层的位置对应线路电极,并焊接 线路电极的步骤中,采用激光局部加热封装或超声波焊接的方法将芯片金锡合金层焊接线 路电极。 对上述方案的进一步改进为,在进行光学透明碗杯设计,自碗杯金锡合金层所在 的一侧开始对透明材料进行加工,于透明材料的中间部分加工形成内腔,获得透明碗杯的 步骤中,采用激光加工或机械加工的方法形成内腔。 对上述方案的进一步改进为,在通过基板金锡合金层与碗杯金锡合金层的焊接将 透明碗杯连接基板,并将LED芯片包围于透明碗杯与基板之间的步骤中,采用激光局部加热 封装或超声波焊接的方法将基板金锡合金层共晶焊接碗杯金锡合金层。 对上述方案的进一步改进为,进行光学透明碗杯设计,自碗杯金锡合金层所在的 一侧开始对透明材料进行加工,于透明材料的中间部分加工形成内腔,获得透明碗杯的步 骤之后,对透明碗杯进行表面维纳结构粗化。 附图说明 图1为实施例1LED光源的封装结构的示意图; 图2为实施例1LED光源的封装方法的工艺流程图; 图3为实施例1步骤S300加工形成的具有碗杯金锡合金层的透明材料的示意图; 图4为实施例1步骤S400中的多个透明碗杯的示意图; 图5为实施例1步骤S400中多个透明碗杯切割后单个透明碗杯的示意图; 4 CN 111584702 A 说 明 书 3/6 页 图6为实施例2LED光源的封装方法的工艺流程图。 附图标记说明: 基板20,导电线路21,线路电极22,基板金锡合金层30,LED芯片40,透明碗杯50,内 腔51,碗杯金锡合金层60,芯片金锡合金层70,透明材料80,LED光源的封装结构100。












