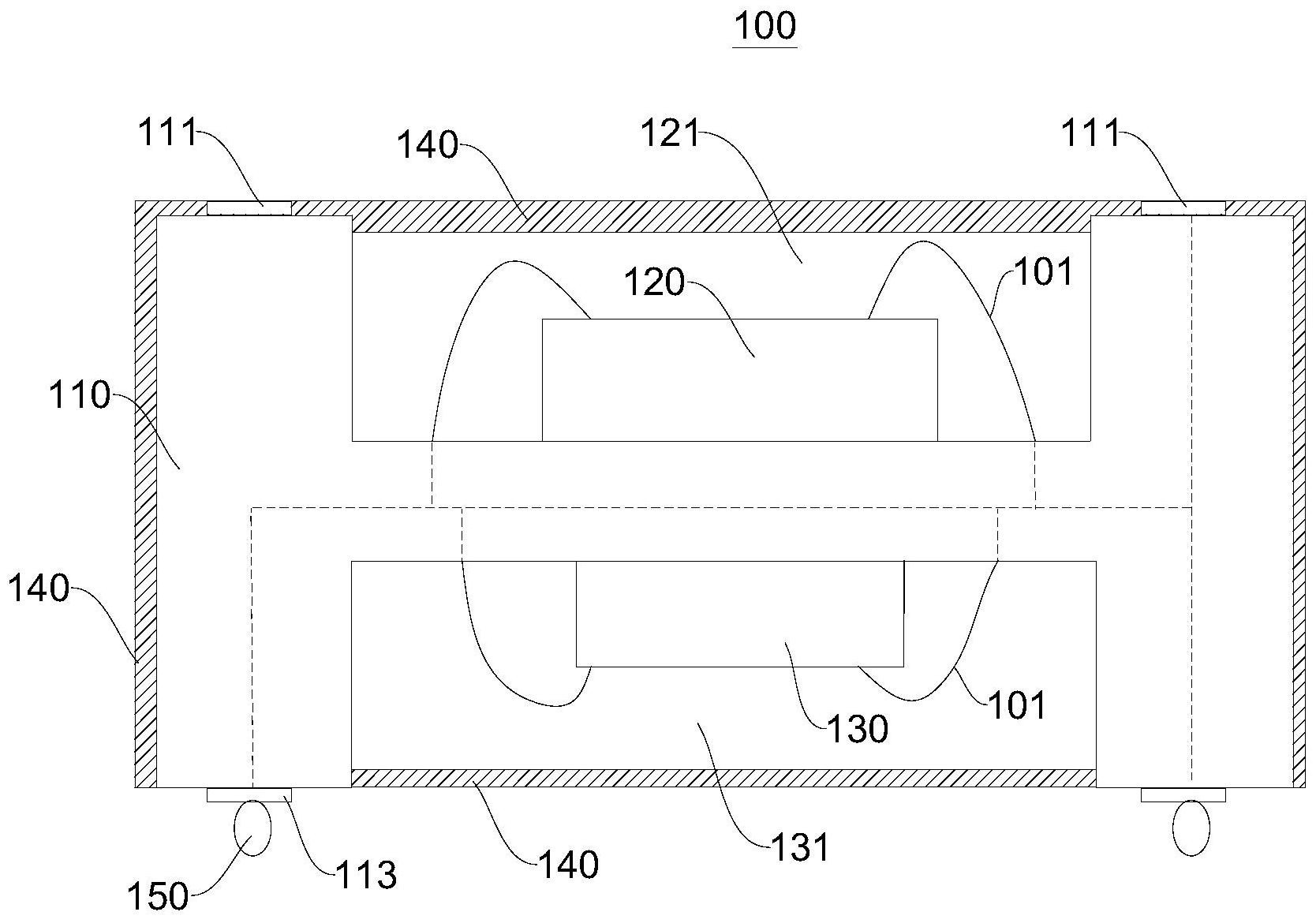
技术摘要:
本发明提供了一种具有电磁屏蔽功能的封装体和封装工艺,涉及电子产品领域。该封装体包括封装基板、第一芯片、第二芯片、第一塑封件、第二塑封件和屏蔽层。封装基板包括相对设置的第一安装面和第二安装面,第一芯片设于第一安装面,第二芯片设于第二安装面;第一塑封件 全部
背景技术:
在电子器件领域里,有很多对电磁干扰较为敏感的集成电路芯片(Integrated Circuit,简称:IC),例如射频芯片,尤其是高频射频芯片,这些芯片在工作前必须对其做好 电磁屏蔽,否则受电磁干扰,难以进行正常工作。 随着半导体行业的快速发展,电子产品微型化越来越高密度,功能越来越多,产品 尺寸越来越小,因此,双面芯片封装结构广泛应用于半导体行业中。它将不同功能的芯片封 装在基板双面(正面/背面),具有高密度集成、封装产品尺寸小、产品性能优越等优势,双面 芯片封装产品主要应用于微型化和薄型化的通信终端产品上。 现有的双面芯片封装结构以及方法中,无法实现电磁屏蔽功能,故难以满足通信 领域中高频信号的产品需求。
技术实现要素:
本发明的目的包括,例如,提供了一种具有电磁屏蔽功能的封装体,其能够实现良 好的电磁屏蔽功能,抗干扰能力好,产品应用范围广。 本发明的目的包括,例如,提供了一种封装工艺,有利于提高封装体质量,并且具 有良好的电磁屏蔽功能。 本发明的实施例可以这样实现: 第一方面,本发明实施例提供一种具有电磁屏蔽功能的封装体,包括封装基板、第 一芯片、第二芯片、第一塑封件、第二塑封件和屏蔽层; 所述封装基板包括相对设置的第一安装面和第二安装面,所述第一芯片设于所述 第一安装面,所述第二芯片设于所述第二安装面;所述第一塑封件设于所述第一安装面以 塑封所述第一芯片,所述第二塑封件设于所述第二安装面以塑封所述第二芯片; 所述第一安装面设有至少一个接地焊盘,所述第二安装面设有植球焊盘;所述屏 蔽层罩设于所述第一塑封件和所述封装基板,所述接地焊盘和所述屏蔽层连接。 在可选的实施方式中,所述封装基板还包括依次相连的第一侧面、第二侧面、第三 侧面和第四侧面,所述第一侧面、所述第二侧面、所述第三侧面和所述第四侧面均设于所述 第一安装面和所述第二安装面之间,并分别与所述第一安装面和所述第二安装面相连; 所述屏蔽层覆设于所述第一安装面、所述第一侧面、所述第二侧面、所述第三侧面 和所述第四侧面。 在可选的实施方式中,所述屏蔽层还覆设于所述第二安装面,且与所述植球焊盘 间隔设置。 在可选的实施方式中,所述第一安装面设有第一凹槽,所述第一芯片安装于所述 4 CN 111554674 A 说 明 书 2/8 页 第一凹槽,所述第一塑封件设于所述第一凹槽内;所述第二安装面设有第二凹槽,所述第二 芯片安装于所述第二凹槽,所述第二塑封件设于所述第二凹槽内;所述接地焊盘设于所述 第一凹槽之外,所述植球焊盘设于所述第二凹槽之外。 在可选的实施方式中,所述第一塑封件远离所述第一凹槽的槽底的一面低于所述 第一凹槽的槽口,所述第二塑封件远离所述第二凹槽的槽底的一面低于所述第二凹槽的槽 口。 在可选的实施方式中,所述第一塑封件远离所述第一凹槽的槽底的一面设有所述 屏蔽层。 第二方面,本发明实施例提供一种封装工艺,包括: 提供一封装基板:所述封装基板包括相对设置的第一安装面和第二安装面,所述 第一安装面设有至少一个接地焊盘,所述第二安装面设有植球焊盘; 封装第一芯片:所述第一芯片设于所述第一安装面,对所述第一芯片进行封装; 封装第二芯片:所述第二芯片设于所述第二安装面,对所述第二芯片进行封装; 制作屏蔽层:在所述封装基板表面覆设屏蔽层,且所述屏蔽层与所述接地焊盘连 接。 在可选的实施方式中,所述制作屏蔽层的步骤包括: 采用整体喷涂方式,在所述封装基板表面形成屏蔽层。 在可选的实施方式中,所述提供一封装基板的步骤还包括: 在所述封装基板的第一表面设置第一凹槽,所述接地焊盘位于所述第一凹槽之 外;在所述封装基板的第二表面设置第二凹槽,所述植球焊盘位于所述第二凹槽之外。 在可选的实施方式中,所述封装第一芯片的步骤包括: 在所述第一凹槽内安装所述第一芯片,采用印刷方式在所述第一凹槽内形成第一 塑封件,且所述第一塑封件低于所述第一凹槽的槽口; 在所述第二凹槽内安装所述第二芯片,采用印刷方式在所述第二凹槽内形成第二 塑封件,且所述第二塑封件低于所述第二凹槽的槽口。 本发明实施例提供的具有电磁屏蔽功能的封装体和封装工艺,其有益效果包括, 例如: 该具有电磁屏蔽功能的封装体包括封装基板、第一芯片、第二芯片、第一塑封件、 第二塑封件和屏蔽层。封装基板包括相对设置的第一安装面和第二安装面,在第一安装面 设有至少一个接地焊盘,在第二安装面设有植球焊盘;屏蔽层罩设于第一塑封件和封装基 板,并且接地焊盘和屏蔽层连接,能实现良好的电磁屏蔽功能,能够满足通信领域高频信号 的产品需求,抗干扰能力强,产品质量更高。 本发明实施例提供的封装工艺,分别在封装基板的第一安装面和第二安装面上设 置接地焊盘和植球焊盘,并在封装基板表面设置屏蔽层,通过接地焊盘和屏蔽层连接,实现 电磁屏蔽功能,抗干扰能力强,该封装工艺有利于提高封装体的质量。 附图说明 为了更清楚地说明本发明实施例的技术方案,下面将对实施例中所需要使用的附 图作简单地介绍,应当理解,以下附图仅示出了本发明的某些实施例,因此不应被看作是对 5 CN 111554674 A 说 明 书 3/8 页 范围的限定,对于本领域普通技术人员来讲,在不付出创造性劳动的前提下,还可以根据这 些附图获得其他相关的附图。 图1为本发明实施例提供的具有电磁屏蔽功能的封装体的整体结构示意图; 图2为本发明实施例提供的具有电磁屏蔽功能的封装体的封装基板的结构示意 图; 图3为本发明实施例提供的封装工艺的主要步骤示意框图; 图4为本发明实施例提供的封装工艺中,安装第二芯片的示意图; 图5为本发明实施例提供的封装工艺中,封装第二芯片的示意图; 图6为本发明实施例提供的封装工艺中,安装第一芯片的示意图; 图7为本发明实施例提供的封装工艺中,封装第一芯片的示意图; 图8为本发明实施例提供的封装工艺中,制作屏蔽层的示意图; 图9为本发明实施例提供的封装工艺中植球的示意图; 图10为本发明实施例提供的封装工艺中冲压前部分封装产品的结构示意图。 图标:100-具有电磁屏蔽功能的封装体;101-导线;110-封装基板;111-接地焊盘; 113-植球焊盘;115-第一安装面;116-第二安装面;117-第一凹槽;118-第二凹槽;120-第一 芯片;121-第一塑封件;130-第二芯片;131-第二塑封件;140-屏蔽层;150-金属焊球。












