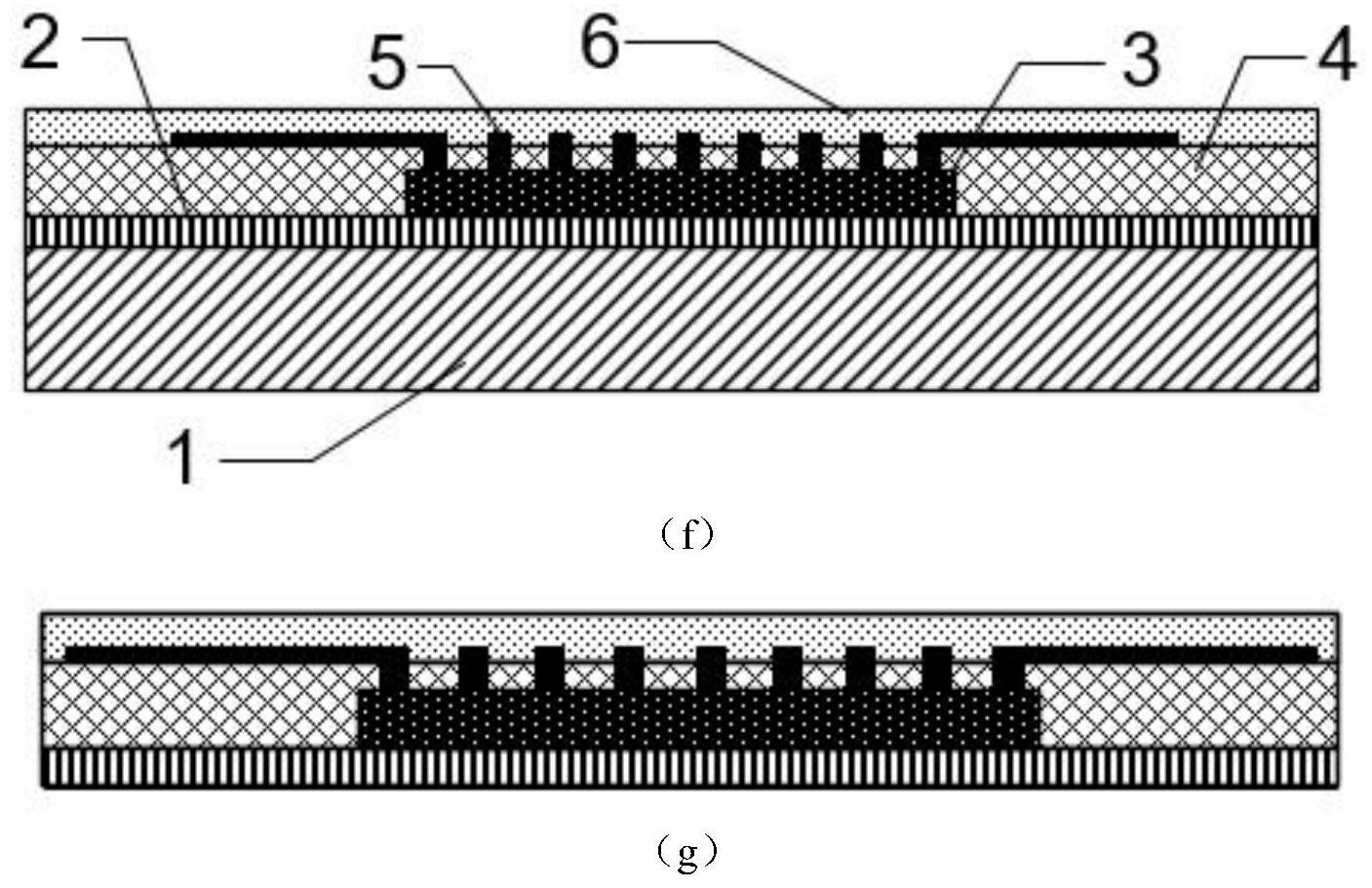
技术摘要:
本发明公开了一种一种IC芯片柔性化制造方法,属于芯片制造技术和半导体技术领域。该方法将裸芯片贴合在衬底表面,形成基体;在所述基体表面旋涂第一层柔性聚合物将芯片完全包埋,包埋厚度30‑100μm;在所述柔性聚合物表面形成电路通道;通过刻蚀和金属溅射工艺实现裸 全部
背景技术:
: 随着半导体技术的发展,芯片制造水平不断提高,柔性电子显著推动IC芯片趋向 柔性化,柔性芯片在电子通信、医疗及军事等领域成为新的发展需求,因此IC芯片柔性化制 造具有重要意义。 检索发现,中国专利文献号CN210073815U,记载了“一种柔性芯片封装结构”,该结 构将柔性支撑薄膜设置于柔性电路板与柔性芯片之间,柔性支撑薄膜具有多孔结构,可增 强芯片封装结构的弯曲变形能力,从而实现芯片封装结构的柔性化。其柔性电路板与柔性 芯片通过金丝键合线电性互连,最后进行柔性薄膜塑封。然而金丝键合点处容易受到外力 的作用,产生应力破坏,这将有可能导致键合点处脱焊,且密集的键合线在塑封过程中极易 相互影响使所制芯片失效。 检索发现,中国专利文献号CN110444480A,记载了一种“制作柔性芯片的方法”,该 方法通过对芯片减薄,使得所制柔性芯片耐弯折性较强,而且克服了柔性芯片在制作流转 过程中容易破裂和损坏的问题,在一定程度上简化了柔性芯片的制作工艺。但该芯片在柔 性化制造过程中,采用将预制芯片焊接到柔性基板上的方法,容易造成芯片电路层金属凸 点与柔性板连接失效,导致性能不可靠。 基于上述专利分析可知,柔性电路板与柔性芯片通过金丝键合线电性互连容易导 致键合点断裂,而且密集的键合线在塑封过程中相互影响,因此导致电路连接不可靠、产品 良率较低等问题;柔性线路板与芯片通过焊接凸点进行过渡连接容易在机械循环试验中出 现不可靠和低寿命的问题。
技术实现要素:
: 本发明的目的是:制作柔性芯片时会对刚性硅片进行减薄处理,而直接使用减薄 后的硅片制作柔性芯片时,因硅片很薄,若使用现有的制作常规芯片的设备和工艺,在制作 过程中很容易碎裂,所制作的柔性芯片可靠性和产品良率较低,并且需要开发新的设备和 工艺,生产成本较高。为实现IC芯片柔性化,避免制造过程中芯片破损,解决制造过程中芯 片电路连接不可靠的问题,本发明提出一种IC芯片柔性化制造方法。 本发明所采用的制造方法包括:提供裸芯片;将裸芯片贴合在衬底表面,形成基 体;在所述基体表面旋涂第一层柔性聚合物将芯片完全包埋,包埋厚度30-100μm;在所述柔 性聚合物表面形成电路通道;通过刻蚀和金属溅射工艺实现裸芯片引脚端口与电路通道互 联互通;在所述已形成电路通道的柔性聚合物表面再旋涂第二层柔性聚合物形成完整封 装;将上述形成完整封装的芯片进行切割,通过直接剥离完成与衬底的分离,获得柔性芯 片,完成所述芯片柔性化制造。 3 CN 111613579 A 说 明 书 2/3 页 所述第二层柔性聚合物的抗拉强度大于第一层的柔性聚合物。 更进一步的,所述衬底材料为硅、蓝宝石或玻璃; 更进一步的,所述将裸芯片非引脚面贴合在衬底表面形成基体,通过在衬底表面 涂热熔型粘合剂实现,具体可以为聚氨酯、聚苯乙烯、聚丙烯酸酯、苯并环丁烯等; 更进一步的,所述基体表面旋涂柔性聚合物,其材料包括聚酰亚胺、苯并环丁烯、 六甲基二硅胺烷、聚二甲基硅氧烷,使所制备的芯片具有良好的柔性与抗拉强度,避免内部 芯片因外部冲击、撕拉等因素受到破坏; 更进一步的,所述在所述柔性聚合物表面形成电路通道,包括:在所述柔性聚合物 表面通过刻蚀形成微通孔;微通孔通过溅射金属形成电路通道,电路通道与芯片I/O端口相 连。在水平方向上,通过电镀及刻蚀工艺形成芯片引脚与其他电子元件相连的电路通道; 更进一步的,在所述已形成电路通道的柔性聚合物表面再旋涂柔性聚合物,其材 料包括聚酰亚胺、苯并环丁烯、六甲基二硅胺烷、聚二甲基硅氧烷,通过完全涂覆,增强芯片 内部柔韧性。 本发明的有益效果是:利用现有的制作常规芯片的设备和工艺通过涂覆粘合剂、 旋涂柔性聚合物等工艺,IC裸芯片实现柔性化制造,不但增强了芯片的柔韧性,还极大地保 护了内部芯片。由于芯片性能极易受到外部环境影响,传统的键合线互连工艺容易因冲击、 振动等因素影响连接不牢,而通过溅射金属电路将其逐层引出的方式避免了这一缺点。由 于溅射工艺密度高、针孔少,可控性和重复性好,溅射金属与芯片引脚的附着牢固,电路通 道连接比焊接工艺更加可靠避免了因金属线键合、电路连接不可靠导致产品良率低的问 题,节省成产成本,提高柔性芯片的产品可靠性和产品良率。 附图说明 图1是本实施例中IC芯片柔性化制造工艺过程示意图。 图中,1-衬底,2-粘合剂,3-裸芯片,4-第一柔性聚合物,5-电路通道,6-第二柔性 聚合物。












