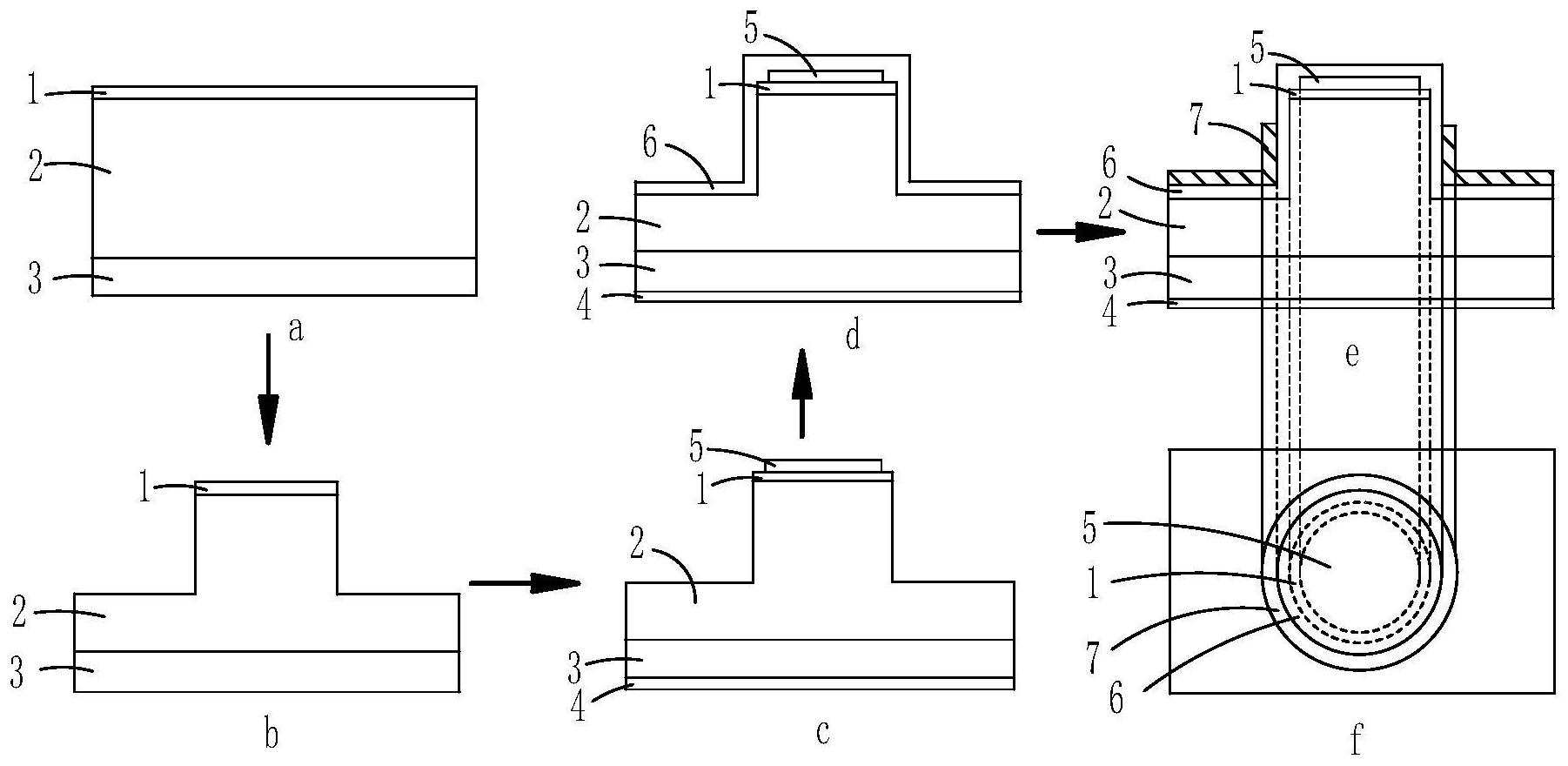
技术摘要:
本发明提供了一种垂直结构金刚石基金氧半场效晶体管及制备方法,属于半导体技术领域,包括:在高浓度重掺杂P型金刚石衬底的正面生长低浓度轻掺杂p型金刚石外延层;在缓冲层的上表面生长高浓度重掺杂p型金刚石外延层;光刻源区图形,刻蚀出柱状源区和栅区;在柱状源区的 全部
背景技术:
电力电子系统越来越趋向于小型化、高功率、低损耗,这就对功率半导体器件提出 了更高的要求。金刚石的禁带宽度大,击穿电场高,热导率高,同时,金刚石半导体材料还具 有高的电子和空穴迁移率。金刚石材料以其优异的特性被称为第四代半导体材料。其在电 力电子器件方面的特性优值,显著优于SiC和GaN材料,是制作大功率、高频、高温、低功率损 耗电力电子器件的理想材料。功率MOSFET(金属-氧化物半导体场效应晶体管,简称金氧半 场效晶体管,Metal-Oxide-Semiconductor Field-Effect Transistor,MOSFET)是一种可 以广泛使用在模拟电路与数字电路的场效晶体管(field-effect transistor),作为全控 的半导体开关器件,在电力系统中具有很重要的作用。 目前大部分研究集中在金刚石肖特基势垒二极管、金刚石MESFET (Metal Semiconductor Field Effect Transistor)、以及金刚石材料作为其他材料器件散热层等 方面,金刚石MESFET栅极和金刚石沟道形成肖特基接触,这就导致了漏极只能加正电压,而 且反向漏电较大,而金刚石功率MOSFET的研究还处于空白。
技术实现要素:
本发明的目的在于提供一种垂直结构金刚石基金氧半场效晶体管,以解决现有金 刚石MESFET栅极和金刚石沟道形成肖特基接触,反向漏电较大的问题。 为实现上述目的,本发明采用的技术方案是:提供一种垂直结构金刚石基金氧半 场效晶体管,包括:在高浓度重掺杂P型金刚石衬底的正面生长低浓度轻掺杂p型金刚石外 延层,作为缓冲层;在所述缓冲层的上表面生长高浓度重掺杂p型金刚石外延层; 光刻源区图形,刻蚀出柱状源区和栅区,其中,有源区在所述柱状源区的顶部,栅 区在所述柱状源区的侧壁; 在所述柱状源区的顶部光刻出源区图形窗口,淀积源极金属,形成源电极;在所述 高浓度重掺杂P型金刚石衬底的背面淀积漏极金属,形成漏电极,经过退火形成源极欧姆接 触和漏极欧姆接触; 在所述柱状源区的顶部、侧壁及周围沉积栅介质,其中所述栅介质覆盖所述源电 极的表面; 在所述栅介质上光刻出栅形貌,剥离形成栅电极; 淀积钝化保护层; 光刻制作电极图形。 作为本申请另一实施例,所述在高浓度重掺杂P型金刚石衬底的正面生长低浓度 轻掺杂p型金刚石外延层,作为缓冲层,在所述缓冲层的上表面生长高浓度重掺杂p型金刚 4 CN 111599681 A 说 明 书 2/5 页 石外延层,具体包括:所述低浓度轻掺杂p型金刚石外延层的厚度为1nm-100μm;所述高浓度 重掺杂p型金刚石外延层的厚度为1nm-10μm;其中,所述轻掺杂的浓度为1×1014cm-3至1× 1017cm-3,所述重掺杂的浓度为1×1018cm-3至1×1022cm-3。 作为本申请另一实施例,所述光刻源区图形,刻蚀出柱状源区和栅区,其中,有源 区在所述柱状源区的顶部,栅区在所述柱状源区的侧壁,具体包括:采用干法刻蚀,刻蚀深 至所述缓冲层;所述柱状源区为圆柱体。 作为本申请另一实施例,所述在所述柱状源区的顶部光刻出源区图形窗口,淀积 源极金属,形成源电极;在所述高浓度重掺杂P型金刚石衬底的背面淀积漏极金属,形成漏 电极,经过退火形成源极欧姆接触和漏极欧姆接触,具体包括:通过电子束蒸发分别淀积所 述源极金属和漏极金属;所述源电极和漏电极采用Ti、Pt、Au、Ir中的一种或者多种的组合, 经过高温合金退火后形成。 作为本申请另一实施例,在所述柱状源区的顶部、侧壁及周围沉积栅介质,其中所 述栅介质覆盖所述源电极的表面,具体包括:所述栅介质包括Al2O3、SiNx、SiO2、TiO2、MoO3、 AlN中的一种或多种;厚度为5nm-500nm。 作为本申请另一实施例,所述在所述栅介质上光刻出栅形貌,剥离形成栅电极,具 体包括:所述栅电极为Al、Ni、Ti、Au中的一种或者多种的组合形成,并与所述低浓度轻掺杂 p型金刚石外延层形成肖特基结。 作为本申请另一实施例,所述栅电极覆盖所述柱状源区的四周,并向上延伸至所 述柱状源区的侧壁。 作为本申请另一实施例,所述钝化保护层包括Al2O3、SiNx、SiO2、TiO2、MoO3、AlN中 的一种或多种;厚度为5nm-20μm之间。 作为本申请另一实施例,所述光刻制作电极图形,具体包括:通过干法刻蚀或者湿 法刻蚀腐蚀出所述电极图形,并对所述电极图形进行加厚处理。 本发明的另一目的在于提供一种垂直结构金刚石基金氧半场效晶体管,包括高浓 度重掺杂P型金刚石衬底、低浓度轻掺杂p型金刚石外延层、高浓度重掺杂p型金刚石外延 层、源电极、栅电极、漏电极、栅介质; 所述低浓度轻掺杂p型金刚石外延层生长在所述高浓度重掺杂P型金刚石衬底的 正面,所述漏电极生长在所述高浓度重掺杂P型金刚石衬底的背面; 所述高浓度重掺杂p型金刚石外延层生长在所述低浓度轻掺杂p型金刚石外延层 的上表面,所述源电极生长在所述高浓度重掺杂p型金刚石外延层的上表面,所述栅介质覆 盖所述低浓度轻掺杂p型金刚石外延层的表面及所述源电极的表面,所述栅电极生长在所 述栅介质上。 本发明提供的垂直结构金刚石基金氧半场效晶体管及制备方法的有益效果在于: (1)金刚石材料击穿场强高,散热好,可以有效减小器件的散热部件体积;(2)规避金刚石n 型掺杂的激活率低的不足,通过栅压控制导通沟道的空间电荷区进而实现器件的开和关; (3)垂直结构器件可以实现大量晶胞的重复,在保证击穿电压和导通的同时,实现大的功率 输出(4)由于栅介质的存在,相比于MESFET器件,可以承受更大的反向击穿电压,正向导通 时,栅压可以在沟道处诱导产生更多的载流子,实现更低的导通电阻;(5)另一方面,由于栅 介质的存在,其截止频率没有MESFET器件高。 5 CN 111599681 A 说 明 书 3/5 页 附图说明 为了更清楚地说明本发明实施例中的技术方案,下面将对实施例或现有技术描述 中所需要使用的附图作简单地介绍,显而易见地,下面描述中的附图仅仅是本发明的一些 实施例,对于本领域普通技术人员来讲,在不付出创造性劳动的前提下,还可以根据这些附 图获得其他的附图。 图1为本发明实施例提供的垂直结构金刚石基金氧半场效应晶体管的制备工艺流 程图; 图2为本发明实施例提供的垂直结构金刚石基金氧半场效应晶体管的制备流程对 应的结构示意图。 图中:1、高浓度重掺杂p型金刚石外延层;2、低浓度轻掺杂p型金刚石外延层;3、高 浓度重掺杂P型金刚石衬底;4、漏电极;5、源电极;6、栅介质;7、栅电极。












