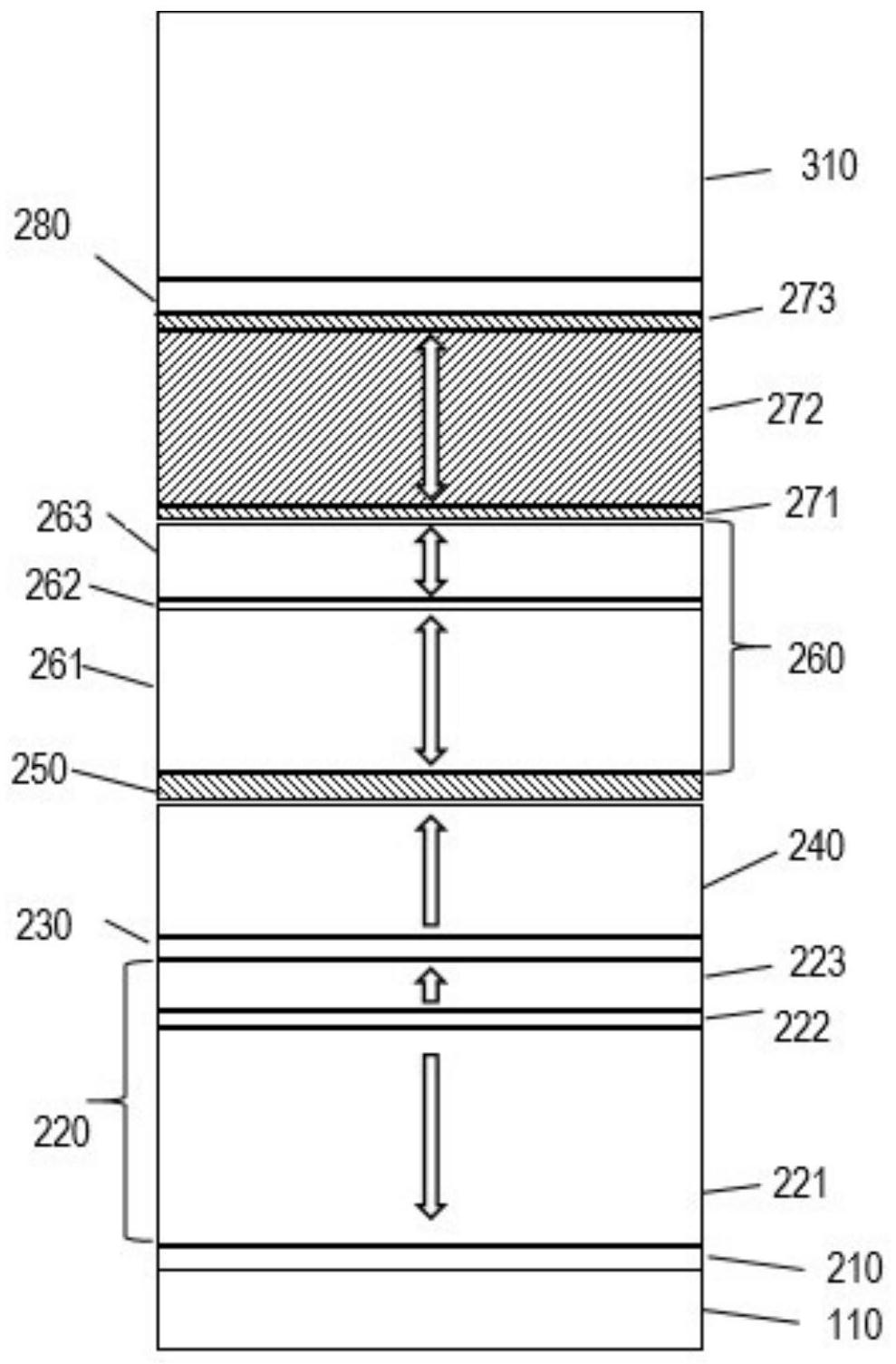
技术摘要:
本发明公开了一种磁性随机存储器存储单元及磁性随机存储器,存储单元包括层叠设置的参考层、势垒层、第一自由层,还包括第二自由层,以及其下的垂直磁耦合层和其上的磁阻尼阻挡层,第二自由层中的磁化矢量始终垂直于第一自由层,并与第一自由层中的磁化矢量平行;垂直 全部
背景技术:
近年来,采用磁性隧道结(Magnetic Tunnel Junction,MTJ)的MRAM被人们认为是 未来的固态非易失性记忆体,它具有高速读写、大容量以及低能耗的特点。铁磁性MTJ通常 为三明治结构,其中有磁性记忆层(自由层),它可以改变磁化方向以记录不同的数据;位于 中间的绝缘隧道势垒层;磁性参考层,位于隧道势垒层的另一侧,它的磁化方向不变。 为能在这种磁电阻元件中记录信息,建议使用基于自旋动量转移或称自旋转移矩 (STT,Spin Transfer Torque)转换技术的写方法,这样的MRAM称为STT-MRAM。根据磁极化 方向的不同,STT-MRAM又分为面内STT-MRAM和垂直STT-MRAM(即pSTT-MRAM),后者有更好的 性能。在具有垂直各向异性(PMA)的磁性隧道结(MTJ)中,作为存储信息的自由层,在垂直方 向拥有两个磁化方向,即:向上和向下,分别对应二进制中的“0”和“1”。在实际应用中,在读 取信息或者空置的时候,自由层的磁化方向保持不变;在写的过程中,如果有与现有不同状 态的信号输入的时候,那么自由层的磁化方向将会在垂直方向上发生180度的翻转。业界把 这种空置状态之下,磁性存储器的自由层保持磁化方向不变得能力叫做数据保存能力 (Data Retention)或者热稳定性(Thermal Stability)。在不同的应用场景中要求不一样。 对于一个典型的非易失存储器(Non-volatile Memory,NVM)的热稳定性要求是在125℃的 条件可以保存数据10年。 另外,作为磁性存储器(MRAM)的核心存储单元的MTJ,还必须和CMOS工艺相兼容, 必须能够承受在400℃条件下的长时间退火。 图1为现有的磁性随机存储器存储单元的结构示意图。自由层一般由CoFeB、CoFe/ CoFeB、Fe/CoFeB或CoFeB/(Ta,W,Mo,Hf)/CoFeB等组成,相当于本发明专利中的第一自由 层,为了提高磁性存储器的密度,近年来,磁性隧道结的关键尺寸(Critical Dimension)做 得越来越小。当尺寸进一步缩小时,会发现磁性隧道结的热稳定性(Thermal Stability Factor)急剧变差。对于超小尺寸的MRAM磁性存储单元而言,为了提高热稳定,通常可以降 低自由层的厚度,降低自由层的饱和磁化率或者增加界面各向异性。如果降低自由层的厚 度,则隧穿磁阻率(Tunnel Magnetoresistance Ration,TMR)将会降低,这将会增加读操作 时候错误率;在厚度不变的条件下,在自由层里添加或把自由层改为低饱和磁化率的材料, 同样会使TMR降低,不利于器件的读操作。
技术实现要素:
为了解决现有技术的问题,本发明提供了一种具有双层自由层的磁性随机存储器 存储单元及磁性随机存储器,在具有垂直各向异性(Perpendicular Magnetic Anisotropy,PMA)的磁性随机存储器(MRAM,Magnetic Radom Access Memory)的第一自由 4 CN 111613720 A 说 明 书 2/7 页 层和覆盖层之间穿插一层第二自由层,技术方案如下: 一方面,本发明提供了一种具有双层自由层的磁性随机存储器存储单元,包括层 叠设置的参考层、势垒层、第一自由层,还包括第二自由层,以及其下的垂直耦合层和其上 的磁阻尼阻挡层,所述第二自由层中的磁化矢量始终垂直于第一自由层界面,并与第一自 由层中的磁化矢量平行; 所述第一自由层包括层叠设置的第一自由层(I)、第一自由层(II)和第一自由层 (III),所述垂直耦合层设置在所述第一自由层与第二自由层之间,所述垂直磁耦合层用于 实现所述第一自由层与第二自由层的磁性耦合。 进一步地,所述第二自由层材料选自Fe,Co,Ni,CoFe,FeB,CoB,W,Mo,V,Nb,Cr,Hf, Ti,Zr,Ta,Sc,Y,Zn,Ru,Os,Ru,Rh,Ir,Pd,Pt或CoFeB。 进一步地,所述第二自由层具有CoFeB、CoFe/CoFeB、Fe/CoFeB、CoFeB/(W,Mo,V, Nb,Cr,Hf,Ti,Zr,Ta,Sc,Y,Zn,Ru,Os,Ru,Rh,Ir,Pd,Pt)/CoFeB,Fe/CoFeB/(W,Mo,V,Nb,Cr, Hf,Ti,Zr,Ta,Sc,Y,Zn,Ru,Os,Ru,Rh,Ir,Pd,Pt)/CoFeB、CoFe/CoFeB/(W,Mo,V,Nb,Cr,Hf, Ti,Zr,Ta,Sc,Y,Zn,Ru,Os,Ru,Rh,Ir,Pd,Pt)/CoFeB或在CoFeB、CoFe/CoFeB、Fe/CoFeB之间 多次穿插非磁性金属W,Mo,V,Nb,Cr,Hf,Ti,Zr,Ta,Sc,Y,Zn,Ru,Os,Ru,Rh,Ir,Pd或Pt的结 构。 进一步地,所述第二自由层具有CoFeB/(W,Mo,V,Nb,Cr,Hf,Ti,Zr,Ta,Sc,Y,Zn, Ru,Os,Ru,Rh,Ir,Pd,Pt)/CoFeB结构,第一层的CoFeB的厚度为0.2-1.4nm,Co:Fe的原子比 例为1:3至3:1,B的原子百分比为15%-40%;第二层的非磁性金属为W,Mo,V,Nb,Cr,Hf,Ti, Zr,Ta,Sc,Y,Zn,Ru,Os,Ru,Rh,Ir,Pd和/或Pt,其厚度为0.1-0.6nm;第三层的CoFeB的厚度 为0.2-1.0nm,Co:Fe的原子比例为1:3至3:1,B的原子百分比为15%-40%; 所述第二自由层的总厚度为0.5-2nm。 进一步地,所述势垒层由非磁性金属氧化物制成,所述非磁性金属氧化物包括 MgO,MgZnxOy,MgBxOy或MgAlxOy。 进一步地,所述第一自由层为可变磁极化,所述第一自由层(260)具有CoFeB、 CoFe/CoFeB、Fe/CoFeB、CoFeB/(W,Mo,V,Nb,Cr,Hf,Ti,Zr,Ta,Sc,Y,Zn,Ru,Os,Ru,Rh,Ir, Pd,Pt)/CoFeB、Fe/CoFeB/(W,Mo,V,Nb,Cr,Hf,Ti,Zr,Ta,Sc,Y,Zn,Ru,Os,Ru,Rh,Ir,Pd, Pt)/CoFeB或CoFe/CoFeB/(W,Mo,V,Nb,Cr,Hf,Ti,Zr,Ta,Sc,Y,Zn,Ru,Os,Ru,Rh,Ir,Pd, Pt)/CoFeB结构。 另一方面,本发明提供了一种磁性随机存储器,包括如上所述的存储单元,还包括 底电极、种子层、反平行铁磁超晶格层、晶格隔断层、覆盖层及顶电极,所述底电极、种子层、 反平行铁磁超晶格层、晶格隔断层、参考层、势垒层、第一自由层、自由层铁磁耦合层、磁阻 尼阻挡层、覆盖层及顶电极顺序层叠设置。 进一步地,所述反平行铁磁超晶格层包括下铁磁超晶格层、反平行铁磁耦合层和 上铁磁层,所述反平行铁磁超晶格层具有[Co/Pt]nCo/(Ru,Ir,Rh)、[Co/Pt]nCo/(Ru,Ir, Rh)/(Co,Co[Pt/Co]m)、[Co/Pd]nCo/(Ru,Ir,Rh)、[Co/Pt]nCo/(Ru,Ir,Rh)/(Co,Co[Pd/Co]m)、 [Co/Ni]nCo/(Ru,Ir,Rh)或[Co/Ni]nCo/(Ru,Ir,Rh)/(Co,Co[Ni/Co]m)超晶格结构。 进一步地,所述底电极由Ti、TiN、Ta、TaN、W、WN或其组合材料制成; 所述顶电极由Ta、TaN、Ti、TiN、W、WN或其组合材料制成。 5 CN 111613720 A 说 明 书 3/7 页 进一步地,所述种子层由Ta、Ti、TiN、TaN、W、WN、Ru、Pt、Ni、Cr、NiCr、CrCo、CoFeB或 其组合材料制成,所述种子层具有Ta/Ru、Ta/Pt或Ta/Pt/Ru的多层结构; 所述晶格隔断层由Ta,W,Mo,Hf,Fe,Co(Ta,W,Mo或Hf),Fe(Ta,W,Mo或Hf),FeCo (Ta,W,Mo或Hf)或FeCoB(Ta,W,Mo或Hf)制成; 所述覆盖层由W、Mo、Mg、Nb、Ru、Hf、V、Cr或Pt材料制成,所述覆盖层具有(W,Mo , Hf)/Ru双层结构或Pt/(W,Mo,Hf)/Ru三层结构。 进一步地,在所述底电极、种子层、反平行铁磁超晶格层、晶格隔断层、参考层、势 垒层、第一自由层、垂直耦合层、磁阻尼阻挡层、覆盖层和顶电极沉积之后,在400℃的温度 下进行至少90分钟的退火操作。 本发明提供的具有热稳定性增强层的磁性随机存储器存储单元能够产生以下有 益效果:本发明中额外的第二自由层的加入,并不会影响TMR,增加了自由层的厚度,降低阻 尼系数,增加热稳定性因子,而临界写电流并不会增加。 a .第二自由层和第一自由层呈现铁磁耦合,在热扰动或者外加磁场条件下,要想 使自由层磁化矢量发生翻转,就必须提供大于自由层能量壁垒和热稳定性增强层能量壁垒 之和的能量,大大提高了热稳定性; b.第二自由层的加入,对TMR没有影响; c .在沉积第二自由层之前和之后都会沉积一层非磁性金属层,其材料为:MgO , MgZnxOy,MgBxOy,MgAlxOy,其厚度分别为0.3nm~1.5nm和0.5nm~3.0nm。这样可以额外提供 一个界面各向异性的来源,从而进一步增加了热稳定;另外,由于第二自由层之上的磁阻尼 阻挡层的加入,有效降低了整个膜层结构的阻尼系数,有利于写电流的降低; d.能够经受得住400℃下的长时间退火; e.第二自由层的加入,增加了自由层的厚度,有利于在阻尼系数的降低,从而临界 写电流并不会增加。 附图说明 为了更清楚地说明本发明实施例中的技术方案,下面将对实施例描述中所需要使 用的附图作简单地介绍,显而易见地,下面描述中的附图仅仅是本发明的一些实施例,对于 本领域普通技术人员来讲,在不付出创造性劳动的前提下,还可以根据这些附图获得其他 的附图。 图1为现有技术中的磁性随机存储器存储单元的结构示意图; 图2为本发明实施例提供的磁性随机存储器存储单元结构示意图; 图3为本发明优选实施例提供的磁性随机存储器存储单元的结构示意图; 图4是本发明实施例提供的第二自由层添加前后,在外磁性场下自由层的翻转行 为对比示意图。 其中,附图标记包括:110-底电极,210-种子层,220-反平行铁磁超晶格层,221-下 铁磁层,222-反平行铁磁耦合层,223-上铁磁层,230-晶格隔断层,240-参考层,250-势垒 层,260-第一自由层,261-第一自由层(I),262-第一自由层(II),263-第一自由层(III), 271-垂直耦合层,272-第二自由层,272a-第二自由层(I),272b-第二自由层(II),272c-第 二自由层(III),273-磁阻尼阻挡层,280-覆盖层,310-顶电极。 6 CN 111613720 A 说 明 书 4/7 页












