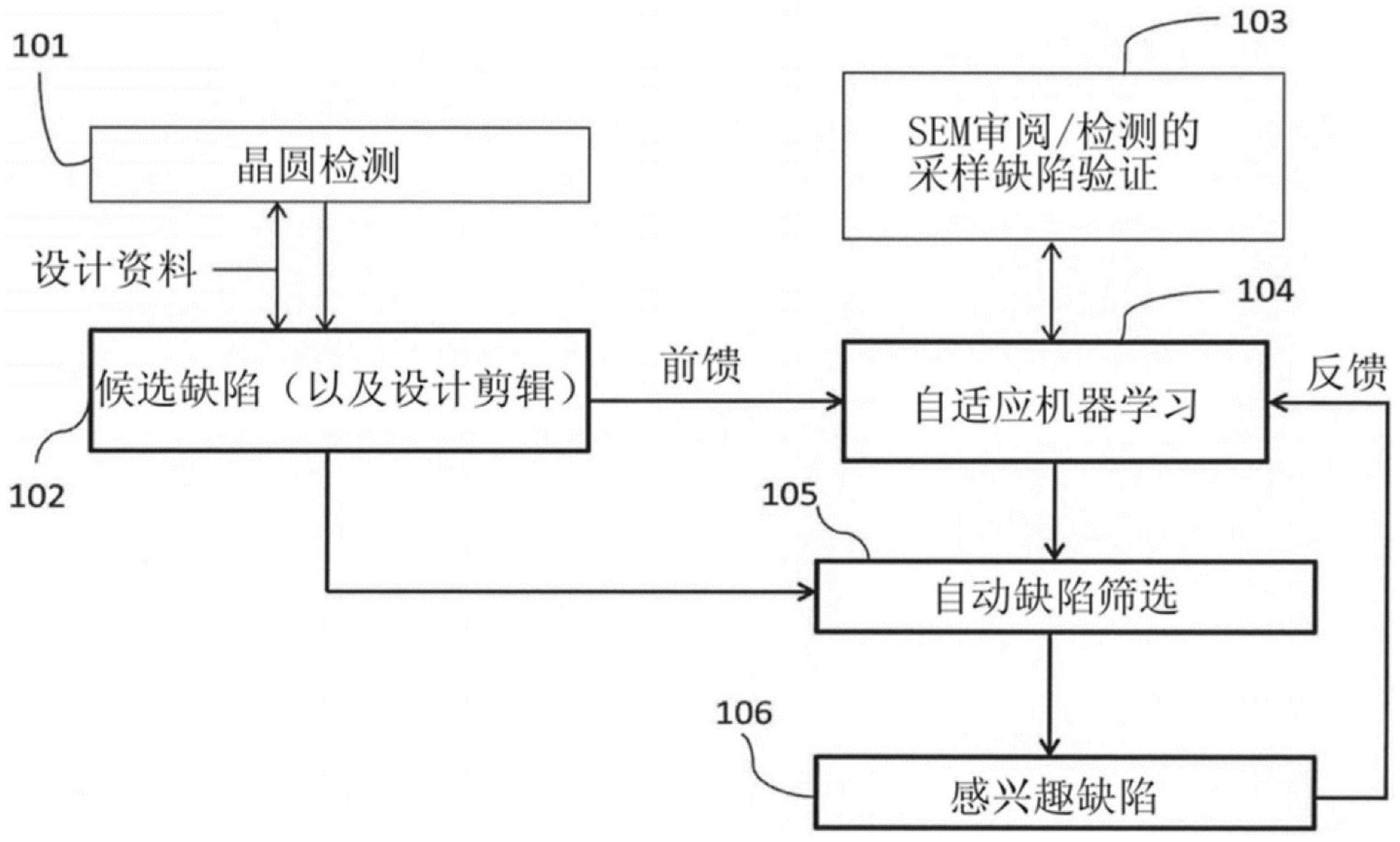
技术摘要:
一种利用自适应机器学习进行自动缺陷筛选的系统,包括了自适应模型控制器、缺陷/干扰点档案库以及用于执行资料模型化分析的模块。其中的自适应模型控制器具有前馈路径以及反馈路径,前馈路径接收晶圆检测中取得的多个候选缺陷,反馈路径接收晶圆检测后由一个以上的已知 全部
背景技术:
半导体元件的制造,是藉由将多层电路图案制作于晶圆上,以形成具有大量集成 的电晶体的一复杂电路。在半导体元件的制造流程中,微影制程是负责将电路设计人员创 造的电路图案转移到晶圆上的制程。 具有根据电路图案的不透光及透光图案的光罩/光盘用于在晶圆上将元件层图案 化。光罩上邻近图案的效应、光学绕射、光阻发展与蚀刻、对晶圆的邻近图层所进行的化学 机械抛光(chemical-mechanical polishing ,CMP),以及图案与制造在晶圆上的邻近图层 之间的几何与层叠关系都可能会造成元件层图案的变形。随着集成电路的元件密度的增 加,集成电路的图案与布局的复杂度也随之增加,此外,由图案变形所产生的系统缺陷,或 者因制程的变数而产生的随机缺陷或污染,皆会进一步导致制造在晶圆上的元件的故障。 在制造半导体元件的生产流程中,在不同图层上进行晶圆检测属于常规的流程。 其中,具有一小时内能完成一个以上的完整晶圆的产出量的光学检测,是晶圆检测领域中 的主力。在一般的晶圆检测过程中,侦测到的缺陷通常也包含了干扰点,这些干扰点属于错 误的检测结果,或者属于不感兴趣的缺陷。随着设计规则的缩小,许多关键缺陷的尺寸也变 得更小,而相较于杂讯的信号以及正常制程的变数来说,缺陷的信号也变得更弱。因此,在 先进技术的节点中,通常在能侦测到小数量的关键感兴趣缺陷之前,会先得到大量的干扰 点回报。对于半导体元件的制造商而言,要能够在制造过程中的加速与量产期间辨识出关 键缺陷,实为一大考验。 在光学检测工具中,较先进的检测配方会提供干扰点的过滤技术,藉此协助减少 干扰点的数量。为了能利用干扰点的过滤技术,使用者必须利用各种缺陷分析工具或者扫 描电子显微镜(Scanning Electron Microscope,SEM)工作站仔细分析与审阅从一个以上 的晶圆所搜集到的检测结果,藉此将各个候选缺陷标示为真实缺陷或干扰点。经标记的真 实缺陷与干扰点被用来产生一干扰点过滤器。上述的检测工具的先进配方可以利用该干扰 点过滤器来过滤干扰点。 随着元件的技术改良到20nm以下,为了能保留关键的感兴趣缺陷,即使在应用干 扰点过滤技术之后,在晶圆检测过程中侦测到的干扰点数量通常仍然代表了由光学检测工 具回报的缺陷中90%以上的数量。干扰点过滤技术的效能没有办法达到有效地过滤干扰点 的理想结果,主要有以下几个原因。 其中一个原因在于,实际上不可能从少量的检测晶圆中搜集足够用于产生干扰点 5 CN 111584397 A 说 明 书 2/8 页 过滤器的关键缺陷种类。另一原因在于,为检测所搜集的局部光学影像不能看清楚电路的 图案,其仅能提供关于先进技术节点的非常有限的资讯。此外,为了达到配合晶圆的高速生 产,检测工具所需要处理的大量资料,也会对检测过程中使用的干扰点过滤器的可负担计 算的复杂度造成限制。再者,制程容许范围中的持续变化也会改变干扰点的表现,并且会引 发新的缺陷种类,使得干扰点过滤器变得过时并且无法有效发挥作用。因此,为了不错失关 键的感兴趣缺陷,检测工具仍然需要输出大量的干扰点。 因此,在加速制造期间,必须投入大量的工程师与操作人员来透过SEM审阅工具以 肉眼审阅检测结果,藉此将关键的感兴趣缺陷筛选出来供后续诊断,进而改善制造过程的 产量。在量产期间,假设大部分的关键缺陷都已经在加速制造期间被排除,通常会采样少量 的缺陷进行扫描电子显微镜(SEM)审阅以控制制造过程。结果,半导体元件的制造有很大的 风险会在所制造的半导体元件产量受到严重影响后才发现未知的关键缺陷。
技术实现要素:
本发明的目的在于克服半导体元件的制造过程中,与晶圆检测的关键缺陷筛选相 关的前述的缺点以及挑战。据此,本发明提供了一种系统与方法,其利用自适应机器学习在 半导体元件的制造流程中进行自动缺陷筛选。 根据本发明的自适应机器学习的系统包括一自适应模型控制器、一缺陷/干扰点 档案库以及用于执行资料模型化分析的一模块。其中的自适应模型控制器从半导体元件制 造流程的前馈路径与反馈路径中接收资料、与扫描电子显微镜(SEM)审阅/检测介接、更新 缺陷/干扰点档案库、编整模型训练资料以及模型验证资料,并且将该些资料传送以执行资 料模型化分析。 自适应模型控制器包括一缺陷采样器、一SEM介面以及一训练资料与模型管理器。 缺陷采样器从前馈路径接收晶圆检测中的多个候选缺陷,并且从反馈路径中接收 在晶圆检测后,已经由一个以上的已知缺陷筛选模型筛选所得出的感兴趣缺陷。 缺陷采样器将包含采样的候选缺陷与感兴趣缺陷的资料样本传送至与SEM审阅/ 检测进行通讯的SEM介面,藉此取得对应于该些资料样本的SEM结果。每一个资料样本经过 验证,并且在对应SEM结果中被标示为真实缺陷或干扰点。 训练资料与模型管理器接收所述的资料样本以及对应SEM结果、建立并更新一缺 陷/干扰点档案库,并且为资料模型化分析编整模型训练资料与模型验证资料,藉此产生作 为自动缺陷筛选的缺陷筛选模型的资料模型。在自动缺陷筛选的初始阶段中,系统执行自 适应机器学习的数个连续巡回,藉此基于一目标规格建立一个以上的缺陷筛选模型。缺陷 采样器持续接收前馈与反馈资料,以供训练资料与模型控制器控制透过资料模型化分析更 新缺陷筛选模型的时机。 本发明进一步提供一关键特征档案库,其与资料模型化分析介接以执行关键特征 分析,并且为自动缺陷筛选产生关键特征模型。关键特征档案库包括多个关键特征资料库。 每一个关键特征资料库中储存了多数量的关键电路图案、相关联的设计剪辑、缺 陷特征、局部光学影像、SEM影像以及对应的关键特征模型。 6 CN 111584397 A 说 明 书 3/8 页 附图说明 图1是显示根据本发明的在半导体元件的制造流程中利用自适应机器学习的自动 缺陷筛选的方块图; 图2是显示根据本发明的用于执行自动缺陷筛选的自适应机器学习的系统的方块 图; 图3是显示根据本发明的自适应机器学习中的自适应模块控制器的方块图; 图4是显示根据本发明的利用自适应机器学习的自动缺陷筛选,进一步与一关键 特征档案库介接的示意图; 图5是显示自适应机器学习参考关键特征档案库利用关键特征分析产生关键特征 模型的示意图; 图6是显示关键特征档案库包括数个关键特征资料库的示意图;以及 图7是显示根据本发明的用于执行自动缺陷筛选的自适应机器学习的方法的流程 图。 其中,附图标记说明如下: 101 晶圆检测 102 候选缺陷 103 SEM审阅/检测 104 自适应机器学习 105 自动缺陷筛选 106 感兴趣缺陷 200 缺陷/干扰点档案库 201 自适应模型控制器 202 模型训练资料 203 模型验证资料 204 资料模型化分析 205 缺陷筛选模型/资料模型 301 缺陷采样器 302 SEM介面 303 训练资料与模型管理器 400 关键特征档案库 504 关键特征分析 505 关键特征模型 601 关键特征资料库 701 步骤 702 步骤 703 步骤












